Проектирование КМОП-КНС-ИМ с поликремниевыми затворами
Содержание
Введение
1. Разработка технологического процесса изготовления
КМОП-КНС-ИМ с поликремниевыми затворами
1.1 Подготовка поверхности подложки
.2 Эпитаксия
.3 Термическое оксидирование
.4 Нанесение фоторезиста
.5 Совмещение и экспонирование фоторезиста
.6 Проявление и задубливание фоторезиста
.7 Травление SiO2
.8 Удаление фоторезиста
.9 Локальное травление
.10 Удаление SiO2
.11 Термическое оксидирование
.12 Вторая фотолитография
.13 Ионное легирование фосфором
.14 Удаление SiO2
.15 Термическое оксидирование
.16 Наращивание поликристаллического кремния
.17 Третья фотолитография
.18 Нанесение ФСС
.19 Четвертая фотолитография
.20 Нанесение БСС
.21 Пятая фотолитография
.22 Диффузия
.23 Удаление ФСС и БСС
.24 Термическое оксидирование
.25 Шестая фотолитография
.26 Напыление Al
.27 Седьмая фотолитография
2. Технологические операции изготовления КМОП-КНС-ИМ с
поликремниевыми затворами
2.1 Гетероэпитаксия
.2 Термическое оксидирование
.3 Первая фотолитография
.4 Локальное травление
.5 Удаление SiO2
.6 Термическое оксидирование
.7 Вторая фотолитография
.8 Ионное легирование фосфором
.9 Удаление SiO2
.10 Термическое оксидирование
.12 Наращивание поликристаллического кремния
.12 Третья фотолитография
.13 Нанесение ФСС
.14 Четвертая фотолитография
.15 Нанесение БСС
.16 Пятая фотолитография
.17 Диффузия
.18 Удаление ФСС и БСС
.19 Термическое оксидирование
.20 Шестая фотолитография
.21 Напыление Al
.22 Седьмая фотолитография
3. Технологическая операция “Снятие фоторезиста”
3.1 Назначение и сущность операции
.2 Оборудование
.3 Материалы и оснастка
.4 Подготовка рабочего места
.5 Контрольный процесс
.6 Технологический процесс
Заключение
Литература
Введение
В способе формирования КМОП-структур с поликремниевым затвором на
полупроводниковой пластине первого типа проводимости формируют области второго
типа проводимости. Формируют окисный слой, затем проводят его селективное
травление в областях каналов p- и n-канальных транзисторов и областях стоков и
истоков p-канальных транзисторов. Формируют подзатворный диэлектрик в вытравленных
областях, осаждают слой поликремния, формируют на нем фоторезистивную маску,
удаляют незащищенный маской поликремний, легируют примесью второго типа
проводимости области стоков и истоков p-канальных транзисторов. Формируют маску
для легирования примесью первого типа проводимости путем удаления слоя окисла
над областями стоков и истоков n-канальных транзисторов, а легирование
поликремния проводят одновременно с легированием областей истока и стока
n-канальных транзисторов, после чего проводят окисление поликремниевых
затворов.
Изобретение относится к микроэлектронике, в частности к способам создания
полупроводниковых интегральных КМОП-схем.
Известен способ изготовления КМОП-структур, включающий формирование на
полупроводниковой пластине первого типа проводимости областей второго типа
проводимости (карманов), формирование окисного слоя, формирование в
вытравленных областях подзатворного диэлектрика. Осаждение слоя
поликристаллического кремния, легирование поликремния, формирование
фоторезистивной маски на поликремнии, соответствующей топологическому рисунку
затвора, удаление незащищенного маской поликремния, удаление фоторезистивной
маски, формирование фоторезистивной маски, травление подзатворного диэлектрика
в областях стоков и истоков р-канальных транзисторов, удаление маски, осаждение
окисной пленки, легированной примесью, создающей тип проводимости,
противоположный типу проводимости "кармана", формирование
фоторезистивной маски и удаление части окисного слоя за пределами "кармана",
удаление маски фоторезиста и проведение селективной диффузии примеси из окисной
пленки в подложку с целью создания областей стоков и истоков транзисторов,
расположенных в области "карманов", введение примеси в подложку,
используя окисную пленку в качестве маски с целью формирования областей стоков
и истоков транзисторов, расположенных за пределами "кармана",
удаление окисной пленки, осаждение диэлектрического слоя на всю поверхность
подложки. Недостатком данного способа является большая длительность формированного
КМОП-структур и высокий расход дорогостоящих веществ, обусловленные
необходимостью неоднократного травления и осаждения окисных слоев.
1. Разработка технологического процесса
изготовления КМОП-КНС-ИМ с поликремниевыми затворами
1.1
Подготовка поверхности подложки

Рисунок 1 - Подготовка поверхности подложки
1.2 Эпитаксия

Рисунок 2 - Эпитаксия
1.3
Термическое оксидирование

1.4 Нанесение
фоторезиста

Рисунок 4 - Нанесение фоторезиста
1.5
Совмещение и экспонирование фоторезиста

Рисунок 5 - Совмещение и экспонирование фоторезиста
1.6
Проявление и задубливание фоторезиста

Рисунок 6 - Проявление и задубливание фоторезиста
1.7 Травление
SiO2

Рисунок 7 - Травление SiO2
1.8 Удаление
фоторезиста

Рисунок 8 - Удаление фоторезиста
1.9 Локальное
травление

Рисунок 9 - Локальное травление
1.10 Удаление
SiO2

Рисунок 10 - Удаление SiO2
1.11
Термическое оксидирование

Рисунок 11 - Термическое оксидирование
1.12 Вторая
фотолитография

Рисунок 12 - Вторая фотолитография
1.13 Ионное
легирование фосфором

Рисунок 13 - Ионное легирование фосфором
1.14 Удаление
SiO2

Рисунок 14 - Удаление SiO2
1.15
Термическое оксидирование

Рисунок 15 - Термическое оксидирование
1.16
Наращивание поликристаллического кремния

Рисунок 16 - Наращивание поликристаллического кремния
1.17 Третья
фотолитография
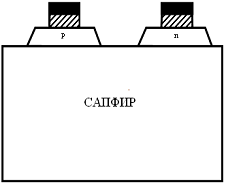
Рисунок 17 - Третья фотолитография
1.18
Нанесение ФСС

Рисунок 18 - Нанесение ФСС
1.19
Четвертая фотолитография
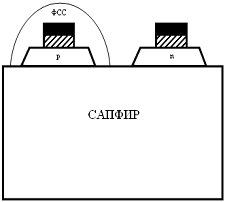
Рисунок 19 - Четвертая фотолитография
1.20
Нанесение БСС
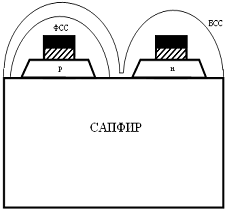
Рисунок 20 - Нанесение БСС
1.21 Пятая
фотолитография

Рисунок 21 - Пятая фотолитография
1.22 Диффузия
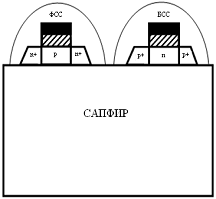
Рисунок 22 - Диффузия
1.23 Удаление
ФСС и БСС

Рисунок 23 - Удаление ФСС и БСС
1.24
Термическое оксидирование

Рисунок 24 - Термическое оксидирование
1.25 Шестая
фотолитография

Рисунок 25 - Шестая фотолитография
1.26
Напыление Al

Рисунок 26 - Напыление Al
1.27 Седьмая фотолитография

Рисунок 27 - Седьмая фотолитография
2
Технологические операции изготовления КМОП-КНС-ИМ с поликремниевыми затворами
.1 Гетероэпитаксия
Данная операция предназначена для наращивания слоя кремния на сапфире.
Для начала с помощью вакуумного пинцета переместить пластины из
транспортной кассеты в кварцевую лодочку и нажать кнопку «пуск». На
программаторе задать температуру в реакторе 750ºC и продуть камеру азотом.
Операцию проводить 20 минут.
После окончания процесса с помощью вакуумного пинцета переместить
пластины из кварцевой лодочки в транспортировочную кассету.
Заполнить сопроводительный лист и передать партию на следующую операцию.
2.2 Термическое оксидирование
Данная операция предназначена для создания оксидной пленки на поверхности
кремниевой подложки.
Для начала поместить пластины из транспортировочной кассеты в пазы
кварцевой кассеты - лодочки и лодочку с пластинами установить на площадку
загрузочного устройства установки. Запрограммировать: предварительную температуру
1050 ºC, рабочую температуру 1200 ºC, загрузка пластин со скоростью 30
см/мин, нагрев печи со скоростью 20 ºC/мин, подача сухой - влажный - сухой O2, время выдержки 1 час, охлаждение
печи 8 ºC/мин, выгрузка пластин 30 см/мин.
Запустить программатор.
С запуском программатора автоматически выполняются технологические
переходы оксидирования: продувка камеры азотом, нагрев рабочей зоны до
предварительной температуры 1050ºC, загрузка лодочки с пластинами в
рабочую зону установки кварцевым толкателем со скоростью 30 см/мин, нагрев печи
со скоростью 20ºC/мин до рабочей температуры 1200 ºC, подача парогазовой смеси сухой -
влажный - сухой O2, выдержка
пластин в течении 1 часа, охлаждение печи со скоростью 8 ºC/мин, выгрузка пластин кварцевым
толкателем со скоростью 30 см/мин.
После выгрузки пластин, переставить их в транспортировочную кассету. Заполнить сопроводительный лист.
2.3 Первая фотолитография
Данная операция предназначена для вскрытия окон, через которые проводят
локальную диффузию. Для получения, скрытого n-слоя.
Технологический процесс выполнения фотолитографии описан ниже.
Нанесение фоторезиста
Данная операция предназначена для получения соответствующего фотошаблону
расположения окон, для доступа травящих веществ к пластине кремния.
В начале процесса нужно пересыпать пластины из транспортировочной кассеты
в рабочую, затем поставить рабочую кассету на платформу устройства загрузки
выгрузки. В устройстве загрузки выгрузки пластина по пассикам перемещается на
полки каретки. Пластина нажимает на рычаг датчика. По сигналу датчика каретка с
пластиной перемещается к вакуумному столику центрифуги, с которого упорами
каретки предварительно выгружена предыдущая пластина. При движении каретки
назад, с помощью фиксатора пластина останавливается. Дальнейшее движение
каретки приводит к тому, что полки выезжают из-под пластины, которая опускается
на вакуумный столик. Далее на подложку наносят несколько капель фоторезиста, и
мгновенно включается центрифуга, так как вязкость фоторезиста быстро меняется
из-за испарения растворителя. При вращении центрифуги, жидкий фоторезист
растекается по поверхности пластины под действием центробежных сил. Применение
пластин кремния с периферийной фаской и работа при частотах вращения
центрифуги, больших 2000 об/мин, позволяет получить более плоскую поверхность
фотослоя.
После нанесения фоторезиста, пластина по пассикам перемещается в кассету.
Термообработка (первая сушка)
Данная операция предназначена для удаления растворителя из пленки
фоторезиста.
В начале процесса нужно поставить кассету в термостат, затем закрыть
дверцу термостата и нажать кнопку «Пуск». Основными параметрами процесса сушки
является температура и время. Для равномерного испарения растворителя и
снижения внутренних механических напряжений в фотослое сушку выполняют в два
этапа: (15 - 20) мин при (18 - 20)ºC, (30 - 60) мин при (90 - 120)
ºC.
После сушки пластины помещаются в пазы кассеты.
Совмещение и экспонирование фоторезиста
В начале процесса установить рабочую кассету с пластинами на платформу
загрузки установки ЭМ-576, установить пустую кассету на платформу выгрузки
установки ЭМ-576.
Подложки из кассеты по пневмомолотку поступают на позицию предварительной
ориентации, где производится базирование подложки по ее базовому срезу.
После завершения предварительной ориентации подложка вместе со столиком
поднимается вверх и прижимается к опорным выступам калибратора, подложка
фиксируется вакуумом на калибраторе, переносится им на рабочую позицию и
закрепляется на вакуумном подложкодержателе. Производится глубокое совмещение.
При больших перемещениях совместить фигуры совмещения. Выполнить очное
совмещение. В пределах существенно меньших перемещений с помощью фигур
совмещения. После чего нужно:
устранить зазор между фотошаблоном и пластиной;
провести экспонирование.
После выполнения операций совмещения и экспонирования подложка по
пневмомолотку подается в приемную кассету;
Проявление фоторезиста
Данная операция предназначена для удаления фоторезиста с засвеченных
областей.
Для начала нужно погрузить кассету с пластинами в раствор проявителя,
затем в качестве проявителей применить слабые водные и водно-глицериновые
щелочные растворы KOH, NaOH, Na3PO4*12H2O. Если слой проэкспонирован не полностью, раствор
окрашивается в малиновый цвет, так как часть молекул кислоты превращается в
соль натрия, а соединяется с неразрешенными молекулами НХД, образуя краситель.
В конце промыть пластины в потоке деионизованной воды.
Термообработка (вторая сушка)
Данная операция предназначена для полного удаления растворителя из пленки
фоторезиста.
Для начала поместим пластины в устройство термообработки, затем
проводится вторая сушка для удаления проявителя, воды , повышения химической стойкости
и адгезии фотомаски к подложке. Чтобы не произошло ухудшение качества
фотомаски. Сушку проводят в два - три этапа с постепенным подъемом температуры
до максимальной. Максимальная температура второй сушки 150 ºC, общее время 1,5 часа.
Травление SiO2
Данная операция предназначена для передачи изображения с фотомаски на
диоксид кремния путем травления.
Для начала погрузим кассету с пластинами в раствор HF: NH4F:H2O. Затем диссонирующий в растворе фторид аммония связывает
газообразный тетрафторид кремния в устойчивый ион, что предотвращает бурное
выделение пузырьков тетрафторида кремния, которые оказывают гидромеханическое
воздействие на фотомаску и способствует ее отслаиванию.
Промыть пластины в деионизованной воде.
Жидкостное удаление фотомаски
Данная операция предназначена для удаления фотомаски.
Для начала проведем жидкостное удаление фотомаски в серно-пероксидном
растворе. Затем нужно удалить фотомаску с диоксида кремния. Далее промыть
пластины деионизованной водой.
Пересыпать пластины из рабочей кассеты в транспортировочную.
Заполнить сопроводительный лист.
2.4 Локальное травление
Данная операция предназначена для передачи изображения с фотомаски на
диоксид кремния путем травления.
Для начала погрузим кассету с пластинами в раствор HF. Затем диссонирующий в растворе
фторид аммония связывает газообразный тетрафторид кремния в устойчивый ион, что
предотвращает бурное выделение пузырьков тетрафторида кремния, которые
оказывают гидромеханическое воздействие на маску и способствует ее отслаиванию.
Промыть пластины в деионизованной воде.
2.5 Удаление SiO2
Данная операция предназначена для удаления кремния путем травления.
Погружаем кассету с пластинами в раствор HF: NH4F:H2O. Диссонирующий в
растворе фторид аммония связывает газообразный тетрафторид кремния в устойчивый
ион, что предотвращает бурное выделение пузырьков тетрафторида кремния, которые
оказывают гидромеханическое воздействие на фотомаску и способствует ее
отслаиванию.
Затем промыть пластины в деионизованной воде.
Заполнить сопроводительный лист и передать партию на следующую операцию.
2.6 Термическое оксидирование
Данная операция предназначена для создания оксидной пленки на поверхности
кремниевой подложки.
Для начала поместим пластины из транспортировочной кассеты в пазы
кварцевой кассеты - лодочки. Далее лодочку с пластинами установить на площадку
загрузочного устройства установки.
Запрограммировать устройство и запустить программатор. С запуском
программатора автоматически выполняются технологические переходы оксидирования:
продувка камеры азотом, нагрев рабочей зоны до предварительной температуры 1050ºC, загрузка лодочки с пластинами в
рабочую зону установки кварцевым толкателем со скоростью 30 см/мин, нагрев печи
со скоростью 20ºC/мин до рабочей температуры 1200 ºC, подача парогазовой смеси сухой -
влажный - сухой O2, выдержка
пластин в течении 1 часа, охлаждение печи со скоростью 8 ºC/мин. Выгрузка пластин кварцевым
толкателем со скоростью 30 см/мин.
После выгрузки пластин, переставить их в транспортировочную кассету;
Заполнить сопроводительный лист.
2.7 Вторая фотолитография
Данная операция предназначена для создания окна для проведения операции
ионного легирования.
Операция выполняется в соответствии с п. 2.4 пояснительной записки.
2.8 Ионное легирование фосфором
Данная операция предназначена для образования высоколегированного n - скрытого слоя.
Для начала пластины из транспортной кассеты с помощью вакуумного пинцета
нужно поставить в пазы кварцевой кассеты-лодочки, планарной стороной друг к
другу через один паз. Затем установить кварцевую лодочку на загрузочное
устройство установки и на программаторе выставить значения: предварительную
температуру 1050ºC, рабочую температуру 1200 ºC. Далее запустить.
По завершению поместить пластины из кассеты-лодочки в транспортировочную
кассету. Заполнить сопроводительный лист.
2.9 Удаление SiO2
Операция выполняется в соответствии с п. 2.6 пояснительной записки
2.10 Термическое оксидирование
Операция выполняется в соответствии с п. 2.3 пояснительной записки.
2.11 Наращивание поликристаллического
кремния
Данная операция предназначена для заполнения канавок поликристаллическим
кремнием.
Для начала с помощью вакуумного пинцета переместить пластины из
транспортной кассеты в кварцевую лодочку и нажимаем кнопку «пуск». Лодочка с
пластинами переместится в рабочую камеру. На программаторе задаем температуру в
реакторе 400ºC. Главное камеру продуть азотом.
В качестве получения поликристаллической пленки используется тетрохлорид,
который при температуре до 1000 ºC осаждает поликристаллическую пленку.
Операцию проводить один час.
После окончания операции заполнить сопроводительный лист и передать
партию на следующую операцию.
2.12 Третья фотолитография
Данная операция предназначена для проведения операции нанесение ФСС.
Операция выполняется в соответствии с п. 2.4 пояснительной записки.
2.13 Нанесение ФСС
Силикатное стекло имеет повышенную теплостойкость и твердость, но мало
применимо из-за хрупкости и трудности придания ему формы, имеющей сложную
кривизну.
Для начала пластины помещаем в центрифугу и начинаем центрифугирование и
за счет центробежных сил раствор разбивается на мелко дисперсионные (менее 10
мкм) капли композиции. На металлической площадке под головкой находится
полупроводниковая пластина, на которую подается противоположный потенциал. Заряженные
капли золь-гель раствора двигаются по направлению к пластине и конформно и
равномерно наносятся по всей плоскости пластин. Для качественного испарения
спиртов, входящих в состав золь-геля, пластины предварительно подогреваются с
помощью нагревателя до 45°С.
Заполнить сопроводительный лист и передать партию на следующую операцию.
2.14 Четвертая фотолитография
Данная операция предназначена для проведения операции нанесение БСС. Операция выполняется в соответствии с п. 2.4 пояснительной
записки.
2.15 Нанесение БСС
Силикатное стекло имеет повышенную теплостойкость и твердость, но мало
применимо из-за хрупкости и трудности придания ему формы, имеющей сложную
кривизну.
Для начала пластины помещаются в центрифуга и начинают центрифугирование
и за счет центробежных сил раствор разбивается на мелко дисперсионные (менее 10
мкм) капли композиции. На металлической площадке под головкой находится
полупроводниковая пластина, на которую подается противоположный потенциал.
Заряженные капли золь-гель раствора двигаются по направлению к пластине и
конформно и равномерно наносятся по всей плоскости пластин. Для качественного
испарения спиртов, входящих в состав золь-геля, пластины предварительно
подогреваются с помощью нагревателя до 45°С. Заполняем сопроводительный лист и
передать партию на следующую операцию.
2.16 Пятая фотолитография
Данная операция предназначена для создания окна для проведения операции
для операции диффузия.
Операция выполняется в соответствии с п. 2.4 пояснительной записки.
2.17 Диффузия
Данная операция предназначена для образования высоколегированного n+, p+ - скрытых слоев.
Для начала пластины из транспортной кассеты с помощью вакуумного пинцета
поставить в пазы кварцевой кассеты-лодочки, планарной стороной друг к другу
через один паз. В паз между пластинами устанавливаем пластину легированного
сурьмой. Затем устанавливаем кварцевую лодочку на загрузочное устройство
установки.
На программаторе выставляем значения: предварительную температуру 1050ºC, рабочую температуру 1200 ºC, загрузка пластин со скоростью
30см/мин, нагрев печи со скоростью 20 ºC/мин, время диффузии два часа,
охлаждение печи 8 ºC/мин, выгрузка пластин 30см/мин.
Запускаем программатор.
После окончания операции помещаем пластины из кассеты-лодочки в
транспортировочную кассету.
Заполняем сопроводительный лист.
2.18 Удаление ФСС и БСС
Это операция служит для удаления ФСС и БСС.
Для начала погружаем кассету с пластинами в раствор HF: NH4F:H2O.
Диссонирующий в растворе фторид аммония связывает газообразный
тетрафторид кремния в устойчивый ион, что предотвращает бурное выделение
пузырьков тетрафторида кремния, которые оказывают гидромеханическое воздействие
на ФСС и БСС и способствует ее отслаиванию.
Промыть пластины в деионизованной воде.
Заполнить сопроводительный лист и передать партию на следующую операцию.
2.19 Термическое оксидирование
Операция выполняется в соответствии с п. 2.3 пояснительной записки.
2.20 Шестая фотолитография
Данная операция предназначена для проведения операции напыления Al. Операция
выполняется в соответствии с п. 2.4 пояснительной записки.
2.21 Напыление Al
Это операция служит для напыления металла на поверхность пластины.
Для начала перемещаем пластины в рабочую кассету и погружаем на
платформу. Затем задаем нужную программу на панели управления. После окончания
операции переместить пластины в транспортировочную кассету.
2.22 Седьмая фотолитография
Операция выполняется в соответствии с п. 2.4 пояснительной записки.
3. Технологическая операция “Снятие
фоторезиста”
Фотолитография - метод получения определенного рисунка а поверхности
материала, широко используемый в микроэлектронике и других видах
микротехнологий. Один из основных приемов планарной технологии, используемой в
производстве полупроводниковых приборов.
3.1
Назначение и сущность операции
Настоящая операция предназначена для удаления защитной маски фоторезиста
с полупроводниковых пластин химическим методом.
Снятия фоторезиста м кремния, окисла кремния, поликремния, нитрида
кремния проводиться в смеси КАРО (смеси серной кислоты и перекиси водорода) с
последующей отмывкой ПАР-5 (перекисно-аммиачном растворе).
Снятия фоторезиста с металла, контактов между металлами, ванадия и
пассивации проводиться в смеси диметилформамида с моноэтанолами.
3.2
Оборудование
Установка химической обработки А1 ЩЦМ 3.240.023 предназначена для
объемной химической обработки кремниевых пластин в различных невзрывоопасных
химических реактивах с последующей промывкой в деионизованной воде.
В установке пластины обрабатываются групповым методом в тефлоновых
импортных кассетах типа KM-40N.
В каждой ванне одновременно могут обрабатываться две кассеты с пластинами
100 мм.
Питание установки осуществляется от трехфазной четырехпроводной сети
переменного тока напряжением 380В и 220В частоты 50 Гц.
Установка должна быть подключена к вытяжной вентиляции производительности
не менее 1500 м3/ч.
Так же в ней содержаться установки сушки. Установка сушки предназначена
для сушки пластин центрифугированием в среде нагретого азота.
В установке пластины обрабатываются групповым методом в стандартных
фторопластовых кассетах.
Установка не является источником радиопомех.
3.3 Материалы
и оснастка
Таблица 1 - Материалы и оснастка
|
Материалы и оснастка
|
Государственный стандарт
|
|
Кислота кремниевая
|
дРО.038.845 МК
|
|
Перекись водородная
|
дРО.038.845 МК
|
|
Демитилформамид “ч”
|
ГОСТ 20289-74
|
|
Спирт этиловый технический
высший сорт
|
ГОСТ 18300-87
|
|
Ткань хлопчатобумажная
|
ГОСТ29298-1005
|
|
Пинцет
|
7690-8200
|
|
Пенал
|
7800-4845
|
|
Контейнер
|
7800-7726
|
|
Флакон цилиндрический
|
ТУ6-19-110-78
|
|
Перчатки резиновые
|
ГОСТ 20010-93
|
|
Напальчники резиновые
|
ТУ38 106567-88
|
|
Одежда и принадлежности
технологические
|
СТПТ4.7-96
|
|
Воздух
|
СТПТ4.34-96
|
|
Вода деионизованная марки А
|
СТПТ4.59-2011
|
|
Азот
|
СТПТ4.34-96
|
3.4
Подготовка рабочего места
Технологическая одежда травильщика должна соответствовать требованиям.
Не допускается загромождать рабочее место лишними предметами, не
выполнять лишних движений в чистой зоне, не наклоняться над пластинами.
Подготовить установки химической обработки, установки обработки в
органических растворителях, установки отмывки и сушки согласно технологической
инструкции.
Использовать растворы согласно таблице:
Таблица 2 - Виды снятия
|
Вид снятия
|
Обрабатываемые слои
|
|
Смесь КАРО + ПАР-5
|
Знаки совмещения, карман,
подлегирование подложки, подлегирование, контакты 1, легирование поликремния,
затвор, травление поликремния с обратной стороны, подлегирования кармана,
глубокий коллектор, разделение, база, эмиттер, резистор, конденсатор.
|
|
Смесь КАРО + ПАР-5
|
Исток-сток n-канального
транзистора, исток-сток p-канального транзистора, слои с ионным легированием
(энэргия более 60 кэВ).
|
|
Смесь КАРО
|
Слои с СТФСС и БФСС.
|
|
Смесь диметилформамида с
моноэтаноламином
|
Металлизация, межслойные
контакты, пассивация.
|
3.5
Контрольный процесс
При несоответствии с мерами вернуть на предыдущую операцию.
Проинформировать технолога или мастера, партию взять в работу после устранения
несоответствия.
3.6
Технологический процесс снятия фоторезиста
Снятия фоторезиста в смеси серной кислоты и перекиси водорода и перекисно
- аммиачном растворе:
) залить в ванну серную кислоту в количестве 7.5 л в каждую ванну.
) подогреть серную кислоту до температуры (135±10)°С;
) долить в каждую ванну по 0.5 л перекиси водорода;
) убедиться по сопроводительному листу, что все предыдущие операции
выполнены и срок хранения пластин соответствует дРо.045.500;
) записать в лист время начала операции;
) открыть крышку контейнера и перезагрузить пластины с помощью пинцета
или перегрузчика в рабочую кассету;
) поместить кассеты с (помощью захвата) с пластинами в первую ванну со
смесью и выдержать 1 мин, контролируя время по секундомеру;
) перенести кассеты с пластинами с помощью захвата в ванну установки с
горячей водой и выдержать пластины 3 мин. Контролировать температуру с помощью
термометра;
) перенести кассету с пластиной в первую ванну рецикла установки и отмыть
до дельного сопротивления не менее 5мОм;
) перенести кассету с пластиной в другую ванну рецикла и отмывать 15 мОм,
но не менее 5 мин;
) поместить пластины в ванну с ПАР-5 и выдержать 2 мин. В ванне
обрабатывать не более 1000 пластин;
) перенести кассету с пластинами в стоп-ванну, наполненную водой. Промыть
пластину до слива воды из ванны и заполнения ее с помощью душа;
) перенести с помощью захвата кассету с пластиной к установки отмывки и
сушки;
) открыть крышку центрифуги и поместить кассету с пластинами. При
обработке пластин в установке отмывке и сушки противостоящие кассеты должны
быть уравновешенны балластами. Разница в противостоящих кассетах не
допускается;
) провести процесс сушки пластин в автоматическом режиме.
) открыть крышку центрифуги после окончания сушки и извлечь кассеты с пластинами;
) поместить пластины с помощью пинцета или перегрузчика из рабочей
кассеты в транспортную;
) поместить транспортную кассету в контейнер и перенести в установку
контроля;
) проконтролировать 3 пластины из партии на качество снятия фоторезиста;
) повторить переходы 14-18 для всех пластин партии при обнаружении
несоответствия качества хотя бы на одной пластине;
) заполнить сопроводительный лист, проверив соответствия номера партии и
сопроводительного листа. Пластины в кассетах должны быть расположены, по
возрастанию номеров в соответствии с номерами пазов кассет планарной стороны к
этикетки на контейнере с номером партии;
) ввести информацию в АСОУКП;
) слить смесь серной кислоты с перекисью водорода из каждой ванны после
снятия 1100 пластин;
) выполнять переходы 4-22 для всех последующих партий пластин;
) вести учет количества обработанных пластин в журнале по форме.
Снятия фоторезиста в смеси демитилформамида и моноэтаноламина:
) повторить переходы 4-6;
) поместить захватом кассету с пластинами в отсек ванны с холодным
демитилформамидом;
) выдержать кассету с пластинами в демитилформамиде в течении 6 мин,
Контролируя время по секундомеру;
) перенести захватом кассету с пластинами в отсек с кипящей смесью
демитилформамида с моноэтаноламином и выдержать в течении 8 мин;
) перенести захватом кассету с пластинами в следующую ванну с холодным
демитилформамидом и сделать пять-семь окунаний;
) перенести кассету с пластинами в ванну с горячей водой при температуре
(55±10)°С, сделать пять-семь окунаний и перенести в ванну с холодной водой.
Промыть пластины 15 мин, кроме слоя “Пассивация”. Данный слой промывать не
более 4 мин;
) повторить переходы 16-25.
Заключение
поликремниевый
оксидирование фотолитография
В данной курсовой работе я разработал КМОП-КНС-ИМ с поликремниевыми
затворами. Для создания данной ИМ мне потребовалось 27 операций, из которых 7
фотолитографий.
Основные факторы, ограничивающие стоимость и качество КМОП - КНС- ИМ:
высокая стоимость сапфира, сложность его механической обработки, связанная с большой
твердостью, жесткие требования к качеству подготовки поверхности из-за
несовместимости кристаллической решетки с кремниевой. Все это привело к
появлению большого числа работ по созданию структур “кремний на аморфных
подложках”.
Наряду с приведенными технологическими процессами, существуют и другие.
Следует отметить, что технология ИМ непрерывно совершенствуется, постоянно идет
поиск новых конструктивно- технических решений.
Литература
1. Зи, С. Технология СБИС: В 2 т./ С.Зи. - M. : Мир, 1986. Т.
1-2. 2.
. Степаненко, И. П. Основы микроэлектроники : [учебное
пособие] / И. П. Степаненко. 2-е изд. - М. : Лаборатория базовых знаний, 2004.
- 488 с. : ил. (Технический университет). ISBN 5-93208-045-0 : 24485-00.
. Рындин, Е. А. Субмикронные интегральные схемы: элементная
база и проектирование. /Е. А. Рындин, Б.Г. Коноплев. - Таганрог, 2001. - 146 с.
. Моро, У. Микролитография. В 2-х ч. / У. Моро. Пер. с англ.
- М.: Мир, 1990. Ч 1- 605 с., Ч 2 - 632 с. 5.
.Плазменная технология в производстве СБИС. Пер. с англ. под
ред. Н. Айспрука, Д. Брауна. - М.: Мир, 1987. - 470 с.
. Черных, А. Г. Технологические маршруты изготовления ИС [+
электр. вариант] : лаб. практикум по курсам "Маршрутная технология
ИС" и "Технологические процессы микроэлектроники" для студ.
спец. 1-41 01 02 "Микрои наноэлектронные технологии и системы" и 1-41
01 03 "Квантовые информационные системы" всех форм обучения / А. Г.
Черных, С. В. Ригольд. - Мн. : БГУИР, 2006. - 35 с. (Кафедра микрои
наноэлектроники). ISBN 985488-016-8 : б/ц
. Черных, А. Г. Технология изготовления КМОП-транзисторов [+
электр. вариант] : метод. пособие по дисц. "Технологические процессы
микроэлектроники" для студ. спец. 1-41 01 03 "Квантовые
информационные системы" дневной формы обучения / А. Г. Черных, Д. А.
Котов. - Мн. : БГУИР, 2008. - 47 22 с. : ил. (Кафедра микрои наноэлектроники).
ISBN 978-985-488-351-9 : 654400.
. Моро У. Микролитография : принципы, методы, материалы : в 2
ч. Ч. 1 / У. Моро ; пер. с англ. - М. : Мир, 1990. - 606 с. : ил. ISBN
5-03-001716-Х : 8100-00.
. Моро У. Микролитография : принципы, методы, материалы : 2 в
ч. Ч. 2 / У. Моро ; пер. с англ. - М. : Мир, 1990. - 639 с. : ил. ISBN
5-03-001717-8 : 500.
. Технология СБИС : в 2 кн. Кн. 1 / под ред. С. Зи ; пер. с
англ. Ю. Д. Чистякова. - М. : Мир, 1986. - 404 с. : ил.
. Технология СБИС : в 2 кн. Кн. 2 / под ред. С. Зи ; пер. с
англ. Ю. Д. Чистякова. - М. : Мир, 1986. - 453 с. : ил.
. Борисенко В. Е. Наноэлектроника : учебное пособие [доп. МО
РБ] / В. Е. Борисенко, А. И. Воробьѐва, Е. А. Уткина. - М. : БИНОМ.
Лаборатория знаний, 2009. - 223 с. : ил. (Нанотехнология). ISBN
978-5-94774-914-4 : 3041600.
. Плазменная технология в производстве СБИС / под ред. Н.
Айнспрука, Д. Брауна ; перевод с англ. Ю. М. Золотарева, В. В. Юдина ; под ред.
Е. С. Машковой. - М. : Мир, 1987. - 469 с. : ил.
. Технологические процессы микроэлектроники [Электронный
ресурс] : электронный учебно-методический комплекс : 1-14 01 03. - Мн. : БГУИР,
2012. (Кафедра микрои наноэлектроники). 1 электрон. опт. диск (CD-ROM). Систем.
требования: IBM PC/AT, совмест. с процессором i80486 и выше; 8 Мб ОЗУ; 4х
CD-ROM; Windows 95 или Windows NT 3.51 и выше. б. ц.
. Черных, А.Г. «Технологические процессы микроэлектроники»
Часть 2. «Технология изготовления элементов ИС» «Маршрутная технология интегральных
и больших гибридных интегральных схем», для студентов специальностей 1-41 01
03, всех форм обучения: электронный учебно-методический комплекс / А.Г.Черных.
- Мн.: БГУИР, 2012.
. Сокол, В.А. Электрохимическая технология гибридных
интегральных микросхем : монография / В. А. Сокол. - Мн. : Бестпринт, 2004. -
360 с. ISBN 985-6767-04-0 : 8000-00.