Сравнительный анализ влияния низкотемпературного и высокотемпературного электронного облучения на электрофизические характеристики полупроводниковых приборов
Сравнительный анализ
низкотемпературного и высокотемпературного электронного облучения на
электрофизические характеристики полупроводниковых приборов
ОГЛАВЛЕНИЕ
ВВЕДЕНИЕ
. ОБЩАЯ ХАРАКТЕРИСТИКА ПОЛУПРОВОДНИКОВ
.1 Электрофизические свойства полупроводников
.2 Структура полупроводниковых кристаллов
.3 Элементы зонной теории твердого тела
. АНАЛИЗ ВЛИЯНИЯ ТЕМПЕРАТУРЫ ЭЛЕКТРОННОГО ОБЛУЧЕНИЯ НА
ЭЛЕКТРОФИЗИЧЕСКИЕ ХАРАКТЕРИСТИКИ ПОЛУПРОВОДНИКОВЫХ ПРИБОРОВ
.1 Микроструктурные исследования влияния электронного
облучения на электрофизические характеристики полупроводниковых приборов
.2 Электрический анализ низкотемпературного и
высокотемпературного электронного облучения на электрофизические характеристики
полупроводниковых приборов
ВЫВОДЫ
СПИСОК ИСПОЛЬЗОВАННОЙ ЛИТЕРАТУРЫ
ВВЕДЕНИЕ
Некоторые аспекты взаимодействия различных ядерных излучений с твердыми
телами с целью изучения их свойств рассматривались еще в начале прошлого
столетия. Основными направлениями этих исследований было изучение изменения цвета
некоторых минералов, солей [1,2] и алмаза [3], а также явления старения [4] и
модификации кристаллической решетки [5] под действием излучения радиоактивных
веществ. Основываясь на экспериментальных данных, были заложены основы теории
взаимодействия заряженных частиц с веществом [2,6].
Создание ядерных реакторов и вооружений обусловили всплеск повышенного
интереса к исследованиям по воздействию на твердые тела корпускулярного и у
-излучения. В конце 1942 г. Вигнер указал, что нейтроны с большой энергией и
осколки, образующиеся в процессе деления, должны обладать способностью смещать
атомы из равновесных положений в кристаллической решетке [7]. Он утверждал, что
интенсивная бомбардировка твердых тел тяжелыми частицами большой энергии может
привести к серьезным технологическим эффектам. Эти соображения привели к
осуществлению большой программы теоретических и экспериментальных работ по
изучению природы и величины ожидаемых эффектов. В результате была разработана
теория образования простых точечных дефектов, а именно внедренных атомов и
вакантных мест в решетке, при бомбардировке частицами большой энергии [8-14].
Стало ясно, что изучение радиационных эффектов может привести к решению
некоторых фундаментальных вопросов физики твердого тела - новым важным представлениям
о свойствах дефектов в твердых телах и их связях с физическими и химическими
свойствами материала.
В дальнейшем развитие атомной промышленности, ядерной энергетики и
космической техники потребовало разработки радиационно стойких материалов и
электронного оборудования, способных работать в условиях воздействия
ионизирующих излучений. Вопросы стабильности свойств материалов при длительном
воздействии на них излучений, необходимость индикации и дозиметрии излучений
ускорили и расширили круг исследований по влиянию различных типов облучения на
свойства твердых тел и приборов на их основе. В ходе этих исследований было
определено, что облучение высокоэнергетичными частицами и квантами излучения
вызывало относительно стабильные изменения электрофизических, оптических и
люминесцентных свойств полупроводникового материала. Как следствие, развилось
новое направление исследований - радиационная технология полупроводников, в
котором использовались ионизирующие излучения различной природы в широком
диапазоне их энергий и доз. Цель исследований - контролируемое облучение
исходного материала и готовых приборных структур управления основными
параметрами материала (радиационная компенсация материала, введение центров
излучательной рекомбинации, управление временем жизни неравновесных
носителей)[15,16]. Для создания структур, легированных по глубине неоднородно,
использовалось ионное легирование, которое обеспечивает эффективное изменение
свойств полупроводников на контролируемых глубинах и в локальных областях [17,18].
В последние годы становятся все более актуальны проблемы создания
радиационно стойкого электронного оборудования, в том числе детекторов
высокоэнергетических частиц, способных работать в экстремальных условиях - при
повышенных уровнях радиации, температуры и химической активности. Такие приборы
необходимы в космической электронике, различных ядерно-энергетических
установках, при контроле отработанного ядерного топлива. Кроме того, для
проведения физических экспериментов с большой радиационной нагрузкой, которые
планируются на ускорителях будущего поколения в ЦЕРНе - большой адронный
коллайдер (LHC) и его модернизация (SLHC), - требуются приборы, способные
обеспечить долговременный дозиметрический контроль во внутренних треках ядерных
установок [19]. Приборы с указанной совокупностью свойств не выпускаются в мире
и не могут быть реализованы с использованием традиционных полупроводниковых
материалов (Ge, Si, CdTe, GaAs).Наиболее перспективным полупроводником для
создания подобных приборов является SiC, промышленно выпускаемый в настоящее
время с размерами пластин до 3 дюймов в диаметре. Большая ширина запрещенной
зоны SiC (2.83-3.23 эВ в зависимости от политипа) обеспечивает
работоспособность приборов до высоких температур, вплоть до 900°C [20]. Кроме
того, SiC имеет высокую химическую и механическую прочность, а также высокие
значения пороговой энергии дефектообразования 25-35эВ, что является
предпосылкой высокой радиационной стойкости полупроводника [21,22].
Первые работы по изучению влияния облучения нейтронами [23,24] и
а-частицами [25,26] на свойства SiC и приборов на его основе показали
перспективность использования этого материала для высокотемпературных
радиационно стойких приборов и детекторов частиц высоких энергий. Однако ввиду
низкого качества исходного материала данные по изучению радиационного
дефектообразования в нем и исследованию электрических характеристик
выпрямителей на основе SiC после облучения оказались неоднозначными. В
последние годы достигнут значительный прогресс в выращивании чистых эпитаксиальных
слоев SiC методами газотранспортной эпитаксии (CVD) и сублимационным (SSE) с
низкими значениями концентраций нескомпенсиро-ванных доноров (< 1015см~3) и
дефектных центров (~ 1012см~3), относительно высокими значениями диффузионных
длин (Lp « 20 мкм) и времен жизни неосновных носителей заряда (тр «
1мкс)[27-29]. Это позволило исследовать более детально процессы радиационного
дефектообразования в SiC [22,30]. Потребности в решении фундаментальных
вопросов дефектообразования в SiC и в разработке радиационно стойкого
электронного оборудования, в том числе и детекторов ядерного излучения,
объясняет более широкое и целенаправленное изучение влияния различных видов
излучения на структурные, оптические и электрофизические характеристики этого
материала и приборов на его основе, которое наблюдается в последнее
десятилетие.
Цель работы - изложение результатов комплексных исследований влияния
низкотемпературного и высокотемпературного электронного облучения на
электрофизические характеристики SiC в виде кристаллов и чистых эпитаксиальных
слоев, а также приборных структур, изготовленных на этом материале.
Задачами работы являются:
- изучение низкотемпературного электронного облучения на
электрофизические характеристики полупроводниковых приборов;
- изучение высокотемпературного электронного облучения на
электрофизические характеристики полупроводниковых приборов;
- проведение сравнительного анализа влияния температуры
электронного облучения на электрофизические характеристики полупроводниковых
приборов.
Предметом работы электрофизические характеристики полупроводниковых
приборов.
Объектом работы является температурный режим электронного облучения и его
влияние на электрофизические характеристики полупроводниковых приборов
1. ОБЩАЯ
ХАРАКТЕРИСТИКА ПОЛУПРОВОДНИКОВ
1.1 Электрофизические свойства полупроводников
Развитие твердотельной электроники тесно связано с успехами физики и
химии полупроводниковых материалов. По удельному сопротивлению ρ
полупроводники занимают
промежуточное место между металлами и диэлектриками. Для полупроводников ρ
составляет 10-5-108
Ом•м, для диэлектриков 1016-1022 Ом•м, для металлов 10-8-10-6 Ом•м.
Температурный коэффициент сопротивления у полупроводников отрицателен, т.е. с
увеличением температуры их сопротивление уменьшается.
В отличие от металлов полупроводники сильно изменяют свои свойства от
присутствия даже очень небольших концентраций примеси. У полупроводников
заметное изменение ρ наблюдается также под действием света, ионизирующих
излучений и других энергетических воздействий.
Так, например, при концентрации примесных атомов в полупроводнике около
10-4 атомных процентов его удельная проводимость изменяется на несколько
порядков.
Полупроводники - наиболее распространенная в природе группа веществ. К
ним относятся химические элементы: бор (В), углерод (С), кремний (Si), фосфор
(Р), сера (S), германий (Ge), мышьяк (As), селен (Se), олово (Sn), сурьма (Sb),
теллур (Те), йод (I); химические соединения типа: AIBVII, AIIIBV, AIVBIV,
AIBVI, AIVBVI, (GaAs, GeSi, CuO, PbS и др.); большинство природных химических
соединений - минералов, число которых составляет около 2 тыс., многие
органические вещества.
В электронике находит применение лишь ограниченное число
полупроводниковых веществ. Исходные материалы, из которых изготавливают
полупроводниковые приборы, должны обладать определенными физико-химическими и
механическими свойствами.
Они должны иметь вполне определенное ρ в диапазоне рабочих температур ∆T.
Такое удельное сопротивление можно получить при достаточно большом количестве
свободных носителей заряда и их беспрепятственном движении в объеме
полупроводника. Следовательно, необходимо твердое тело, в котором концентрация
свободных носителей заряда n, их диффузионная длина L и время жизни τ
были бы достаточно
большими. Этим требованиям удовлетворяют в первую очередь монокристаллы, в
которых в отличие от аморфных тел и поликристаллов обеспечивается высокая
периодичность решетки. Однако не все монокристаллы обладают полупроводниковыми
свойствами. А среди полупроводниковых кристаллов лишь немногие по своим
параметрам и свойствам пригодны для изготовления полупроводниковых приборов.
На приведенном фрагменте таблицы Периодической системы элементов Д. И.
Менделеева (рис. 1.1) жирной линией обведена область, в которой расположены
элементы, обладающие полупроводниковыми свойствами. Слева и снизу от этой
области расположены металлы, справа и сверху - диэлектрики.

Рис. 1.1 Фрагмент таблицы Периодической системы элементов Д. И.
Менделеева
Электропроводность твердого тела зависит от структуры внешних электронных
оболочек его атомов, определяющих месторасположение элементов в таблице. Число
справа внизу от химического символа обозначает ширину запрещенной зоны элемента
в электрон-вольтах, число в правом верхнем углу - порядковый номер элемента в
таблице.
Из рис. 1.1 видно, что полупроводниковыми свойствами обладают лишь 12
химических элементов. Среди них наиболее подходящими для производства
полупроводниковых приборов оказались германий (Ge) и кремний (Si).
Германий встречается, главным образом, в сернистых минералах, некоторых
силикатах и карбонатах, а также в каменных углях и богатых углем породах.
Содержание Ge в земной коре всего 7•10-4%, он широко рассеян в горных породах.
Для полупроводниковых приборов необходим Ge, почти не содержащий примесей
других элементов. На 108 его атомов лишь один может быть чужеродным, но и то не
любым, а принадлежащим к группе определенных «легирующих» элементов (чаще всего
Sb, As, Ga, In, как показано на рис. 1.1 стрелками). Поэтому производство Ge
представляет известную сложность.
Кремний - наиболее распространенный (после кислорода) элемент, но в
чистом виде он не встречается. Давно известным соединением Si является его
двуокись SiO2. Твердая земная кора содержит 'по массе 27,6% кремния и состоит
более чем на 97% из природных силикатов, т. е. солей кремниевых кислот, а также
двуокиси кремния SiO2 преимущественно в виде кварца. Для производства
полупроводниковых приборов необходим также очень чистый Si. Получение чистых
кристаллов кремния еще более сложно, чем кристаллов германия. Кремний имеет
высокую температуру плавления (около 1500°С) и в расплавленном состоянии очень
высокую химическую активность. Это резко повышает технологические трудности
получения чистых кристаллов и легирования их нужными примесями (в качестве
последних чаще всего используются В, Аl и Р, как показано на рис. 1.1). Поэтому
чистый кремний, как и германий, довольно дорогой элемент.
Для изготовления полупроводниковых приборов применяют и Ge и Si, они не
являются конкурирующими элементами, так как сообщают приборам разные свойства.
Например, транзисторы из германия работают до +(100-120)°С, а из кремния до
+(150-200) °С. Однако германиевые транзисторы работают при более низких
температурах и обладают лучшими частотными характеристиками, чем кремниевые,
так как подвижность свободных носителей заряда в Ge выше.
На 2.1 указаны еще несколько элементов, обладающих полупроводниковыми
свойствами. Однако большинство из них непригодно для изготовления
полупроводниковых приборов: либо они проявляют полупроводниковые свойства при
температуре меньше 20°С (S и I) или 13°С (Sn), либо только в виде пленок (Sb и
As), они сублимируют (I и As), хрупки (Те), легко плавятся (Sn), недостаточно
изучены (В) и пр.
В электронике поэтому находит применение лишь ограниченное количество
химических элементов, обладающих полупроводниковыми свойствами. На первом месте
стоят Ge и Si, используемые в качестве основы при изготовлении
полупроводниковых приборов. Бор, фосфор, мышьяк, сурьма, индий, галлий, алюминий
используют в качестве примесей. В последние годы начинают применять некоторые
соединения, например, арсенид галлия (GaAs), антимонид индия (InSb) и др.
Интересны также сплавы и соединения элементов IV группы периодической системы -
карбид кремния, сплав кремний - германий и др. Однако они еще недостаточно
изучены.
Основными параметрами Ge и Si, определяющими свойства изготовленных из
них приборов, являются: ρ - удельное сопротивление; ∆ε-
ширина запрещенной зоны;
n- или p-концентрации свободных носителей заряда (электронов и дырок); δ
- плотность дислокаций;
L - диффузионная длина; τ - время жизни носителей заряда. Чтобы оценить эти
параметры, необходимо рассмотреть основы физики полупроводниковых материалов.
1.2 Структура полупроводниковых кристаллов
Кристаллическое вещество представляет собой сплошную упорядоченную
структуру (монокристалл) либо состоит из большого числа мелких монокристаллов,
различно ориентированных в пространстве (поликристалл).
Кристаллические вещества анизотропны, т.е. их свойства зависят от
кристаллографического направления.
Для описания закономерности строения кристаллов необходимо задание
направления (прямой). Для задания направления в кристалле достаточно задать
координаты любого атома тройкой целых чисел, заключенных в скобки (x,y,z). Если
плоскость параллельна какой-либо из координатных осей, то индекс,
соответствующей этой оси равен нулю. Основные кристаллографические плоскости
кубической решетки показаны на рисунке 1.2.

Рис. 1.2 Основные кристаллографические плоскости кубической решетки
Кремний и германий представляют собой кристаллы с регулярной структурой.
Кристаллическая решетка кремния и германия называется тетраэдрической или
решеткой типа алмаза Основу решетки составляет тетраэдр - пространственная
фигура, имеющая четыре треугольные грани. В вершинах тетраэдра и в его центре
расположены атомы. Центральный атом находится на одинаковом расстоянии от
четырех других, находящихся в вершинах. А каждый атом, расположенный в вершине,
в свою очередь, является центральным для других четырех ближайших атомов.
При рассмотрении физических процессов в полупроводниковых материалах
удобнее пользоваться плоским эквивалентом тетраэдрической решетки (рис. 1.3).
Все атомы (большие шарики) находятся в парноэлектронной, ковалентной или просто
валентной связи. Парноэлектронные связи (линии на рисунке) образуются
валентными электронами (на рисунке - маленькие шарики) при сближении атомов.
Так располагаются атомы чистых четырехвалентных элементов, в том числе Ge и Si,
при очень низкой температуре.

Рис. 1.3 Плоский эквивалент тетраэдрической решетки
При выращивании монокристаллов из расплава очень трудно получить
материалы со строго регулярной структурой. Обычно в процессе производства
получаются неоднородности разных типов, нарушается периодичность
кристаллической решетки, появляются дефекты.
Существуют разнообразные дефекты кристаллических решеток.
Нульмерные или точечные дефекты, к которым относятся например, межузельный
атом или вакансия (рис. 1.4)

Рис. 1.4 Нульмерные или точечные дефекты
Одномерные или линейные дефекты, например, цепочки межузельных атомов,
цепочки вакансий, дислокации.
Двухмерные или поверхностные дефекты, например, границы кристалла, зерен
(кристаллитов), т. е. места, где нарушается периодичность решетки.
Трехмерные или объемные дефекты, например, инородные включения, размеры
которых существенно больше характерного размера решетки, ее параметра а0. Для
Ge постоянная решетки а0 равна 565 Å, для Si -543 Å.
К важнейшим дефектам кристаллических решеток относятся дислокации
-специфические линейные дефекты, связанные с нарушением правильного чередования
плоскостей, в которых располагаются группы атомов. Различают несколько видов
дислокаций.
Дислокации могут служить центрами генерации и рекомбинации свободных
электронов, они влияют на время жизни носителей заряда.
Плотность дислокаций δ определяется как отношение общей
длины линий дислокаций к объему образца. Для изготовления полупроводниковых
приборов применяют Ge и Si с плотностью дислокаций δ,
не превышающей 104 на
1см2, причем для разных типов приборов существует свое предельное значение δ.
Например, для сплавных
транзисторов требуются Ge и Si с плотностью дислокаций до 103-5•104 см-2, для
эпитаксиальных - до 102 см-2 и т. д.
Плотность дислокаций исходного полупроводникового материала во многом
определяет электрические параметры приборов, а также разброс этих параметров от
экземпляра к экземпляру. От плотности дислокаций в материале зависит и процент
годных приборов в серийном производстве.
1.3 Элементы зонной теории твердого тела
полупроводник кристалл электронный облучение
Анализ процессов, происходящих в полупроводниковых материалах и
полупроводниковых приборах, основывается на зонной теории твердого, тела,
учитывающей различные квантовомеханические эффекты.
Твердое тело, в том числе рассматриваемые полупроводниковые
монокристаллы, представляет собой систему, состоящую из большого числа атомов,
плотность которых составляет примерно 1022 на 1 см3. Каждый атом
характеризуется дискретным спектром энергий ε1,
ε2,ε3, … ,εn разрешенных для электронов.
По представлениям квантовой механики состояние электрона в атоме
характеризуется квантовыми числами. Электроны в атоме могут занимать только
вполне определенные, разрешенные энергетические уровни. В нормальном
(невозбужденном) состоянии атома электроны должны располагаться на самых низких
энергетических уровнях.
Однако в соответствии с принципом Паули в одном и том же атоме (или в
какой-либо квантовой системе) не может быть двух электронов, обладающих
одинаковой совокупностью квантовых чисел. Поэтому электроны в соответствии с их
состояниями распределяются по определенным оболочкам вокруг ядра. Атом кремния
имеет 14 электронов, расположенных на трех оболочках по 2, 8 и 4 электрона.
Атом германия имеет 32 электрона, расположенных на четырех оболочках по 2, 8,
18 и 4 электрона. Валентные электроны на последней (верхней) оболочке, имеющие
набольшую энергию, определяют электропроводность кремния и германия.
Практическое следствие из принципа Паули при рассмотрении германия и
кремния заключается в том, что при объединении двух атомов происходит
расщепление каждого уровня на два, а при объединении N атомов в кристалл
происходит расщепление каждого энергетического уровня на N уровней.
В рассматриваемом случае находящиеся на очень близком энергетическом
расстоянии отдельные уровни, образовавшиеся при объединении множества атомов Ge
или Si в кристалл, становятся практически неразличимы. Совокупность близко
расположенных энергетических N уровней называется энергетической зоной.
Разрешенные энергетические зоны отделены друг от друга запрещенными
энергетическими участками, которые называются запрещенными зонами. Ширина
запрещенных зон зависит от расстояния между атомами, т.е. определяется
строением кристаллической решетки, а также строением и состоянием атомов,
образующих монокристалл.
Электропроводность возможна лишь тогда, когда возможен переход электрона
на другой энергетический уровень. Это означает, что в проводимости могут
участвовать электроны только тех зон, где есть свободные уровни, а при
температуре абсолютного нуля они имеются лишь в самой верхней разрешенной зоне,
которую называют поэтому зоной проводимости. Нижний энергетический уровень зоны
проводимости обозначается εc. В зоне проводимости находятся
электроны, осуществляющие электропроводность кристалла.
Зона проводимости отделена от валентной запрещенной зоной, ширина которой
обозначается ∆ε.
Валентная зона - зона, в которой все энергетические уровни заняты при
температуре абсолютного нуля, поэтому электроны этой зоны не могут участвовать
в проводимости. Однако с повышением температуры электроны переходят из
валентной в зону проводимости, в валентной зоне образуются свободные уровни и
появляется возможность перехода на них электронов.
Верхний энергетический уровень валентной зоны обозначается εv.
Электропроводность твердых тел зависит от взаимного расположения зоны
проводимости и валентной зоны. Именно по характеру энергетических диаграмм
твердые тела более четко разделяются на проводники (металлы), полупроводники и
диэлектрики (изоляторы) (рис. 1.5).

Рис. 1.5 Энергетические диаграммы
В металлах зона проводимости и валентная зона перекрываются, и электроны
валентной зоны могут легко переходить в зону проводимости независимо от
температуры тела. В зоне проводимости электроны принадлежат всему твердому телу
и свободно внутри него перемещаются. Проводящее состояние является обычным. В
отличие от металлов при нулевой температуре у изоляторов и полупроводников зона
проводимости пуста и электропроводность отсутствует.
Ширина запрещенной зоны ∆ε - один из важнейших параметров
полупроводникового материала, определяющий его электрические и химических
свойства. На рис. 1.1 числами справа внизу указаны значения ширины запрещенной
зоны ∆ε в электронвольтах. Из рисунка видно, что чем больше число
оболочек в атоме, тем меньше ширина запрещенной зоны и тем слабее связаны
валентные электроны с ядром.
В отличие от металлов электропроводность полупроводника обусловлена
электронами и дырками, т.е., кроме электронной, в полупроводнике существует и
другой вид проводимости - дырочная. Переход электронов из валентной зоны в зону
проводимости приводит к образованию дырок - вакантных уровней в валентной зоне.
При температуре, отличной от нуля, в зоне проводимости полупроводника всегда
имеется n электронов, а в валентной зоне - р дырок.
Переход электронов из валентной зоны в зону проводимости и образование
дырки на освободившемся энергетическом уровне - процесс генерации носителей. Но
наряду с генерацией происходит и рекомбинация носителей - переход электронов из
зоны проводимости обратно в валентную зону на свободный уровень. При
динамическом равновесии оба процесса идут непрерывно, их скорости равны.
Если в кристалле имеются дефекты, то создаваемое ими электрическое поле
может захватить электрон, подобно тому как электрон захватывается свободными
ионами. Локализованный вблизи дефекта электрон имеет энергию, соответствующую
энергии запрещенной зоны.
При исследовании механизма электропроводности в полупроводниках обычно
считается, что такие уровни возникают в результате присутствия примесных
атомов. Поэтому сами уровни называются примесными. Если такой уровень
расположен вблизи зоны проводимости, то даже при небольшом повышении
температуры электроны будут переходить в эту зону, в результате чего они
получат возможность свободно перемещаться по кристаллу. Полупроводник, у
которого подвижные электроны возникают вследствие их перехода с примесных
уровней в зону проводимости, называют полупроводником с электропроводностью
n-типа или электронным полупроводником. Уровни, поставляющие электрон в зону
проводимости, называют донорными.
Если примесные уровни расположены вблизи потолка валентной зоны, то при
повышении температуры электроны валентной зоны могут захватываться ими, это
приводит к образованию подвижных дырок в валентной зоне. Полупроводник с таким
механизмом возникновения подвижных носителей заряда называют полупроводником с
электропроводностью p-типа и дырочным полупроводником. Уровни, захватывающие
электроны или генерирующие дырки в валентной зоне, называют акцепторными.
Зонные диаграммы собственного (а), примесного -типа (б) и примесного p-типа (в)
полупроводников показаны на рис.1.6.
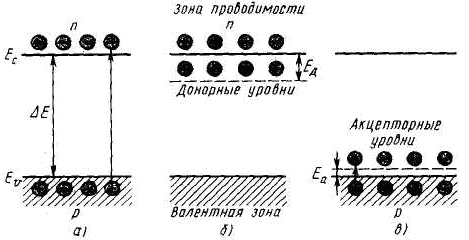
Рис. 1.6 Зонные диаграммы полупроводников
2. АНАЛИЗ
ВЛИЯНИЯ ТЕМПЕРАТУРЫ ЭЛЕКТРОННОГО ОБЛУЧЕНИЯ НА ЭЛЕКТРОФИЗИЧЕСКИЕ ХАРАКТЕРИСТИКИ
ПОЛУПРОВОДНИКОВЫХ ПРИБОРОВ
Электронное облучение характеризуется сравнительно слабыми повреждениями
решетки кристалла и неизменностью химического состава твердого тела в отличие
от воздействия других высокоэнергетичных частиц. При этом концентрация
индуцированных дефектных центров относительно мала и распределена с высокой
однородностью по объему образца, что делает более достоверными данные всех
видов измерений. Поэтому электронное облучение в широком интервале энергий и
доз электронов активно используется для изучения радиационного
дефектообразования в полупроводниках.
Облучение электронами с высокими энергиями (> 1МэВ) приводит к
созданию как простых точечных дефектов, а именно вакансий, атомов замещения и
межузельных атомов, так и их комплексов. Облучение же электронами с малыми
энергиями (< 1МэВ) позволяет определять конфигурацию дефектных центров и
проследить характер их поведения под воздействием различных факторов, а также
позволяет определять энергию дефектообразования для атомов вещества (ЕД т.е.
минимальную энергию, которую должна передать частица полупроводниковой матрице
для образования в ней пары Френкеля - вакансии и межузельного атома [3].
2.1 Микроструктурные исследования влияния электронного облучения на
электрофизические характеристики полупроводниковых приборов
Наиболее информативными методами изучения микроструктуры дефектов и их
идентификации являются электронный парамагнитный (EPR), оптический (ODMR) и
электронный спиновый (ESR) резо-нансы, а также магнитный циркулярный дихроизм
адсорбции (MCDA). Весьма чувствительными методиками к дефектам вакансионного
типа являются метод аннигиляции позитронов (PAS), медленная позитронная
имплантационная спектроскопия (SPIS), резерфордовское обратное рассеяние (RBS),
а также фотолюминесценция (PL), особенно при низких температурах ~ 1.7K (LTPL),
и катодолюминесценция (CL).
Первые работы по облучению SiC высоко-энергетичными электронами
проводились на кристаллах Лели, имеющих высокие концентрации как носителей
заряда, так и дефектов, что приводило к значительным различиям в полученных
результатах. Однако, согласно измерениям по методам EPR, ESR и PAS, основными
радиационными дефектами в различных политипах SiC были изолированные
нейтральная вакансия кремния VSi или отрицательно заряженная вакансия VSi-, а
также комплексы с ними [4]. Кроме того, была определена предельная доза
облучения iC электронами при переходе материала в аморфное состояние, равная
1022-1023 см-2 [5].
Появление дефектов, определенных как нейтральные вакансии VSi и комплексы
с ней, наблюдалось и позднее из спектральных зависимостей сигналов ODMR,
измерений ESR, PAS, PL и холловских измерений при облучении чистых
эпитаксиальных слоев n-3C,6H и 4H-SiC (Nd - Na < 1016см-3) электронами с
энергиями 1-2.5МэВ дозами 1017 -1018 см-2 [8]. Пози-тронные времена жизни ~ 190
и ~ 210 нс приписывались вакансии VSi и комплексам дефектов с ней [9]. Согласно
теоретическим данным, эти комплексы могли быть дивакансии [4]. Были сделаны
предположения, что дефектные комплексы с вакансией VSi создают глубокие уровни
в запрещенной зоне SiC. Было отмечено также, что интенсивность спектров PL
резко падала при облучении образцов электронами дозой выше 1017 см-2, что
объяснялось появлением безызлучательных дефектных центров [4]. При проведении
отжигов облученных образцов частичный отжиг вакансий VSi наблюдался при 200° C,
что объяснялось захватом этими вакансиями межузельных атомов [8]. Полный отжиг
вакансионных центров VSi наблюдался при температурах 750-900°C, а комплексов с
ними при 1200-1400°C [2].Кроме того, в некоторых работах [5] указывалось на
возможное присутствие заряженных вакансий VSi 2+, которые, согласно
теоретическим данным, располагаются вблизи потолка валентной зоны (рис.
2.1)[4].
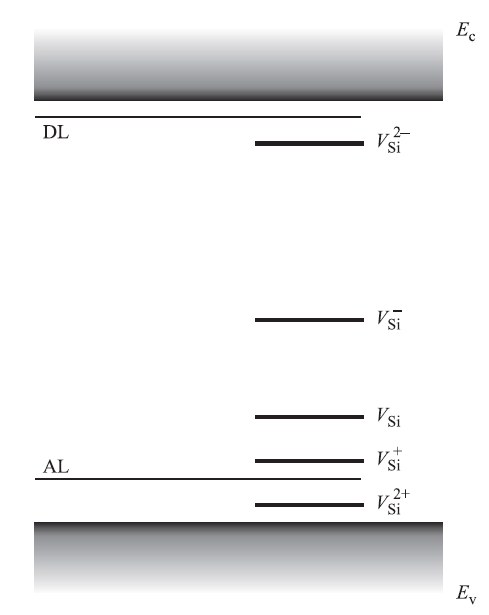
Рис. 2.1 Схематическое изображение положения энергетических уровней
вакансий кремния в запрещенной зоне SiC, подтвержденные как теоретическими
вычислениями, так и экспериментальными данными. DL - донорный уровень, AL -
акцепторный уровень
Последующие исследования по методу PAS показали, что температура отжига
радиационных дефектов, образующихся при облучении электронами, зависит от
политипа SiC [6]. CVD-слои политипов n-3C,4H и 6H-SiC облучались электронами с
энергией 0.5-2МэВ дозами (3-6) • 1017 см-2, а затем отжигались до 1700°C в
вакууме или атмосфере Ar. Для всех политипов были выявлены дефекты VSi и
вакансионные комплексы с VSi, однако температура отжига этих комплексов была
различна для разных политипов. Температура отжига увеличивалась с увеличением
гексагональности SiC (на 0% - 3C, 33% - 6H, 50% - 4H) от 1000 до 1700° C
соответственно (рис. 2.2)[6]. Выявленный для всех политипов двухступенчатый
отжиг вакансий VSi при 200 и выше 700° C был аналогичен наблюдаемому в работе
[8] и объяснялся взаимной рекомбинацией вакансии и межузельного дефекта и
миграцией вакансий VSi соответственно.
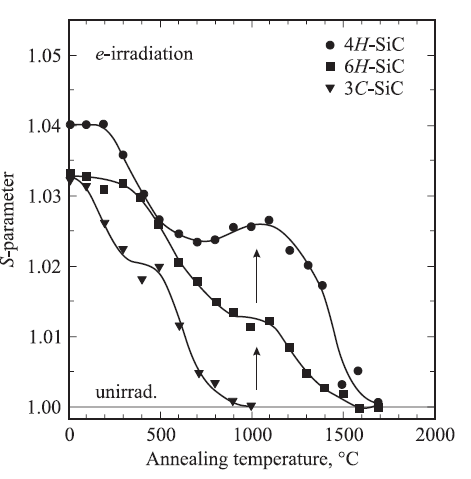
Рис. 2.2 Зависимости величины 5-параметра (PAS) от температуры отжига
образцов n-3C,4H и6H-SiC, облученных электронами с энергией 2МэВ дозой 3 •
1017см-2
Влияние величины дозы электронов на характеристики радиационных центров
дефектов было отмечено при облучении эпитаксиальных слоев n-6H-SiC с Nd - Na =
1.4 • 1016 см-3 [7]. Согласно измерениям PAS, увеличение дозы облучения (более
1019 см-2) приводило к образованию сложных дефектов VSi- VSi.Дефекты с VSi,
идентифицированные как дивакансия VSi-VC или комплексы VSi-SiC, были обнаружены
и ранее при проведении ODMR-измерений [8].Кроме того, было установлено
уменьшение дозы аморфизации с уменьшением концентрации примеси в образцах
[7].Для концентрации Nd -Na = 1.4 • 1016 см-3 эта доза составляла 1.8 • 1019
см-2 и, согласно рентгеновской дифрактометрии, наблюдалось увеличение
параметров решетки SiC a и c (разбухание) на относительные величины 6.4 • 10-5
и 6. 9 • 10-5 соответственно.
Появление и температурное поведение углеродных вакансий при облучении SiC
быстрыми электронами исследовалось в основном в образцах р-типа проводимости.
При облучении p-3C, 4H и 6Н- SiC (Na - Nd = 1016 -1017 см-3) электронами с
энергиями 1 -3 МэВ дозами 1018см-3 были обнаружены методами ESR, PAS, EPR и PL положительно
заряженные вакансии VС+ (центр T5) [15].Эти дефекты VС+ позитронным временем
жизни ~ 153 нс отжигались при температуре 150-200° , в то время как вакансии
кремния VSi были стабильны до температур 750° [15 ]. Более стабильны были и
комплексы с вакансиями VSi с температурой отжига ~ 1200° C по сравнению с
комплексами с VС - 400° [12].
Облучение p-4H-SiC и 6H-SiC электронами при повышенных температурах (~
400°C), когда углеродные вакансии становятся наиболее подвижны, позволило
выявить с помощью высокочастотных (~ 95 ГГц) измерений EPR различные центры
дефектов E11- E16 [16]. Они были идентифицированы как E11 - (VC-H), VSi, E13 -
(VC-2H), E14 - (VС+- VС+), SiC + (рис. 2.3). Было определено также, что
релаксация центра E16 сильно зависит от температуры и он действует как донор в
Si р-типа проводимости, т.е. может служить компенсирующим дефектом для
получения полуизолирующего Si . Положение дефекта VС+ было определено на
гексагональной и квазикубической сторонах подрешетки SiC [19]. Измерения EPR
(4-300 K), проведенные при положениях магнитного поля, параллельных
кристаллографическим плоскостям (1120), (1100) и (0001) в SiC, выявили 3
неэквивалентных положения дефекта VС+ в решетке SiC [20].Один из них (Ky3)
располагался на гексагональной стороне и два дефекта (Ky 1и Ky2) на
квазикубической стороне.

Рис. 2.3 Спектры EPR дефектных центров E15 и E16, измеренные на
эпитаксиальных слоях p-4H (a) и 6H-SiC (b), облученных электронами с энергией
2.5 МэВ
Использование фото-EPR-измерений при исследовании p-4H-SiC, облученного
электронами с энергией 2.5 МэВ дозой 2 • 1018см-2 с последующим отжигом до
температуры 1600° C, позволило выявить как ранее наблюдаемые дефекты VС+ и
SiС+, так и новые центры дефектов [21].Центр с энергией E > 1.15эВ,
обнаруженный ранее в n-6H-SiC и названный P6/P7 [22], был определен как
термически стойкая пара VC- СSi, появление которой объяснялось трансформацией
вакансии VSi при температуре 600- 800°C. Дефект донорного характера с энергией
ионизации Ev + 1.47 эВ выше потолка валентной зоны ассоциировался с появлением
комплексов с вакансией VSi [23]. Теоретически появление комплексов дефектов
вакансионного типа VC- СSi и VSi-SiC показано в некоторых работах [14]. Был
сделан вывод, что в образцах SiC р-типа проводимости наиболее вероятно
проявление стабильного дефекта VC- СSi, а в образцах n-типа наибольшая
вероятность появления комплексов с вакансией VSi.
Влияние качества исходного материала на радиационное дефектообразование в
образцах n-4H и6H-SiC, облученных электронами с энергией 2.2 МэВ дозой 7 • 1016
см-2, исследовалось методами EPR и PAS [25]. Было показано, что количество
образующихся при облучении вакансий VSi, VC и вакансионных комплексов с ними не
зависит от концентрации азота и от количества вакансий и вакансионных кластеров
в исходных образцах. При изучении температурного поведения радиационных
дефектов в облученных образцах при изохронном отжиге до температуры 1450°C было
выявлено, что вакансии VSi при температуре около 1000°C трансформируются в
менее подвижный комплекс дефектов VC-CSi, что согласуется с данными работ [3].
В интервале температур 1200- 1400°C более подвижные, по сравнению с комплексом
дефектов, вакансии VSi мигрировали, временно образуя дивакансии, которые затем
захватывались вакансионными кластерами, присутствующими в исходных образцах
[27].
Более детально природа радиационных дефектов при отжиге до температуры
1200°C облученных электронами с энергией 2.5 МэВ дозой 1.6 • 1018 см-2 образцов
n-6H-SiC исследовалась с привлечением разноплановых методик EPR, MCDA, LTPL
[68]. В подтверждение выше представленных результатов [18] дефекты VS- и VSi
отжигались частично при 150-300°C и полностью при температурах 600-750°C. Отжиг
вакансионного центра VSi сопровождался появлением пары дефектов VC- CSi уже
после 150° C, которая отжигалась при температурах 900-1050°C. Процесс
образования пары VC-CSi при этом представлялся как результат перехода атома C в
вакансию VSi, что согласуется с ранее высказанными предположениями [22].
Энергетический барьер для трансформации VSi в пару дефектов VC-CSi ниже для
образцов p-типа и был теоретически определен как ~ 2.2эВ [9]. При температурах
отжига выше 750°C были обнаружены новые центры дефектов, природа которых была
предположительно определена как кластерные комплексы с атомами замещения
VCCSi(SiCCSi) или VCCSi(SiC- CSi)[10]. При температурах выше 900°Cэти комплексы
исчезали с появлением новых вакансий VSi. Было замечено, что исчезновение
комплексов дефектов сопровождалось возрастанием концентрации известного дефекта
D1 (2.6эВ)[11] при измерениях по методу LTPL. Температурное поведение
комплексов дефектов позволило сделать предположение, что D1 -люминесценция
обязана своим происхождением комплексу с атомами замещения ( SiCCSi)[12].
Облучение низкоэнергетичными электронами позволило выявить дополнительное
многообразие конфигураций и зарядовых состояний радиационных дефектов. Так,
образование пар Френкеля в виде VSi- - Si, и VSi3-- Si, наблюдали при
измерениях EPR (4-300 K) кристаллов 3C,4H,6H-SiC n-и p-типов проводимости после
облучения их электронами с энергиями 300-900 кэВ дозами 5 • 1017 - 3 • 1019
см-2 [25].Однако другие центры дефектов были различны для образцов с разным
типом проводимости. Во всех образцах n-типа были обнаружены центры, содержащие
отрицательно заряженные вакансии VSi3- или VSi2-, а также комплекс VC-H
[78](рис. 2.4). Авторы полагали, что вакансии VSi3- и VSi2- создают уровни,
близкие к зоне проводимости, что согласуется с данными работы [24]. Облученные
образцы SiC p-типа характеризовались присутствием вакансий VС+ и комплексов
VC-2H [18]. Заметим, что водород активно участвовал в дефектообразовании, что
авторы объясняют высокой концентрацией атомов H, которые подвижны при комнатной
температуре. Теоретически возможность появления межузельного водорода и
вакансионных комплексов с ним была показана для 3C-SiC n-и p-типов проводимости
[19]. При этом авторы считали, что для p-SiC межузельный H является мелким
донором, компенсирующим акцепторы. Для n-типа энергия образования межузельного
H2 велика, поэтому он образует комплексы VSi-Би VC- H, которые служат ловушками
для электронов и дырок соответственно.

Рис. 2.4 Спектр EPR (300K), измеренный для кристаллов n-6H-SiC после
облучения электронами 300 кэВ дозами 5 - 1017−1018 см−2
Зависимость радиационного дефектообразования от энергии облучающих
электронов в диапазоне 0.3-2.5 МэВ в кристаллах и эпитаксиальных слоях 3С и
6H-SiC n-и p-типов проводимости исследовалась в некоторых работах [32].
Измерения по методу PAS показали, что наименьшая энергия электронов (> 300
кэВ) требуется для образования вакансий VC с позитронным временем жизни <
160 нс. Увеличение энергии облучающих электронов приводило к появлению вакансий
кремния в различных зарядовых состояниях (VSi, VSi -, VSi 2- и VSi 3-), а затем
к появлению центров дефектов предположительно в виде дивакансий (VSi-VSi или
VC-VSi). Был сделан вывод, что независимо от политипа и типа проводимости SiC
увеличение энергии электронов при облучении ведет к разнообразию видов, а также
увеличению их концентраций и размеров дефектов с участием вакансий. Однако при
этом температурная стабильность вакансионных центров дефектов была зависима от
типа проводимости SiC [33]. Было отмечено, что вакансионные центры дефектов
вобразцах p-типа отжигались при более низких температурах (~ 700° C) по
сравнению с аналогичными дефектами в образцах n-типа проводимости (850°C).
Облучение SiC низкоэнергетичными электронами также позволяет исследовать
модели межузельных дефектов, их подвижности и взаимосвязи с другими дефектами и
атомами. Так, при облучении электронами в просвечивающем электронном микроскопе
(TEM) с энергиями 90-300 кэВ эпитаксиальных слоев 3С,4H, 6H-SiC и 15R-SiC n-и
р-типов проводимости удалось идентифицировать дефектный центр D1, обнаруженный
ранее в политипах 3C,4H и 6H-SiC [24].Образцы были насыщены изотопами 13C, что
позволило идентифицировать при измерениях LTPL (7K) наблюдаемые оптические
центры как гантелеобразной конфигурации расщепленные междоузлия C-C (рис.
2.5)[26].Эти центры образовывались из межузельного углерода при облучении
образцов электронным пучком с энергией ниже 150 эВ. Как показали теоретические
вычисления, центры с такой конфигурацией имеют наименьшую энергию формирования
после углеродной вакансии [27]. Однако для политипа 4H-SiC при таких энергиях
облучающих электронов был обнаружен нерасщепленный межузельный центр только
одного типа, из чего было сделано заключение, что этот политип более стоек к
облучению по сравнению с 6H-SiC. При повышении энергии облучающих электронов
выше 150 кэВ во всех политипах наблюдали другой центр, который предположительно
считали C- Si гантелеобразной конфигурации или расщепленное междоузлие (C-С)С
на углеродной стороне в нейтральном состоянии для политипа n-4H-SiC [30].
Важнейшим параметром при оценке радиационной стойкости полупроводникового
материала является величина энергии, необходимая для смещения атома из его
положения в кристаллической решетке, - пороговая энергия дефектообразования
(Ed). Одним из результативных способов определения величины Ed является
облучение материала низкоэнергетичными электронами. Теоретические значения
величины Ed в SiC различались незначительно у разных авторов и составляли либо
для обоих атомов 27.5 эВ [31], либо для атомов C и Si - 24 и 35 эВ соответственно
[32], либо для атомов C 20эВ и Si 30-35 эВ [34]. При этом обращалось внимание
на присутствие анизотропии этих величин, как и в других полупроводниках,
облученных высокоэнергетичными частицами [35]. Указанные значения были
наименьшие для атомов C в направлении [П00] и атомов Si вдоль [00011][32].

Рис. 2.5 Модель гантелеобразной конфигурации расщепленного междоузлия в
C-Св3С-SiC, расположенного на стороне углеродной подрешетке
Экспериментально пороговые энергии смещения Ed для атомов C и Si, равные
~ 18 и ~ 43 эВ соответственно, были определены при облучении кристаллов
n-6H-SiC в TEM электронами с энергиями 200 и 300 кэВ с одновременным анализом
дифракционных картин [16]. Было определено также, что энергия смещения атома Si
в политипе 3C-SiC выше, нежели в политипе 6H-SiC [17]. Величины пороговых
энергий смещений Ed для атомов C и Si, равные ~ 20 и ~ 30 эВ, были
рекомендованы для вычислений величины повреждений (dpa - displacements per
atom), наблюдаемых в SiC при облучении [17].
Анизотропия величины пороговой энергии смещения Ed в SiC была
подтверждена экспериментально при облучении низкоэнергетичными электронами
образцов 4H и 6H-SiC n-и р-типов проводимости. Согласно данным PL, значительная
анизотропия наблюдалась между значениями Ed в направлениях [0001] и [ 00011] ,
и их наименьшие значения составляли 20 и 24 эВ для атомов C и Si
соответственно.
При облучении полупроводников низкоэнергетичны-ми электронами также
появляется возможность точно определить энергию облучающих электронов,
необходимую для создания вакансий. Эти величины были установлены при облучении
в просвечивающем электронном микроскопе (TEM) чистых кристаллов и
эпитаксиальных слоев 4H и 6H-SiC n-и р-типов проводимости электронами с
энергиями 50-300 кэВ в широком интервале доз 1016 -1020 см-2 [28]. Атомы
углерода смещались при энергиях электронов выше 90 кэВ и наблюдалась некоторая
дисперсия этой величны в зависимости от направления падающего электронного
луча, (0001) или (00011 )[98]. Для смещения атомов Si и появления вакансий VSi
требовалось облучение электронами с энергией 200-300 кэВ. При этом атомы Si
смещались независимо от направления электронного луча относительно
кристаллографических осей образцов.
2.2 Электрический анализ низкотемпературного и высокотемпературного
электронного облучения на электрофизические характеристики полупроводниковых
приборов
Известно, что энергетический спектр является ключом к пониманию
электронных свойств твердого тела. Вопрос об энергетическом спектре носителей
заряда является поэтому одним из важнейших в радиационной физике
полупроводников.
Согласно экспериментальным данным основным изменениям в результате
воздействия радиации подвергается область энергетического спектра,
соответствующая запрещенной зоне необлученного кристалла. Облучение «вводит» в
запрещенную зону полупроводника широкий набор энергетических уровней,
связанных, как правило, с той или иной разновидностью решеточных радиационных
дефектов. Одному дефекту может при этом соответствовать несколько локальных уровней
как донорной, так и акцепторной природы. Теория таких локализованных
электронных состояний разработана весьма слабо, и основная информация об этих
дефектах получена из экспериментальных данных. Эти уровни обнаруживаются обычно
при измерении температурных зависимостей проводимости и эффекта Холла,
исследовании спектров фотопроводимости и оптического поглощения, при анализе
кинетики неравновесных процессов в облученных полупроводниках и т. д. В ряде
случаев весьма эффективным методом обнаружения и изучения радиационных дефектов
и их энергетических уровней является электронный парамагнитный резонанс.
Положение и концентрация энергетических уровней, вводимых облучением,
обычно зависят от вида и энергии бомбардирующих частиц, дозы облучения, условий
отжига, наличия химических примесей в облученном образце и других факторов. Для
иллюстрации в табл. III приведен ряд
энергетических уровней, возникающих в запрещенной зоне облученного кремния.
Таблица 2.1
Энергетические уровни в запрещенной зоне облученного кремния {Ее- дно
зоны проводимости, Еu -
потолок валентной зоны)

Большинство из наблюдаемых уровней можно связать с различными точечными
дефектами решетки - вакансиями, атомами внедрения, их ассоциациями друг с
другом,
С примесями и т. д. Отметим, в частности, данные работ Уоткинса с
сотрудниками, в которых на основе исследования электронного парамагнитного
резонанса и инфракрасного поглощения установлена важная роль комплексов
вакансий с химическими примесями при расшифровке эпергетического спектра
облученного кремния. Оказалось, например, что акцепторный уровень Ес - 0,17 эв
принадлежит так называемому /1-центру, т. е. комплексу «вакансия плюс примесный
атом кислорода»; донорный уровень Ес - 0,4 эв соответствует А-центру,
представляющему собой ассоциацию вакансии с мелким донором пятой группы (в
частности, с фосфором). Ряд наблюдаемых уровней, кроме того, связан с
различными зарядовыми состояниями дивакансии.
В связи с расшифровкой новых уровней интересной является возможность
«радиационной активации» остаточных химических примесей. Активация состоит в
переходе атома меди (золота) в результате взаимодействия с радиационными
дефектами из междуузельного положения в узел решетки, где он обладает глубоким
уровнем, ответственным за примесную фотопроводимость. Именно такой активацией
обусловлено появление в спектре облученного кремния донорных (Е1) + 0,24 эв; Еu + 0,35 эв) и акцепторных (Еu + 0,49 эв; Ес-0,54 эв) уровней меди
и золота соответственно.
Важная особенность наблюдаемого спектра радиационных нарушений состоит в
том, что, кроме указанных дискретных уровней, в запрещенной зоне облученного
кремния обнаружены области непрерывно распределенных уровней, причем
соответствующая плотность состояний падает по мере удаления от границ
разрешенных зон [19, 14]. Авторы этих работ связывают появление изменений в
спектре с образованием френкелевских пар дефектов с различным расстоянием между
вакансиями и внедренными атомами. В связи с этим напомним, что «хвосты»
плотности состояний являются свойством сильно легированных неупорядоченных
полупроводников, связанным с флуктуирующим потенциалом заряженных центров [17].
Появление аналогичных «хвостов» в облученных кристаллах поэтому не является
неожиданным.
Выше был приведен ряд важных результатов, полученных при исследовании
энергетического спектра облученного кремния. Отметим, что, как и в кремнии,
удается надежно расшифровать только уровни, обусловленные простейшими
радиационными дефектами и их ассоциациями с некоторыми примесями. Наряду с этим
расшифровка всех наблюдаемых спектров облученных кристаллов связана с
серьезными трудностями. Эти трудности, по-видимому, вызваны не только
сложностью и разнообразием радиационных дефектов, но в ряде случаев
макроскопичностью дефектов и неоднородностью их пространственного
распределения. Действительно, как отмечалось в предыдущей главе, при облучении
нейтронами и тяжелыми заряженными частицами наряду с образованием изолированных
точечных дефектов в твердых телах возникают пики смещения, тепловые пики и т.
д. Они вызывают появление макродефектов, представляющих собой в полупроводниках
разупорядоченные области (кластеры) с линейными размерами порядка десятков или
сотен ангстрем и более и средней плотностью точечных дефектов, достигающей
1019-1020 см-3 [19]. Будучи заряжены и окружены слоем пространственного заряда,
такие области создают в образце случайный плавный потенциал, который модулирует
разрешенные энергетические зоны полупроводника.
Подобная модуляция особенно существенна, если радиация вызывает инверсию
типа проводимости полупроводника, как это имеет место, например, в германии
гетипа. Амплитуда случайного потенциала при этом может стать порядка ширины
запрещенной зоны. Однако рока концентрация областей пространственного заряда
невелика, случайная составляющая потенциала отлична от нуля лишь в малой части
объема кристалла. С ростом дозы облучения области пространственного заряда
начинают перекрываться, и полупроводник превращается в неупорядоченную систему
р - n-переходов [12]. В этом случае
энергетический спектр и свойства полупроводника существенно определяются
случайным потенциальным рельефом и должны обладать особенностями, характерными
для неупорядоченных систем [15].
Отметим, в частности, что, если потенциальный рельеф, возникший в
результате облучения, достаточно глубок, то, как и в компенсированных полупроводниках
[16], в плавных потенциальных ямах возможна «коллективная» локализация
электронов (дырок) - образование электронных (дырочных) капель, отделенных друг
от друга потенциальным барьером.
Следует подчеркнуть, что модель полупроводника со случайным крупномасштабным
потенциальным рельефом- «модель искривленных зон» - является характерной для
весьма широкого класса неупорядоченных полупроводников, в частности, она широко
используется для описания свойств- сильно легированных, компенсированных, а
также аморфных полупроводников. Экспериментальные данные свидетельствуют, что
эта модель с успехом применима и для описания облученных полупроводников, в
частности, для облученного нейтронами германия n -типа [92-95].
Облучение, изменяя энергетический спектр носителей заряда, способно
существенно повлиять на электрические, фотоэлектрические, оптические, магнитные
и другие свойства полупроводника 116]. Влияние на электропроводность
обусловлено главным образом изменением концентраций свободных электронов и
дырок, изменение подвижности имеет меньшее значение. Абсолютные изменения
электропроводности могут достигать нескольких порядков, в ряде случаев
происходит инверсия типа проводимости. С ростом дозы облучения
электропроводность, как правило, стремится к вполне определенному для данного
полупроводника значению. Например, германий как п-, так и р-типа при длительном
облучении переходит в р-тип с высокой концентрацией дырок. Подобным образом
ведет себя и сурьмянистый индий при электронном и гамма-облучении. Проводимость
кремния и арсенида галлия, подвергнутых облучению, стремится к собственной
[16]. Рис. 2.6 и 2.7, взятые из [17], показывают изменение проводимости
германия (рис. 2.6) и кремния (рис. 2.7) как n -, так и р-типа в результате облучения быстрыми нейтронами.
Интерпретация данных об изменении проводимости основана на представлении о
донор-вых и акцепторных энергетических уровнях, возникаю щих в запрещенной зоне
полупроводника при появлении в решетке простейших радиационных дефектов. В
кремнии и арсениде галлия эти состояния компенсируют друг друга, в германии и
сурьмянистом индии акцепторные уровни оказываются более эффективными.

Рис. 2.6 Изменение проводимости германия

Рис. 2.7 Изменение проводимости кремния
Интерпретация значительно усложняется в ряде случаев, в частности, при
облучении нейтронами, в связи с образованием в образце макродефектов типа
разупорядоченных областей, окруженных пространственным зарядом. Степень влияния
таких дефектов на электрические свойства полупроводника зависит от их
концентрации, размеров, высоты и толщины потенциального барьера, окружающего их
[11]. При малой концентрации они уменьшают эффективную площадь сечения образца
при протекании тока, а также могут непосредственно повлиять на подвижность
[10]. При большой концентрации в образце возникает сложный потенциальный
рельеф, и проводимость следует описывать методами «теории протекания», как это
делается в теории сильно легированных компенсированных, а также неупорядоченных
полупроводников [10]. Согласно этой теории энергия активации проводимости при
наличии неоднородного потенциального рельефа определяется расстоянием от уровня
Ферми до «уровня протекания». Последний представляет собой, как это уже
отмечалось в § 24, минимальную энергию, обладая которой, электрон (дырка) может
пройти от одного контакта до другого «классическим образом», т. е. огибая,
обходя потенциальные барьеры, а не туннелируя через них.
Весьма сильным изменениям в результате облучения подвергаются
фотоэлектрические свойства полупроводников. Здесь нужно отметить два типа
эффектов - влияние на спектральную характеристику фотопроводимости и изменение
времени жизни неравновесных электронов и дырок. Влияние на спектр
фотопроводимости связано с появлением локализованных электронных состояний,
обусловленных радиационными дефектами. Спектральная характеристика облученных
образцов приобретает длинноволновые «хвосты», структура которых позволяет в
ряде случаев определить положение новых энергетических уровней. Такие «хвосты»
наблюдались в германии, кремнии т.д.. В других случаях наблюдались
бесструктурные «хвосты» спектральной характеристики, которые могут быть связаны
как с перекрытием уровней различных дефектов (например, уровней дефектов
Френкеля с различным расстоянием между вакансией и атомом внедрения [16, 11 ]),
так и с «хвостами» плотности состояний, обусловленными флуктуациями потенциального
рельефа в сильно облученном образце. На рис. 2.8 приведена спектральная
характеристика фотопроводимости кремния при 100 °С [16]. Кривая 1 соответствует
необлученному образцу р-типа с содержанием кислорода, не превышающим 1011 см-3,
и удельным сопротивлением 9500 ом-см при комнатной температуре. Кривая 2
получена после облучения этого образца электронами (энергия 1 Мэв, интегральный
поток 2-1015 смг'2). Отчетливо видна бесструктурная область спектра,
простирающаяся до 4 мкм. Кривая 3 относится к облученному таким же потоком
электронов образцу кремния, содержащему ~1016 &и_3 атомов кислорода и
акцепторную примесь бора.

Рис. 2.8 Спектральная характеристика фотопроводимости кремния
Исключительно чувствительными к облучению являются рекомбинационные
свойства полупроводников. Уже при малых дозах облучения время жизни
неравновесных носителей заряда заметно падает, что немедленно сказывается на
работе полупроводниковых приборов [16]. Этот эффект был использован, в
частпости, для нахождения пороговой энергии образования решеточных дефектов в
кремнии и германии [102].
Исследования показали, что радиационные изменения времени жизни
существенно зависят от содержания и типа примесей (например, кислорода в
кремнии). В частности, эффективными центрами рекомбинации в кремнии в
зависимости от условий получения исследованных кристаллов могут быть либо
А-центры, либо Е-центры, причем в последнем случае сечения захвата зависят от
характера донорной примеси, входящей в состав рекомбинационного центра [18].
Особенно интересны фотоэлектрические свойства облученных полупроводников
при большой концентрации разупорядоченных областей, когда становится
справедливой «модель изогнутых зон». Теория фотопроводимости в этой модели
развита в [24]. Один из главных результатов теории состоит в том, что
вследствие разделения неравновесных электронов7и" дырок во внутренних
ПОЛЯХ их рекомбинация затруднена, время жизни резко возрастает, и после снятия
освещения повышенная проводимость может сохраняться достаточно долго.
Экспериментально такие эффекты наблюдались на германии, облученном быстрыми
нейтронами [13]. Увеличение фоточувствительности облученного нейтронами
кремния, связанное с наличием разупорядоченных областей, отмечено в [18].
Оптические и магнитные свойства облученных кристаллов, так же как
электрические и фотоэлектрические, несут в себе информацию о радиационных
дефектах, их строении, свойствах, энергетическом спектре. Изолированные
радиационные дефекты ведут к появлению новых полос оптического поглощения и
люминесценции. Интенсивность этих полос возрастает с увеличением дозы облучения
вплоть до насыщения. Например, в спектре инфракрасного поглощения облученного
кремния возникает большое количество новых полос в области 1 - 15мкм [15]. Было
установлено, что часть из них обусловлена появлением радиационных А-центров,
дивакансий, Е-центров и т. д. При этом новые полосы связаны как с электронными
переходами, так и с локализованными колебательными модами радиационных
дефектов. В частности, колебательпая полоса вблизи 12 мкм обусловлена
Л-центром. Подобные колебательные моды были наблюдены и в облученном германии
[19].
Наряду с этим при облучении нейтронами и быстрыми заряженными частицами,
как правило, наблюдается размытие и сдвиг края основного поглощения в
длинноволновую область, а также появление бесструктурных хвостов в широком
энергетическом интервале. Такие данные имеются для Ge, Si, GaAs, CdS, CdTe и
других полупроводников и связываются с появлением в объеме облученных образцов
разупорядоченных областей [11]. Как и при интерпретации других свойств, в этом
случае полезным может оказаться привлечение представлений о флуктуирующем
потенциальном рельефе, образовании квазиметаллических капель и т. д.
Изменение магнитных свойств при облучении связано прежде всего с
появлением в полупроводнике парамагнитных радиационных дефектов - центров
локализации неспаренных электронов [11]. Это приводит, с одной стороны, к
изменению парамагнитной восприимчивости [11, 12] в облученных образцах, а с
другой - к наблюдению в них сигналов электронного парамагнитного резонанса нри
совпадений частоты электромагнитного поля с расстоянием между зеемановскими
уровнями парамагнитного дефекта. Исследование электронного парамагнитного
резонанса в облученных кристаллах, особенно в кремнии, оказалось исключительно
плодотворным и позволило в сочетании с другими методами надежно установить
детальную структуру ряда важнейших радиационных дефектов, в частности А- и
/.'-центров, дивакансий и других дефектов в Б1 [85] и других полупроводниках.
Кроме того, с помощью парамагнитного резонанса удалось исследовать характер
движения вакансий в Бц в частности было установлено, что энергия активации
этого движения зависит от положения уровня Ферми и составляет в кристаллах
р-типа 0,3 эв, а в кристаллах /г-типа не более 0,1 - 0,2 эв [15].
Многообразные радиационные центры дефектов, образующиеся в результате
облучения электронами, создают в запрещенной зоне SiC широкий спектр
энергетических уровней, параметры которых наиболее информативно определяются
емкостной и токовой релаксационной спектроскопией (C-DLTS, 7-DLTS).
Результаты исследований глубоких центров (ГЦ), которые появлялись в
кристаллах n-6H-SiC, эпитаксиальных слоях и р+ - n-переходах на их основе, с
концентрациями нескомпенсированных доноров 5 • 1014 -8 • 1017см-3 при облучении
их электронами в широком интервале доз (5 • 1013-1018 см-2) с энергиями 1.5-5
МэВ, представлены в работах [16]. Температурное поведение ГЦ исследовалось при
проведении отжигов облученных образцов до 1600-1700°C. Согласно полученным
данным, независимо от концентрации примесей в исследуемых образцах и режимов облучения
электронами было обнаружено более 10 радиационно-индуцированных уровней в
энергетическом интервале 0.15-1.65 эВ от дна зоны проводимости 6H-SiC. Наиболее
характерными являлись уровни с энергиями ионизации 0.18, 0.38/0.44, 0.51,
0.68/0.70, 1.15/1.25 и 1.5эВ (отсчет от уровня зоны проводимости Ec), которые
рассматривались как ловушки дырок (рис. 2.9)[16]. Центр Ec-0.38/0.4эВ (ED3 на
рис. 2.6), известный как центр E1/E2 [12], был термически стойким и отжигался
при температуре 1600°C [16]. Природа этого центра предполагалась как дивакансия
(VC-VSi) или комплекс, содержащий вакансии VSi [9].Подругой версии центр Ec -
0.38/0.4эВ объясняется как система из двух отрицательно заряженных U-центров, каждый из которых формирует
два уровня в запрещенной зоне - акцепторый и донорный [15]. В соответствии с
этой концепцией уровень с энергией ионизации Ec - 0. 38 эВ считается центром
акцепторного типа, а уровень с Ec-0.44 - донорного. Центр Ec-0.5эВ с
независимым от температуры сечением захвата носителей заряда 2 • 10-15 см2 -
термически нестабилен, исчезает при прогреве до 250°C и ассоциируется с
вакансией VС+ или комплексом вакансия-примесь [16]. ГЦ с энергией Ec
-(0.68-0.71) эВ идентифицируется какизвестныйцентр Z1/Z2 [102,103]. Выявленные
при повышенных температурах измерения ГЦ с энергиями ионизации Ec-(1 .15-1 .25)
и Ec-1 .5 эВ предположительно связываются со структурными дефектами в виде
ассоциатов с вакансиями [11].

Рис. 2.9 Нормализованный спектр DLTS образца и-бЯ-SiC, облученного
электронами с энергией 1.7 МэВ и величиной дозы D,1014см-2: 1 - 90.4, 2 - 45.2, 3 - 33.8, 4 - 11.3, 5 - 2.26
Особенности радиационного дефектообразования при облучении электронами в
зависимости от политипа SiC рассматривались в некоторых работах [17], где
экспериментальные данные, полученные для политипа n-4H-SiC, сравнивались с
известными результатами для политипа n-6H-SiC. Электронами с энергиями
0.2-15МэВ и дозами 5 • 1013 -1017 см-2 облучались эпитаксиальные слои n-4H-SiC
с концентрациями Nd - Na = 2 • 1014-2 • 1016 см-3 и p+ - n-переходы на их
основе. В некоторых работах после облучения образцы отжигались до температур
900-2000°C [17]. С использованием DLTS-спектрометрии был получен широкий спектр
центров акцепторного типа, аналогичных наблюдаемым в n-6H-SiC, с
энергетическими уровнями 0.39, 0.45, 0.5, 0.68/0.7, 1.13 эВ (рис. 2.10) (отсчет
от дна зоны проводимости). Центр с энергией Ec-0.39 эВ (E1 /E2) был в отличие
от n-6H-SiC термически нестабильным в n-4H -SiC и отжигался при температурах
360-400 K. В n-4H-SiC он ассоциировался с дефектом замещения C, который
аннигилировал при температуре 400K [14].Центр Ec-0.68/0.7эВ (Z1/Z2) имел
большие значения сечений захвата электронов 1.3 • 10-14 -1.3 • 10-13см2 и был
термически стойким. Он отжигался частично при температуре 1300°C, однако и при
отжиге в 2000°C было отмечено присутствие этого дефекта с концентрацией 25% от
исходной. Был сделан вывод, что он образуется за счет диффузии простых
дефектов, в частности вакансий VSi, атомов замещения SiC или комплексов с ними.
Однако отмечалась низкая термостойкость центра Z1 /Z2. Он отжигался при
аномально низких температурах 400- 470 K и рассматривался как собственный
дефект или как комплекс с собственным дефектом и атомами N или H [14]. Эти
данные подтверждают ранее отмеченную активность атомов H в образовании
радиационных дефектов. По другой версии центр Ec - 0.68/0.7эВ (Z1/Z2)
рассматривался как система из двух отрицательно заряженных U-центров [18] по аналогии с центром
Ec - 0.38/0.4эВ в n-6H-SiC [15]. Был сделан вывод, что эти отрицательные U-центры в n-4H и 6H-SiC имели
идентичные структуры, поскольку имели много общих свойств, в частности они
отжигались при температурах > 1400° C. Новыми в n-4H-SiC были обнаруженные
дефекты с энергией ионизации Ev + 0. 35 эВ, которые рассматривались как ловушки
для дырок и появлялись после отжига при температуре 350-400° C, а также
акцепторный центр Ec -1.65эВ EH6/EH7 на рис. 2.7)[107,116].Центр EH6/EH7 с
большим сечением захвата электронов ~ 10-13 см2, независимым от температуры,
был термически стойким с отжигом при температурах ~ 2000° C и объяснялся
присутствием вакансий VC или структурных дефектов комплексного типа.
Зависимость радиационного дефектообразования от типа проводимости
исследовалась в эпитаксиальных слоях p-6H-SiC с Na -Nd = 6.6 • 1018 см-3,
облученных электронами с энергией 1.7 МэВ дозами 2.26 • 1014 см-2 и 1. 13 •
1015 см- 2 [17]. Были выявлены два новых ГЦ, расположенных выше валентной зоны
с энергиями ионизации Ev + 0.55эВ (H2) и Ev + 0.78 эВ (H2), которые отжигались
при температурах 500 и 200°C соответственно. Сечения захвата дырок составляли 1
. 23 • 10-11 см2 и 1.35 • 10-13см2 для центров H 1и H2. Эти центры были
донорного типа. Учитывая их различное температурное поведение, было сделано
заключение, что эти центры обусловлены двумя различными дефектами неизвестной
природы. Согласно измерениям EPR и ESR, проведенным на образцах p-6H и4H-SiC,
эти центры могут быть идентифицированы как вакансии VС+ и комплексы с ними [2].

Рис. 2.10 Спектр DLTS для образца 4H-SiC, облученного электронами с
энергией 2.5 МэВ дозой 2.5 • 1014см-2
ВЫВОДЫ
В настоящее время имеется обширный экспериментальный материал (о влиянии
облучения быстрыми частицами и жесткими фотонами па адсорбционные и
каталитические свойства неметаллических кристаллов. Радиационные эффекты
возникали как при облучении образцов от внешнего источника (реакторное
облучение, облучение па ускорителях заряженных частиц и т. д.), так и при
«собственном» радиоактивном самооблучепии при введении в образцы радиоактивных
примесей. Во многих случаях облучение изменяло адсорбционную способность и
каталитическую активность па несколько порядков. Столь сильные радиационные
эффекты вызывают серьезный практический интерес, требуют понимания общих
механизмов наблюдаемых явлений, их количественной интерпретации.
Взаимодействие быстрых частиц и жестких квантов с веществом представляет
собой слояшый каскадный процесс, сопровождающийся, как правило, ионизационными
эффектами и структурными изменениями в кристаллической решетке твердого тела.
Наиболее существенными из возникающих при этом многочисленных нарушений
являются следующие: а) неравновесные свободные и локализованные носители заряда
(электроны и дырки), б) дефекты решетки типа «вакансия - внедрение» и их
комплексы, в) химические примеси, возникшие в результате ядерных реакций в
твердом теле или при ионном легировании. Наблюдаемые радиационные эффекты
обычно являются следствием прежде всего этих нарушений.
Как правило, те или иные типы нарушений связаны с различным характером
взаимодействия радиации с веществом. Быстрые частицы взаимодействуют с
регулярными атомами упруго или неупруго. При упругих взаимодействиях суммарная
кинетическая энергия сталкивающихся частиц сохраняется. Такие столкновения
ответственны главным образом за смещения атомов или ионов в решетке. При
неупругих взаимодействиях часть кинетической энергии идет на образование
одночастичных и коллективных возбуждений твердого тела (электроны, дырки,
экситопы, плазмопы, фононы и т. д.). Неупругими являются также процессы,
приводящие к ядерным превращениям.
Общими результатами указанных выше работ можно считать, что независимо от
политипа и типа проводимости появление в Si всех дефектов не требует
дополнительного нагрева образцов при облучении электронами. При этом увеличение
дозы электронов при облучении приводит к увеличению концентрации радиационных
дефектов в Si вплоть до ее насыщения, а также к уменьшению скорости накопления
центров дефектов, что характерно и для других полупроводников, облученных
высокоэнергетичными частицами [15]. Увеличение концентрации радиационных
дефектов сопровождается уширением спектров DLTS, что позволяет предположить
образование энергетических зон дефектов в запрещенной зоне SiС. Центры,
расположенные вблизи дна зоны проводимости, не оказывают заметного влияния на
степень компенсации легирующей примеси, что проявляется в вольт-фарадных
характеристиках (ВФХ). Установлено, что наиболее термостойкими являются центры
дефектов E1/E2 (Ec-0.4эВ) в 6H-SiC, а также Z1/Z2 (Ec-0.6/0.7эВ) и EH6/7 (Ec
-1.5/16эВ) в 4H-SiC с большими сечениями захвата носителей заряда, не
зависящими от температуры.
Многообразные радиационные центры дефектов, образующиеся в результате
облучения электронами, создают в запрещенной зоне SiC широкий спектр
энергетических уровней, параметры которых наиболее информативно определяются
емкостной и токовой релаксационной спектроскопией (C-DLTS, 7-DLTS).
Результаты исследований глубоких центров (ГЦ), которые появлялись в
кристаллах n-6H-SiC, эпитаксиальных слоях и р+ - n-переходах на их основе, с
концентрациями нескомпенсированных доноров 5 • 1014 -8 • 1017см-3 при облучении
их электронами в широком интервале доз (5 • 1013-1018 см-2) с энергиями 1.5-5
МэВ, представлены в работах [16]. Температурное поведение ГЦ исследовалось при
проведении отжигов облученных образцов до 1600-1700°C. Согласно полученным
данным, независимо от концентрации примесей в исследуемых образцах и режимов
облучения электронами было обнаружено более 10 радиационно-индуцированных
уровней в энергетическом интервале 0.15-1.65 эВ от дна зоны проводимости
6H-SiC. Наиболее характерными являлись уровни с энергиями ионизации 0.18,
0.38/0.44, 0.51, 0.68/0.70, 1.15/1.25 и 1.5эВ (отсчет от уровня зоны
проводимости Ec), которые рассматривались как ловушки дырок (рис. 2.9)[16].
Центр Ec-0.38/0.4эВ, известный как центр E1/E2 [12], был термически стойким и
отжигался при температуре 1600°C [16]. Природа этого центра предполагалась как
дивакансия (VC-VSi) или комплекс, содержащий вакансии VSi [9].Подругой версии
центр Ec - 0.38/0.4эВ объясняется как система из двух отрицательно заряженных U-центров, каждый из которых формирует
два уровня в запрещенной зоне - акцепторый и донорный [15]. В соответствии с
этой концепцией уровень с энергией ионизации Ec - 0. 38 эВ считается центром
акцепторного типа, а уровень с Ec-0.44 - донорного. Центр Ec-0.5эВ с
независимым от температуры сечением захвата носителей заряда 2 • 10-15 см2 -
термически нестабилен, исчезает при прогреве до 250°C и ассоциируется с вакансией
VС+ или комплексом вакансия-примесь [16]. ГЦ с энергией Ec -(0.68-0.71) эВ
идентифицируется какизвестныйцентр Z1/Z2 [102,103]. Выявленные при повышенных
температурах измерения ГЦ с энергиями ионизации Ec-(1 .15-1 .25) и Ec-1 .5 эВ
предположительно связываются со структурными дефектами в виде ассоциатов с
вакансиями [11].
Анализируя отраженные в обзоре результаты исследований по облучению SiC и
приборов на его основе высокоэнергетичными частицами, можно выделить основные
положения.
Все виды воздействия высокоэнергетичными частицами создают в SiC
широкий спектр первичных и вторичных дефектов в различных зарядовых состояниях,
определяющих их подвижности, а также положения энергетических уровней дефектов
в запрещенной зоне. Более подвижные вакансии VC и комплексы с ними отжигаются
при более низких температурах, нежели дефекты на основе вакансий VSi.
С увеличением массы облучающих частиц увеличивается число типов
дефектов, их концентраций и особенно их размеров, что приводит к росту
температуры как появления сложных дефектов, так и их отжига. Увеличение массы
облучающих частиц уменьшает пороговую дозу перехода в аморфное состояние с
одновременным увеличением температуры отжига дефектов.
Наиболее высокотемпературными глубокими радиационными дефектами
при облучении SiC всеми исследованными видами частиц являются центры с уровнями
E1/E2 (Ec - 0.35/0.43эВ), Z1/Z2 (Ec - 0.6/0.74эВ), R (Ec - 1.0/1.2эВ) и EH6/7
(Ec - 1.5/1.6эВ).
Нагрев SiC в процессе облучения приводит к уменьшению скорости
генерации радиационных дефектов и увеличению критической дозы облучения,
приводящей к аморфизации, с наибольшим эффектом при температуре 400°C.
Оптимальной рабочей температурой SiC-приборов можно считать
400-500° C, когда происходит активный отжиг простых дефектов и мала скорость
образования высокотемпературных сложных комплексов дефектов.
Показана возможность увеличения радиационного и временно го
ресурсов SiC-приборов в условиях радиации при повышенных температурах.
СПИСОК
ИСПОЛЬЗОВАННОЙ ЛИТЕРАТУРЫ
1. Аваев
Н.А., Наумов Ю.Е., Фролкин В.Т. Основы микроэлектроники. - М.: Радио и связь,
1991.
. Аствацатурьян
Е.Р., Громов Д.В., Елесин В.В.и др. Радиационные процессы в GaAs
полупроводниковых приборах и интегральных схемах.. //Зарубежная
радиоэлектроника. 1988, №1,с48-83.
. Балашов
Ю.С., Горлов М.И. Физические основы функционирования интегральных устройств
микроэлектроники. Учебное пособие. - Воронеж: ВГТУ, 2002.-160с.
. Богородицкий
Н.П., Пасынков В.В., Тареев В.М.. Электротехнические материалы. - М.:
Энергоатомиздат, 1985.
. Бойко
С.И., Осинский В.И., Синищук И.К. и др Исследование влияния радиационных
дефектов на динамические параметры транзисторов с барьером Шоттки методом тока,
индуцированного электронным зондом..//Физические основы надежности и деградации
полупроводниковых приборов. Кишинев.: Штиинца. 1991, с. 75-76.
6. Босый В.И., Иващук А.В., Ильин И.Ю.и др. Малошумящие транзисторы миллиметрового и субмиллиметрового
диапазонов длин волн. Материалы и технология. //Материалы конференции
«Крымико-96» 6ой Международной Крымской конференции «СВЧ-техника и
телекоммуникационные технологии». Крым, Украина, 16-19 сентября 1996.
Севастополь: Вебер,1996, с.3-9.
. Брудный
В.Н. Исследование радиационных дефектов в полупроводниках в условиях
всестороннего сжатия. // Физика и Техника Полупроводников.- 1999.-Т.33, вып.
11.- С. 1290-1294.
. Брудный
В.Н. Радиационная модификация и дефекты некоторых алмазоподобных
полупроводников сложного состава // Дисс. на соискание ученой степени доктора
физико-математич. наук. Томск. ТомГУ, 1993.-383 с.
. Брудный
В.Н., Каменская И.В. Исследование радиационных дефектов в полупроводниках в
условиях всестороннего сжатия // Физика и Техника Полупроводников.- 1999.-Т.33,
в. 11.- С.1290-1294.
. Вавилов
В.С., Горин Б.М., Данилкин Н.С.и др. /Радиационные методы в твердотельной
электронике.М.: «Радио и связь». 1990, 184 с.
. Венгер
Е.Ф., Грендел М., Данишка В.и др. Структурная релаксация в полупроводниковых
кристаллах и приборных структурах. //Под. ред. Ю.А.Тхорика. Киев: «Феникс».
1994, 248 с.
. Горелик
С.С., Дашевский М. Я. Материаловедение полупроводников и диэлектриков. - М.:
Металлургия, 1988.
. Горлов
М.И., Ануфриев Л.И. Обеспечение и повышение надежности полупроводниковых
изделий в процессе серийного производства. - М.: Бесптринт, 2003.-202с.
. Готра
З.Ю. Технология микропроцессорных устройств: Справочник - М.: Радио и связь,
1991.-528с.
. Действие
проникающей радиации на изделия электронной техники. Под ред. Е.А. Ладыгина.
М.: ЦНИИ Электроника, 1980, 224с.
. Ефимов
И.Е., Козырь Л.Я., Горбунов Ю.М. Микроэлектроника. - М.: Высш. шк., 1986.
. Журавлева
Л.В. Электроматериаловедение. - М.: ACADEMIA, 2004 г.
. Игумнов
Д.В., Королев Г.В., Громов И.С. Основы микроэлектроники. - М.: Высш. шк., 1991.
. Казанцев
А.П. Радиотехнические материалы: Метод. пособие. - Мн.: БГУИР, 1993.
. Казанцев
А.П. Электротехнические материалы. - Мн.: Дизайн ПРО, 1998, 2001.
. Калинина
Е.В. Влияние облучения на свойства SiC и приборы на его основе. Обзор.// Физика
и техника полупроводников, 2007, том 41, вып. 7.
. Конакова
Р.В., Миленин В.В., Соловьев Е.А. и др. лияние g-радиации на электрофизические
свойства арсенидгаллиевых ПТШ .//Радиоэлектроника. 2000, №6, с.45-51.
. Конакова
Р.В., Миленин В.В., Соловьев Е.А.и др. Влияние радиации на вольтамперные
характеристики арсенидгаллиевых полевых транзисторов с затвором
Шоттки..//Радиоэлектроника. 1999, №4, с.73-75.
. Конакова
Р.В., Тхорик Ю.А., Хазан Л.С.. Возможности радиационной технологии при
изготовлении диодов //Электронная техника. Сер.2. Полупроводниковые приборы.
1988, вып. 2, с.47-56.
. Конакова
Р.ВТхорик., Ю.А., Хазан Л.С.. Особенности радиационной технологии при
изготовлении GaAs диодов для СВЧ-электроники //Арсенид галлия. Под ред. Гамана
В.И. Томск: ТГУ, 1982, с.183-185.
. Оболенский
С.В., Павлов Г.П..Влияние нейтронного и космического облучения на
характеристики полевого транзистора с затвором Шоттки //ФТП. 1995, т. 29, вып.
3, с.413-420.
. Пасынков
В.В., Сорокин В.С. Материалы электронной техники. - М.: Высш.шк.,1986, 1980.
. Петров
К.С. Радиоматериалы, радиокомпоненты и электроника. - СПб.: Питер, 2004 г.
. Степаненко
И.П. Основы микроэлектроники. - М.: Сов. радио, 2000.
. Таиров
Ю.М., Цветков В.Ф. Технология полупроводниковых и диэлектрических материалов. -
М.: Высш. шк., 1983, 1990.
. Технология
СБИС/ Под ред. Ю.Д. Чистякова. - М.: Мир, 1986.
. Физика
и материаловедение полупроводников с глубокими уровнями. Под ред. В.И. Фистуля.
М.: Металлургия, 1987, 232с.
. фимов
И.Е., Козырь И.Я., Горбунов Ю.И. Микроэлектроника. Физические и технологические
основы, надежность: Учебное пособие - М.: Высшая школа, 1986.-464с.
. Харрисон
У. Электронная структура и свойства твердых тел (физика химической связи).- М.:
Мир, 1983.-Т.1.-381С.
. Эварестов
Р.А. Квантовохимические методы в теории твердого тела.- Л.: ЛГУ, 1982.- 279 с.