Разработка системы стандартных образцов для определения толщины однослойных тонкопленочных материалов на основе металлов и их сплавов методом энергодисперсионной рентгеновской спектроскопии
Министерство
образования и науки Российской Федерации
Федеральное
государственное бюджетное образовательное учреждение
высшего
профессионального образования
"Кубанский
государственный университет" (ФГБОУ ВПО "КубГУ")
Физико-технический
факультет
Кафедра радиофизики
и нанотехнологий
Допустить к защите в ГАК
Заведующий кафедрой
д-р физ.-мат. наук, профессор
Г.Ф. Копытов
Выпускная
квалификационная работа бакалавра
Разработка
системы стандартных образцов для определения толщины однослойных тонкопленочных
материалов на основе металлов и их сплавов методом энергодисперсионной
рентгеновской спектроскопии
Работу выполнил
Шкилёв Дмитрий Алексеевич
Научный руководитель
канд. хим. наук. В.Ю. Бузько
Нормоконтролер
к.х.н, доцент. М.Е. Соколов
Краснодар
2014
Реферат
Выпускная квалификационная работа 48 страниц, 10 рисунков, 4 таблицы, 31
источник.
Рентгеновская спектроскопия, однослойные тонкопленочный материалы,
нанометрология, растровый электронный микроскоп, характеристические полосы
испускания.
Объектом исследования данной выпускной квалификационной работы являлись
однослойные тонкоплёночные материалы на основе металлов.
Целью квалификационной работы являлась разработка системы стандартных
образцов для определения толщины однослойных тонкопленочных материалов на
основе металлов и их сплавов методом энергодисперсионной рентгеновской
спектроскопии для осуществления метрологического контроля в области
нанотехнологий.
В результате выполнения квалификационной работы были получена серия
однослойных образцов металлов и их сплавов, напылённых на подложки с
варьируемой толщиной слоя. Изучено влияние толщины напылённого слоя на
соотношение характеристических полос испускания в рентгеновских спектрах
относящихся к напылённому слою и подложке при постоянном ускоряющем напряжении.
Изучено влияние ускоряющего напряжения электронного пучка на соотношении
характеристических линий испускания спектров напылённого слоя и подложки.
Содержание
Введение
.
Литературный обзор
.1 Основы
растровой электронной микроскопии
.1.1 Устройство
РЭМ
.1.2
Взаимодействие электронного пучка с веществом
.2 Применение
РЭМ в области нанометрологии
.2.1
Определение размерных характеристик микро- и наноструктур
.2.2
Определение состава микро- и наноструктурных материалов
.2.3 Проблемы
неразрушающего контроля качества наноматериалов и устройств электроники
.
Экспериментальная часть
3. Обсуждение
результатов
Заключение
Список
использованных источников
Введение
Тонкие пленки - это слои вещества толщиной от долей нанометров до
нескольких микрометров, обладающие рядом особенностей атомно-кристаллической
структуры, магнитных, электрических и других физических свойств [1].
В тех случаях, когда говорят о поверхности твердого тела, то обычно имеют
в виду несколько самых верхних атомных слоев кристалла, т.е. области толщиной в
несколько нанометров. При этом наличие поверхности может оказывать влияние на
свойства и более глубоко лежащих слоев. Если свойства твердых тел во многих
случаях можно описать, опираясь на тот факт, что расположение атомов в
кристалле обладает периодичностью в трех измерениях, то появление поверхности
разрушает эту периодичность. Более того, в случае появления очень маленьких
частиц, периодичность может нарушаться уже в трех измерениях. В последние годы
бурно развиваются такие направления научных и технологических исследований как
"нанонаука" и "нанотехнология". Эти направления
рассматриваются как основа новой промышленной революции [2].
Тонкие пленки представляют вид состояния конденсированных веществ. Это
обусловлено спецификой процесса их формирования: тонкие пленки получаются
конденсацией молекулярных или атомных потоков вещества на поверхности, путем
внедрения атомных частиц (ионов) в тонких приповерхностных слоях, химическим
вакуумным осаждением, лазерной абляцией и др. [1-2]
Целью данной квалификационной работы является разработка системы
стандартных образцов для определения толщины однослойных тонкопленочных
материалов на основе металлов и их сплавов методом энергодисперсной
рентгеновской спектроскопии для осуществления метрологического контроля в
области нанотехнологий.
Для достижения этой цели необходимо решить следующие задачи:
получить серию однослойных образцов металлов и их сплавов, напылённых на
подложки с варьируемой толщиной слоя;
изучить влияние толщины напылённого слоя на соотношение
характеристических полос испускания в рентгеновских спектрах относящихся к
напылённому слою и подложке при постоянном ускоряющем напряжении;
изучить влияние ускоряющего напряжения электронного пучка на соотношении
характеристических линий испускания спектров напылённого слоя и подложки.
1. Литературный обзор
.1 Основы растровой электронной микроскопии
Растровый электронный микроскоп (РЭМ) представляет собой источник
электронов, систему их фокусировки в тонкий пучок, оборудование для развертки пучка
в растр, набор соответствующих устройств для регистрации электронов, излучаемых
образцом, монитор для вывода изображения на экран. Рентгеновский спектрометр
является в РЭМ дополнительным оборудованием, которое может использоваться для
получения карты распределения элементов и анализа. Наиболее широко
используемыми типами изображения являются вторичные электроны (SE), дающие
топографическое изображение поверхности образца и обратно рассеянные
(отраженные) электроны (BSE), дающие информацию о распределении элементов
поверхности по среднему атомному номеру микрокомпонентов (минеральный состав и
неоднородность состава). Изображение в рентгеновских лучах или
"карты", позволяют увидеть распределение элемента на поверхности
образца [7].
Увеличение растрового изображения равно отношению размера изображения на
экране монитора к размеру растра. Наименьшее увеличение ограничивается
величиной угла отклонения пучка электронов без искажения изображения и зависит
от рабочего расстояния, будучи максимально низким при максимально возможном
расстоянии от образца до объективной линзы. Увеличение можно повышать, уменьшая
растр на поверхности образца с помощью отклоняющих катушек. РЭМ имеет
возможность менять площадь изображения, "zoom", в очень большом
диапазоне, что иллюстрируется фотографиями, представленными на рисунке 1.
Максимально допустимое полезное увеличение ограничивается, разрешающей [7, 8,
12, 27].
Пространственное разрешение для практических целей адекватно может
определяться, если обстоятельства позволяют увидеть более мелкие детали при
меньшем увеличении. Оно ограничивается диаметром пучка электронов и
взаимодействием электронов с поверхностью образца.

Рисунок 1 - Изображение сеточки для просвечивающего электронного
микроскопа (ПЭМ) при разных увеличениях, показывающие возможности
"zoom" растрового электронного микроскопа (a - ×12, b - ×100)
Диаметр пучка определяется различными инструментальными факторами и в
большинстве РЭМ может быть 10 нм и менее (или ниже 1 нм у специализированных
приборов с высоким разрешением и катодом с полевой эмиссией). Во многих случаях
предельное разрешение РЭМ не требуется и можно использовать больший диаметр
пучка, соответственно, с большим током. Ток пучка и размер контролируются
вначале конденсорной линзой, затем конечной апертурой.
Предельное разрешение определяется взаимодействием пучок/образец, область
размером примерно от 1 мкм для изображений в рентгеновских лучах и до 1 нм для
изображений во вторичных электронах. При неразумно высоком значении увеличения
изображение будет выглядеть расплывчатым. Чтобы избежать этого, следует
пользоваться простым практическим критерием, заключающимся в том, что размер
растра должен быть не менее, чем в 100 раз больше необходимой величины
разрешения, откуда следует, что максимальное рабочее разрешение будет ×1000 (при разрешении 1 мкм) до ×100000 (при разрешении 10 нм).
Изображение получается очень резким, когда концевая (объективная) линза
точно фокусируется на поверхности исследуемого образца. Чтобы получить
правильный фокус нужно проводить регулировку линзы при большем увеличении (с
запасом), чем предположительное рабочее увеличение. Астигматизм, приводящий к
искаженному и нерезкому изображению (рисунок 2) можно устранить с помощью
стигматора. Отклоняющие катушки для сканирования пучка располагаются выше
объективной (концевой) линзы поэтому изображение вращается при регулировке
питания линзы, поскольку электроны в магнитном поле летят по спирали. Этот
эффект обычно мало заметен при фокусировке, но может быть значителен, если
изменяется рабочее расстояние.
Для данного ускоряющего напряжения мощность линзы прямо зависит от
рабочего расстояния и наоборот, рабочее расстояние может быть уменьшено при
установке линзы на резкое изображение. Это соображение полезно при выборе
правильного рабочего расстояния при работе с рентгеновским спектрометром, когда
проводится анализ. Мощность магнитной линзы, требуемая для данного фокального
расстояния, зависит от ускоряющего напряжения и когда оно изменяется,
необходимо отрегулировать параметры линзы, чтобы установить резкое изображение.
В некоторых приборах это делается автоматически. Иногда применяют
устройства для автофокусировки, хотя получение идеального результата
практически всегда связано с работой оператора.
Основным назначением РЭМ является получение изображений трехмерных
объектов. Правильно сфокусировать пучок можно только в одной плоскости; однако,
глубина резкости РЭМ гораздо больше, чем у оптического микроскопа, поэтому в
большинстве случаев изображение получается резким. При наклоне образца, не
всегда возможно получение резкого изображение по всему растру, но в некоторых
приборах фокусное расстояние линзы может меняться автоматически, чтобы
скорректировать этот эффект [9, 10, 11].
Растровое изображение часто сопровождается "шумом", например,
случайными флуктуациями яркости от точки к точке, что мешает разрешать мелкие
детали. Шум имеет два источника: статистические флуктуации, связанные с
количеством детектируемых электронов и шумы электроники системы детектирования.
Первая неустранима, но может быть минимизирована при повышении тока пучка (с
соответствующим ухудшением пространственного разрешения за счет увеличения
диаметра пучка). Вторая изменяется с изменением характеристик системы
детектирования [13].
Ток в 1 нА соответствует 6×10электронов в секунду и в большинстве
случаев количество вторичных или отраженных (обратно-рассеянных) электронов,
регистрируемых на один электрон первичного пучка. Следовательно, для
вышеуказанного тока пучка это составляет примерно 108 регистрируемых за секунду
электронов. Время, которое приходится на отображение одной точки растрового
изображения исходя из 500 линий на растр при скорости (частоте) сканирования 25
Гц составляет 160 нс, так что на одну точку растра приходится всего 20 регистрируемых
электронов. (При растровом изображении высокого разрешения во вторичных
электронах SE ток пучка гораздо ниже и детектируется всего несколько электронов
на точку растра). Поэтому растровое изображение со скоростью телевизионной
развертки совершенно заполнено шумами [14].
Причем, детали изображения размываются из-за ограничений собственной
ширины полосы несущей частоты системы детектирования. Влияние собственных шумов
и ширины полосы можно значительно снизить при использовании медленного
сканирования, когда изображение наблюдается на (КЛТ) с большим послесвечением,
когда изображение на дисплее наблюдается за один проход, несмотря на
относительно большое время сканирования растровой картинки. При частоте
сканирования 1 Гц, время, приходящееся на отображение одной точки картинки (для
растра в 500 линий) составляет 4 мкс, что дает около 400 электронов на одну
точку при одном и том же токе первичного пучка; поэтому на изображении гораздо
меньше шумов. Дальнейшее снижение шумов может достигаться за счет еще большего
замедления сканирования в процессе фиксации изображения либо фотографированием,
либо записью картинки в памяти компьютера (ЭВМ). Нет смысла снижать шумовой
порог ниже возможностей человеческого глаза в разделении градации яркости, в то
же время усиление контраста усиливает шумы, о чем следует помнить при фиксации
(записи) изображения [15, 16].
В системе сканирования первичного пучка "аналогового" типа,
точка отклоняется с помощью непрерывного сигнала, причем электронный сигнал,
используемый для модуляции яркости (КЛТ), также имеет аналоговую форму. В
цифровой системе сигнал развертки растра создается в дискретной форме
компьютером с помощью цифро-аналогового преобразователя (ЦАП). В данном случае
сигнал управления формируется в виде ступенчатой кривой, когда пучок переходит
с одной ступеньки на другую; каждой ступеньке соответствует "время
задержки" перед переходом на другую ступеньку. Обычно одна кривая содержит
1024 ступеньки. Детекторный выход оцифровывается с помощью аналого-цифрового
преобразователя (АЦП) и каждое число хранится в памяти компьютера для каждой
точки растровой картинки (или "пикселя"). Для воспроизведения
картинки эти числа преобразуются обратно в импульс электрического напряжения с
помощью ЦАП; он модулирует яркость КЛТ. В результате получается картинка
подобная аналоговой развертке, на ней можно увидеть дискретные точки; кроме
того, "уровень серого" также "квантуется", хотя, как
правило, качество изображения от этого не ухудшается, поскольку человеческий глаз
более 16 уровней серого на одной картинке не различает. С системой цифрового
сканирования картинка может храниться и выводиться на экран со скоростью
телевизионной ТВ развертки или более медленную развертку суммировать с
сохраненными данными. Такой подход позволяет видеть непрерывную картинку,
качество которой улучшается при каждом следующем сканировании по растру
благодаря снижению уровня шумов и давая преимущество по сравнению с
"живым" аналоговым изображением. Другим преимуществом системы
цифрового сканирования является простота хранения и вывода картинки на экран
монитора, возможность обработки изображений с добавлением цветовых эффектов,
чтобы выделить некоторые интересные особенности образца [14].
Основной функцией РЭМ является получение изображений трехмерных объектов.
Преимуществом перед оптической микроскопией является большее поперечное
разрешение и разрешение по глубине. К счастью, природа изображений на РЭМ
такова, что человеческий мозг может привычным образом интерпретировать
топологическую информацию, которую они содержат. Картинки, как во вторичных,
так и в отраженных электронах содержат топографический контраст, однако, первые
больше связаны с рельефом, а вторые с составом образца [17].
Вторичные электроны излучаются из слоев образца очень близких к
поверхности, а их энергии составляют несколько электрон вольт.
Число вторичных электронов увеличивается с уменьшением угла между
падающим пучком и поверхностью образца (рисунке 2), что приводит к росту
трехмерного эффекта изображения объекта. Детектор электронов Эверхарта-Торнли,
имеющий положительно заряженную сетку притягивает даже те электроны, которые не
находятся в прямой видимости детектора и из каверн на поверхности образца, хотя
такие электроны собираются менее эффективно, чем те электроны, которые выходят
из деталей поверхности, лежащих в прямой видимости детектора. В значительной
степени, контраст на картинке во вторичных электронах растет при изменении
выхода вторичных электронов относительно поверхности образца; максимальный
выход наблюдается, когда пучок электронов падает под углом. Этот эффект очень
близок тому, который наблюдается при освещении предмета прямым пучком света и
частично диффузным освещением, что делает эффектом в результате наклонного угла
падения электронов к плоскости поверхности образца. (Следует отметить
повышенную глубину резкости) топографическую информацию легко интерпретируемой.
Детектор должен быть обращен к верхней части (стороне) растра (т.е. в задней
части камеры образцов), чтобы имел место эффект "максимальной освещенности".
Если расположить его ниже, то может проявиться обратный эффект (открытого
склона, "холма") или (закрытого склона, "долины").
Эффективность детектора, связанная с его ориентацией, может быть
подкорректирована вращением направления сканирования (растра). Увеличение числа
вторичных электронов может иметь место при краевом эффекте, что проявляется в
повышенной яркости освещения края объекта образца на экране. "Краевой
эффект" сильнее проявляется при высоких ускоряющих напряжениях за счет
большей глубины проникновения электронов в образец. Эмиссия вторичных
электронов не очень зависит от состава образца (имеется в виду эффективный
атомный номер) и в случае напыления образца каким-либо покрытием определяется,
главным образом, материалом покрытия. В некоторых случаях эффект влияния
атомного номера может иметь место на изображениях во вторичных электронах за
счет регистрации отраженных электронов (когда их число сравнимо с числом
вторичных электронов на данном участке образца благодаря рассеянию вторичных
электронов на деталях камеры образца, например, на полюсном наконечнике
магнитной линзы). Этот эффект может быть минимизирован (если это необходимо) за
счет нанесения покрытия с низким атомным номером на детали камеры образца.
Выход детектора Эверхарта-Торнли так же дает вклад в суммарный сигнал,
регистрируя отраженные электроны, хотя доля его незначительна, если детектор
настроен на регистрацию вторичных электронов [18, 19].

Рисунок 2 - Изменение выхода вторичных электронов в зависимости от угла
наклона поверхности образца относительно горизонтали

Рисунок 3 - Сигналы
обратно-рассеянных электронов, зарегистрированные от противоположных секторов
детектора для плоского образца (а) и от ступеньки (b). Видно, что разность
сигналов дает топографию образца, а суммарный сигнал минимизирует топографию и
дает распределение по составу
Результирующий эффект дает значительное влияние на топографию (рельеф)
изображения. Детектор Эверхарта-Торнли, при отсутствии смещения на сетке
регистрирует отраженные электроны, и не регистрирует вторичные электроны.
Однако, гораздо эффективнее отраженные электроны регистрируются с помощью
сцинтиллятора с большой площадью или кольцевым полупроводниковым детектором.
Если кольцевой детектор разделить на сектора, то разность сигналов от секторов
расположенных с разных сторон образца будет давать топографию, а суммарный
сигнал от всех секторов детектора будет давать информацию о составе образца.
При использовании обычных типов детекторов обратно-рассеянных электронов,
которые не чувствуют электроны низких энергий (вторичные электроны), для
получения изображения в отраженных электронах необходимо ускоряющее напряжение
первичного пучка не ниже 15 кВ.
Однако следует помнить, что с увеличением ускоряющего напряжения,
поперечное разрешение на картинке в отраженных электронах будет ухудшаться.
Поэтому при больших увеличениях изучать топографию предпочтительнее во
вторичных электронах.
.1.1 Устройство РЭМ
Электронно-оптическая колонна растрового электронного микроскопа состоит
из электронной пушки, нескольких электромагнитных фокусирующих линз,
отклоняющей системы и набора диафрагм (рисунок 4). Электронная пушка является
стабильным источником электронов, а система линз используется для формирования
узкосфокусированного электронного пучка. На выходе из катода электроны
представляют собой электронное облако, сконцентрированное у острия. Путем
подачи положительного напряжения на анод, расположенный в области острия
катода, электроны разгоняются и превращаются в направленный пучок электронов
[20].
В настоящее время разработано несколько типов катодов, которые работают
на принципе термоэлектронной и/или автоэлектронной эмиссии, т.к. преодолеть
работу выхода электронов из твердого тела (в данном случае из острия катода)
можно либо путем разогрева электронов, либо путем приложения сильного
электрического поля. Рассмотрим основные типы эмиссии и устройство катодов на
их основе.

Рисунок 4 - Принципиальная схема РЭМ
.1.2 Взаимодействие электронного пучка с веществом
Большой класс экспериментальных методов основан регистрации сигналов,
возникающих в процессе облучения исследуемого объекта электронным пучком. Эти
методы называют электронно-зондовыми. К ним относятся такие методы, как
растровая электронная микроскопия РЭМ, рентгеноспектральный микроанализ (РСМА),
катодолюминесценция (КЛ), оже-спектроскопия и др. для корректной интерпретации
получаемых данных необходимо понимание процессов взаимодействия электронов с
исследуемыми объектами [12].
Характерная энергия электронов в пучке составляет от 1 до 50 кэВ. Это
означает, что электроны с такой энергией могут возбудить большое количество
разнообразных процессов в объекте. Однако, за исключением специальных редких
случаев (таких, как органические материалы). Энергии налетающих электронов
недостаточно для разрыва атомной связи или смещения атома. Поэтому
электронно-зондовые методы относятся к неразрушающим методам анализа. При
взаимодействии с образцом электроны пучка претерпевают взаимодействия, которые
можно разделить на упругие и неупругие. Для высокоэнергетических электронов
выше вероятность рассеяться упруго, для низкоэнергетических электронов -
неупругое [15].
При упругом рассеянии изменяется направление вектора скорости электрона,
а ее величина и, следовательно, величина кинетической энергии фактически
остается постоянной. Образцу при каждом акте упругого рассеяния передается
энергия порядка 1эВ, что пренебрежимо мало по сравнению с первоначальной
энергией электронов в пучке (~ 1 кэВ). Угол отклонения от направления падения
может принимать значения в переделах от 0° вплоть до180°, но его наиболее
вероятное значение составляет по порядку величины единицы градусов. Упругое
рассеяние происходит в результате столкновений электронов высокой энергии с
ядрами атомов, частично экранированных связанными электронами. В результате
упругих взаимодействий электрон может покинуть образец. Такой электрон
называется отражённым. Экспериментально установлено, что доля отраженных
электронов может достигать 30% от изначального количества электронов пучка.
Электроны пучка, которые вылетают с поверхности образца в качестве отражённых
электронов, имеют меньшую энергию, чем до взаимодействия, так как проходят некоторое
расстояние внутри твёрдого тела и теряют энергию. Контраст изображения,
полученный в режиме отражённых электронов в растровой электронной микроскопии
позволяет извлекать полезную информацию о различии среднего атомного номера
исследуемого объекта. Коэффициент отражения электронов прямо пропорционален
атомному номеру матрицы, поэтому более светлые области на изображении
соответствуют фазам с большим средним атомным номером [17, 18, 19]
Неупругое рассеяние. При неупругих взаимодействиях траектория электрона
изменяется мало, при этом происходит передача энергии твёрдому телу. Неупругие
взаимодействия происходят, в основном, между электронами пучка и электронами
образца. Благодаря неупругим взаимодействиям возникают: вторичные электроны;
непрерывное рентгеновское излучение; характеристическое рентгеновское
излучение; оже-электроны; колебания решётки (фононы); электронные
колебания(плазмоны); электронно-дырочные пары; катодолюминесценция.
Взаимодействие электронного пучка с твёрдым телом может привести к высвобождению
слабо связанных электронов зоны проводимости (т.е. медленных вторичных
электронов). Вторичными принято называть электроны, обладающие энергией до 50
эВ. (Этот порог задан условно для того, чтобы различать вторичные и отражённые
электроны.) Большая часть вторичных электронов имеет энергию от 3 до 5 эВ.
Чтобы вылететь из твердого тела, вторичные электроны должны преодолеть
поверхностный потенциальный барьер. Поэтому только вторичные электроны,
находящиеся в тонком приповерхностном слое толщиной от 5 до 50 нм, могут
покинуть образец. Следовательно, плотность и направление вторичных электронов
зависит от рельефа поверхности. Регистрируя вторичные электроны можно получить
информацию о топографическом контрасте в РЭМ. В режиме вторичных электронов достигается
высокое пространственное разрешение, которое определяется диаметром
электронного зонда и составляет величине 5 нм в серийно выпускаемых РЭМ [21,
22].
Процессы вторичного явления, происходящие при взаимодействии электронного
пучка с твёрдым телом, могут быть причиной других физических явлений. Например,
рентгеновское излучение поглощается образцом. Поглощение может в разы уменьшать
интенсивность рентгеновского излучения, выходящего из образца. Интенсивность
характеристического рентгеновского излучения, распространяющегося в поглощающей
среде, спадает с расстоянием по закону Бугера. В веществе может также
происходить неупругое рассеяние рентгеновского излучения, в результате которого
происходит изменение энергии за счёт эффекта Комптона, при котором рентгеновское
излучение взаимодействует со свободным электроном. Однако вероятность этого
эффекта при данных энергиях настолько мала, что им можно пренебречь. Следует
также упомянуть о вторичном рентгеновском излучении (вторичной флуоресценции).
Атомы вещества поглощая рентгеновское излучение оказываются в ионизованном
возбуждённом состоянии. Релаксируя, они испускают характеристическое излучение,
которое называют вторичным (т.к. оно возникло под действием рентгеновского
излучения, в отличие от первичного, которое обусловлено непосредственной
электронной ионизацией). Вторичное рентгеновское излучение может возникать под
действием как тормозного излучения, так и характеристического. Как правило,
вклад тормозного излучения во вторичную флуоресценцию пренебрежимо мал [15].
Рассмотрим случай вторичной флуоресценции под действием
характеристического излучения подробнее. Допустим, что в образце есть два
элемента А и В с близкими значениями характеристических линий. Если энергия
характеристического излучения элемента A превышает энергию поглощения элемента
B, то возникнет вторичное излучение элемента B, обусловленное элементом A. Для
возникновения значительного эффекта вторичной флуоресценции необходимо, чтобы
линия элемента А хорошо поглощалась элементом В. На практике, такие ситуации
встречаются довольно редко (Ni, Kα вызывает вторичную флуоресценцию Fe,
Kα и др.) Все эти
процессы взаимодействия электронного пучка с веществом выявляет ряд
рентгеновских излучений, таких как характеристическое и тормозное рентгеновское
излучение [15, 21].
Характеристическое рентгеновское излучение. Исследование спектров
вторичных рентгеновских лучей позволило обнаружить, что при достаточно большом
ускоряющем напряжении между электродами рентгеновской трубки в спектре
рентгеновских лучей на фоне непрерывной составляющей появляются узкие пики
высокой интенсивности. Эти пики называются рентгеновскими спектральными линиями
(по аналогии с оптическими спектральными линиями). В экспериментах было
установлено, что расположение спектральных линий на оси длин волн определяется
элементным составом материала анода. При этом каждому химическому элементу
соответствует определенный индивидуальный набор длин волн линейчатого
рентгеновского спектра. Существенно, что численные значения этих длин волн не
зависят от вида химического соединения, в который входит данный химический
элемент. По этой причине рентгеновское излучение, имеющее линейчатый спектр,
называется характеристическим рентгеновским излучением (ХРИ). Этим
рентгеновские линейчатые спектры принципиально различаются от оптических
спектров атомов, которые существенно изменяются при объединении атомов в
молекулы. Линейчатый рентгеновский спектр, в отличие от атомных оптических
спектров, состоит из небольшого числа резких пиков, которые объединяются в серии
по близости значений длин волн. Самая коротковолновая серия ХРИ называется
К-серией. Для большинства химических элементов хорошо разрешаются 3 пика этой
серии: Кα,
Кβ,
Кγ,
где греческие буквы
расставлены в порядке убывания интенсивности спектральных линий. В линейчатых
рентгеновских спектрах присутствует также более длинноволновая L-серия
спектральных линий. Для любого химического элемента длины волн L-серии в
несколько раз больше, чем длины волн К-серии. Интенсивность линий L-серии, как
правило, меньше, чем интенсивность линий К-серии того же химического элемента,
находящегося в тех же условиях эксперимента. При увеличении разрешающей
способности рентгеновских спектрометров и просмотре более длинноволновых
участков рентгеновского диапазона обнаруживаются у тяжелых элементов
рентгеновские спектральные серии, обозначаемые буквами M, N и O. Каждая из этих
серий состоит из спектральных линий всё более длинных волн, которые постепенно
смещаются в направлении ультрафиолетового диапазона шкалы электромагнитных
волн. Длинноволновые серии ХРИ отличаются более сложным составом и меньшей
интенсивностью спектральных линий по сравнению с коротковолновыми сериями для
того же химического элемента [22, 23].
В результате торможения электрона (или иной заряженной частицы)
электростатическим полем атомного ядра и атомарных электронов вещества
антикатода возникает тормозное рентгеновское излучение. Механизм его можно
пояснить следующим образом. С движущимся электрическим зарядом связано
магнитное поле, индукция которого зависит от скорости электрона. При торможении
уменьшается магнитная индукция и в соответствии с теорией Максвелла появляется
электромагнитная волна. При торможении электронов лишь часть энергии идет на
создание фотона рентгеновского излучения, другая часть расходуется на
нагревание анода. Так как соотношение между этими частями случайно, то при
торможении большого количества электронов образуется непрерывный спектр
рентгеновского излучения. В связи с этим тормозное излучение называют еще
сплошным [24].
При помощи растрового электронного микроскопа можно пользоваться методом
энергодисперсионного рентгеновского анализа. Этот метод позволяет провести
элементный анализ образца. Спектрометр с энергетической дисперсией (ЭД) создан
на базе полупроводникового детектора, формирующего электрические импульсы,
пропорциональные энергии рентгеновского фотона, которые затем сортируются по
величине многоканальным анализатором для получения рентгеновского спектра.
Поступающие в многоканальный анализатор импульсы быстро обрабатываются и
суммируются в каждом канале анализатора; время набора импульсов устанавливается
оператором. ЭД спектрометры, работающие в энергетическом диапазоне
рентгеновского излучения представляют собой полупроводник (обычно кремниевый,
но иногда германиевый) с электронной зонной структурой, в которой валентная
зона в нормальном состоянии заполнена электронами. Если один из них переходит в
зону проводимости, он становится свободным для перемещения и повышает
электропроводность материала, при этом в валентной зоне образуется
"дырка", ведущая себя как свободный (подвижный) положительный заряд.
Валентная зона отделена от зоны проводимости запрещенной зоной (для кремния
1.1эВ). При комнатной температуре только некоторые электроны имеют достаточную
тепловую энергию, чтобы преодолеть запрещенную зону, поэтому его
электропроводность очень низкая. Когда материалом детектора поглощается
рентгеновский фотон, он генерирует Оже- и фотоэлектроны, передающие часть своей
энергии электронам валентной зоны, которые переходят в зону проводимости. Таким
образом, каждый рентгеновский фотон попадающий в детектор, формирует короткий
импульс электрического тока, создаваемый электронами и "дырками",
движущимися в противоположных направлениях под воздействием приложенного к детектору
электрического поля (смещения). Энергия генерации одной электронной пары для Si
составляет 3,8 эВ. Величина выходного импульса зависит от числа электронов и
"дырок", образующихся при кратности энергии рентгеновского фотона 3,8
эВ. Следовательно, фотон AlKα (энергия 1,487 кэВ) производит в
среднем 391 пару электрон- "дырка", тогда как фотон NiKα (7,477 кэВ) производит 1970 пар.
Поэтому рентгеновские фотоны можно разделять по величие выходных электрических
импульсов. Даже кремний высокой очистки содержит примеси, которые повышают
электропроводность кремния, и он не удовлетворяет (по уровню проводимости)
необходимым к материалу детектора требованиям. Снижение электропроводности
кремния обеспечивается введением в него примеси атомов лития с помощью, так
называемого, процесса "дрейфа" (обычно методом ионной имплантации) -
поэтому полученный материал называется "литий дрейфовый кремний" или
Si(Li) детектор. Также существует кремний-дрейфовый детектор (SDD),
используемый в настоящей работе. Метод EDS используется для просвечивающей
электронной микроскопии благодаря высокой эффективности детектирования [14,
25].
.2 Применение РЭМ в области нанометрологии
Создание новой техники, наукоемких технологий и новых материалов,
обеспечивающих коренные сдвиги в структуре и техническом уровне производства,
во многом определяется уровнем метрологического обеспечения измерений. Одна из
наиболее интенсивно развивающихся наукоемких отраслей промышленности -
электронная, особенно микроэлектроника. Эволюционному процессу развития микроэлектроники
свойственно непрерывное последовательное уменьшение геометрических размеров
элементов и структур микросхем, обусловленное потребностями повышения степени
интеграции и быстродействия. Для традиционных изделий микроэлектроники
наметился этап перехода к структурам, имеющим на внешней поверхности рельефные
элементы субмикронных размеров. Сегодня технология микроэлектроники
превращается в нанотехнологию, т.е. технологию, где необходимо применение
техники нанометровых измерений - нанометрии [21, 25, 26].
Линейные измерения на субмикро- и нанометровом уровнях играют важную роль
в разработке принципиально новых технических решений при создании
микроэлектронных приборов и микросистемной техники различного назначения.
Например, в микроэлектронике при производстве интегральных схем исключительно
важное значение имеют измерения геометрических размеров элементов трехмерной
топологии базовых структур (периода, ширины линии, высоты профиля, положения и
качества краев), составляющих десятые доли микрометра и соизмеримых с длиной
волны видимого света [26, 27].
Все страны, вступившие в нанотехнологический прорыв, прекрасно
представляют необходимость опережающего развития метрологии в этой бурно
развивающейся области знания. Ведь именно уровень точности и достоверности измерений
способен либо стимулировать развитие соответствующих отраслей экономики, либо
служить сдерживающим фактором. Особо это подчеркивает то обстоятельство, что в
нанотехнологиях приборно-аналитическая и технологическая составляющие работают
на пределе своих возможностей, что увеличивает вероятность ошибки, тем более
связанной с человеческим фактором [28].
Одна из первоочередных задач стандартизации в нанотехнологиях -
стандартизация параметров и свойств материалов, объектов, элементов и структур
нанотехнологий, подлежащих измерениям. При межотраслевом и междисциплинарном
характере нанотехнологий, различной терминологии и разных исследовательских и
измерительных приемах и методах - это непростая, последовательно решаемая
задача, несущая в себе объединяющее начало. К ней вплотную примыкает другая
задача - необходимость стандартизации терминов и определений в нанотехнологиях,
направленная на решение проблем общения и взаимопонимания различных групп
исследователей не только внутри одной отдельно взятой страны, но и в рамках
междисциплинарного обмена информацией между странами. Отсюда закономерное
следствие - необходимость аттестованных и стандартизованных методик выполнения
измерений, методик калибровки и поверки средств измерений, применяемых в
нанотехнологиях, и многое другое, что определяется потребностями развития
инфраструктуры наноиндустрии. Особый аспект стандартизации - решение задач
обеспечения здоровья и безопасности операторов технологических процессов и лиц,
взаимодействующих с продукцией нанотехнологий на всех этапах ее производства,
испытаний, исследований и применений, а также экологической безопасности
окружающей среды. Обеспечение единства измерений физико-химических параметров и
свойств объекта измерения требует привязки соответствующего средства измерений
к эталону, воспроизводящему единицу данной физической величины (например,
проводимости - к эталонному сопротивлению), а в нанотехнологиях в большинстве
случаев - еще и обязательной привязки к базисному эталону единицы длины [29].
Линейка объектов нанотехнологий и собственно наноиндустрии чрезвычайно
широка, простирается от ультрадисперсных сред до наноструктурированных
многослойных материалов и кристаллов. Она включает квантоворазмерные структуры
с размерностями локализации: одна - так называемые квантовые ямы (сверхтонкие
слои), две - квантовые проволоки или нити, три - квантовые точки. Особенности
физических эффектов и протекающих при этом процессов, в том числе оптических,
люминесцентных, электрических, магнитных, механических и многих других,
определяются характерным размером. Причем в одном и том же материале различные
эффекты, связанные с размером, проявляются по-разному. Например, особенность
оптических свойств материала в ультрадисперсном виде может проявляться при
одних размерах наночастиц, а теплофизических - при других. Большинство методов
исследований и измерений, которые широко применяются в наноиндустрии, -
просвечивающая и растровая электронная микроскопии РЭМ, сканирующая зондовая
микроскопия, ионно-полевая микроскопия, фотоэмиссионная и рентгеновская
спектрометрии и рентгеновская дифрактометрия, требуют калибровки средств
измерений по стандартным образцам состава, структуры, свойств с известными
размерными (геометрическими) характеристиками.
Первостепенной задачей опережающего развития нанометрологии считают
необходимость реализации наношкалы в нанометровом и прилегающих к нему
диапазонах. Именно этой первостепеннейшей задаче нанометрологии посвящаются
конференции и многочисленные публикации. Отметим существенный вклад России в решение
этой фундаментальной измерительной проблемы. Достижение предельных возможностей
при измерениях длины в нанометровом диапазоне связано с использованием
высокоразрешающих методов РЭМ и сканирующей зондовой микроскопии в сочетании с
лазерной интерферометрией и рентгеновской дифрактометрией при сохранении
абсолютной привязки к первичному эталону метра.
В результате длительных исследований в России концептуально создана
основа метрологического обеспечения измерений длины в диапазоне от 1 до 1000
нм. При этом разработаны: методология обеспечения единства измерений в
диапазоне длин от 1 до 1000 нм, включающая принципы зондовой микроскопии и
лазерной интерферометрии и рентгеновской дифрактометрии; эталонный комплекс
средств измерений, обеспечивающий воспроизведение и передачу размера единицы
длины в диапазоне от 1 до 1000 нм вещественным мерам длины с погрешностью 0,5
нм; поколение мер малой длины для калибровки средств измерений в диапазоне от 1
до 1000 нм, в том числе меры нанорельефа поверхности; методология и алгоритмы
измерения параметров профиля элементов микро- и наноструктур и пакет
компьютерных программ для автоматизации таких измерений. Важнейший этап в
решении задач метрологического обеспечения линейных измерений в нанометровом
диапазоне - это создание вещественных носителей размера - мер, с
программируемым нанорельефом поверхности. Они обеспечивают калибровку средств
измерений с наивысшей точностью. Именно такие трехмерные меры малой длины, или
эталоны сравнения, - материальные носители размера, позволяют осуществлять
комплексную калибровку и контроль основных параметров растровых электронных и
сканирующих зондовых микроскопов [30].
Для аттестации эталонов сравнения используют эталонную трехмерную
интерферометрическую систему измерений наноперемещений. Аттестуют шаг меры и
размеры верхних и нижних оснований выступов и канавок (ширина линии), а также
высоту (глубину) рельефа. Эталоны сравнения можно изготовить с разной шириной
линий от 10 нм до 1500 нм и высотой рельефа от 100 нм до 1500 нм, но при одном и
том же шаге структуры.
Кроме того, при необходимости подтвердить правильность измерений можно
контролировать параметры РЭМ непосредственно в процессе проведения измерений
размеров исследуемого объекта. Это является дополнительной гарантией высокого
качества измерений. Мера позволяет легко автоматизировать линейные измерения и
создавать на основе растровых электронных микроскопов автоматизированные
измерительные комплексы. Ряд подобных комплексов уже существует. Так в
научно-исследовательском центре по изучению свойств поверхности и вакуума
(НИЦПВ) создан автоматизированный комплекс для линейных измерений в области
размеров от 1 нм до 100 мкм на основе растрового электронного микроскопа
JSM-7500F.
Развитие нанотехнологий ужесточает требования к измерительным системам,
погрешности измерений которых должны быть сравнимы с межатомными расстояниями.
Все это требует серьезного отношения к вопросу обеспечения единства линейных
измерений в нанометровом диапазоне. РЭМ и сканирующий зондовый микроскопы
только тогда могут считаться средствами измерений, когда их параметры будут
соответствующим образом аттестовываться, калиброваться и контролироваться,
причем последнее непосредственно в процессе измерений. Трехмерные меры или
эталоны сравнения - материальные носители размера - своеобразный мост между
объектом измерений и эталоном метра, являются идеальным средством для
осуществления таких операций. Важно одно: культура измерений требует, чтобы
любой растровый электронный или сканирующий зондовый микроскоп, независимо от того,
где он находится должен быть укомплектован мерами, обеспечивающими калибровку и
контроль параметров этого сложного устройства. Только тогда измерения,
производимые на нем, могут претендовать на достоверность. Кроме того,
использование методов и средств калибровки и аттестации растровых электронных и
сканирующих зондовых микроскопов производителями соответствующих приборов
позволит им создавать новые приборы с лучшими характеристиками, которые, в свою
очередь, позволят продвинуться дальше на пути развития нанотехнологий [20]
Достижение предельных возможностей в нанометрии связано с использованием
высокоразрешающих методов сканирующей зондовой микроскопии: растровой
оптической, растровой электронной, сканирующей туннельной и атомно-силовой в
сочетании с лазерной интерферометрией и фазометрией.
Основная проблема измерений длины в указанном диапазоне связана с
недостаточно исследованными соотношениями между объектом измерений и его
изображением в измерительных микроскопах, работающих на различных физических
принципах. Регистрируемое изображение неадекватно реальному профилю измеряемого
элемента рельефа поверхности объекта. Эта проблема имеет фундаментальный
характер и усугубляется сложной природой взаимодействия инструмента с объектом
измерений, их сильным взаимным влиянием. Объекты таких размеров не имеют
строгой геометрической границы, и необходимо учитывать физические свойства
объекта и специфику выбранных методов измерений длины в нанометровом диапазоне.
В связи с этим особую важность приобретает физическая модель взаимодействия
средств измерений с создаваемыми объектами, и интерпретация в рамках этой
модели результатов измерений с привлечением методов математического
моделирования, обеспечивающих уменьшение систематической погрешности измерений
линейных размеров, связанных с локализацией края измеряемого элемента [20, 28].
Особенность нанотехнологии состоит в том, что необходим независимый
контроль прецизионного перемещения и взаимного расположения измерительного
зонда и объекта, а также фиксация положения объекта с погрешностью 0,1 нм, что
соответствует локальности метода сканирующей зондовой микроскопии. Это, в свою
очередь, требует создания суперпрецизионных систем нанопозиционирования как
зонда, так и объекта, и разработки высокоточных средств измерений их
линейно-угловых перемещений в реальном масштабе времени с погрешностью менее 1
нм. Кроме того, для контроля нанотехнологии сверхточной обработки поверхностей
микрообъектов необходимы бесконтактные быстродействующие средства измерений
шероховатости и формы поверхности с нанометровой погрешностью.
Важная роль в решении проблемы обеспечения единства и достижения
требуемой точности линейных измерений в микро- и нанометровом диапазонах
принадлежит специальным "тест-объектам", аттестованным в качестве
эталонных мер малой длины и стандартных образцов с размерами структурных
элементов от 10 до 3000 нм, служащих для калибровки и аттестации
контрольно-измерительного и технологического оборудования нового поколения.
Технология создания мер и стандартных образцов должна обеспечивать заданную
топологию поверхности, стабильные и воспроизводимые параметры геометрической
структуры и отвечать требованиям их применения в различных средствах измерений
малых длин.
Возрастающие требования к точности измерений линейных размеров,
разнообразие свойств материалов и геометрической структуры, увеличение числа
элементов в единице объема приводят к значительному росту числа измерений и
необходимости создания высокопроизводительных автоматизированных средств.
Согласно предъявляемым требованиям погрешности рабочих средств измерений длины
в диапазоне от 0,1 до 10 мкм составляют от 1 до 10 нм, что соизмеримо с
погрешностью Государственного первичного эталона единицы длины (ГЭТ) [
Спецификой изучения свойств наноструктурированных материалов является то
обстоятельство, что используемые для этой цели средства измерений работают на
пределе своих возможностей. Небольшие изменения параметров взаимодействия
электронных пучков, используемых для этой цели, определяют существенные
изменения информативных сигналов, резкое изменение контраста изображений.
Многие детали этого взаимодействия требуют существенного уточнения,
дополнительных экспериментальных и теоретических исследований. Это ставит перед
метрологией ряд задач, таких как разработку новых стандартных образцов для
поверки калибровки и настройки оборудования.
.2.1 Определение размерных характеристик микро- и наноструктур
Средства измерений классифицируются по весьма разнообразным признакам,
которые в большинстве случаев взаимно независимы, и в каждой системе единиц
(СИ) могут находиться почти в любых сочетаниях.
Основные критерии:
принцип действия;
способ образования показаний;
способ получения числового значения измеряемой величины;
точность;
условия применения;
степень защиты от внешних магнитных и электрических полей;
устойчивость против механических воздействий и перегрузок;
стабильность;
чувствительность;
пределы и диапазоны измерений.
Поверка средств измерений.
Поверка - совокупность действий, выполняемых для определения или оценки
погрешностей СИ. Поверки бывают государственные (внеплановые), обязательные
(при производстве прибора) и периодические. При поверке сравниваются меры или
показатели измерительных приборов с более точной образцовой мерой или с
показаниями образцового прибора. Класс точности образцового прибора должен быть
на 3 единицы выше поверяемого.
Операции поверки средств измерений. В операцию поверки входит
предварительный внешний осмотр и проверка комплектности прибора. Поверка
производится по поверочной схеме, составленной соответствующей метрологической
организацией. Сроки и методы поверки регламентируются нормативной
документацией. Результаты поверки оформляются в виде протокола и по окончании
поверки делается вывод про пригодность данного прибора к эксплуатации.
Методы поверки средств измерений. Поверка - совокупность действий,
выполняемых для определения или оценки погрешностей СИ.
Основные методы поверки:
путем непосредственного сличения;
с помощью приборов сравнения;
поверка СИ по образцовым мерам;
поэлементная поверка СИ;
поверка измерительных приборов сравнения.
Стандартизация - деятельность по разработке, опубликованию и применению
стандартов; также деятельность по установлению норм, правил и характеристик в
целях обеспечения безопасности продукции, работ и услуг для окружающей среды,
жизни, здоровья и имущества, технической и информационной совместимости, а
также взаимозаменяемости продукции; качества продукции, работ и услуг в
соответствии с уровнем развития науки, техники и технологии; единства
измерений; экономии всех видов ресурсов; безопасности хозяйственных объектов с
учётом риска возникновения природных и техногенных катастроф и других
чрезвычайных ситуаций; обороноспособности и мобилизационной готовности страны
Стандартизация направлена на достижение оптимальной степени упорядочения
в определенной области посредством установления положений для всеобщего и
многократного применения в отношении реально существующих или потенциальных
задач [26].
.2.2 Определение состава микро- и наноструктурных материалов
Стандартные образцы - вещества (материалы) с достаточно точно известными
и официально аттестованными значениями величин, характеризующих их хим. состав
(содержание элементов, соединений и др.), свойства (термодинамические,
оптические и др.) либо некоторые физико-химические или технические параметры
(напр., молярной массы полимеров, площадь поверхности порошков, коррозионная
стойкость сплавов). Стандартные образцы изготовляют по спец. технологии;
аттестованные значения величин и показатели, характеризующие стандартные
образцы, устанавливают по данным тщательно спланированных исследований.
Сведения об аттестованных значениях величин, а также др. информацию,
необходимую для применения стандартных образцов, приводят в особом
документе-свидетельстве. К последнему иногда прилагают инструкции или
рекомендации по применению стандартных образцов данного типа. Стандартные
образцы используют на стадиях разработки, освоения, эксплуатации и
совершенствования методик и приборов для получения градуировочных характеристик
и для контроля правильности результатов анализов (или др. испытаний). В
последнем случае стандартные образцы периодически подвергают анализу
(испытанию) в условиях, типичных для данной лаборатории; устойчивая, достаточно
хорошая воспроизводимость значения величины (напр., содержания компонента),
приведенного в свидетельстве, рассматривается как доказательство правильности
результатов текущих анализов (испытаний). В противном случае необходимо выявить
и устранить причины неудовлетворительной воспроизводимости результатов. Большое
значение имеет соответствие (адекватность) стандартных образцов анализируемым
или испытуемым веществам по показателям, от которых зависит правильность
результатов, напр. по интервалам содержания "мешающих" компонентов
или по кристаллографических структуре. Номенклатура стандартных образцов
составляет несколько тысяч типов. Стандартные образцы используют при разведке,
добыче и переработке минерального сырья, в металлургии, химической и
нефтехимической промети, при контроле загрязнений окружающей среды, в
исследованиях состава и свойств веществ, в агрохимической службе, при
клинико-химических анализах [20,26,29].
Государственные стандартные образцы (ГСО) - это стандартные образцы,
параметры качества которых регламентируются фармакопейной статьей, утвержденной
в установленном порядке. В анализе готовых лекарственных форм могут
использоваться рабочие стандартные образцы (РСО) лекарственных веществ
(субстанций).
Дополнительной сложностью использования ГСО в Российской Федерации
является несовершенство существующей Государственной фармакопеи. Это
обусловлено ограниченным количеством ФС на ГСО веществ растительного
происхождения и отсутствие их в ГФ РФ.
При этом большинство государственных стандартных образцов указанных в
соответствующих ФС в настоящее время либо не доступны для приобретения, либо
производятся в недостаточных количествах.
РСО - это образец серийной субстанции, отвечающий требованиям
соответствующего стандарта качества лекарственных средств (из Приказа Минздрава
РФ от 01.11.2001 №388 "О государственных стандартах качества лекарственных
средств" вместе с "ОСТ 91500.05.001-00. Отраслевой стандарт.
Стандарты качества лекарственных средств. Основные положения").
Рабочие стандартные образцы калибруются на основании сравнения с
государственными стандартными образцами по упрощенной процедуре. В случае
большого расхода стандартных образцов веществ они используются вместо ГСО в
целях экономии последних, а также из соображений удобства (сокращение сроков
получения ГСО из централизованных источников). Таким образом, оказывается
достаточным единовременно получить ГСО вещества, а впоследствии использовать в
аналитических целях РСО того же вещества [26].
.2.3 Проблемы неразрушающего контроля качества наноматериалов и устройств
электроники
Для неразрушающего контроля наноматериалов и устройств используются
эталонные стандартные образцы.
повышение уровня безопасности жизни и здоровья граждан, имущества
физических и юридических лиц, государственного и муниципального имущества, объектов
с учётом риска возникновения чрезвычайных ситуаций природного и техногенного
характера, повышение уровня экологической безопасности, безопасности жизни и
здоровья животных и растений;
обеспечение конкурентоспособности и качества продукции (работ, услуг),
единства измерений, рационального использования ресурсов, взаимозаменяемости
технических средств (машин и оборудования, их составных частей, комплектующих
изделий и материалов), технической и информационной совместимости,
сопоставимости результатов исследований (испытаний) и измерений, технических и
экономико-статистических данных, проведения анализа характеристик продукции
(работ, услуг), исполнения государственных заказов, добровольного подтверждения
соответствия продукции (работ, услуг);
содействие соблюдению требований технических регламентов;
создание систем классификации и кодирования технико-экономической и
социальной информации, систем каталогизации продукции (работ, услуг), систем
обеспечения качества продукции (работ, услуг), систем поиска и передачи данных,
содействие проведению работ по унификации.
Стандартизация осуществляется в соответствии с принципами:
добровольного применения документов в области стандартизации;
максимального учёта при разработке стандартов законных интересов
заинтересованных лиц;
применения международного стандарта как основы разработки национального
стандарта, за исключением случаев, если такое применение признано невозможным
вследствие несоответствия требований международных стандартов климатическим и
географическим особенностям Российской Федерации, техническим и (или)
технологическим особенностям или по иным основаниям либо Российская Федерация в
соответствии с установленными процедурами выступала против принятия
международного стандарта или отдельного его положения;
недопустимости создания препятствий производству и обращению продукции,
выполнению работ и оказанию услуг в большей степени, чем это минимально
необходимо для выполнения целей стандартизации;
недопустимости установления таких стандартов, которые противоречат
техническим регламентам;
обеспечения условий для единообразного применения стандартов.
В технике стандартизация ведет к снижению себестоимости продукции,
поскольку:
позволяет экономить время и средства за счет применения уже разработанных
типовых ситуаций и объектов;
повышает надежность изделия или результатов расчетов, поскольку
применяемые технические решения уже неоднократно проверены на практике;
упрощает ремонт и обслуживание изделий, так как стандартные узлы и детали
- взаимозаменяемые (при условии, что сборка осуществлялась без пригоночных
операций) [20,26,31].
2. Экспериментальная
часть
Для проведения исследования были использованы помещение и оборудования
ЦКП "Диагностика структуры и свойств наноматериалов". На основе
имеющегося оборудования были изготовлены опытные образцы тонкопленочных систем
на кремниевой основе методом магнетронного напыления. В дальнейшем, образцы
исследовались в растровом электронном микроскопе на элементный анализ.
Для получения образцов тонких пленок использовался напылительный
магнетронный комплекс Quorum Q150T ES. В качестве рабочей атмосферы
использовался инертный газ аргон. процесс создания в камере магнетрона состоит
из трех этапов: предварительной откачки воздуха из рабочей камеры с помощью
поршневого насоса, промежуточной очистки камеры турбомолекулярным насосом, и
заполнением камеры рабочим газом до давления 5×10-3 Па. В магнетроне предусмотрена
предварительная очистка мишени от оксидной пленки. Для этого на катоде
создается мощный разряд плазы, а подложка отгораживается от мишени
металлической заслонкой, соединенной рычагом с системой электромагнитов, и
открывающейся после цикла очистки непосредственно перед напылением. Напряжение
на катоде, необходимое для очистки должно достигнуть 300 В, поэтому ток в
плазме должен быть достаточно большим, и может достигать 200 мА.
В качестве подложки для напыления металла использовались кремнивые
пластины 3 см в диаметре и толщиной от 30 до 50 микрон. Подготовка подложек
заключалась в химической очистки ("жидкостная очистка"), которая
проходила в несколько стадии с применение концентрированных химических
реагентов.
Процесс химической очистки производили следующим образом:
кипятили в смеси H2SO4/H2O2 (7:3) при 120°C (при этом удаляются органические загрязнения, ионы
металлов);
кипятили в смеси H2O/HF (100:0,5) при 20°C (при этом удаляется пленка естественного слоя SiO2);
кипятили в смеси NH4OH/H2O2/H2O (1:1:6) при 80°С (при этом удаляются механические
частицы, органические загрязнения);
кипятили в смеси HCl/H2O2/H2O (1:1:6) при 80°С (при этом удаляются металлические
загрязнения);
отмывали в воде после обработки в каждом из реагентов;
высушивали при 110°С.
Установка для напыления имеет столик для установки подложки с функцией
вращения для создания более равномерного напыляемого слоя. Скорость вращения
может варьироваться или же вращение может отключаться вовсе. Так же внутри
камеры установлено устройство измерения толщины, напыляемой пленки, кварцевый
кристалл, который пересекает плоскость вращения столика.
В качестве напыляемого металла была взята мишень Ag. Мишень была
раскатана и подготовлена по размеру катодной мишени магнетрона и являлась
составной частью. Напыление материала производилось в диапазоне от 20 нм до 80
нм.
Контроль напыляемого слоя осуществлялся при помощи пьезокерамического
кристалла, установленного в нем.
Пьезокерамический кристалл, упомянутый выше, используется в конструкции
установки для определения толщины покрытия в реальном времени, и для
прекращения процесса напыления при достижении покрытием заданной толщины.
Работа датчика основана на эффекте изменения резонансной частоты кристалла в
зависимости от увеличения толщины покрытия.
Для обеспечения управляющей системы этой информацией кристалл
подключается к генератору плавающей частоты и измерительной схеме. Резонанс
фиксируется и изменение этой частоты со временем дает информацию о процессе
роста напыляемой пленки.
После получения тонкопленочной системы Ag было произведено исследование
на растровом электронном микроскопе модели JSM-7500F для определения качества
напыленного слоя и получения результатов количественного элементного анализа
для составления системы стандартных образцов.
3. Обсуждение результатов
В рамках проведения эксперимента был изготовлен стандартный образец с
напылением Ag и исследован на растровом электронном микроскопе с применение
ЭДС.
Была получена серия однослойных образцов металлов и их сплавов,
напыленных на подложку с варьируемой толщиной слоя.
На рисунках 5-8 показаны, полученные в разных режимах работы РЭМ и при
разном ускоряющем напряжении, топографические снимки поверхности напыленного
слоя Ag.
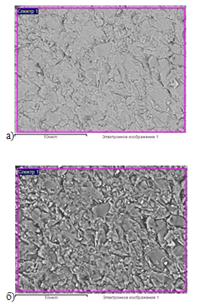
Рисунок 5 - Серебряная тонкая плёнка толщиной 20 нм, напылённая на
кремниевую подложку при ускоряющем напряжении а) 10 кэВ б) 15 кэВ
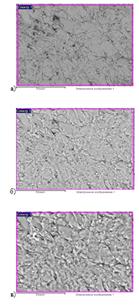
Рисунок 6 - Серебряная тонкая плёнка толщиной 40 нм, напылённая на
кремниевую подложку при ускоряющем напряжении а) 10 кэВ б) 15 кэВ в) 20 кэВ
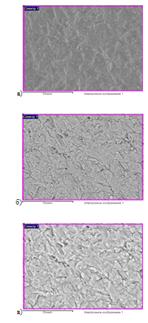
Рисунок 7 - Серебряная тонкая плёнка толщиной 60 нм, напылённая на
кремниевую подложку при ускоряющем напряжении а) 10 кэВ б) 15 кэВ в) 20 кэВ
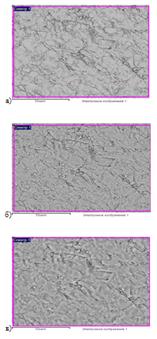
Рисунок 8 - Серебряная тонкая плёнка толщиной 80 нм, напылённая на
кремниевую подложку при ускоряющем напряжении а) 10 кэВ б) 15 кэВ в) 20 кэВ
Так же был проведен энергодисперсионный рентгеновский анализ на
количественное содержание химических элементов в мишени при ускоряющем
напряжении пучка заряженных электронов 10, 15 и 20 кэВ. Была выделена область
образца и получено четыре спектра, один по всей площади исследуемой области,
три точечных и их среднее значения. Спектры получали в трех различных точках в
выделенной области, а также из всей площади исследуемой области.
Полученная зависимость содержание Ag в зависимости от ускоряющего
напряжения показана на рисунке 9. Зависимость содержания Ag в зависимости от
толщины напыленного слоя показана на рисунке 10.

Рисунок 9 - График зависимости концентрации напыленного Ag от ускоряющего
напряжения при толщине напылённого слоя 40, 60, 80 нм

Рисунок 10 - График зависимости концентрации Ag от толшины напылённого
слоя n при ускоряющем напряжении 10, 15, 20 кэВ
Итак, после анализа полученных данных, был разработан стандартный образец
тонкопленочной системы на основе металла серебра на кремниевой подложки.
Стандарт разрабатывался относительно толщины напыленного слоя, ускоряющего
напряжения, при котором был получен анализ образца, и изменения
характеристических пиков относительно результатов спектрального анализа мишени
серебра. Соответственно были получены результаты приведенные в таблицах 1-4.
Таблица 1 - Процентное содержания Si и Ag в тонкой пленке толщиной 20 нм
на кремниевой основе
|
10 кэВ
|
15 кэВ
|
|
№
|
Si
|
Ag
|
Si
|
Ag
|
|
1
|
94,31
|
5,69
|
97,71
|
2,29
|
|
2
|
93,78
|
6,22
|
97,40
|
2,60
|
|
3
|
94,92
|
98,06
|
1,94
|
|
4
|
92,72
|
7,28
|
96,37
|
3,63
|
|
ср
|
93,81
|
6,19
|
97,28
|
2,72
|
Таблица 2 - Процентное содержания Si и Ag в тонкой пленке толщиной 40 нм
на кремниевой основе
|
10 кэВ
|
15 кэВ
|
20 кэВ
|
|
№
|
Si
|
Ag
|
Si
|
Ag
|
Si
|
Ag
|
|
1
|
85,76
|
14,24
|
93,86
|
6,14
|
96,57
|
3,43
|
|
2
|
85,24
|
14,76
|
93,86
|
6,14
|
96,77
|
3,23
|
|
3
|
85,70
|
14,31
|
92,57
|
7,43
|
97,09
|
2,91
|
|
4
|
85,23
|
14,77
|
93,84
|
6,16
|
96,71
|
3,29
|
|
ср
|
85,39
|
14,61
|
93,42
|
6,58
|
96,86
|
3,14
|
Таблица 3 - Процентное содержания Si и Ag в тонкой пленке толщиной 60 нм
на кремниевой основе
|
10 кэВ
|
15 кэВ
|
20 кэВ
|
|
№
|
Si
|
Ag
|
Si
|
Ag
|
Si
|
Ag
|
|
1
|
23,42
|
90,52
|
9,48
|
94,44
|
5,56
|
|
2
|
78,62
|
21,38
|
90,06
|
9,94
|
96,47
|
3,53
|
|
3
|
65,50
|
34,50
|
90,45
|
9,55
|
92,22
|
7,78
|
|
4
|
75,63
|
24,37
|
86,35
|
13,65
|
94,04
|
5,96
|
|
ср
|
73,25
|
26,75
|
88,95
|
11,04
|
94,24
|
5,76
|
Таблица 4 - Процентное содержания Si и Ag в тонкой пленке толщиной 80 нм
на кремниевой основе
|
10 кэВ
|
15 кэВ
|
20 кэВ
|
|
№
|
Si
|
Ag
|
Si
|
Ag
|
Si
|
Ag
|
|
1
|
62,94
|
37,06
|
84,17
|
15,83
|
91,14
|
8,86
|
|
2
|
59,63
|
40,37
|
87,97
|
12,03
|
91,49
|
8,51
|
|
3
|
57,71
|
42,29
|
79,56
|
20,44
|
95,60
|
4,40
|
|
4
|
55,04
|
44,96
|
90,00
|
10,00
|
10,91
|
|
ср
|
57,46
|
42,54
|
85,84
|
14,16
|
92,06
|
7,94
|
Заключение
Основные результаты дипломной работы состоят в следующем:
) Получил серию однослойных образцов металлов и их сплавов, напылённых на
подложки с варьируемой толщиной слоя;
) Изучил влияние толщины напылённого слоя на соотношение
характеристических полос испускания в рентгеновских спектрах относящихся к
напылённому слою и подложке при постоянном ускоряющем напряжении;
) Изучил влияние ускоряющего напряжения электронного пучка на соотношении
характеристических линий испускания спектров напылённого слоя и подложки.
Список
использованных источников
1. Zaluzec N.J. Quantitative X-ray microanalysis. In: Introduction to analytical
electron microscoy / Goldstein J.I., Joy D.C. - Plenum, New York, 2010. - P.
121.
.
Watanabe M. Atomic-level detection by X-ray microanalysis in the analytical
electron microscope. Ultramicroscopy / Williams D.B. - 1999. - Vol. 8. - №10. -
P. 78-89. металл спектр напылённый рентгеновский
.
Grant J.T. Surface Analysis by Auger and X-ray Photoelectron Spectroscopy, ed.
/ J.T. Grant, D. Briggs // published by IM Publications. - 2003. - №10. - P.
38-59.
4. Растровая
электронная микроскопия и рентгеноспектральный анализ. Аппаратура, принцип
работы, применение / Ю.А. Быков, С.Д. Карпухин, М.К. Бойченко и др. - М.: МГТУ
им. Н.Э. Баумана, 2003. - 69 с.
.
Weilie Zhou. Scanning Microscopy for Nanotechnology (Techniques and
Applications). // Nano Letters. - 2006. - №12. - P. 522.
7. Растровая
электронная микроскопия и рентгеновский микроанализ: в 2 т. / Дж. Гоулдстейн,
Д. Ньюбери, П. Эчлин и др. - М.: Мир, 1984. - 57 с.
8.
Electron microscopy: methods and protocols Electron energy-loss spectroscopy as
a tool for elemental analysis in biological specimens. 2nd ed. // D. Studer, P.
Gehr et al // Humana Press. - 2007. - P. 431-447.
9.
Нанотехнологии и наноматериалы / Н.А. Азаренко, А.А. Веревкин - М.: ХПИ, 2009.
- 75 с.
. Деркач В.П.
Электронно-зондовые устройства. / Кияшко Г.Ф., Кухарчук М.С. - Киев: Наука
думка, 1974. - 354 с.
11.
Seah M.P. Practical Surface Analysis by Auger and X-ray Photoelectron
Spectroscopy, 2nd edition / D.Briggs //published by Wiley. 1992. - P. 16-35.
. Растровая
электронная микроскопия и рентгеновский микроанализ / Голудстейн Дж., Ньюбери
Д. // Пер. с англ. - М.: Мир, 2001. - 656 с.
. Оджаев В.Б.
Современные методы исследования материалов / В.Б. Оджаев. - М.: ФИЗМАТЛИТ,
2009. - 168 с. 63
. Криштал
М.М. Сканирующая электронная микроскопия и рентгеноспектральный микроанализ в
примерах практического применения / М.М. Криштал, И.С. Ясников, В.И. Полунин. -
М.: Техносфера, 2009. - 208 с.
. Демиховский
В.Я. Физика квантовых низкоразмерных структур. / В.Я. Демиховский, О.Ю. Горбенко.
- М.: Логос, 2000. - 248 с.
. Барсуков
Д.А. Основы атомной физики. / Ельяшевич М.А. - М.: Научный мир, 2006. - 648 с.
18.
Kreidik L. Atomic Structure of Matter-Space Bydgoszcz, 2001. - 584 p.
19. Харрисон
У. Электронная структура и свойства твердых тел. - М.: Мир, 1983. - Т. 2. - 332
с. 23 Тодуа П.А. Метрология в нанотехнологии. // Российские нанотехнологии,
2007. - Т. 2, №1-2, 61-69 с.
. Новиков
Ю.А. Точность измерения линейных размеров на растровых электронных микроскопах
в микро и нанотехнологиях. / А.В. Раков, П.А. Тодуа. - Измерительная техника -
2008 - №6, 15-18 с.
. Тодуа П.А.
Метрологическое обеспечение измерений длины в микрометровом и нанометровом
диапазоне и их внедрение в микроэлектронику и нанотехнологию. / В.А. Быков,
Ч.П. Волк, и др. - Микросистемная техника, 2004. - №1, 38-44 с.; №2, 24-39 с.;
№3, 25-32 с.
22.
Postek М.Е. Nanometer - Scale Metrology //
Proceedings of SPIE. 2002 - vol. 4608, P. 84-96.
23.
Гоулдстейн Дж. Растровая электронная микроскопия и рентгеновский микроанализ. -
М.: Мир, 1984. - Т. 1. - 303 с.
. Рогачев
А.В. Свойства пленок / А.В. Рогачев, Н.Н. Федосенко. - М.: ГГУ им Ф. Скорины,
2008. - 43 с.
25.
Watt I. Microscopy and Analysis. - 2002. - Vol. 16. - P. 19−21. 30 Раков А.В. АСМ по трем координатам
с использованием одного аттестованного размера. - Измерительная техника - 2008.
- №5 - 13-15с.
. Гавриленко
В.П. Первые российские стандарты в нанотехнологиях. / Е.Н. Лесновский, Ю.А.
Новиков, А.В. Раков. // Известия РАН. - 2009. - T. 73. - 454-462 с.
. Майссела Л.
Технологии тонких пленок. Справочник. / Р. Глэнга. - Том 1. - 1977. - 155 с.
. Панфилов Ю.
Нанесение тонких пленок в вакууме. "Технология в электронной
промышленности", 2007, 76-80 с.
. Гладких
Н.Т. Изменение параметра решетки тонких пленок ванадия и хрома / А.И. Песин,
И.Е. Проценко. - 2003. - Т. 18. - 208 - 211 с.
. Майссела Л.
Технологии тонких пленок. Справочник. / Р. Глэнга. - 2007. - Т. 3. - 768 с.
Берлин Е.В.
Вакуумная технология и оборудование для нанесения и травления тонких пленок. /
С.А. Двинин, Л.А. Сейдман. - М. - 2007. - 45 с.