Исследование качеств структур Ge/Si
Введение
электрон квантовый наногетероструктура
С физикой тонких пленок связаны достижения и перспективы
дальнейшего развития микроэлектроники, оптики, приборостроения и других
отраслей новой техники. Успехи в этой области стали возможны благодаря использованию
управляемого эпитаксиального выращивания тонких слоев полупроводников, металлов
и диэлектриков в вакууме из различных сред.
Сейчас очень трудно представить современную физику твердого
тела без полупроводниковых гетероструктур. Если возможность управления типом
проводимости полупроводника с помощью легирования различными примесями и идея
инжекции неравновесных носителей заряда были теми семенами, из которых выросла
полупроводниковая электроника, то гетероструктуры дают возможность решить
значительно более общую проблему управления фундаментальными параметрами в
полупроводниковых кристаллах и приборах: шириной запрещенной зоны, эффективными
массами носителей и их подвижностями, показателем преломления, электронным
энергетическим спектром и т.д.
Полупроводниковые гетероструктуры и, особенно, двойные
гетероструктуры, включая квантовые ямы, проволоки (КП) и точки (КТ), являются
сегодня предметом исследований 2/3 исследовательских групп в области физики
полупроводников. Наиболее многообещающим методом формирования упорядоченных
массивов КП и КТ является метод, использующий явление самоорганизации на
кристаллических поверхностях. Релаксация упругих напряжений, в случаях роста на
рассогласованных по параметру решетки материалах, может приводить к
формированию упорядоченных массивов КТ.
Взрыв интереса к данной области связан с необходимостью
получения полупроводниковых наноструктур с размерами в диапазоне нескольких
нанометров, чтобы обеспечить энергетические зазоры между подуровнями электронов
и дырок порядка нескольких kT при комнатной температуре. А спонтанное
упорядочение наноструктур позволяет получать включения узкозонных
полупроводников в широкозонной матрице и тем самым создавать локализующий
потенциал для носителей тока. Явления спонтанного возникновения наноструктур
создают основу для новой технологии получения упорядоченных массивов квантовых
проволок и квантовых точек - базу для опто- и микроэлектроники нового
поколения.
1. Обзор литературы
.1
Ge/Si гетероструктуры с квантовыми точками
Рост Si/Ge растворов, с низким содержанием дефектов, и
Ge/Si гетеропереходов, имеет большое значение для прикладных целей,
таких, например, как электронных и оптических приборов большой мощности.
Технология А3В5 продемонстрировала более лучшие
характеристики, по сравнению с кремниевой, не смотря на это, кремниевая
технология остается популярнее на рынке. Главная причина - это цена. Стоимость
изготовления схем, на один квадратный сантиметр, на основе КМОП в сто раз
дешевле аналогичных использующих А3В5 технологию. По этой
причине системы на основе сочетания германия и кремния давно привлекают
исследователей, для возможности получения приборов с новыми характеристиками.
Одно из направлений исследований на основе сочетания германия
и кремния явилось создание структур содержащих GexSi1-x
нанокластеры в кремниевой матрице. Гетероструктуры с пространственным
ограничением носителей заряда во всех трех измерениях (квантовые точки)
реализуют предельный случай размерного квантования в полупроводниках, когда
модификация электронных свойств материала наиболее выражена. Электронный спектр
идеальной квантовой точки (КТ) представляет собой набор дискретных уровней,
разделенных областями запрещенных состояний, и соответствует электронному
спектру одиночного атома, хотя реальная квантовая точка при этом может состоять
из сотен тысяч атомов. Таким образом, появляется уникальная возможность
моделировать эксперименты атомов физики на макроскопических объектах. С
приборной точки зрения, атома подобный электронный спектр носителей в квантовых
точках в случае, если расстояние между уровнями заметно больше тепловой
энергии, дает возможность устранить основную проблему современной микро и
оптоэлектроники - «размывание» носителей заряда в энергетическом окне порядка
kT, приводящее к деградации свойств приборов при повышении рабочей температуры
[2].
Возросший интерес к таким нанокластерам связан с рядом
обстоятельств. Это успехи в разработке технологии получения достаточно
однородного по размеру массива нанокластеров Ge. Размеры нанокластеров
удалось уменьшить до значений, обеспечивающих проявление эффектов размерного
квантования и электрон-электронного взаимодействия вплоть до комнатной
температуры. Разработанные методы совместимы с существующей кремниевой
технологией изготовления дискретных приборов и схем. Такие разработки,
считавшиеся до последнего времени экзотическими, могут привести к настоящей
революции в кремниевой интегральной технологии. Светоизлучающие и фотоприемные
кремний - германиевые устройства, позволят кремниевой технологии успешно конкурировать
с традиционно оптоэлектронными материалами, такими как соединения А3В5.
С 1992 года начинают происходить изменения в технологии
получения структур с квантовыми точками. До этого времени основным способом
создания таких структур была фотолитография, с присущим этому методу
ограничением в минимальных размерах. Проявление эффекта самоорганизации
упорядоченных массивов островков нанометровых размеров в гетеросистемах Ge-Si
позволило получать бездефектные квантовые точки предельно малых размеров (10 -
100 нм) с плотностью 1010 -1011 см-2 и привело
к более четкому проявлению атомно-подобных характеристик в электронных и
оптических спектрах этих объектов [1,3].
Интерес к исследованию оптических свойств КТ обусловлен ярко
выраженной практической направленностью и рядом преимуществ таких объектов по
сравнению с двумерными сверхрешетками. Особенностью КТ является, во-первых,
возможность управления спектральной полосой фотоотклика путем предварительного
заселения дискретных состояний с требуемой энергией переходов; во-вторых,
наличие латерального квантования в нульмерных системах снимает запрет на
оптические переходы, поляризованные в плоскости фотоприемника, а значит,
предоставляет возможность осуществить поглощение света при нормальном падении
фотонов; в-третьих, в КТ ожидается сильное увеличение времени жизни
фотовозбужденных носителей вследствие так называемого эффекта «узкого фононного
горла».
На примере гетеросистемы германий на кремнии давно изучается
переход от послойного роста пленки к образованию 3D островков (механизм
Странского - Крастанова). При относительно низких температурах синтеза, такие
островки не содержат дислокаций несоответствия (ДН), даже после существенного
превышения ими критических толщин. Последние 10 лет идет бурный рост исследований
механизмов образования напряженных наноостровков и особенностей их
самоорганизации, как имеющих практическое применение в наноэлектронике [4].
.2 Самоорганизующийся рост Ge/Si (001)
Тщательные исследования Gе/Si (001) позволяет понять
ключевые фундаментальные механизмы, которые лежат в основе методики роста,
таким образом интерпретация поведения более сложных систем представляет широкий
интерес, таких как In(Ga) As/GaAs (001).
В 1990 году был исследован рост когерентных 3D островов Ge.
В частности, были представлены явные образования «хат островков», ограниченных
{105} гранями. Обоснование такой высокоиндексной ориентации не вызвало
затруднения, это объясняется высоко энергетичными поверхностями. Однако было
позже показано, что коренная перестройка имеет место, приводя к очень
эффективному сокращению плотности повисшей связи и фактически устраняя как -
конфигурация лестницы сокращения. Дополнительные вычисления, основанные на
функциональной теории плотности ФТП, показывают, что Ge(105) фактически
сильно стабилизирован сжимающим напряжением, определенным неполной релаксацией
несоответствия. Было видно из величин фактической поверхностной энергии, что Ge(105),
уплотняется(сжимается) в отношении параметра кристаллической решетки Si,
может конкурировать в стабильности с Ge(001)/Si(001). Более свежие
результаты продемонстрировали, что поверхностная энергия Ge(105) еще
ниже, чем ранее полученная, что указывает на предпочтительную ориентацию
относительно (001). Коллективная волновая модель была предложена для создания
такого последовательного (когерентного) образца: начинаясь с изолированной
волны, имеет место горизонтальное повторение, производя плотно упакованные
структуры с равными ширинами. Несмотря на получение количественного
соответствия с экспериментами, модель осталась предположением, поскольку
никакого прямого экспериментального доказательство «размножающейся» волны не
было предоставлено.
Недавно, было обнаружено, что, изолированные (105) - в
плоскости нанонити могут быть получены с помощью роста Ge и отжига.
Ключевой движущей силой является повторное воздействие низкоэнергетических
{105} поверхностей. В статье [5] показано, что с помощью подходящего выбора
параметров, можно получить массив нанонитей. Из-за вариаций с Si (1 1
10), 20 проводов могут удлиниться вдоль двух ортогональных направлений, приведя
к специфическому, регулируемому, мезомасштабному самосоставлению мозаики (001)
поверхности.

Рис. 1.1. (a-d) показывает изображения
атомно-силового микроскопа (АСМ).Ge наноструктуры полученные после 12 ч,
отжига, при температуре в 500°С, 520°С, 540°С, и 550°С, соответственно. При
низких температурах отжига 500°С и 520°С мы образуются «связки», которые
состоят из десятков плотно упакованных нанонитей Ge.
Кроме просто научного интереса, образующиеся острова Ge на Si
потенциально могут применяться как стрессоры, которые изменяются электронные
свойства Si при рассеивании фононов для уменьшения теплопроводности и
одноканальные супертоковые транзисторы [5].
.3
Фундаментальные предпосылки
Движущей силой образования кластера, в общем случае, является
стремление системы к состоянию с минимальной свободной энергией. Основные
закономерности зарождения островков в эпитаксиальной гетеросистеме определяются
балансом поверхностной энергии пленки и подложки, а также энергии границы
раздела пленка-подложка и внутренней энергии объема островка. Свободная энергия
вновь образованного зародыша на поверхности подложки может быть выражена в виде
трех составляющих:
 .
.
Здесь первый член - работа образования нового зародыша объема
V,  - термодинамическая движущая сила
кристаллизации - пересыщение; второй член - работа, необходимая для создания
дополнительной поверхности s,
- термодинамическая движущая сила
кристаллизации - пересыщение; второй член - работа, необходимая для создания
дополнительной поверхности s,  - поверхностная энергия зародыша. Третий член представляет
дополнительную энергию, возникающую из-за упругой деформации зародыша. Если два
первых члена этого выражения представляют классический вариант теории
зарождения, то последний член появляется только в случае выращивания
напряженных пленок.
- поверхностная энергия зародыша. Третий член представляет
дополнительную энергию, возникающую из-за упругой деформации зародыша. Если два
первых члена этого выражения представляют классический вариант теории
зарождения, то последний член появляется только в случае выращивания
напряженных пленок.
Вклад поверхности в изменение свободной энергии системы наиболее
значителен для кластеров малого размера. Влияние упругой деформации возрастает
по мере увеличения размера кластера. Строгие количественные оценки названных
величин затруднены, ибо для этого необходимо построение точной модели кластера.
Поэтому такие понятия, как «кристаллическая решетка» или «поверхность» кластера
часто носят весьма условный характер [6].
В первом приближении ключевым фактором перехода от
двумерно-слоевого к трехмерному островковому росту псевдоморфных пленок
является понижение энергии напряжений в вершинах островков из-за упругой
релаксации. Определяющую роль морфологической нестабильности поверхности пленок
играют упругие напряжения несоответствия, приводящие к релаксации пленки путем
образования островков. В случае гомоэпитаксии на достаточно чистой поверхности
практически для всех полупроводников объемные островки не образуются, а рост
пленок идет либо за счет движения ступеней (ступенчато-слоевой рост), либо
путем формирования и срастания двумерных островков. Шероховатая поверхность
напряженного слоя имеет меньшую суммарную энергию вследствие упругой релаксации
напряжений в вершинах выступов. Увеличение поверхностной энергии является
фактором, противодействующим развитию рельефа пленки, однако только частично
уменьшает энергетический выигрыш за счет релаксации. Чем больше рассогласование
параметров решетки пленки и подложки, тем при меньшей толщине псевдоморфной
пленки теряется ее морфологическая стабильность. Образование островков является
крайним проявлением морфологической неустойчивости напряженных пленок и обычно
наблюдается в системах с большим рассогласованием параметра решеток пленки и
подложки (>2%), типичными представителями которых
являются Ge-Si и InAs-GaAs.
Процесс образования новой фазы включает такие основные стадии как
зародышеобразование, независимый рост центров и, наконец, их развитие во
взаимодействии друг с другом.
Начальная
стадия роста Ge на чистой поверхности Si(100) такая же как для
гомоэпитаксии кремния. В начальном состоянии на поверхности подложки находится
пересыщенный адсорбат, и на первом этапе происходит зарождение 2D центров.
Далее наступает второй этап роста центров, в процессе которого происходит
снижение пересыщения вокруг центров, но последние еще не взаимодействуют.
Поэтому зарождение новых центров в местах, удаленных от уже образовавшихся
островков, продолжается. После того, как области диффузионного «питания»
центров перекрываются и пересыщение между островками снижается, вероятность
появления новых центров падает, наступает третий этап - этап коррелированного
роста. Большие островки растут, малые исчезают. В случае непрерывной подачи
атомов на поверхность (открытая система) островки разрастаются до
соприкосновения и образуется сплошной монослой. Затем ситуация повторяется, но
из-за рассогласования решеток, пленка германия оказывается сжатой, и по мере
увеличения толщины растет энергия упругих деформаций. Так, в случае роста Ge
на Si и InAs на GaAs именно наличие этих деформаций
приводит к переходу от послойного роста к образованию 3D кластеров на
поверхности подстилающего слоя германия (или InAs), т.е. реализации
механизма Странского - Крастанова. Существенная неоднородность упругой
релаксации островка по его высоте приводит к зависимости энергетического
выигрыша от формы островка. Появляются несколько дискретных энергетически
наиболее выгодных форм («hut», «dome», «superdome»). Упругие искажения по
периферии кластера и в прилегающей области подложки возрастают с увеличением
его размеров, что изменяет закономерности присоединения адатомов к кластеру
[7].1.4. Рост и особенности упорядочения
Поверхность
кремния (100)
Из-за взаимодействия оборванных связей, атомы в приповерхностной
области стремятся перестроиться в более энергетически выгодные положения,
образуя на поверхности двумерную периодическую структуру. С помощью метода ДМЭ
Шлиер и Фарнсворт впервые наблюдали реконструированную поверхность Si(100), имеющую
элементарную ячейку 2x1 и домены двух типов, ориентированные вдоль направлений
[011] и [0-11]. Атомы идеальной поверхности (100) имеют две ненасыщенные связи,
одна из двух оборванных связей поверхностного атома вместе с соответствующей
связью соседнего атома образует новую димерную связь. Соседние атомы
притягиваются друг, к другу образуя пары, что ведет к удвоению элементарной
ячейки в направлении перпендикулярном рядам димеров. СТМ изображение чистой
поверхности представлено на рис. 1.2 [9].
Обычно, поверхность имеет две чередующиеся реконструированные
фазы, повернутые на 900 относительно друг друга (см. рис. 1.2), т.е.
на поверхности присутствуют два вида террас - SA и SB, с димерными рядами
перпендикулярно и параллельно ступени соответственно. Поверхность может состоять
так же из террас только одного вида, при этом ступени между ними имеют высоту
два монослоя.

Рис. 1.2. Изображение структуры ступени вицинальной
поверхности Si(100).
Из-за такой реконструкции поверхности, поверхностная диффузия
становится анизотропной. Адатомы «бегают» вдоль димерных рядов значительно
быстрее, чем поперек. При малых скоростях осаждения Ge и достаточной
температуре, анизотропия поверхностной диффузии приводит к тому, что островки
имеют вытянутую форму.
Эффекты
самоорганизации
Процесс самоорганизации вызывает появление в системе
островков предпочтительных значений их характеристик: размеров, формы,
расстояний между островками и их взаимного расположения. Это является
результатом минимизации суммарной свободной энергии системы. Наличие избранных
характеристик должно проявляться в спектрах рассеяния и дифракции электронов и
рентгеновских лучей при взаимодействии с поверхностью, содержащей
наноструктуры, а также в электронных и оптических спектрах.
Основной механизм, ведущий к выравниванию размеров островков,
заключается в том, что большие островки напряжены у основания сильнее, поэтому
атомам германия выгодней встроиться в меньший островок, где упругие напряжения
меньше. Поэтому рост упругой деформации в подложке и в основании кластера с
увеличением размера последнего уменьшает скорость его роста. Это приводит к
заметному сужению распределения островков по размерам.
Среди возможных путей улучшения однородности размеров
островков можно выделить следующие: (а) - использование отклоненных подложек;
(б) - специального метода организации одновременного синхронного зарождения
кластеров. Обоснованию этих путей могут служить следующие известные факты и
рассуждения: островки зарождаются предпочтительно на несовершенствах 2D слоя Ge,
следовательно, предварительное создание мест, предпочтительных для зарождения
кластеров, может явиться полезным приемом для улучшения упорядочения последних.
Ширина распределения островков по размерам зависит от
скорости роста. Распределение становится уже с увеличением скорости. Такое
поведение подтверждает важность одномоментного гетерогенного зарождения. С
увеличением скорости роста повышается вероятность зарождения островков в самом
начале процесса и вследствие этого островки растут равные времена и имеют
близкие размеры. Дальнейшее увеличение скорости роста приводит к тому, что
пересыщение адатомов на поверхности становится настолько большим, что новые
островки зарождаются непрерывно. Вследствие этого момент зарождения вновь
«размазывается» во времени, и распределение островков по размерам становится
шире.
Обеспечить почти одномоментное зарождение островков на всей
поверхности подложки можно, создав в первый момент роста значительное
пересыщение адатомов германия. Этого можно добиться, например, кратковременным
увеличением плотности молекулярного пучка или кратковременным снижением
температуры подложки. Эффект синхронизирующего воздействия периодических
кратковременных изменений поверхностного пересыщения на двумерное
зародышеобразование был обнаружен еще при гомоэпитаксии кремния и германия. На
основе этого эффекта был обоснован и реализован метод МЛЭ с синхронизацией
зародышеобразования [11].
Упорядочение по площади - наиболее слабая форма упорядочения,
что связано со слабостью взаимодействия островков на начальном этапе их
формирования. Поэтому предварительное создание упорядоченных мест для
зарождения нанокластеров является основным путем для получения их последующего
пространственно - упорядоченного состояния.
Пространственное упорядочение островков возрастает с
увеличением покрытия (отношения суммарной площади островков к площади
подложки), что обусловлено минимизацией отталкивающими силами упругого
взаимодействия между соседними островками.
Поэтому более пространственно упорядоченные массивы островков
там, где островки практически соприкасаются.
При выращивании структур с несколькими слоями Ge
квантовых точек, которые заращиваются материалом, согласованным с подложкой (Si),
замечено, что новый слой островков растет так, что островки оказываются
расположенными друг под другом в вертикальном направлении и приводит к
улучшению упорядочения островков по их размерам. Возмущения полей упругой
деформации от кластера проникают на разные расстояния в заращивающий слой, в
зависимости от объема конкретного островка и от их скопления. На поверхности
заращивающего слоя создаются места преимущественного зарождения новых островков
на следующем «этаже». Регулируя толщину заращивающего слоя можно
отфильтровывать влияние слабых островков. Такие многослойные гетероструктуры с
квантовыми точками имеют прикладное значение в связи с открывающимися новыми
возможностями (например, электронная связь кластеров по вертикали, формирование
трехмерных решеток, состоящих из островков - кластеров, 0 часто называемых «искусственными
атомами») [10].
Размеры и плотность островков
Исследования твердых растворов GeSi с большим
содержанием Si весьма удобны для модельных экспериментов, позволяющих
легко выяснить основные закономерности формирования островков вследствие их
относительно больших размеров [6]. С ростом доли Si напряжения в кластере
уменьшаются, и необходимый выигрыш энергии за счет упругой релаксации островков
наступает при их больших размерах. Однако практический интерес исследователей
концентрируется на системах с размером наноостровков около 10 нм и менее
(чистый Ge на Si), что, в первую очередь, связано с их
оптическими свойствами. Плотность островков имеет также большое значение,
поскольку отклик системы на внешнее воздействие напрямую связан с числом
островков, а значит и с их плотностью. Оба этих параметра (размер и плотность)
зависят от таких условий выращивания, как температура подложки и скорость роста.
Понижение температуры роста, также как и увеличение потока Ge ведут к
уменьшению диффузионной длины Ge адатомов на подложке. Соответственно,
область сбора адатомов для одного островка уменьшается, уменьшаются и его
размеры, а плотность возрастает [5].
.5 Цель работы
По результатам выполненного обзора можно сделать следующие
выводы:
1. В литературных источниках приводится подробное описание
исследования Ge на слое твердого раствора Ge/Si.
2. Эксперименты для получения массива нанонитей и
наноструктур в форме наноколодцев в литературе практически не представлены.
На основании вышеизложенных утверждений задача бакалаврской
работы формулируется следующим образом:
. Исследовать начальные стадии роста Ge на слое
твердого раствора Ge/Si в широком диапазоне температуры, состава,
толщины.
2. Получить однородный массив островков Ge на поверхности Ge/Si
высокой плотности в диапазоне температур 300-700.°C.
. Выявить условие формирования наноструктур в форме
наноколодцев (quantum fortress).
. Получить нанонити путем отжига смачивающего слоя Ge
в широком диапазоне температур и толщины.
2. Влияние температуры роста и качества
поверхности на формирование квантовых наногетероструктур Ge/Si
.1 Молекулярно-лучевая эпитаксия
Эпитаксиальный рост - это процесс, в котором слои материала
осаждаются на подложку, сохраняя кристаллическую структуру подложки. Существует
несколько методов эпитаксиального роста: жидкофазная эпитаксия, газофазная
эпитаксия, химическое парофазное осаждение, осаждение металлорганических
соединений из газообразной фазы. По сравнению со всеми этими техниками
эпитаксиального роста, техника молекулярно-лучевой эпитаксии (МЛЭ) позволяет
использовать более широкий диапазон материалов, имеет точный контроль роста,
условия роста наиболее удалены от теплового равновесия, отсутствует эффект
памяти, а также имеет ряд других преимуществ.
Впервые годы развития МЛЭ исследования были направлены на
выяснение процесса роста простых полупроводниковых материалов Si и Ge. В частности, в 1941 г.
Шокли и Пирсон, пытаясь создать полевые тонкопленочные усилители, использовали
напыленные пленки Ge, Si, Cu. Напыленные пленки халькогенидов свинца и олова
исследовались весьма широко уже с 40-х годов, хотя более совершенная эпитаксия
была достигнута лишь в 1964 году, когда было продемонстрировано выращивание
эпитаксиальных пленок PbS на кристалле NaCl с помощью молекулярных
пучков, создаваемых диффузионными ячейками.
По сути МЛЭ - это конденсация молекулярных пучков в
сверхвысоком вакууме. Сам процесс состоит в испарении основного материала
эпитаксиальной пленки совместно с легирующими примесями. В сверхвысоком вакууме
длина свободного пробега частиц достаточно велика, и потоки атомов попадают на
подложку, практически не взаимодействую друг с другом. Таким образом, при
испарении формируются независимые потоки частиц, которые зависят только от
времени испарения. Отсутствие промежуточных реакций в совокупности с высокой
термической скоростью позволяют быстро изменять свойства растущего слоя при
изменении параметров источника, в частности простым закрытием заслонки
испарителя. Высокая чистота молекулярных пучков обеспечивается бестигельными
методами испарения, такими как электронная бомбардировка, в результате которой
расплав контактирует только с кристаллической фазой этого же материала, что
исключает возможность загрязнения частицами со стенок тигля. Низкая температура
эпитаксии, а также послойный рост позволяют получать сверхтонкие слои с резкими
изменениями состава на границах, вследствие отсутствия взаимной диффузии и
размытия профилей.
Кинетика поверхностных процессов при
эпитаксиальном росте
Молекулярно-лучевая эпитаксия включает в себя следующие
элементарные процессы, протекающие в зоне роста:
o Адсорбция (прилипание)
падающих на подложку атомов или молекул, составляющих выращиваемое соединение;
o Миграция (поверхностная
диффузия) адсорбированных атомов по поверхности подложки, которая может предваряться
диссоциацией (распадом) молекул выращиваемого соединения;
o Встраивание атомов,
составляющих гетероструктуру, в кристаллическую решетку подложки или растущий
моноатомный слой;
o Термическая десорбция
(отрыв) атомов, не встроившихся в кристаллическую решетку;
o Образование и дальнейший
рост двумерных зародышей кристалла на подложке или поверхности растущего слоя;
o Взаимная диффузия атомов,
встроившихся в кристаллическую решетку.
Каждый твердотельный материал может быть выращен послойно при
фиксированной скорости роста. Температура подложки обеспечивает оптимальную для
данного соединения скорость поверхностной диффузии. Так как химические связи в
различных материалах разные, то различаются и энергии активации поверхностной
диффузии атомов, входящих в состав этих соединений. В связи с этим качество
гетерограниц может существенно отличаться в зависимости от того, какое из
соединений при выбранном температурном режиме растет первым. Границы называют
нормальными, если компонент с более низкой температурой плавления растет
первым. Если последовательность роста обратная, то такие границы называют
«инвертированными».
Слишком высокие температуры подложки не желательны, поскольку
в этом случае уменьшается коэффициент прилипания и активизируется взаимная диффузия
атомов между 38 слоями. В связи с тем, что гетероструктуры представляют собой
резко неоднородные по химическому составу системы, то из-за процессов взаимной
диффузии с течением времени эти системы должны либо переходить в
термодинамически равновесное состояние с однородным распределением концентраций
всех компонентов, либо расслаиваться на фазы определенного состава. Однако,
поскольку энергия активации взаимной диффузии, например, в полупроводниках
обычно составляет 4-5 эВ, то в интервале температур от 500 до 7000С этот эффект
пренебрежимо мал. Таким образом, ясно, что выбор и поддержание оптимальной
температуры роста является одним из важнейших условий реализации МЛЭ.
Механизмы роста эпитаксиальных пленок
Рост на атомарно шероховатых поверхностях и торцах ступеней
требует преодоления потенциальных барьеров для встраивания отдельных атомов или
молекул, а рост на атомарно гладких поверхностях требует еще и образования
ступеней роста. Присоединение новых частиц к атомарно шероховатым поверхностям
происходит с макроскопической точки зрения в любом месте, так что поверхность в
процессе роста смещается по нормали к себе в каждой своей точке. Такой рост
называется нормальным. Атомарно гладкие поверхности, напротив, растут путем
последовательного отложения слоев, то есть тангенциального перемещения
ступеней. Такой рост называют тангенциальным или послойным.
При послойном росте изломы, к которым присоединяются частицы,
сосредоточены лишь на торцах ступеней. Элементарные ступени (высотой в один
монослой) отделены друг от друга атомарно гладкими участками, для роста которых
требуется образование зародышей новых ступеней. Поэтому рост ступенчатой
поверхности при пересыщениях, недостаточных для образования зародышей на
атомарно гладких участках, осуществляется лишь путем движения уже имеющихся
ступеней. При недостаточно высоких температурах подложки, когда длина диффузии
адатомов на поверхности мала, происходит образование новых зародышей, поскольку
не все атомы могут добраться и встроиться в ступень.
Взаимная ориентация растущей пленки и подложки зависит,
прежде всего, от энергии границы раздела. Энергия системы будет минимальна,
если будет минимальной поверхностная энергия:
где Etotal - суммарная
поверхностная энергия, Esur-vac - энергия поверхности
подложки, Esur-lay - энергия границы
раздела «пленка-подложка», Elay-vac - энергия поверхности
пленки, ε - доля поверхности занятая адатомами. В
зависимости от суммарной энергии различают три классических механизма роста
(рис. 2.1):
) Франка-ван дер Мерве: этот механизм реализуется, если (Esur-lay+ Elay-vac) < Esur-vac. Большая величина
поверхностной энергии подложки в этом выражении, превышающая сумму двух других,
соответствует полному смачиванию. Происходит увеличение ε и тем самым понижается суммарная энергия, что энергетически
выгодно. Осажденные атомы (адсорбционный слой), участвуя в тепловом движении,
имеют возможность перемещаться по поверхности, перепрыгивая с места на место. В
процессе диффузии на поверхности атомы формируют двумерные островки. Зарождение
островков происходит непрерывно на всей поверхности. Формирование новых
островков в определенный момент прекращается и происходит последующий двумерный
рост сформированных островков, вплоть до образования сплошного монослоя. Затем
на вновь выращенном слое реализуется аналогичная ситуация. Таким образом,
происходит рост слой за слоем (послойный рост).
) Вольмера-Вебера: если же (Esur-lay+ Elay-vac) > Esur-vac, то происходит рост
второго и последующих монослоев на поверхности двумерных островков и
смачивающий слой не образуется. Данный механизм называется островковым.
) Странского-Крастанова: механизм имеет место в условиях
присутствия напряжений, являющихся результатом несоответствия в константах
решеток. Между двумя последовательными слоями неравенство (Esur-lay+ Elay-vac) < Esur-vac выполняется также как
для механизма Франка-ван-дер-Мерве, но нарастающие напряжения изменяют режим
роста на островковый после нескольких монослоев. Толщину, при которой
происходит срыв пленки и переход 2D-3D, называют смачивающим слоем. Установлено, что для
полупроводников с большим рассогласованием параметров решетки процесс роста
происходит по Странскому-Крастанову.
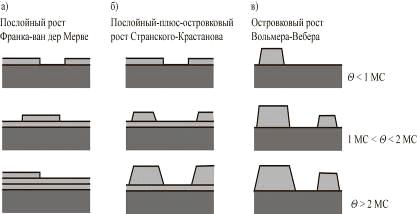
Рис. 2.1. Три классических механизма роста при эпитаксии
2.2 Метод дифракции быстрых электронов
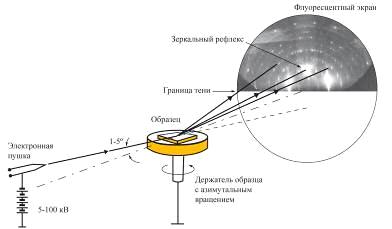
Рис. 2.2. Методика дифракции быстрых электронов на отражение
Дифракция быстрых электронов на отражение (ДБЭ) является
распространенным методом анализа структуры поверхности пленок в процессе МЛЭ.
Большое распространение этого метода связано с простотой использования методики
и наличие большого свободного пространства перед образцом. Еще одним из
преимуществ ДБЭ (в отличие от дифракции медленных электронов) является то, что
из-за большого различия по энергии между упруго рассеянными электронами и фоном
неупругого рассеяния, отсутствует необходимость тщательной энергетической
фильтрации. А достаточность энергии первичных электронов для возбуждения
свечения люминесцирующего экрана, не требует их повторного ускорения.
ДБЭ позволяет непрерывно (in situ) следить за ростом
эпитаксиальных пленок на поверхности, вследствие того, что фронтальная часть
образца становится доступной для испаряющихся источников. Большой интерес к
молекулярно-лучевой эпитаксии, как к способу выращивания материалов для
полупроводниковых приборов, оказал стимулирующее воздействие на применение ДБЭ.
Помимо улучшенного доступа к поверхности, обеспечиваемого
геометрией ДБЭ, по сравнению с ДМЭ, этот метод обладает и другими
преимуществами при изучении эпитаксиального роста и процессов на многослойных
поверхностях. В частности, использование падения с малыми углами скольжения
делает этот метод чувствительным к микрорельефу. Если ДМЭ (обычно при
нормальном падении) выделяет хорошо упорядоченные области поверхности с
ориентацией, близкой к средней ориентации поверхности, то электроны при
скользящем падении будут проникать в шероховатости на поверхности, если она
является микроскопически гладкой. Очевидно, что это повышает требования к более
тщательному приготовлению образцов для исследования методом ДБЭ, но в тоже
время означает, что этот метод может выявить изменения в морфологии
поверхности. Например, если эпитаксиальный рост приводит к росту островков на
поверхности, то картина скользящего отражения от плоской поверхности, которая
наблюдалась в отсутствие островков, сменится картиной содержащей дифракционные
рефлексы от трехмерных объектов. Это может использоваться, например, для
определения толщины смачивающего слоя псевдоморфной пленки, и определения
ориентации граней островков[12].
Хотя в последнее время, почти в каждом исследовательском
коллективе появилась диагностическая аппаратура (СТМ, АФМ) предоставляющая
визуальную информацию о структуре поверхности и процессах происходящих во время
роста, тем неменее метод дифракции быстрых электронов, благодаря своей
простоте, дешевизне и удобности геометрии остается неотъемлемой частью
диагностического оборудования в установках молекулярно-лучевой эпитаксии, для
материалов, не разрушающихся под воздействием электронной бомбардировки.
Кроме анализа структуры поверхности пленок, регистрация
осцилляций зеркально-отраженного пучка быстрых электронов от поверхности
растущей пленки дает возможность измерять скорость роста пленок и
контролировать их состав и толщину. Анализируя характер осцилляций можно
изучать реализуемые механизмы роста, определять параметры поверхностной
диффузии и встраивание адатомов.
Качественную картину возникновения ДБЭ-осцилляций
иллюстрирует рис. 2.3. Атомарно гладкая поверхность дает максимальное значение
интенсивности зеркального рефлекса. Образование двумерных островков высотой в
один монослой приводит к уменьшению интенсивности зеркального рефлекса, что
связано с рассеянием отраженного пучка на атомных ступенях. Уменьшение
интенсивности происходит до степени заполнения θ=0.5, а затем интенсивность вновь начинает расти. Рост
интенсивности связан со срастанием двумерных островков и увеличением вследствие
этого гладкости поверхности. При θ=1, когда поверхность
вновь становится атомарно гладкой, интенсивность зеркального рефлекса близка к
своему первоначальному значению. Этот цикл изменения интенсивности многократно
повторяется по мере роста следующих слоев.
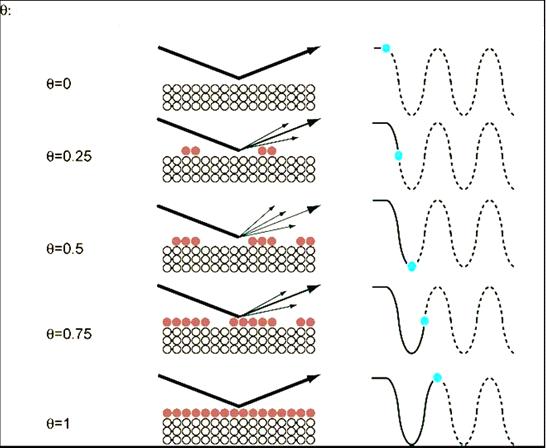
Рис. 2.3. Изменение интенсивности зеркального рефлекса в
процессе осаждения
Метод ДБЭ позволяет:
) качественно оценить структурное совершенство
поверхности (от хорошо упорядоченной поверхности наблюдается ДБЭ картина с
четкими яркими рефлексами и низким уровнем фона);
) определить обратную решетку поверхности из геометрии
дифракционной картины;
) определить атомную структуру поверхности путем
сравнения зависимостей интенсивности дифракционных рефлексов от угла падения
первичного пучка электронов (кривые качания), рассчитанных для структурных
моделей, с зависимостями, полученными в эксперименте;
) определить структуру трехмерных островков,
сформировавшихся на поверхности;
) контролировать послойный рост эпитаксиальных пленок с
атомарной точностью по осцилляциям интенсивности дифракционного пучка.
.3
Экспериментальная установка
Автоматизированная многокамерная установка
молекулярно-лучевой эпитаксии «Катунь» предназначена для получения многослойных
эпитаксиальных пленочных структур в условиях сверхвысокого вакуума. Схема
используемой в работе части установки показана на рис. 2.4.

Рис. 2.4. Схема экспериментальной установки: 1 -
люминесцентный экран, 2 - криопанель, 3 - нагреватель, 4 - манипулятор, 5 -
кварцевый измеритель толщины, 6 - рейка для транспортировки подложек, 7 -
шибер, 8 - камера МЗВ, 9 - манипулятор с кассетами, 10 - система регистрации
ДБЭ
Основные части установки включают в себя: модуль
загрузки-выгрузки, транспортный узел и модуль эпитаксии полупроводников.
Модуль загрузки-выгрузки (МЗВ) предназначен для загрузки,
выгрузки и транспортировки полупроводниковых подложек в сверхвысоковакуумную
установку. В модуле так же производится первичное обезгаживание подложек. МЗВ
состоит из вакуумной камеры, вакуумных насосов, двух манипуляторов с кассетами
для подложек, натекателя и датчика давления. Модуль позволяет одновременно
загрузить 20 подложек диаметром до 100 мм.
Транспортный узел предназначен для перемещения рейки с
подложками из МЗВ в камеру роста.
Модуль эпитаксии полупроводников позволяет производить
эпитаксиальный рост моноатомных полупроводников, тугоплавких металлов и
осуществлять легирование в процессе роста. Модуль содержит в себе следующие
устройства: вакуумная камера, система насосов, манипулятор с нагревателем, блок
испарителей, криопанель, датчики давления, дифрактометр быстрых электронов,
кварцевый измеритель толщины.
Вакуумная система состоит из механического, адсорбционного,
сублимационного и магниторазрядного насосов, обеспечивая предельное остаточное
давление 1*10-8 Па.
Манипулятор с нагревателем предназначен для захвата подложки
и ориентировки ее относительно молекулярных пучков и аналитических приборов, а
также для нагрева и вращения подложки во время эпитаксии. Нагрев подложки
осуществляется тепловым излучением нагревателя, который окружен системой
многослойных экранов для уменьшения излучения на стенки камеры. Максимальная
температура нагрева подложек 1100°С.
Блок испарителей является одним из основных узлов
технологических модулей и предназначен для получения молекулярных пучков. Блок
включает в себя электронно-лучевой испаритель (ЭЛИ) кремния, две молекулярных
ячейки Кнудсена германия и олова, криопанель. ЭЛИ позволяет получать
молекулярные потоки веществ, имеющих высокую температуру испарения или
требующих испарения из автотиглей из-за большой химической активности. Ячейки
Кнудсена создают молекулярный поток за счет нагрева тигля с испаряемым
веществом. Конструкция ячеек позволяет получать температуры на тигле испарителя
в диапазоне 0-1300°С с точностью поддержания температуры ±0,5°С.
Электронно-лучевой испаритель
Из-за большой химической активности кремния для получения
пленок с минимальным количеством ненужных примесей встает необходимость
использования «автотиглей» (расплав испаряемого вещества не контактирует с
другими материалами) для получения чистых атомных пучков этих материалов.
Использование электронно-лучевого испарителя решает эту проблему.
Основные части ЭЛИ включают в себя катод, фокусирующий
электрод, ускоряющий катод и мишень - испаряемый материал (рис. 2.5). Поворот и
фокусировка электронного пучка в центр мишени производится постоянным магнитным
полем самарий-кобальтовых магнитов, укрепленных под корпусом испарителя.
Кристаллическая мишень (кремниевая) размещена в тигле в водоохлаждаемым
корпусом. Поток электронов разогревает центральную часть кристалла до
плавления.

Рис. 2.5. Электронно-лучевой испаритель: 1 - корпус, 2 -
фокусирующий электрод, 3 - катод, 4 - изолятор, 5 - основание катодного узла, 6
- магниты, 7 - тигель, 8 - трубка охлаждения
Применение магнитного поля для фокусировки электронного пучка
позволяет сделать катодный узел невидимым из места расположения подложек. Тем
самым устраняется опасность прямого попадания продуктов ионного распыления на
подложку и эпитаксиальную пленку.
Скорость осаждения можно изменять, меняя величину «озера»
расплавленного материала, т.е. управляя мощностью электронной бомбардировки.
Для предотвращения загрязнения испаряемого материала это «озеро» не должно
выходить за границу кристалла, т.е. сам кристалл является тиглем и, таким
образом, реализуется режим «автотигля». Управление мощностью осуществляется
изменением тока эмиссии при неизменном ускоряющем напряжении.
При длительной работе ЭЛИ в центре материала, загруженного в
тигель, образуется кратер, что может привести к уменьшению скорости испарения и
изменению углового распределения потока испаряемого материала. Это приводит к
увеличению неравномерности толщины пленки по радиусу подложки. Для выравнивания
профиля загруженного материала место расплава временно смещают в разные стороны
от центра тигля, оплавляя края кратера и таким образом перемещая испаряемый
материал к центру тигля. Смещение места расплава производят изменением
ускоряющего напряжения и внешними магнитами, размещенными на стенке вакуумной
камеры.
Дифрактометр быстрых электронов
Дифрактометр быстрых электронов предназначен для наблюдения
структуры тонких пленок в процессе их нанесения методом МЛЭ, а так же для
наблюдения структуры поверхности подложек в процессе предэпитаксиальной
подготовки.
Действие дифрактометра основано на формировании дифракционной
картины в результате отражения от поверхности исследуемого вещества.
Электронный луч, сформированный электронной пушкой и магнитной линзой, попадает
на образец и, упруго рассеиваясь от него, попадает на люминесцентный экран.
Ускоряющее напряжение - 25 кВ.
Кварцевый измеритель толщины
Использование кварцевого измерителя толщины позволяет
независимо от ДБЭ измерять толщину напыляемой пленки. Физический принцип
прибора основан на измерении изменения периода собственных колебаний кварцевой
пластинки (резонатора).
Измерительный резонатор, помещенный в вакуумный объем
напылительной установки, определяет период колебаний выносного генератора.
Собственный период колебаний измерительного резонатора прямо зависит от толщины
пленки, осаженной на него. Сравнивая период колебаний выносного генератора с
эталонным, можно определить толщину выросшей пленки.
2.4
Результаты экспериментов и их анализ
Методом дифракции быстрых электронов исследован рост тонких
пленок Ge1-xSix на кремнии в диапазоне
температур от 300 до 700°С. На рис. 2.5 представлена дифракционная картина,
сформированная чистой атомарно-гладкой поверхностью Si(100), при дифракции быстрых
электронов на отражение под малым углом падения.

Рис. 2.5. Дифракционная картина чистой атомарно-гладкой
поверхности Si(100)
Центральный рефлекс - зеркально отраженный пучок электронов.
Наличие на дифракционной картине дополнительных рефлексов (2x1) говорит о
реконструкции поверхности атомов кремния, удваивающих периодичность атомов. С
увеличением толщины пленки GeSi растет энергия упругих напряжений и с
некоторой толщины пленке становится выгоднее частично снять напряжение за счет
увеличения площади поверхности. В результате, на дифракционной картине тяжи от
дифракции на поверхности меняются на рефлексы от объемной дифракции (на
просвет) от островков.
На рис. 2.6 показана характерная дифракционная картина при
толщине осажденной пленки Ge0,3Si0,7 при температуре 450°С
10,8 Å с объемными рефлексами от островков.

Рис. 2.6. Дифракционная картина поверхности Si(100) c пленкой Ge0,3Si0,7 10,8 Å
Дальнейшее увеличение толщины пленки GeSi приводит к постепенному
увеличению размеров островков. Характерная дифракционная картина от такой
поверхности показана на рис. 2.7.

Рис. 2.7. Дифракционная картина поверхности Si(100) c пленкой Ge0,3Si0,7 25,2Å
Дифракционные картины процессов роста германия и пленок GeSi на кремнии(100) похожи.
На первом этапе эпитаксиального роста наблюдаются дифракционные картины от
плоской поверхности смачивающего слоя и картины начала трехмерного роста. С
ростом толщины осаждаемого слоя растут упругие напряжения, вызванные
рассогласованием параметров решетки Si и пленок GeSi. Начиная с некоторого
критического значения толщины происходит переход от двумерного к трехмерному
росту, при этом часть напряжений релаксирует, что является энергетически
выгодным, так как понижается свободная энергия системы. Эта толщина, называемая
также толщиной смачивающего слоя, зависит от условий роста: температуры и
концентрации атомов сплава Ge1-xSix. Момент перехода 2D-3D
определяется по резкому увеличению интенсивности рефлекса от трехмерного
объекта, проходящего в направлении зеркального рефлекса на дифракционной
картине. Изменение интенсивности профиля этого рефлекса представлено на рис.
2.8.

Рис. 2.8. Изменение профиля интенсивности в процессе
осаждения Ge0,3Si0,7 на Si(100)
Отличительной характеристикой процессов роста германия и
пленок GeSi на Si(100) является то, что во время роста не наблюдаются
осцилляции зеркального рефлекса. Это означает, что двумерный рост пленок GeSi происходит за счет
движения атомарных ступеней.
На основе изображений сканирующей туннельной микроскопии
получена зависимость отношение ширины островков к их длине (рис. 2.9), а также
определена однородность нитей по ширине (рис. 2.10).
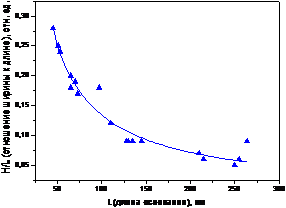
Рис. 2.9. зависимость отношение ширины островков к их длине

Рис. 2.10. Зависимость числа нанонитей от их ширины
Из данных дифракции быстрых электронов, сканирующей туннельной
микроскопии можно заключить, что эпитаксиальный рост гетероструктур
Ge1-xSix на кремнии в диапазоне температур роста
300-700°С следует механизму роста Странского-Крастанова. Во время роста не
наблюдаются осцилляции зеркального рефлекса, значит двумерный рост происходит
за счет движения атомарных ступеней. Морфология поверхности гетероструктур Ge0.3Si0.7/Si(100) изучалась при помощи сканирующей туннельной микроскопии и
атомно-силовой микроскопии. Были получены зависимости числа, размера и
плотности островков при различных температурах роста.
Заключение
В ходе бакалаврской работы была проделана следующая работа:
) На основании исследований, по росту Ge на слое твердого
раствора GeSi в диапазоне температур 300-700°С, получен массив квантовых точек
высокой плотности с однородностью до 10%.
) Путем отжига смачивающего слоя Ge получен массив нанонитей
с длинной больше 200 нм.
) Получен массив структур в виде четырех наноколодцев,
называемых «quantum fortress».
Список литературы
[1] X. Sun, R. Camacho-Aguilera, Lionel C. «Ge-on-Si laser
operating at room temperature.» March 1,2010.
[2] J. Zhang, M. Grydlik «Evolution of epitaxial semiconductor
nanodots and nanowires from supersaturated wetting layes» Phys. Rev. Lett.,
(2014).
[3] P. Muller and R. Kern. «Equilibrium shape of epitaxially
strained crystals (Volmer-Weber case)» J. Cryst. Growth, 193, 257 (2002).
[4]
О.П. Пчеляков, Ю.Б. Болховитянов, А.В. Двуреченский и др. Кремний-германиваемые
наноструктуры с квантовыми точками: механизмы образования и электрические
свойства, Физика, 2000, том 34, вып. 11.
[5] F. Liu and M.G. Lagally. «Self-organized evolution of
Ge/Si(001) into intersecting bundles of horizontal nanowires during annealing»
Phys. Rev. Lett., 103,08 3156 (2013).
[6] Y. Chen and J. Washburn. «Structural Transition in
Large-Lattice-Mismatch Heteroepitaxy» Phys. Rev. Lett., 77, 4046 (2012).
[7] D.E. Jesson, G. Chen, K.M. Chen, and S.J. Pennycook.
«Self-Limiting Growth of Strained Faceted Islands» Phys. Rev. Lett., 80, 5156 (1).
[8] M. Kästner and B. Voigtländer, «Kinetically Self-Limiting Growth of Ge Islands
on Si(001)» Phys. Rev. Lett., 82, 2745 (1999).
[9]
Н.Н. Леденцов, В.М. Устинов, И.В. Щукин, П.С. Копьев и др., «Гетероструктуры с
кванотовыми точками получение, свойства, лазеры)» ФТП, №2 (1997)
[10] V.A. Shchukin, D. Bimberg. «Strain-driven self-organization
of nanostructures on semiconductor surfaces» Appl. Phys., A 67, 687 (2004)