СВЧ-транзисторы и их применение
1. Биполярные и полевые СВЧ-транзисторы
.1 Биполярные СВЧ-транзисторы
В основе работы микроволновых полупроводниковых биполярных (БТ) и полевых
(ПТ) транзисторов лежат те же физические процессы, которые определяют их
действие на низких (НЧ) и высоких частотах (ВЧ). Однако ряд факторов
ограничивает использование НЧ- и ВЧ- транзисторов на сверхвысоких частотах
(СВЧ) и требует решения ряда конструкторских и технологических задач.
Следует отметить, что частотный диапазон БТ ограничивается временем
переноса носителей заряда через пространство активного взаимодействия. Это
время для БТ оценивается суммарным временем задержек, характеризующих
последовательные стадии пролёта носителей заряда от эмиттера к коллектору: tэк = 0,5/pfт = tэ +tк + tс, где tэ,
tк времена, определяющие заряд эмиттерных и коллекторных ёмкостей; tс время задержки в коллекторном р n-переходе; fт - граничная частота.
Можно показать, что tэ = RэСэ + t¢э, где Rэ = (¶Iэ/¶Uэ)1 сопротивление эмиттера; Сэ
ёмкость эмиттера; t¢э = d2э(2D0b0)1 время рассасывания неосновных носителей в эмиттерном слое; dэ глубина залегания эмиттерного
перехода; D0 коэффициент диффузии неосновных
носителей заряда в эмиттере; b0 - коэффициент усиления по току.
Время задержки сигнала в базовом слое в случае однородного легирования
базы, в которой скорость диффузионного пролёта Vдиф= =(D/n)(dn/dx) »2Dв/dв, где dв толщина базы в направлении тока
базы, равно tв = d2б(2Dв)1, где Dв
коэффициент диффузии неосновных носителей в базе.
При неоднородном легировании базы в ней может образоваться внутреннее
поле Евнутр, приводящее к значительному ускорению пролёта базы электронами, и
если Евнутр = const, то
tв = d2в{2Dв[1 + (Евнутр/Е0)3/2]}1,
где tв - время
задержки в базовом р n-переходе;
Е0 = 2D/mdв.
Время задержки в обеднённом слое коллекторного р n-перехода благодаря сильному полю в
нём определяется дрейфом носителей заряда с предельной скоростью Vнас и принимается равным половине
времени пролёта:
tc = Lк/2Vнас.
Время
заряда обеднённой ёмкости коллектора tк = RкСк,
где Rк - последовательно включённое сопротивление
коллектора. Полным временем задержки  определяется
граничная частота fт :
определяется
граничная частота fт :
fт =
1/2ptэв ,
которая для БТ соответствует частоте, при которой коэффициент усиления по
току в режиме короткого замыкания (КЗ) выхода схемы с ОЭ b = =(¶Iк/¶IБ)
равен единице. Условие b =
1 соответствует уменьшению коэффициента усиления по току a в схеме с общей базой (ОБ) в два
раза [так как b = a¤(1 a)].
Можно оценить конструкторско-технологические решения, которые позволяют
создавать БТ, работающие в СВЧ-диапазоне.
Исходным материалом для планарного БТ служит пленка высокоомного кремния n-типа, создаваемая эпитаксиальным
наращиванием его на Si-подложку, где
формируется вывод коллекторного контакта. Методом ступенчатой фотолитографии в
изолирующей пленке создают окна, через которые в несколько стадий вводят
легирующие примеси и формируют область базы с проводимостью р-типа, низкоомную
приконтактную область базы р+, а в дальнейшем - эмиттерную область с
проводимостью n+-типа. Металлическая пленка эмиттера
(Э), базы (Б) и коллектора (К) обеспечивает подачу управляющих и питающих
напряжений.
На границе эмиттер-база создается обеднённый подвижными носителями заряда
эмиттерный р n-переход, а на границе база-коллектор
- коллекторный.
Кроме того, для СВЧ-транзисторов принимают меры по уменьшению времени
переноса заряда через базу, для чего уменьшают её длину lб. Современная технология позволяет
реализовать lб до десятых долей микрона. Наличие
сверхтонкой базы является одной из особенностей БТ.
Однако при уменьшении толщины базы снижается пробивное напряжение
коллектора и уменьшается выходная мощность.
Следовательно, для СВЧ-транзисторов значение выходной мощности единичного
транзистора снижается (компенсация достигается объединением в одном корпусе
нескольких структур).
Сокращение времени переноса носителей через базу возможно также и за счет
обеспечения преимущественно дрейфового (а не диффузионного) характера переноса.
Дрейфовая скорость может существенно превышать диффузионную скорость
движения, если создать в базе внутреннее ускоряющее поле. Для этого при
изготовлении дрейфового транзистора легирующие примеси в базе распределяются
неравномерно.
Например, для базы р-типа обеспечивается превышение концентрации
акцепторных примесей в эмиттере по сравнению с их концентрацией в коллекторе.
Можно показать, что в случае экспоненциального распределения примесей в базе
напряжённость электрического поля оказывается постоянной по толщине и
определяется отношением концентраций примесей на границах базы:
Евнутр = jтlб1lnNбэ/Nбк,
где jт = kT/q температурный потенциал; lб толщина базы.
Величину m = Евнутрlб/2jт называют фактором поля. Она характеризует
соотношение между напряжением в базе, возникающим за счет внутреннего поля, и
температурным потенциалом и для кремния может достигать 10. Так, если при 300 К
jт = 0,25 мВ и m = 2, то в базе с толщиной 0,3 мкм
возникает поле порядка 4 кВ/см.
В дрейфовых транзисторах время переноса заряда через базу в m раз меньше по сравнению с
бездрейфовыми (так как дрейфовая скорость равна диффузионной при электрическом
поле порядка 1 В/см, то в реальных транзисторах Евнутр >> 1 В/см и
допустимо не принимать во внимание диффузионный перенос носителей). Граничная
частота коэффициента переноса тока также увеличивается в m раз.
Уменьшение толщины базы способствует снижению мощности и ведёт к
увеличению сопротивления базы в поперечном направлении, что увеличивает
постоянную времени заряда (Cк) р
n-перехода и, следовательно, снижает fт. Для уменьшения влияния роста Rк под базовым выводом легируют
область полупроводника, создавая низкоомный слой р+-типа. Тем не менее
протекание базового тока параллельно плоскости кристалла приводит к
возникновению неравномерного падения напряжения на распределенном сопротивлении
материала базы (протекание тока базы обусловлено вводом и выводом носителей
заряда через базу для обеспечения ее электронейтральности). Возникающее из-за
тока базы падение напряжения на эмиттерном переходе в центре эмиттера
оказывается меньше падения напряжения у его краёв.
Плотность
тока эмиттера экспоненциально зависит от напряжения на р n-переходе.
Поэтому падение напряжения вдоль оси Х в тонкой базе составляет несколько jт, но приводит к различию в значениях jэ примерно на
порядок (jэôx=0 < jэôx=l/2). Возникает эффект “оттеснения тока эмиттера” (рис.
1), для устранения которого эмиттер выполняют в виде узких полосок (увеличивают
их длину по координате Z для получения нужного тока эмиттера, а для
выравнивания напряжения вдоль  их
располагают в виде большого числа отдельных полосок - до 15 штук, между
которыми располагают полоски выводов базы), т.е. формируют гребенчатую
структуру (рис. 2).
их
располагают в виде большого числа отдельных полосок - до 15 штук, между
которыми располагают полоски выводов базы), т.е. формируют гребенчатую
структуру (рис. 2).
Конфигурации
эмиттера и базы определяют частоту fт, причём для ее увеличения БТ
должны иметь максимальный периметр эмиттера при минимальной его площади.
Выполнение первого требования обеспечивает равномерное распределение тока
эмиттера, второго - уменьшение ёмкости эмиттера, снижающей уровень инжекции и
шунтирующей эмиттерный переход.
В
виде гребенчатой структуры реализованы эмиттеры с lэ = 1 мкм и fмакс
= 40/(lэ + 2t), где t - ширина полоски в мкм.

Рис. 1 Рис. 2
Для создания более мощных БТ используют объединение в одном кристалле до
150 единичных структур с сохранением большого отношения периметр/площадь. В
многоэмиттерных структурах реализуют полоски низкоомного р+-слоя в кристалле, а
внутри каждой ячейки располагают прямоугольный эмиттер. Вывод эмиттера
изолируют от базовой сетки слоем SiO2.
Внешние выводы делают в виде коротких полосок, что снижает их паразитные
параметры С и L. Причём транзисторы выполняют без
внешнего металлического корпуса.
В заключение следует привести еще одну величину: fмакс = =[h21бfт/(8prбСк)]0,5, fмакс
= fгр, при которой |a| = 20,5a0/2a и которая характеризует предельные
частотные возможности БТ. На частотах выше fмакс БТ перестает быть активным элементом, т.е. только
поглощает подводимую мощность. Генерация или усиление в этом случае невозможны
ни при каких схемных включениях.
Частотные зависимости модулей коэффициентов передачи для схем с ОБ и ОЭ
определяются частотами wh21э и
wh21б, на которых коэффициент усиления
по мощности уменьшается в 2 раза по сравнению с максимальным. Эти частоты
находятся в соотношении wh21б>
> wh21э и определяются через снижение
коэффициента передачи тока h21i (h21б = Iэ/Iк½Uк=0 » a, h21э = Iк/Iб½Uк=0 » b) до значения 20,5h21б,э/2 (рис. 3).
Следует помнить, что частоты wh21э,б называть граничными нельзя, так как ½h21э½ » 0 ¸ 40, и при частотах выше wh21э транзистор вполне может работать
(таким образом, для повышения fгр
необходимо снижать rб и Ск, что
является противоречивым требованием).

Рис.
3
Современные
БТ работают до частот 20 28 ГГц. Получены следующие значения Рмакс непр: 300
Вт на частоте f = 3 ГГц; 20 Вт 6 ГГц;
Вт
10 ГГц; 0,3 Вт 25 ГГц. При этом КПД составляет: 50 % на частоте 13 ГГц, 20 %
1415 ГГц, 10 % 2425 ГГц. Значение коэффициента шума составляет 2,5 3,0 дБ на
частоте 2 - 4 ГГц; 7,0 дБ на частотах более 10 ГГц.
Гетероструктурные
БТ. Радикально повысить быстродействие БТ можно, если увеличить легирование
базы без изменения коэффициента эффективности эмиттера, что возможно при
использовании в качестве эмиттера гетероперехода. Пример гетероструктуры n р
типа с широкозонной n-областью приведен на рис. 4.
“Встроенное”
поле на переходе оказывается различным для электронов и дырок, оно и
препятствует дырочному току из р- в n-область. В рассматриваемом
случае дырочный ток уменьшается в exp(-DE/kT)
раз (где DE -
дополнительный гетеробарьер для дырок), поэтому эффективность эмиттера gэ будет близка к 1, даже если уровень легирования р-области (базы)
выше, чем n-области (эмиттера):

Различают
плавные и резкие гетеропереходы (см.рис.4). При этом величина DE в плавном
гетеропереходе (варизонном кристалле) приблизительно равна разности ширин
запрещенных зон DEз.
При этом в плавном гетеропереходе (использован в качестве эмиттера) увеличение
барьера для дырок создаётся за счёт разности ширин запрещённых зон, а в резком
гетеропереходе оно определяется величиной DEv, как показано на рис. 4.

Рис.
4
В
резком гетеропереходе, сформированном слоями GaAlAs и GaAs, барьер может достигать величины более 10 кT,
что вполне достаточно для уменьшения более чем на порядок второго множителя ( ) формулы, определяемого эффективностью эмиттера jЭ.
) формулы, определяемого эффективностью эмиттера jЭ.
Следует
заметить, что повышение эффективности эмиттера в кремниевых БТ имеет место
также при использовании поликристаллического кремния в качестве более
широкозонного материала для эмиттера.
Перспективным
материалом для широкозонного эмиттера является также CrSi. Такие
эмиттеры позволяют избежать туннельного эффекта при легировании базы до уровня
1019 см3 и более, что позволяет сформировать тонкие обеднённые слои и слой
базы, а главное, снизить на порядок величину сопротивления базы.
Гетеропереход “широкозонный коллектор - узкозонная база” позволяет
исключить инжекцию дырок из базы в коллектор благодаря образованию барьера для
дырок, поэтому допустимы значения Nк »
» 1017 см3 и Nб » 1019 см Трехслойная n - р - n-структура с двумя гетеропереходами позволяет реализовать
взаимозаменяемость эмиттера и коллектора в ИС и возможность оптимизировать
параметры базы и коллектора.
Ожидается, что наибольшим быстродействием будут обладать БТ со структурой
GaAlGe - GaAs за счет того, что Gа допускает сильное легирование акцепторными примесями и
имеет высокую подвижность дырок, которая обеспечивает малое сопротивление базы.
Возможные конструкции гетероструктурных БТ (ГСБТ) приведены на рис. 5.
Первая реализация ГСБТ (рис. 5, а) представляет собой двухслойную
структуру: широкозонную - GaAlAs
(вдоль поверхности) и под ней узкозонную - GaAs. Эмиттерный гомопереход в широкозонном
приповерхностном слое пропускает ничтожно малый ток (по сравнению с током через
гетеропереход) в узкозонную область, где высота барьера на DЕ меньше. Практически транзистор
работает в вертикальном направлении при отключенной горизонтальной части. Эти
же идеи использованы для создания обращённого транзистора (узкий коллектор с
малой Ск на поверхности) с одновременным сужением активной части эмиттера (рис.
5, б).

а) б)
Рис. 5
Для таких структур с микронным эмиттером и электронной базой при I = 2 мА, Vл = 0,5 В получено tД = 8 nс, fт » 29 ГГц, fмакс » 19 ГГц, Рд= =1 мВт (время задержки
при переключении).
Серьёзные технологические трудности пока не позволяют использовать указанные
структуры в БИС и СБИС (так как физика дефектообразования и ряд других
процессов в материалах группы А3В5 существенно отличаются от аналогичных
процессов в кремнии, хотя отдельные образцы с широким эмиттером (гетеролазеры,
гетерофототранзисторы) уже получены с удовлетворительными характеристиками.
Варизонные БТ (ВБТ). Благодаря возрастанию ширины запрещенной зоны от
коллектора к эмиттеру в ВБТ по всей структуре n - р - n для
неосновных носителей заряда имеется встроенное поле Евстр. Это поле, с одной
стороны, ускоряет пролет инжектированных электронов через базу (как в дрейфовых
БТ), а с другой - препятствует инжекции дырок из базы в эмиттер (как в плавном
гетеропереходе).
Энергетическая диаграмма такой структуры приведена на рис. 6.

Рис.
6
Эффект
уменьшения времени задержки дрейфового пролета (tб(DЕв)» dб/2mЕвстр = d2бq/2mDЕд) в варизонной структуре значительно превышает аналогичный эффект в
дрейфовом транзисторе (где значение Евстр обусловлено неоднородным легированием
базы, которое не превышает нескольких кТ/q).
Так,
при DЕд = 0,15 эВ, dб = 5×105 см получаем Евстр = 5 кВ/см. В этом случае при Nб =
1018 см-3 tб составит приблизительно 5 пс.
.2 Полевые
СВЧ-транзисторы
транзистор
полупроводниковый излучение
В отличие от БТ, где управление потоком неосновных носителей
осуществляется током инжекции из эмиттера, в ПТ управление потоком основных
носителей осуществляется заданием поля (потенциала) на затворе, как это
реализовывалось в вакуумных приборах. Принято разделять ПТ СВЧ на три группы
(рис. 7,а,б,в соответственно):
ПТ, в которых в качестве затвора используется р - n-переход или контакт
металл-полупроводник (МЕППТ, барьер Шоттки), а пространство между истоком и
стоком имеет один тип проводимости;
ПТ с затвором в виде структур металл-диэлектрик-полупроводник или
металл-окисел-полупроводник (МДППТ, МОППТ), а типы легирования областей стока и
истока противоположны типу легирования области затвора;
Наиболее широкое применение на СВЧ находят ПТ с барьером Шоттки (рис. 7,
а). В их высокоомной подложке, выполненной из арсенида галлия, создан
эпитаксиальный проводящий канал n-типа.
Через невыпрямляющие контакты (n-металл
истока и стока) этот канал подсоединен к выводам истока и стока, между которыми
расположен затвор З, на границе которого с n-каналом образован барьер Шоттки.
При приложении внешних питающих напряжений в канале протекает ток,
приводящий к падению напряжения на распределённом вдоль длины канала
сопротивлении. Обеднённый слой по этой причине является несимметричным.



а) б) в)
Рис. 7
Одним из основных параметров ПТ, определяющим его частотные свойства,
является время пролета носителей заряда в канале tк = lк/Vнас, где lк - длина канала, lк = l1 + l2 + l3; Vнас - дрейфовая скорость насыщения
носителей заряда в канале.
Следовательно, для получения СВЧ-прибора необходимо иметь короткий канал
(lк) и большую величину скорости
насыщения Vнас. С учётом этого формируются
основные требования к материалу и геометрическим размерам ПТ.
В качестве материала полупроводника применяют арсенид галлия, так как по
сравнению с кремнием подвижность носителей заряда в нём в 6 раз выше и составляет
4700 см2/В×с, а
предельная скорость насыщения больше в 2 раза (0,9×105м/с и 1,8×105м/с), причём достигается она при
значительно меньших электрических полях. Применяется также и фосфид индия InP, дрейфовая скорость носителей заряда
в котором в 1,5 раза выше, чем у арсенида галлия.
Величина lк снижена до 0,5
2,0 мкм, при этом ток прибора, а следовательно, его мощность повышается за счет
увеличения ширины канала до 2 3 мм и создания многоканальных структур (рис.
8), где приведены структуры ПТ гребенчатого типа и структура с двумя выводами
затвора.

Рис.
8
Для
ПТ с частотой fт более 4 ГГц реализованы структуры с l3 =
1,5 мкм, l1, l2 = 1,0 и 2,0 мкм, lк = 2,6 мм, n =
30 единичных структур соединенных параллельно с Рвых = 2,0 Вт. Уменьшение длины
канала неблагоприятно сказывается на значение коэффициента отражения от входа,
что затрудняет согласование ПТ со входом СВЧ-тракта.
Преимущества
ПТ заметно проявляются с повышением рабочей частоты. Так, на частоте 6 ГГц получена
мощность 25 Вт при КПД 50 %, а коэффициенте шума составил 3 дБ. На частоте 15
ГГц получено соответственно 2 Вт, КПД 20 25 %, шум 3 6 дБ. На частотах более
20 ГГц промышленность БТ вообще не выпускает, а ПТ на 20 ГГц дают мощность
более 1 Вт при КПД 10 20 % и коэффициенте шума 5 8 дБ.
Малошумящие
ПТ имеют коэффициент шума 0,7 дБ на частоте 4 ГГц, 1,7 - на частоте 12 ГГц,
менее 3 дБ - на частоте 18 ГГц, причем коэффициент усиления наиболее
высокочастотных равен 5 дБ.
В
ближайшее время ожидается получение ПТ, генерирующих частоты порядка 30 ГГц, с
выходной мощностью 1 Вт и коэффициентом шума порядка 3 дБ.
«Низкочастотные»
ПТ обычно имеют планарную металлизацию, представленную на рис. 8, а г.
2. Сверхбыстродействующие транзисторы
.1 Баллистические и аналоговые транзисторы
Быстродействие транзисторов определяется временем пролета носителей
заряда от эмиттирующего носители электрода (эмиттера, истока) до принимающего
электрода (коллектора, стока). (В дальнейшем мы будем говорить только об
электронах, хотя всё остается справедливым и для дырок). Это время определяется
скоростью движения носителей тока и расстоянием между электродами, предел
уменьшения которого ограничивается существующими технологиями изготовления
транзисторов. Для увеличения скорости используется электрическое поле (либо
контактное, либо внешнее), разогревающее электроны, и чистый, беспримесный
полупроводник, обеспечивающий электронам возможность свободного
бесстолкновительного пролёта, т.е. возможность инерционного баллистического пролёта.
Быстродействующие (микроволновые) транзисторы можно условно разделить на пять
групп: баллистические электронные транзисторы (БЭТ) с гетероструктурой и
туннельным эмиттером; БЭТ с планарно-легированными барьерами; БЭТ с варизонными
барьерами и индуцированной базой; полевые транзисторы с переносом заряда в
пространстве; полевые транзисторы, аналогичные по своей структуре вакуумным
триодам и поэтому названные аналоговыми транзисторами. Рассмотрим все их
последовательно.
БЭТ с туннельным эмиттером, или туннельные транзисторы на горячих
электронах (ТТГЭ), как и обычные БТ, имеют эмиттер, базу и коллектор, но, в
отличие от БТ, они обладают одним и тем же типом проводимости, т.е. ТТГЭ -
униполярный транзистор. За счёт этого снижаются ёмкости эмиттерного и коллекторного
переходов (нет диффузионной ёмкости, связанной с неосновными носителями) и
соответственно повышается предельная частота. На рис. 9 показана
гетероструктура зоны проводимости ТТГЭ.

Рис.
9
Начальная
скорость носителей заряда в ТТГЭ определяется потенциалом VЭБ, но при
превышении уровня энергии 0,7 В начинается потеря скорости носителей тока из-за
взаимодействия с фононами и примесями. Расчеты показывают, что при толщине базы
50 нм, когда ее пролетают баллистически около 60 % электронов, время их пролёта
составляет приблизительно 0,3 пс, однако при этом на величину предельной
частоты влияет большая постоянная времени RбС переходного процесса в БЭТ (где
Rб - сопротивление слоя базы и С - емкость эмиттерного перехода), и приходится
уменьшать сопротивление базы Rб путём её легирования примесями.
Это
касается не только ТТГЭ, но и всех БЭТ, поэтому их часто называют транзисторами
с легированной базой.
БЭТ
с планарно-легированными барьерами - это обычно семислойная структура (рис.
10), в которой эмиттерный и коллекторный барьеры образованы каждый двумя
контактами n+-i-p+ и p+-n, причем p+-слои имеют толщину (»» 25 нм)
на порядок меньше, чем i-слои эмиттера и коллектора и n-слой базы (на рис. 10
сплошная линия показывает зону структуры в отсутствие внешних полей, а
пунктирная линия - при рабочих напряжениях на электродах).

Рис.
10
Горбообразные
барьеры эмиттера и коллектора получили название планарно-легированных барьеров,
проходя которые в эмиттере электроны получают энергию, позволяющую им
баллистически пролетать базу и коллектор. По теоретическим оценкам предельная
частота таких транзисторов может быть более 200 ГГц.
БЭТ
с варизонными барьерами и индуцированной базой. Варизонный барьер - это барьер,
возникающий в слое полупроводника с переменной по его длине концентрацией
компонентов, в результате чего ширина запрещённой зоны изменяется вдоль этого
барьера. Обычно это полупроводник  , причём
х меняется в зависимости от глубины эмиттера (рис. 11, зонная структура такого
БЭТ: 0 < x < 0,3).
, причём
х меняется в зависимости от глубины эмиттера (рис. 11, зонная структура такого
БЭТ: 0 < x < 0,3).
Эмиттерный
переход имеет такую же форму, как и БЭТ с планарно-легированными барьерами (см.
рис. 10). Коллектор может быть выполнен с планарно-легированным барьером, а
может быть в виде резкого гетероперехода, как показано на рис. 11.
При
этом базовая область не легирована и в равновесном состоянии она непроводящая,
а при приложении напряжения к коллекторному переходу электрическое поле
проникает в область базы и там индуцируется вырожденный электронный газ у
стенки гетероперехода. Поэтому такие транзисторы называются транзисторами с
индуцированной базой (ТИБ).

Рис.
11
Малая
толщина базы и ее высокая проводимость обеспечивают быструю зарядку ёмкостей
эмиттерного и коллекторного переходов и баллистический пролёт электронами базы
и коллектора, обусловливают высокое быстродействие ТИБ (порядка долей
пикосекунды). Принцип работы ТИБ такой же, как и у транзисторов с металлической
базой, которые будут рассмотрены позднее. Необходимо отметить, что работа всех
трёх типов БЭТ рассматривалась выше весьма схематично. В действительности в
поведении БЭТ много особенностей, и в настоящее время исследованы и уже нашли
применение разновидности таких БЭТ, в которых используются не только GaAs
и AlGaAs, но и GaInAs, InAs, AlSb, GaSb и
др., причём часть из них работает при температуре 77 К, а целый ряд хорошо
функционирует и при 300 К.
Полевые
транзисторы с переносом заряда. Эти транзисторы имеют две особенности, которые
могут использоваться либо по отдельности, либо обе вместе. Первая особенность -
создание отрицательного сопротивления в канале, и такие полевые транзисторы
называют ПТОС. Вторая особенность инжекция заряда из основного канала, и такие
транзисторы называют ТИЗ. Канал такого ПТ выполнен в виде гетероструктуры с
селективным легированием, зонная модель которой в поперечном сечении канала
показана на рис. 12. В нелегированных слоях (i-GaAs) подвижность электронов
значительно выше, чем в легированных широкозонных полупроводниках типа n+AlGaAs.
При отсутствии внешнего поля в канале все электроны находятся на более низких
уровнях, т. е. в слоях i-GaAs, куда они переходят из-за того, что там более
низкое положение по энергии, из широкозонного легированного слоя, где они
образуются. Это определяет высокую подвижность электронов и быстродействие
таких ПТ. При пропускании тока по каналу, т.е. параллельно границам слоев,
происходит два процесса.
Кроме
того, электроны, набирая энергию от поля, поднимаются вверх по энергетической
оси и попадают в высоколегированные слои n+AlGaAs
(волнистые стрелки на рис. 12), где их подвижность еще больше уменьшается. В
итоге выходная вольт-амперная характеристика такого ПТ (iси = f(Uси)) имеет
участок с отрицательным дифференциальным сопротивлением (ПТОС). Величина iси
может, как и в обычном ПТ, регулироваться напряжением затвора. Однако если в
таком ПТОС сделать проводящую подложку из n-GaAs и подсоединить к ней четвёртый
электрод, то из i-GaAs разогретые электроны через варизонный слой i-AlxGa1-x
As будут инжектироваться в эту подложку (анод) и весь прибор станет аналогом
обычного вакуумного тетрода, в котором роль катода играет канал i-GaAs, роль
первой сетки играет затвор, а роль второй сетки - сток.

Рис.
12
Структура
такого ПТ и его поперечная зонная диаграмма показаны на рис. 1 Видно, что
второй слой AlGaAs выполнен варизонным с тем, чтобы обеспечить
хорошую инжекцию электронов в n-слой GaAs и к электроду с потенциалом VA. Ток
этого электрода зависит от VA при вариации Uис, так же как и в вакуумном
триоде, а зависимость icи = f(Uси) будет иметь участок с отрицательным
сопротивлением лишь при больших VA. В ряде конструкций затвор вообще
отсутствует, а электрод подложки помещается справа, параллельно стоку.
Аналоговые
транзисторы. Эти транзисторы являются разновидностью ПТ вертикального
исполнения с затвором в виде сетки (решетки). Хотя идея создания таких
транзисторов была предложена полвека тому назад, преодолеть, и то лишь
частично, технологические трудности удалось только в последние годы.

Рис.
13
Условно
аналоговые транзисторы можно разделить на три группы, каждая из которых имеет
много разновидностей:
транзисторы
со статической индукцией (СИТ). Это транзисторы с затвором в виде сетки из p -
n-переходов, типичная структура которых показана на рис. 14. Так как электроны
движутся в нелегированном i-слое, они имеют высокую подвижность, что и
определяет быстродействие СИТ. Конструкция СИТ напоминает конструкцию обычного
вакуумного триода и поэтому имеет характеристики, похожие на аналогичные
характеристики триода.

Рис.
14
В
ряде конструкций вместо сетки используются более расширенные области
р+-полупроводника возле затвора и вместо i-слоя - n-слой. В других конструкциях
исток и затвор располагаются в одной плоскости, а в фототранзисторах (ФСИТ)
исток выполняется прозрачным для света. В туннельных СИТ (СИТТ) в истоке
помещен обратносмещённый
р+
- n+-переход (туннельный), обеспечивающий высокую плотность тока;
транзисторы
с проницаемой базой (ТПБ), являющиеся аналогом СИТ, у которого сетка выполнена
из тончайших полосок металла (тантала, молибдена, вольфрама) шириной 0,1 0,5
мкм, а вместо i-слоев используются легированные полупроводники с концентрацией
примесей 1016 1017 см3 и толщиной 0,3 мкм истокового слоя и 2 мкм стокового.
Расчеты показывают, что максимальная частота ТПБ растет с уменьшением ширины
полосок сетки, достигая 600 ГГц при ширине 0,1 мкм, причем это уменьшение
должно сопровождаться ростом концентрации примесей. Управление током
“исток-сток” осуществляется напряжением на барьере Шоттки между металлическим
затвором и полупроводником. Характеристики ТПБ подобны характеристикам СИТ;
транзисторы
с металлической базой. Эти транзисторы можно представить как ПТ с вертикальной
структурой, в котором затвор (база) прозрачен для электронов. Базы предельно
малых размеров делают такие транзисторы сверхбыстродействующими. Практически
был реализован МОМОМ-транзистор, где между металлическими эмиттером,
коллектором и базой (толщиной »» 10 нм) помещены тонкие (»» 1,5 нм) слои
окисла.
Структура
МОМОМ и ее зонная диаграмма показаны на рис. 15, из которого видно, что
электроны эмиттера туннелируют через тонкий окисел и с большой энергией
пролетают через базу и слой окисла коллектора.
К
числу транзисторов с металлической базой относятся также структуры типа
“полупроводник-металл-полупроводник” (ПМП), из которых удалось создать
структуру типа Si-CoSi2-Si, где CoSi2 пленка, толщиной 20 нм, обладающая
металлическими свойствами. Так как постоянные решеток Si и CoSi2 близки по
значению, структура представляет собой единый монокристалл. Эмиттер вблизи базы
имеет нелегированный слой (200 нм), а коллектор (слой 800 нм), наоборот, сильно
легирован.

Рис.
15
При
этом потенциальный барьер вблизи эмиттера выше, чем вблизи коллектора, и
эмитируемые электроны проходят через базу и переход коллектора баллистически.
Максимальные частоты таких транзисторов по теоретическим оценкам могут
превышать 1 ТГц.
3. Состояние и перспективы развития элементной базы, а также технологии
полупроводниковой электроники
.1 Полевые GaAs-транзисторы с
гетеропереходом
В последнее время полевые GaAs-транзисторы
с гетеропереходом и управляющим затвором Шоттки (ГПТШ) вышли на уровень
промышленного производства, но ещё не потеснили Si- и GaAs-биполярные
транзисторы с гетеропереходом (МВТ).
При конструировании полевых транзисторов микроволнового диапазона
приходится решать проблемы не только технологического плана. Известно, что при
дрейфе электронов в канале они испытывают большое число соударений, которое за
время пролёта (10-12 с) составляет десятки или сотни, и за время 10-13 с (между
двумя соударениями) носители проходят расстояние порядка 400 ангстрем.
Соударения ведут к падению подвижности электронов, которая и без того снижается
при повышении концентрации носителей в канале, неизбежной при малой длине
канала. Использование гетеропереходов позволило разрешить это противоречие:
двухмерный электронный газ обеспечивает возможность получения слоя с повышенной
концентрацией носителей без увеличения концентрации доноров. Пространственное
разделение ионов доноров и свободных электронов дает возможность получать
высокие концентрации носителей одновременно с высокими значениями mр и mn.
Изменение степени легирования в данных транзисторных структурах нашло
отражение в их названиях: модуляционно-легированные или
селективно-легированные. Возможны и другие варианты транзисторной структуры с
высокой подвижностью электронов mn (HEMT), например, с каналом в слое GaAs (узкозонный полупроводник) и
слоем "поставщиком" электронов (широкозонный полупроводник AlInAs). Например, в канале InGaAs
электрон достигает подвижности 10 000 см2/(В×с), которая обеспечивает высокую плотность заряда в слое
двухмерного электронного газа (3 ¸ 4,5)×1012 см-2. Однако эти положительные качества HEMT в большей степени
проявляются при пониженных температурах.
Серьёзным препятствием при реализации транзисторов с высокой mn является наличие глубоких ловушек
при высоком уровне содержания алюминия в AlGa1-xAsx. Для получения слоя с
двухмерным электронным газом необходимы значения х ³ 0,2, но при этих значениях глубокие
ловушки приводят к срыву стоковых ВАХ, повышению уровня
генерационно-рекомбинационных шумов и даже к появлению эффекта
фоточувствительности. С целью снижения интенсивности указанных процессов
предложено создавать слой двухмерного электронного газа на границе раздела
AlGaAs/In-GaAs, что обеспечивается введением между слоем AlGaAs (30 - 40
ангстрем) и нелегированным слоем GaAs (1 мкм) слоя InGaAs толщиной в 200
ангстрем. Такая структура получила название псевдоморфного транзистора с
высокой подвижностью электронов. Объясняется действие слоя InGaAs тем, что этот
материал имеет меньшую, чем GaAs, ширину DЕ, что позволяет использовать в паре с ним AlGaAs с низким
содержанием алюминия (х = 0,15).
Поскольку у InGaAs запрещённая зона уже, чем у арсенида галлия, то InGaAs
может играть роль узкозонного полупроводника в гетеропереходе GaAs и квантовый
колодец может быть получен и в этом гетеропереходе. Для этого слой InGaAs
наносится на слой GaAs, а на InGaAs наносится слой AlGaAs, кристаллические
решётки этих трёх слоев отличаются на сотые доли процента. Согласование решёток
достигается за счёт эластичности слоя InGaAs, который в виде тонкого слоя
In0,15Ga0,85As оказывается сжат, отображая структуру GaAs и трансформируя свою
"природную" кубическую структуру в тетрагональную.
Транзисторы этого типа превосходят обычные GaAs-транзисторы по многим
высокочастотным параметрам. Так, крутизна переходной характеристики
HEMT-транзисторов при минимальном уровне шумов в 1,5 раза превосходит крутизну
обычных полевых GaAs-транзисторов. Это дает возможность получить усиление 8 дБ
на частоте 20 ГГц, что недостижимо для последних.
Указанные конструкции - планарные (исток, сток и затвор расположены в
одной плоскости), что требует конструкторско-технологичес-кого решения,
обеспечивающего подсоединение кратчайшим путём всех истоков к общей поверхности
(транзисторы в схемах работают, как правило, с заземлённым истоком в качестве
общего электрода).
Одним из возможных решений является конструкция транзистора с
вертикальной структурой, т.е. с затвором и истоком, расположенными друг против
друга (OGST - opposed gate-source transistor). Подложка состоит из
полуизолирующего слоя GaAs с нанесёнными на его поверхность слоями AlGaAs и
GaAs, а затвор располагается между двумя контактами. Под истоком с обратной
стороны подложки протравливается строго сцентрированное относительно затвора и
стоков отверстие, которое заполняется металлом.
Такая конструкция снижает индуктивность истока, повышает крутизну
передаточной характеристики (за счёт симметричного расположения стоковых
электродов по обе стороны от затвора), снижает потери в линиях передачи на
входе и выходе (за счет согласования их импедансов).
Типовая структура GaAs
ГПТШ (приведена на рис. 16, а) отличается от «обычных» ПТШ (MESFET) наличием гетероперехода между
барьерным (донорным) и нелегированным канальным слоями (в данном случае между
слоями GaAs и AlGaAs). Так как в этой структуре ширина запрещенной зоны DЕ материала канального слоя больше,
чем барьерного слоя, в канале у границы слоев формируется потенциальная яма
(тонкий слой), в которой накапливаются свободные носители, образуя так
называемый двумерный электронный газ (2DEG). А поскольку канальный слой не легирован, в нем
рассеяние носителей заряда минимально, а их подвижность высокая. Именно это
позволило назвать такие транзисторы транзисторами с высокой подвижностью
электронов (НЕМТ). В этом случае задача буферного слоя обеспечить структурный
переход от полуизолирующей подложки к совершенной структуре канального слоя.


а) б)
Рис. 16
Реальным примером рНЕМТ-технологии можно считать приборы компании TriQuint Semiconductor с минимальным размером элементов
0,15 мкм. Базовая структура рНЕМ-транзистора формируется на полуизолирующей GaAs-подложке, на которой создают
буферный слой в виде сверхрешётки AlAs/GaAs, InGaAs-канальный слой и AlGaAs-барьерный слой n-типа. Сверху и снизу к канальному слою примыкает спейсер
слой нелегированного барьера, выполненного из AlGaAs.
Концентрация электронов проводимости в канале при этом достигает 3,2×1012 см3, mn 6500 см2/В×с, максимальный ток канала может
составлять 680 мА/мм2 (при напряжении канала 1,5 В), Uпр 13 В, fT 52
ГГц, максимальная частота усиления мощности 150 ГГц. Рабочее напряжение
составляет 6 В, КПД в режиме усиления 40 %.
На основе этой технологии выпускается ряд усилителей (TGA4516, TGA4046 и др.) на диапазон частот 32 38 ГГц (TGA4516) и на частоту 45 ГГц (TGA4046), с выходной мощностью до 2 Вт.
Для повышения fT
рНЕМ-транзисторов на основе InAlAs/In- и GaAs-структур увеличивают концентрацию индия в InxGa1-xAs-канальном слое, но это ухудшает характеристики
прибора. Возможное решение применение InP-подложек, за счет чего согласуются постоянные
решёток, а это позволило получить fT ³ 400 ГГц.
Реализованные рНЕМТ с InGaAs/InAlAs/InP-структурой на 100-мм и 75-мм пластинах по 0,1-мкм
технологии (компания Northrop Grumman
Space Technology NGST) сегодня производятся серийно (рис. 17, pHEMT-структура InGаAs/InAlAs/InP компании NGST).

Рис.
17
В таких транзисторах концентрация In в InGaAs-канальном
слое составляет 60 %, а подвижность m носителей в канале достигает 104 см2/В×с при плотности электронов в 2DEG-cлое, равной 3,5×1012 см2. Крутизна характеристики транзистора составляет 800
мСм/мм, плотность тока 540 мА/мм, fТ более 190 ГГц. На базе рНЕМТ создан малошумящий двухкаскадный
балансный усилитель с коэффициентом усиления свыше 17 дБ и уровнем шумов менее
2,4 дБ в диапазоне частот 27 39 ГГц.
Однако стоимость таких транзисторов остается высокой, поэтому в качестве
возможного решения сегодня рассматриваются так называемые метаморфные
НЕМТ-структуры (МНЕМТ), т.е. приборы со сложным многослойным буфером (со
ступенчатым изменением концентрации примеси для обеспечения плавного перехода
от GaAs-подложки к InGaAs-каналу). Этим решается проблема применения более
дешёвых GaAs-подложек, что и использовала
компаниия Raytheon, разработавшая технологию
изготовления InAlAs/InGaAs/GaAs
МНЕМТ-структур с концентрацией индия в InGaAs-канале 60 %. Получены транзисторы с крутизной
передаточной характеристики порядка 850 мСм/мм, напряжением пробоя 8 В и током
канала до 700 мА/мм (в постоянном режиме). В импульсном режиме последние два
показателя составили 6 В и 200 мА/мм соответственно. При суммарной ширине
затвора 480 мкм усиление на частоте 94 ГГц при напряжении 2,5 В составило 12
дБ, выходная мощность 360 мВт/мм, КПД свыше 30 %. На базе подобных структур
этой компанией создан ряд однокаскадных усилителей мощности для диапазона
частот от 56 до 100 ГГц. Их усиление при напряжении 3,3 В составляет 6,5 дБ,
КПД 17 % при максимальной выходной мощности 226 мВт.
.2 SiGe-транзисторы
Не остаются без внимания разработчиков и SiGe-технологии, которые позволили реализовать
микроволновые транзисторы, сопоставимые по частотным характеристикам с GaAs-приборами (лидирует здесь компания IBM). Основные достоинства SiGe-структур (при увеличении стоимости
процессов на 10 20 % по сравнению со стандартной Si-технологией) существенное увеличение рабочей частоты и линейность
характеристик. Компания IBM в
рамках Би-КМОП-техпроцесса 7НР с технологическими нормами на длину канала 0,18
мкм производит МИС с граничными частотами 70/45 ГГц для n-МОП/р-МОП транзисторов и 120 ГГц
для МВТ (напомним, что Би-КМОП-технология является объединением КМОП- и
биполярных транзисторов в единой приборной структуре). В 2005 году IBM объявила о создании Би-КМОП МИС
четвертого поколения по технологии 8НР (с 0,13-мкм топологическими нормами).
Граничная частота её биполярных n р n-транзисторов достигает 210 ГГц (100
ГГц для варианта 8WL), максимальная
частота усиления 185 ГГц.
Процесс изготовления SiGe-приборов
по сравнению с кремниевыми требует нескольких дополнительных операций. Так, в
базе биполярных кремниевых n р n-транзисторов формируется
эпитаксиальный SiGe-слой. При
этом образуется гетеропереход Si/SiGe, позволяющий увеличить уровень
легирования базы (что уменьшает ее сопротивление, время переключения и уровень
шумов). Уменьшение ширины DЕ базы позволяет увеличить коэффициент усиления по току, поскольку из-за
разрыва границ валентной зоны в переходе база-эмиттер сокращается инжекция
дырок в эмиттер (что приводит к увеличению коэффициента эффективности
эмиттера).
В буферном слое МОП-транзисторов SiGe используется для формирования в канале области
двумерного электронного газа (рис. 18, структура SiGe КМОП-ячейки ИС).

Рис.
18
В
результате подвижность дырок mр и электронов mn в канале n- и
р-типа составляют 2800 и 1400 см2/В×с
соответственно, что обуславливает более высокочастотные характеристики: fт
МОП-транзисторов на основе SiGe могут превышать 100 ГГц (рис. 19, зависимость fт
транзисторных структур различных типов от ширины затвора).
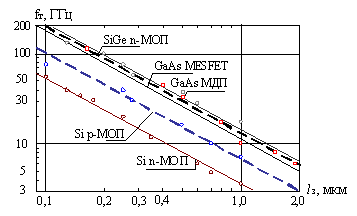
Рис.
19
Серийным
SiGe-усилителем является прибор НМС474МР86 (схема
Дарлингтона), работающий в диапазоне частот 0 6 ГГц с усилением в диапазоне
частот от 9 до 15,5 ГГц при выходной мощности 10 дБм.
.3
Мощные GaN- и SiC-транзисторы
Активно
осваиваются сегодня и полупроводниковые материалы с широкой запрещенной зоной,
что обеспечивает большие значения пробивного и рабочего напряжений, высокую
мощность и рабочую температуру перехода. Это направление наиболее важно для
микроволновой электроники, однако в промышленности используются только для два
широкозонных полупроводниковых материала GaN и SiC.
Полупроводник
GaN (как и вся группа III-нитридов)
представляется наиболее перспективным широкозонным полупроводниковым
материалом, совокупность свойств которого с возможностью формирования на его
основе гетеропереходов позволяет добиться уникальных характеристик
транзисторов рабочего напряжения свыше 60 В, частот до 70 ГГц, мощности до 200
Вт. Hа основе GaN уже создан НЕМТ с выходной
мощностью свыше 176 Вт, рабочим напряжением 63 В, КПД 54 % при усилении 12,9 дБ
на частоте 2,1 ГГц. Рекордное на сегодня значение удельной мощности для них
32,2 Вт/мм при КПД 54,8 %, рабочем напряжении 120 В и частоте 4 ГГц.
Полупроводник
SiC всего лишь несколько лет назад стал рассматриваться в
качестве материала для приборов полупроводниковой (особенно силовой)
электроники. Поэтому сегодня лишь две компании производят приемлемые изделия из
SiC диоды с барьером Шоттки (ДБШ), имеющие рабочее
напряжение 300 1200 В и ток 1 20 А. Уже сейчас применение в преобразователях
с жёстким режимом переключения ДБШ на основе SiC с
напряжением 600 В совместно с CoolMOS Si-полевыми транзисторами
позволяет получить выигрыш по эффективности преобразования в 2 раза по
сравнению с другими ключевыми приборами.
Из
существующих 170 известных политипов SiC только два доступны для
серийного изготовления приборов это 4H-SiC и 6H-SiC.
Таблица
1
Cравнительная
таблица основных свойств полупроводникового материала 4H-SiC с
Si и GaAs
|
Наименование
|
Si
|
GaAs
|
4H-SiC
|
|
Ширина запрещённой энергетической
зоны DЕ, эВ
|
1,12
|
1,5
|
3,26
|
|
Подвижность электронов mn, см2/с×В
|
1400
|
9200
|
800
|
|
Подвижность дырок mр, см2/с×В
|
450
|
400
|
140
|
|
Концентрация собственных
носителей, см3 при З00 К
|
1,5×1010
|
2,1×106
|
5,1×109
|
|
Скорость объёмного заряда
электронов, см/с×107
|
1,0
|
1,0
|
2,0
|
|
Критическая напряжённость
электрического поля, МВ/см
|
0,25
|
0,3
|
2,2
|
|
Теплопроводность, Вт/см×К
|
1,5
|
0,5
|
3,0 3,8
|
Основные преимущества SiC
перед Si и GaAs:
) более чем на порядок выше Uпр, чем у Si и GaAs (это значительно снижает сопротивление
канала в открытом состоянии Ron).
На рис. 20 показана зависимость Ron от
напряжения пробоя кристалла. Низкое удельное Ron в сочетании с высокой плотностью тока и
теплопроводностью позволяет уменьшать размеры кристаллов для силовых приборов;

Рис.
20
)
большая ширина DЕ является результатом более высокого барьера Шоттки
по сравнению с Si и GaAs, что дает малый ток утечки (менее 70 мкА при 200 ОС),
а при повышенной температуре кристалла снижается термоэлектронная эмиссия за
пределами барьера;
)
высокая теплопроводность SiC способствует снижению теплового сопротивления
кристалла;
)
высокая надёжность и стабильность во времени приборов на основе SiC
(их свойства слабо зависят от температуры);
)
SiC устойчив к жёсткой радиации;
)
рабочая температура кристалла SiC более 600 ОС позволяет создавать приборы для жёстких
и специальных условий эксплуатации.
ДБШ
на основе SiC в настоящее время являются единственным коммерчески
доступным продуктом и обычно имеют структуру, приведенную на рис. 21. Высота
потенциального барьера при металлизации 4H-SiC
такими материалами, как Ti и Ni, составляет 0,8 и 1,3 В соответственно [Ni-металлизация
для высоковольтных (более 1500 В) диодов Ti-металлизация
для низковольтных].
Типовые
зависимости прямого падения напряжения от тока при различных температурах Si и SiC
для серийно выпускаемых диодов показаны на рис. 22.
Поскольку
с ростом температуры в SiC снижается mn и повышается удельное сопротивление в открытом
состоянии, прямое падение напряжения, в отличие от Si-ДБШ, имеет
положительный температурный коэффициент.
Рис. 21 Рис. 22
Известно, что силовые приборы имеют ограничение на рабочее напряжение,
обусловленное низкой пробивной напряжённостью. По сравнению с силовыми
приборами на основе Si MOSFET на основе SiC должны иметь более чем в 10 раз бóльшую пробивную напряжённость поля и
в 400 раз меньшее удельное сопротивление в открытом состоянии, что делает SiC почти идеальным материалом для
силовых элементов. Структурно можно выделить несколько типов MOSFET это DMOS-, UMOS-
и JFET-приборы. Структура DMOS Double-implanted MOS-транзистора
(рис. 23, а SiC DMOS-транзистор) аналогична структуре кремниевого double-Diffused MOS-транзистора, области p-базы и n+-истока
которого получают путем ионной имплантации. В этих приборах положительное
смещение на затворе из поликристаллического Si создает инверсный слой на границе раздела между слоем SiO2 и базой SiC p-типа. Электроны переходят из n+-истока через инверсный слой в n-область дрейфа и затем в n+-подложку (сток).

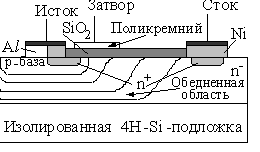
а) б)
Рис. 23
Широкая примесная n-область
обеспечивает высокую электрическую прочность прибора в закрытом состоянии, а
максимальное рабочее напряжение транзистора будет определяться толщиной области
дрейфа и концентрацией примеси в ней. Поскольку максимальная толщина
эпитаксиального слоя коммерчески доступных SiC-подложек не превышает 10 мкм, напряжение пробоя
ограничивается величиной 1,6 кВ. Один из путей его повышения использование
горизонтальной структуры LDMOS
(рис. 23,б Lateral DMOSFET). В такой структуре создается обеднённая область,
которая при закрытом состоянии транзистора и увеличении запирающего потенциала
также увеличивается и, достигнув изолированной подложки, продолжает
распространяться в сторону стока, блокируя приложенное между стоком и истоком
напряжение. При этом максимальное напряжение не зависит от толщины
эпитаксиального слоя и ограничивается только уровнем начала поверхностного
электрического пробоя между электродами [для LDMOSFET (Сrее Inc.),
уровень напряжения пробоя составляет 10 кВ].
Для снижения удельного сопротивления канала UMOS-транзисторов в открытом состоянии их затвор
выполняется в виде U-образной канавки
(trench-gate) (рис. 24 SiCUMOS-транзистор).
На рис. 24 показаны диаграммы распределения электрического поля в р n-переходе и в MOS-структуре. Можно видеть, что в
области оксидной изоляции затвора наблюдается скачок потенциала, превышающий
пиковую напряженность поля в полупроводнике в 2,5 раза. Это приводит к
необратимым пробоям в транзисторе и накладывает ограничение на величину
рабочего напряжения.
Решение этой проблемы предложено центром Purdue University WBG Research Group, которым создана структура с интегральной защитой,
которая ограничила напряжённость поля в оксидном слое затвора и одновременно
снизила удельное сопротивление в открытом состоянии транзистора (рис. 25 SiC ACCUFET-транзистор).

Рис.
24
В
прибор введена дополнительная область р-типа, расположенная под «канавкой»
затвора, позволяющая снизить напряжённость поля на границе раздела
оксид-полупроводник до нуля, что защищает оксидный слой от пробоя в закрытом
состоянии прибора. Дополнительный эпитаксиальный слой под р-базой предотвращает
отсечку канала проводимости в открытом состоянии и способствует протеканию тока
в области дрейфа.

Рис.
25
Прибор
также включает в себя обогащённый n-эпитаксиальный слой, выращенный
на боковой стенке канавки. Этот слой превращает прибор в так называемый MOSFE-транзистор
с обогащённым слоем (accumulation-layer MOSFET или ACCUFET),
у которого увеличена подвижность электронов mn и одновременно снижено в открытом состоянии удельное
сопротивление. Полученные образцы ACCUFET обеспечивают максимальное
напряжение 1,4 кВ, удельное сопротивление 15,7 мОм×см и добротность 125 МВт/см, что в 25 раз превышает
теоретический предел для кремниевых MOSFET.
Рассмотренные
приборы имеют высокую, но не всегда достаточную степень готовности для
серийного производства. В отличие от MOSFET полевые транзисторы с
управляющим р n-переходом и каналом р-типа (рис. 26 SiC JFE-транзистор) отработаны до уровня серийного
производства, и появления их на рынке силовых полупроводников можно ожидать в
ближайшее время.
Недостатком
JFE-транзистора является то, что при пусковом напряжении
на затворе он полностью открыт. Свободна от этого недостатка каскодная схема,
состоящая из высоковольтного (SiC JFET) и низковольтного (Si MOSFET) транзисторов. Такой гибридный прибор управляется,
как обычный MOSFET, при этом обеспечивается его значительно более низкое
сопротивление в открытом состоянии и высокое рабочее напряжение.

Рис.
26
На
рис. 27 показана схема каскода с высоковольтным SiC JFET
и низковольтным Si MOSFET транзисторами,
разработанная исследовательским центром SiCED (SIEMENS AG).
На
рис. 28 приведен сравнительный график зависимости плотности тока и прямого
падения напряжения от удельного сопротивления SiC- и Si-транзисторов
в открытом состоянии.
Можно
видеть, что транзистор SiC JFET с напряжением 3,3 кВ имеет
потери проводимости ниже, чем у транзистора Si CoolMOSТМ
с напряжением 600 В.


Рис. 27 Рис. 28
Для построения высоковольтных ключей можно использовать схему
«супперкаскода» линейку из последовательно включенных транзисторов SiC IFET и управляющего низковольтного Si MOSFET-транзистора, как показано на рис. 29 (каскодный ключ
9 кВ, 1,3 Ом, состоящий из SiC JFET с Uси = 3 кВ и Si MOSFET с Uси =
55 В).

Рис.
29
В настоящее время основными управляемыми приборами силовой электроники в
области коммутируемых токов до 50 А и напряжений до 500 В являются биполярные
транзисторы (BPT) и идущие им на смену полевые транзисторы с изолированным
затвором (MOSFET). Нишу высоковольтных силовых приборов с большими уровнями
токов и напряжений (до единиц киловольт) заняли биполярные транзисторы с
изолированным затвором (IGBT Insulated Gate Bipolar Transistor).транзисторы появились
в 1980-х годах, но и сегодня высоковольтных MOSFET-транзисторов с качественными
характеристиками создать пока не удается, так как сопротивление канала
открытого транзистора растет пропорционально квадрату напряжения пробоя.прибор
представляет собой биполярный p n p-транзистор, управляемый от низковольтного
MOSFET-транзистора с индуцированным каналом (рис. 30).
Потери IGBT-приборов растут пропорционально току, а не квадрату тока, как
у полевых транзисторов. Максимальное напряжение IGBT-транзисторов ограничено
только величиной технологического пробоя; и сегодня выпускаются приборы с
рабочим напряжением до 4 кВ, при этом остаточное напряжение 2 3 В. По
быстродействию силовые IGBT-приборы уступают MOSFET-транзисторам, но
превосходят биполярные.

а) б)
Рис. 30
Структура базовой IGBT-ячейки представлена на рис. 31, а и содержит в
стоковой области дополнительный p+-слой, образующий p n p-биполярный
транзистор с очень большой площадью коллектора (для коммутации значительных
токов). При закрытом состоянии (минус на затворе) внешнее напряжение приложено
к обеднённой области эпитаксиального n--слоя. При подаче на изолированный
затвор положительного смещения возникает проводящий канал в р-области (на рис.
31,а обозначен пунктирной линией) и включается соответствующий МДП-транзистор,
обеспечивающий открытие биполярного p n p-транзистора. Между внешними
выводами коллектора и эмиттера начинает протекать ток. При этом ток стока
МДП-транзистора оказывается усиленным в (b + 1) раз. При включенном биполярном транзисторе в n--область
идут встречные потоки носителей, что ведет к уменьшению сопротивления этой
области и уменьшению остаточного напряжения на приборе.
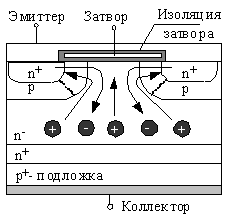
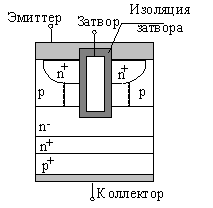
а) б)
Рис. 31
Напряжение на открытом приборе складывается из напряжения на
прямосмещенном эмиттерном переходе p n p-транзистора (диодная составляющая) и
падения напряжения на сопротивлении модулируемой n--области (омическая
составляющая):
UКЭ
откр » UБЭ p-n-p + IБRМДП = UБЭ тp-n-p + IКRМДП/(b + 1),
где RМДП сопротивление MOSFET-транзистора в структуре IGBT
(сопротивление эпитаксиального n--слоя); b коэффициент передачи базового тока биполярного p n
p-транзистора.
В настоящее время для уменьшения падения напряжения на IGBT-транзисторах
в открытом состоянии, расширения диапазонов допустимых токов, напряжений и
области безопасной работы их изготавливают по технологии с вертикальным
затвором trench-gate technology (рис. 31,б). При этом размер элементарной
ячейки уменьшается в 2 5 раз.
Типичные значения времени рассасывания накопленного заряда и спада тока
при выключении IGBT-транзисторов находятся в диапазонах 0,2 0,4 и 0,2 1,5 мкс
соответственно. Область безопасной работы современных IGBT-транзисторов
позволяет успешно обеспечить их надежную работу без применения дополнительных
цепей формирования траектории переключения при частотах от 10 до 20 кГц.
Типовые выходные ВАХ IGBT-транзисторов приведены на рис.32.

Рис.
32
Следует
отметить, что IGBT-транзисторы не так чувствительны к электростатическому
пробою, как, например, КМОП-приборы, однако производить монтажные работы с ними
необходимо в антистатическом браслете, а для защиты затвора от статического
пробоя в схеме необходимо подключать параллельно цепи “затвор-эмиттер” резистор
сопротивлением 10 20 кОм.
Условные
графические обозначения IGBT-транзисторов, используемые различными
производителями при их изображении на принципиальных схемах электронных
устройств, приведены на рис. 3

Рис.
33
Компания
International Rectifier (IR) выпускает четыре семейства силовых
IGBT-транзисторов с учётом диапазонов рабочих частот: Standart, Fast,
UltraFast, Warp (табл. 2).
Таблица
2
Сравнительные
характеристики различных семейств IGBT-транзисторов компании IR
|
Параметр
|
Семейство IGBT-транзисторов
|
|
Standart
|
Fast
|
UltraFast
|
Warp
|
|
Uкэ, В
|
1,3
|
1,5
|
1,8
|
2,1
|
|
Энергия переключения, мДж/А
мм2
|
0,54
|
0,16
|
0,055
|
0,03
|
|
Статические потери, Вт
|
0,625
|
0,75
|
1,1
|
Транзисторы семейства Standart оптимизированы по минимуму падения
напряжения на ключе и статическим потерям, а транзисторы семейств UltraFast и
Warp оптимизированы (для ВЧ-цепей) по минимуму динамических потерь. Малая
энергия переключения позволяет использовать транзисторы семейства Warp вплоть
до частоты 150 кГц, а транзисторы семейства UltraFast до частоты 60 кГц при
приемлемом уровне динамических потерь.
Жёсткие условия эксплуатации могут касаться и температурного режима, для
которого полупроводник SiC
практически незаменим. Можно отметить, что объём рынка высокотемпературной
электроники в 2003 году составил 400 млн. долларов и по прогнозам к 2008 году
увеличится более чем в 2 раза. Это заставляет разработчиков интенсивно вести
исследования в области SiC-технологий.
Наиболее сложным остается вопрос получения надежного электрического контакта
(поскольку при Т ³ ³ 500 ОС металлизация контакта
деградирует из-за взаимной диффузии между слоями, окисления контакта и
композиционных и микроструктурных изменений на границе раздела
металл-полупроводник). Варианты с вакуумированием многократно увеличивают
стоимость и габариты транзисторов, делая их непригодным к широкому применению.
Применение трехслойной металлизации политипа 6H-SiC Ti (100 нм)/ТаSi2 (200 нм)/Рt (300
нм) позволяет получать температурно стабильные ВАХ прибора и омические
сопротивления контакта на воздухе в течение более 600 часов при 500 OС. Особенностью такого контакта
является то, что первоначальное окисление Si создает механизм образования критического диффузионного
барьера, предотвращающего дальнейшее проникновение кислорода в слой
металлизации. Такое решение предложено центром NASA (Glenn Research
Center). Оно делает возможным создание
высокотемпературных приборов с пластмассовыми корпусами либо в бескорпусном
виде.
Важным направлением является и создание SiC-интегральных схем, при этом наибольший интерес
представляет CMOS-технология на основе карбида
кремния, обеспечивающая низкую потребляемую мощность, высокие радиационную и
тепловую стойкости. Первая технология SiC CMOS ИС была
представлена компанией Cree Research в 1996
году, однако проблемы, связанные с высоким пороговым напряжением рMOSFET-транзисторов, не позволили
использовать данную технологию для серийного производства.
Чрезвычайно высокая стоимость SiC-пластин является главным препятствием для внедрения разработанной
технологии при производстве приборов с частотным диапазоном менее 6 ГГц (табл.
3). Проблема эта актуальна не только для SiC-транзисторов, но и для всех мощных приборов на основе
широкозонных полупроводников. Действительно, большая плотность мощности
означает малую площадь теплосъёма, что требует применения подложек с высокой
теплопроводностью. Одним из лучших с этой точки зрения материалов остается SiC. Поэтому сегодня практически все GaN-приборы с рекордными
характеристиками выполнены именно на SiC-подложках.
По состоянию на 2004 год 85 % рынка SiC-подложек принадлежало компании Сrее, которая первой начала
производство 4Н-SiC-пластин,
используемых главным образом для изготовления светодиодов. Подложки 6Н-SiC в США в промышленном масштабе
производит только компания с необычным названием II-VI.
Таблица 3
Подложки для приборов на широкозонных полупроводниках
|
Материал
|
4HSIC
|
AIN
|
GaN
|
GaAs
|
Si
|
|
Ширина DЕ, эВ
|
3,26
|
6,2
|
3,36
|
1,42
|
1,12
|
|
Теплопроводность, Вт/(см×К)
|
4,9
|
3,4
|
1,3
|
0,6
|
1,3
|
|
Напряженность поля пробоя,
МВ/см
|
4,9
|
3,4
|
1,3
|
0,6
|
1,3
|
|
Диаметр производимых
пластин, мм
|
75
|
25
|
50
|
150
|
300
|
|
Цена пластин, долл./дюйм2
|
700
|
> 1000
|
> 1000
|
< 10
|
» 1
|
При этом стоимость 75-мм полуизолирующей SiC-пластины колеблется от 4 до 5 тыс. долл. К началу
2005 года первые шаги на коммерческом рынке SiC-пластин сделали еще несколько компаний DowCorning (США), SiXon (Япония), SiCrystal (Германия) и Okmetic
(Финляндия). А фирмы Сrее и II-VI объявили о запуске линий изготовления 100-мм SiC-пластин, но всё это пока не изменило
рыночной ценовой ситуации.
Положение с ценой на GaN-подложки
не проще, хотя такой материал и уступает по теплопроводности SiC, но в качестве подложки для GaN-приборов предпочтителен благодаря
структурному соответствию. Сегодня проводящие GaN-подложки диаметром не более 50 мм производят лишь три
компании ATMI, Kyma, Sumitomo, но цены их высоки, число пластин ограничено, а плотность их дефектов не
отвечает требованиям, предъявляемым к пластинам для крупномасштабного
производства. Положение с полуизолирующими GaN-подложками ещё сложнее.
AIN-пластины
в промышленных масштабах во всем мире производит только компания Crystal IS (США) и только диаметром 25 мм. Надежда, что в скором
времени это положение изменится, имеется, тем более что ведутся активные работы
по созданию подложек на основе искусственных алмазов.
В то же время значительные успехи достигнуты в области создания GaN-приборов на недорогих Si-подложках с кристаллографической
ориентацией [111]. Лидером освоения и коммерциализации GaN-эпитаксиальных структур на таких подложках выступила
компания Ni-tronex. На её подложках фирма TriQuint Semiconductor уже создала МИС двухкаскадного
усилителя Х-диапазона мощностью 25 Вт. Ширина затвора транзистора в выходном
каскаде составляет 11,4 мм, размер кристалла 3х4,5 мм. Мощность 25 Вт в
импульсном режиме была достигнута на частоте 10 ГГц при напряжении стока 30 В и
усилении 15 дБ, КПД 21 %.
В заключение следует сказать и о технологиях, которые с определённой
уверенностью можно отнести к перспективным.
.4 Антимониды и арсенид индия
Вплоть до недавнего времени заметного прогресса в области создания AlSb/InAs/AlSb HEMT не
наблюдалось, хотя первые сообщения о них появились в конце 1980-х годов. Сегодня
исследования приборов на основе этих материалов поддержаны программой DARPA Antimonide Based Compound Semiconductor ABCS, в которой речь идет о полупроводниковых соединениях GaSb, InAs и AlSb с
близкими значениями постоянных кристаллической решетки (примерно 6,1 ангстрем).
Указанные материалы обладают весьма узкой DЕ, чрезвычайно высоким значением mn (до 33 000 см2/В×с) и скоростью насыщения носителей
свыше 4×107 см/с при комнатной температуре
(табл. 4), что должно позволить создавать на их основе НЕМТ и МВТ с чрезвычайно
высоким быстродействием и рабочими напряжениями порядка 0,5 1 В.
Таблица 4
Свойства InAs и InSb в сравнении с другими
полупроводниковыми материалами
|
Материал
|
Si
|
GaAs
|
In0,58Ga0,47As
|
InAs
|
InSb
|
|
mn в
канале (концентрация носителей 1012 см-2), см2/(В×с)
|
600
|
4600
|
7800
|
16×103-2×104
|
3×104
|
|
Скорость насыщения
электронов, 107 см/с
|
1,0
|
2,2
|
0,8
|
5,0
|
|
Ширина DЕ, эВ
|
1,12
|
1,42
|
0,72
|
0,36
|
0,18
|
В этой области уже достигнуты определенные практические результаты, среди
которых [компания NGST и лаборатория ВМС США (NRL)] создание AlSb/InAs
МНЕМТ-структур с длиной затвора 0,1 мкм (табл. 5). Здесь разрыв между границами
зоны проводимости в области гетероперехода AlSb/InAs
достигает 1,35 эВ, что приводит к формированию глубокой квантовой ямы и обусловливает
высокую концентрацию носителей в 2DEG-области (до 1,28×1012 см2 при подвижности электронов 26 300 см2/В×с).
Крутизна характеристик каналов транзисторов достигает величины 1,3 См/мм
при рабочем напряжении до 0,3 В, fт и fmax превышают значения 220 и 270 ГГц, а
напряжение пробоя сток-затвор составляет 1,42 В. При таких высоких частотах
удельная рассеиваемая мощность приборов оказалась чрезвычайно низкой. В
частности, при напряжениях сток-исток 0,2 и 0,5 В граничные частоты в среднем
составили 160 и 220 ГГц, а токи канала имели значения 135 и 340 мА/мм
соответственно. Столь небольшая рассеиваемая мощность (27 и 170 мВт/мм) по
меньшей мере в 5 10 раз ниже, чем у InP НЕМТ-транзисторов на аналогичных частотах. В диапазоне частот 2 26 ГГц
удельная рассеиваемая мощность не превысила 6 мВт/мм при коэффициенте шума 0,85
дБ и усилении 11,5 дБ.
Таблица 5
Структура AlSb/InAs MHEMT компании Northrop Grumman Space
Technology
|
Слой
|
Материал
|
Толщина, нм
|
|
Cap-слой
|
InAs
|
2
|
|
Барьерный
|
In0,4Al08As AlSb
InAs, легированный Si (3×1019) AlSb
|
4 1,2
1,2 7,5
|
|
Канальный
|
InAs
|
15
|
|
Нижний барьерный
|
AlSb
|
50
|
|
Буферный
|
Al0,7Ga0,3Sb AlSb
GaAs
|
300 1700
230
|
|
Полуизолирующая подложка
|
GaAs
|
|
На базе НЕМТ, выполненных из AlSb/InAs, уже создана микроэлектронная
интегральная схема (МИС) усилителя мощности, коэффициент шума которого в
диапазоне частот 80 100 ГГц составляет 5,4 дБ, усиление 11,1 дБ, а общая
рассеиваемая мощность 1,8 мВт. При усилении 16 дБ в полосе частот 77 103 ГГц
рассеиваемая мощность равна 4,41 мВт.
Еще более многообещающими по сравнению с InAs-приборами выглядят транзисторы с канальным слоем из InSb, который характеризуется самой
высокой подвижностью носителей из всех известных полупроводников (см. табл. 4).
Его свойства были продемонстрированы более восьми лет назад в МДП-транзисторе с
InSb-каналом, сформированном на InSb-подложке с SiO2 в качестве подзатворного диэлектрика.
Первый МНЕМ-транзистор со структурой AlxIn1-xSb/InSb и с 0,1-мкм затвором приведен на
рис. 34 (техноцентр QinetiQ и компания
Intel, двухпальцевый AlxIn1-xSb, lnSb
МНЕМ-транзистор с 0,1-мкм затвором). Прибор изготовлен на GaAs-подложке, на которой располагаются
буферный слой AlyIn1-ySb толщиной 3 мкм, нижний барьерный слой AlxIn1-xSb, lnSb-канальный
слой толщиной 20 нм и AlxIn1-xSb-спейсер толщиной 5 нм. Выше
следовали d-легированный
теллуром тонкий слой AlxIn1-xSb (с концентрацией донорной примеси
1012 см2) и верхний барьерный слой AlxIn1-xSb толщиной 15 45 нм. При доле
алюминия в барьерном слое 30 % подвижность электронов в канале составила 30×103 см2/В×с при концентрации носителей 1,3×1012 см2.

Рис.
34
В
испытуемых lnSb-транзисторах с затвором длиной 0,1 мкм и шириной 40
мкм доля Al в AlInSb составляет 20 %, что обеспечивало концентрацию
носителей в канале 1012 см2 и их подвижность 25 000 см2/В×с. Максимальная крутизна характеристик прибора при
напряжении сток-исток 0,5 В составляет 800 мСм/мм, ток в канале 250 мА/мм,
экстраполированные значения fт и fmax 210 и 270 ГГц соответственно. Рассеиваемая мощность InSb-прибора
примерно в 10 раз меньше, чем у кремниевого n-канального
МОП-транзистора с 80-нм каналом на такой же граничной частоте. Задержка
включения (вентильная задержка) по крайней мере втрое меньше, чем в современных
или перспективных Si-транзисторах при равной длине затвора.
4.5
Алмаз как материал для СВЧ-приборов
Алмаз
как полупроводниковый материал давно привлекает внимание исследователей
благодаря своим уникальным электрофизическим характеристикам: при комнатной
температуре DЕ = 5,47 эВ, mn и mр равны 1800 и 1200 см2/В× с соответственно (могут достигать 4500 и 3800 см2/В×с соответственно). Как показывают расчёты, на основе
алмазов можно создавать МДП-структуры с удельной плотностью мощности до 27
Вт/мм2, плотностью носителей заряда в тонком слое до 1013 см2, напряжением
пробоя порядка 10 МВ/см и рабочими частотами 100 ГГц. Не менее важное свойство
алмазов их высокая теплопроводность (около 20 Вт/К×см), что более чем в 30 раз выше, чем у GaAs
(см. табл. 3). Поэтому первые попытки применения алмазов в СВЧ-приборах были
направлены на создание теплопроводящих подложек, как правило, методом
химического осаждения тонких пленок из газовой фазы (CVD-алмазы). Это
направление развивается в России и сегодня.
Технические
проблемы при формировании активных структур главным образом связаны с
легированием. Легирующие примеси алмаза бор (акцептор), азот и фосфор
(доноры). Но в структуре алмаза энергия активации (ионизации) DЕА этих элементов весьма высокая: у бора 0,37 эВ, фосфора и азота 0,62
и 1,7 эВ соответственно. Это означает, что при комнатной температуре донорная
примесь не будет активироваться, и единственный легирующий элемент это бор. Но
энергия ионизации бора также велика, и полная активация акцепторных связей при
комнатной температуре наступает при концентрации бора свыше 1020 см
Путем
легирования тонкого слоя алмаза бором создана (университет г. Ульм, Германия и
компания Element Six, Великобритания) в 2005 году MESFET-структура
(рис. 35 структура первого MESFET-транзистора на основе алмаза с d-слоем, легированным бором).

Рис.
35
На
подложку из искусственного алмаза, выращенного при высоких значениях давления и
температуры (НРНТ) (ориентация [100]), наносился слой CVD-алмаза
толщиной 250 нм, который являлся основой для выращивания d-слоя CVD-алмаза, легированного бором с максимальной
концентрацией 5×1020 см- Толщина этого d-слоя на
уровне половины максимальной концентрации не превышала 10 нм. Поверх d-слоя осаждался тонкий (< 20 нм) слой CVD-алмаза.
Переход Шоттки создавался путём нанесения на этот CVD-слой
алюминиевого затвора. Канал формировался непосредственно над легированным d-слоем. При этом чем острее профиль легирования d-слоя, тем выше подвижность дырок mр в канале, которая
может достигать 3800 см2/В×с. Ток сток-исток первого
"алмазного" транзистора не превысил 1 мкА при размере затвора 100х0,5
мкм. В целом эксперимент подтвердил правильность расчётов.
Есть
сообщения и о другом способе создания транзисторных структур на основе алмазов.
Так, обработка поверхности алмазной пластины водородом (hydrogen termination) приводит к появлению тонкого приповерхностного слоя
с проводимостью р-типа, в результате формируется слой двумерного дырочного газа
с концентрацией носителей около 1013 см-2. Однако пока физика этого эффекта до
конца не объяснена. Тем не менее уже созданы опытные МДП-структуры на основе
поверхностной проводимости алмазных пленок с использованием CaF2
в качестве затворного диэлектрика, и MESFET с самосовмещённым
Т-образным затвором. Транзисторы с затвором Шоттки изготавливались на различных
подложках: искусственных НРНТ-алмазах с ориентациями [111] и [100], CVD-монокристаллических
подложках и квазиподложках, выращенных на Ir/SrTiO
Во всех случаях были сформированы транзисторные структуры с нормально
обогащённым каналом и малыми токами утечки.
Измеренная
на поверхности mр оказалась на порядок ниже расчётной (150 см2/В×с), что объясняется рассеянием носителей заряда на
поверхностных состояниях, но при низких уровнях тока были получены превосходные
частотные характеристики (fт = 25 ГГц и fmах до 81 ГГц), а уровень
собственных шумов составил 0,72 дБ на частоте 3 ГГц.
4.6 Транзистор на нанотрубках
Фирмой IBM (T.J. Watson Research Center) изготовлены транзисторы на
углеродных нанотрубках с параметрами, которые могут конкурировать с параметрами
Si-полевых нанотранзисторов,
изготовленных по 20-ти нанометровой технологии.
При изготовлении использовались операции традиционной Si-технологии и углеродные нанотрубки с
диаметром 1,4 нм, обладающие полупроводниковыми свойствами (s-SWNT). Эти трубки
“набрасываются” на подложку сильнолегированного Si, на которой предварительно выращен термический окисел
толщиной 150 нм. Материал подложки в дальнейшем служит затвором транзистора, а
окисел - диэлектриком, изолирующим его от канала транзистора (нанотрубки).
Контакты истока и стока формируются методом взрыва (lift-off) из Ti и Co. Расстояние между контактами составляет 1 мкм. Отжиг
приводит к формированию TiC
или CoC на поверхности нанотрубки, что
обеспечивает низкое контактное сопротивление. Пассивация поверхности нанотрубок
SiO2 значительно снижает плотность
ловушек. “Набрасывание” нанотрубок на поверхность является, безусловно, слабым
местом в технологии: где-то они попадут на выращенный термический окисел Si, а где-то и нет. Поэтому только
малая доля транзисторов, изготовленных на подложке, будет работать как следует.
Большая отбраковка не позволяет создать сложную интегральную схему. И всё-таки
лучшие экземпляры транзисторов продемонстрировали удовлетворительные
характеристики (рис. 36).


Рис.
36
Так,
крутизна надпороговой характеристики полученных структур (в открытом состоянии)
и наклон подпороговой характеристики (в закрытом состоянии) меньше, чем у
MOSFET-транзисторов с длиной канала 25 100 нм, а пороговое напряжение
несколько выше. Это связано с большим расстоянием от затвора до нанотрубки и
большой концентрацией заряженных ловушек на поверхности нанотрубки, даже после
её пассивации SiO2. Кроме того, ток транзистора с одной нанотрубкой
слишком мал даже для переключения состояния смежного транзистора в логической
схеме. Чтобы увеличить ток, следует использовать несколько нанотрубок в
качестве канала транзистора, что ведёт к снижению выхода годных транзисторов.
Основанием для конкурентоспособности служит сходство проблем, в частности,
возрастающая роль поверхности.
4.7
Достижения по быстродействию и планы развития high-K
Рекордной
частоты усиления по мощности (fmax = 135 ГГц) достигли сотрудники Mitsubishi в
транзисторе типа Si MOSFET, сформированном на подложке “кремний на изоляторе”
(SOI) и имеющем длину затвора 70 нм. Другой важной характеристикой транзистора
является частота отсечки fт (частота, на которой коэффициент усиления по току
становится равным единице), которая характеризует внутренние свойства
транзистора, в то время как частота fmax характеризует его работу в
радиочастотной/аналоговой или логической схеме. Резкого увеличения частоты
отсечки fт до 140 ГГц добились путём уменьшения длины затвора транзистора до 70
нм. Однако при этом частота fmax осталась на уровне 60 80 ГГц. Нынешнее
достижение сотрудников Mitsubishi приблизило MOSFET к рекордам
гетероструктурных SiGe-транзисторов: fт = 122 ГГц, fmax = 98 ГГц. Определяющим
фактором повышения fmax явилось снижение ёмкости исток-сток, ёмкости и
сопротивления затвора, что и было получено сотрудниками лаборатории
наноэлектроники Mitsubishi.
Толщина
слоя кремния в структуре SOI составляет 150 нм, заглублённого окисла - 400 нм,
толщина подзатворного термического окисла составляет 2 нм. По особой технологии
на SOI формируется затвор длиной 70 нм. В качестве материала затвора
используется силицид кобальта. По бокам затвор покрывается спейсерами, ширина
которых варьируется от 0 до 20 нм для оптимизации высокочастотных свойств
транзистора. Канал транзистора, расположенный под затвором, не легировался.
Исток и сток “подтягивались” к нему от электродов истока и стока за счёт
сильного легирования слоя кремния. Эта процедура выполнялась с помощью
низкоэнергетической имплантации, причём затвор и спейсеры служили при этом
масками, предохраняющими от попадания примеси в канал транзистора. Для
изготовления транзистора использовалась технология, позволяющая формировать его
геометрические размеры (длина канала ПТ до 0,18 мкм). Очень возможно, что на
снимке (рис. 37), полученном с помощью сканирующего электронного микроскопа,
представлен лучший в мире кремниевый полевой транзистор.

Рис.
37
Совершенствование
технологии кремниевых полевых транзисторов позволило фирме Intel на обычной
объёмной кремниевой подложке изготовить транзистор с хорошими параметрами,
имеющий длину затвора всего 30 нм. Считалось, что короткоканальные эффекты не
позволят это реализовать, поскольку при закрытом состоянии транзистора по
каналу течёт слишком большой ток из-за того, что области обеднения p
n-переходов смыкаются. Чтобы этого не происходило, надо использовать
мелкозалегающие p n-переходы, т.е. производить мелкое легирование, что и
сделали сотрудники корпорации Intel.
Другим
способом подавления короткоканальных эффектов является уменьшение подзатворного
слоя SiO2, но это приводит к увеличению туннельного тока в затворе транзистора.
Выход был найден в использовании материалов с высокой диэлектрической
проницаемостью e, тогда толщина подзатворного диэлектрика может быть
сделана гораздо большей. Cпециалистами Intel испытан и этот вариант, причём в
качестве подзатворного диэлектрика использовались оксиды типа ZrO2, HfO2 и SiO2
с равной эффективной толщиной. Лучшие высокочастотные параметры оказались у транзисторов
с HfO2, длина затвора которых составляла 0,1 мкм, а ширина 7 мкм: ft = 83 ГГц,
fmax = 35 ГГц (NMOS) и fт = =41 ГГц, fmax = 25 ГГц (NMOS). Сравнивая эти
параметры с описанными выше, можно понять, что это далеко не наилучшие
показатели в области микроволновых транзисторов.
Указанные
конструкторско-технологические приёмы испытаны и фирмой IBM, которая, кроме
развития традиционных технологий, выполнила исследования и совершенно новых
структур, например использовала в качестве диэлектрика такие материалы, как
HfO2, Al2O3, HfO2/Al2O3, ZrO2, AlNy(Ox). Результаты исследований подтверждают,
что наличие большого числа заряженных поверхностных ловушек и есть главное
препятствие к внедрению материалов с высокой диэлектрической проницаемостью e в технологию.
Усовершенствован
и транзистор FinFET, использующий в качестве канала узкий брусок Si диаметром
порядка 10 нм. Длина такого затвора может быть 10 нм и меньше (University of California, Berkeley).
В настоящее время усилия лабораторий университетов Калифорнии и Беркели
направлены на формирование нескольких каналов (брусков), что обеспечивает
требуемую величину тока транзистора в открытом состоянии. Достоинством такого
транзистора является то, что в нём затвор огибает с трёх сторон канал
транзистора, за счёт чего улучшается управление проводимостью канала с помощью
напряжения на затворе. Однако реальная подвижность носителей в канале
транзистора из-за их рассеяния на шероховатостях бруска (fin), формируемого
травлением, значительно снижена.
5. Приборы на основе квантово-размерных эффектов
Появлению
квантовой механики способствовали результаты экспериментов, согласно которым
поток элементарных частиц (например, электронов) проявлял типично волновые
свойства, такие как интерференция и дифракция. Это позволило рассматривать
поток частиц с импульсами р как некоторую плоскую волну, длина которой  (называемая длиной волны де Бройля), как показало
подробное исследование этого вопроса, связана с р соотношением
(называемая длиной волны де Бройля), как показало
подробное исследование этого вопроса, связана с р соотношением
lдБ = h/p,
где
h = 6,626Ч1034 ДжЧс постоянная Планка. (Проще всего убедиться
в справедливости соотношения, приравнивая энергии в квантовом  и в корпускулярном
и в корпускулярном  представлениях).
Волновая функция
представлениях).
Волновая функция  микрочастицы имеет тот физический смысл, что
микрочастицы имеет тот физический смысл, что  есть вероятность обнаружения частицы в объёме dV,
т.е.
есть вероятность обнаружения частицы в объёме dV,
т.е.  - плотность вероятностного распределения частицы в
данной единице объёма пространства. Распределение в пространстве волновой
функции
- плотность вероятностного распределения частицы в
данной единице объёма пространства. Распределение в пространстве волновой
функции  должно удовлетворять волновому уравнению, которое, по
аналогии с известным из курса «Теория поля» волновым уравнением для
напряжённости электрического поля электромагнитной волны Е
должно удовлетворять волновому уравнению, которое, по
аналогии с известным из курса «Теория поля» волновым уравнением для
напряжённости электрического поля электромагнитной волны Е  , будет иметь вид
, будет иметь вид
 ,
,
где
к волновой вектор, а импульс р связан с массой частицы m и её кинетической
энергией  (W полная энергия частицы, V(x,y,z) - её
потенциальная энергия) очевидным соотношением А = р2/2m. Уравнение, записанное
в виде
(W полная энергия частицы, V(x,y,z) - её
потенциальная энергия) очевидным соотношением А = р2/2m. Уравнение, записанное
в виде

называется
уравнением Шредингера. Если частица имеет полную энергию W, то найденная из
решения с заданными граничными условиями функция  должна
еще иметь обычный временной множитель ej2pnt = ej2pWt/h.
должна
еще иметь обычный временной множитель ej2pnt = ej2pWt/h.
Рассмотрим
решение уравнения для случая, когда электрон с энергией W встречает на своём
пути потенциальный порог (такой порог создается, например, с помощью плоского
конденсатора из сеток, между которыми создано тормозящее электроны поле и
которые очень близко расположены одна от другой). В дальнейшем мы будем
рассматривать случай, когда W зависит только от одной координаты х, т.е. будем
рассматривать «одномерные частицы» (рис. 38, а), когда  . При этом решение уравнения будет в случае V0 > W
для области х<0 иметь вид суммы двух волн (падающей и отражённой):
. При этом решение уравнения будет в случае V0 > W
для области х<0 иметь вид суммы двух волн (падающей и отражённой):
а
для области х > 0 - в виде только падающей слева направо затухающей волны:
 .
.


а) б)
Рис. 38
Из
условия равенства функций  при х = 0 (условие отсутствия разрыва функции) и
условия равенства их производных
при х = 0 (условие отсутствия разрыва функции) и
условия равенства их производных  (условие
отсутствия излома суммарной функции) получим
(условие
отсутствия излома суммарной функции) получим

Из
следует, что коэффициент отражения волны R =½y2/y1½2 =
=1, т.е. волна-частица, полностью отражается от потенциального порога при W
< V0, что совпадает с обычными классическими представлениями об отражении в
механике макромира, причём в квантовом решении при х < 0 падающие и
отраженные волны образуют стоячую волну (рис. 38, б). Кроме того, в отличие от
классических представлений здесь, согласно, при х > 0  , т.е. имеет место частичное проникновение электрона
за потенциальный барьер.
, т.е. имеет место частичное проникновение электрона
за потенциальный барьер.
Аналогичным
образом можно на основе решения уравнения рассмотреть с волновых позиций
поведение потока электронов, падающих на потенциальный барьер (рис. 39) или
находящихся в потенциальной яме (рис. 40).
Рассмотрение
первого случая показывает, что при этом падающая слева направо волна отразится
от барьера не полностью и что имеется определённая вероятность обнаружить
электроны за потенциальным барьером, т.е. в области III, причём уже из легко
определить, что если в этой области  , то эта
вероятность пропорциональна величине
, то эта
вероятность пропорциональна величине
 ,
,
где
d - ширина барьера. Этот чисто квантовый эффект проникновения частиц сквозь
потенциальный барьер при энергии частиц W, меньшей высоты барьера V0,
называется туннельным эффектом. Он часто проявляет себя в различных процессах,
изучаемых электроникой и ядерной физикой, и находит широкое применение в
микроволновой электронике.


Рис. 39 Рис. 40
Решение уравнения для случая потенциальной ямы показывает, что частица в
яме может иметь лишь строго определённый набор значений энергий W = Wn, при
которых яма шириной а оказывается резонатором для волновой функции y. Этот эффект квантования энергии в
потенциальной яме определённых размеров, близких к величине lдБ, называется размерным квантовым
эффектом.
В случае бесконечно глубокой потенциальной ямы шириной а (рис. 41)
решение уравнения с нулевыми граничными условиями выражается в виде синусоид и
показывает, что разрешённые уровни энергии W = Wn в такой яме определяются
выражением

Вид
функций y при разных n показан пунктиром на рис. 41. Он
характеризует эффект квантования энергетических уровней.
Если
яма будет конечной глубины, то разрешённых уровней в ней будет ограниченно
малое количество. Следует отметить, что решение уравнения для случая
потенциальной ямы, образованной для электронов положительным зарядом (ядром
атома), дает серию энергетических уровней Wn, переходы между которыми
соответствуют квантам излучения или поглощения, теоретические величины энергий
которых кратны  и хорошо совпадает с результатами многочисленных
опытов, что в свое время и послужило признанию квантовой физики.
и хорошо совпадает с результатами многочисленных
опытов, что в свое время и послужило признанию квантовой физики.

Рис.
41
На
рис. 41 видно, что размер а ямы должен быть по порядку его величины близким к
длине волны де Бройля lдБ, которая при
комнатной температуре в полупроводниках составляет 108 м »» 10 нм. Современная
технология полупроводников позволяет создавать, используя полупроводники с
разной шириной запрещённой зоны, слоистые структуры с такой толщиной слоев,
т.е. позволяет создавать квантовые ямы и барьеры.
Если
рассмотреть структуру с периодически повторяющимися барьерами и ямами,
называемую сверхрешёткой, то мы получим аналог обычного кристалла, в котором
потенциальные ямы атомов соединяются, что приводит к расплыванию отдельных
разрешённых энергетических уровней электронов в атоме и превращению их в зоны
разрешённых значений энергии, между которыми расположены зоны запрещённых
значений энергии. Но в отличие от кристалла, в котором атомы расположены
достаточно близко, вследствие чего разрешённые зоны получаются достаточно
широкими, в сверхрешётке расстояние между соседними ямами обычно бывает большим
и разрешённые зоны на один-два порядка уже, чем в кристалле. Поэтому их
называют минизонами (рис. 42).
Основным
структурным элементом СВЧ-приборов на основе размерных квантовых эффектов
является двойной потенциальный барьер с квантовой ямой посередине, получивший
название резонансного туннельного диода (РТД).

Рис.
42
Рассмотрим
структуру зоны проводимости такого диода (рис. 43,а), образованного двумя
барьерами широкозонного полупроводника (обычно AlGaAs) и
расположенной между ними потенциальной ямой (обычно GaAs), причём по бокам от
барьеров имеется высоколегированный (вырожденный) донорный полупроводник
(обычно n+-GaAs), у которого уровень Ферми WF лежит ниже первого (нижнего)
резонансного уровня W1 потенциальной ямы, а дно зоны проводимости находится на
уровне W0.

а) б)
Рис. 43
При приложении к такой структуре разности потенциалов U (плюс справа) дно
зон проводимости и все уровни двухбарьерной структуры искривляются и опускаются
справа вниз (рис. 43, б), причём когда уровень WF слева расположится против
уровня W1 ямы, появится возможность у электронов левого n+-полупроводника
туннелировать на резонансный уровень W1 ямы, а оттуда через правый барьер - в
правый n+-полупроводник.
При этом через РТД потечёт ток, который будет расти с увеличением U, а
затем уменьшаться практически до тех пор, пока на уровне W1 ямы не окажется дно
зоны проводимости W0 левого n+-полупроводника. После этого, так как слева уже
нет электронов, энергия которых удовлетворяла бы условию резонансного
туннелирования через яму, ток должен существенно уменьшиться. Но тут начинает
проявлять себя эффект обычного туннелирования через два потенциальных барьера
(рис. 43), и, кроме того, практически всегда при этом выполняется условие W2 =
WF резонанса для второго резонансного уровня ямы и ток вновь начинает
возрастать с ростом напряжения. Вольт-амперная характеристика РТД при этом
имеет вид, показанный на рис. 44.

Рис.
44
Этот
вид может существенно изменяться в зависимости от ширины барьеров, ямы и от
других конструктивных особенностей РТД. Так, в реальных РТД между барьерами и
n+-полупроводниками обычно помещаются тонкие нелегированные слои-спайсеры,
толщина которых влияет на ход ВАХ РТД. На рис. 45, а показана типичная
структура РТД, а на рис. 45, б дана зависимость отношения максимального тока,
обозначенного на ВАХ, к минимальному току от толщины b, включающей
толщины спайсеров и «паразитных» элементов самого РТД.
На
рис. 46 показана простейшая эквивалентная схема микроволнового автогенератора
на РТД, причём слева между точками а и б дана эквивалентная схема самого РТД,
где G - отрицательная проводимость, соответствующая падающему участку ВАХ; Cg
ёмкость, шунтирующая -G и определяемая структурой, расположенной между
участками n+-GaAs (см. рис. 45,а); rs и Ls сопротивление и индуктивность
подводящих участков (n+) РТД (Cg, rs и Ls «паразитные» элементы РТД; Rн и Lн
параметры нагрузки).
Инерционность
процесса туннелирования, т.е. время туннелирования, принято оценивать с помощью
известного из курса физики соотношения неопределённостей, согласно которому это
время (t) связано с шириной линии резонанса туннелирования  (как бы «толщиной» каждого из уровней W1, W2 и т.д.)
соотношением
(как бы «толщиной» каждого из уровней W1, W2 и т.д.)
соотношением  , где h - постоянная Планка.
, где h - постоянная Планка.

Рис. 45 Рис. 46
Такая
оценка показывает, что верхняя частотная граница РТД fверх » »1/t > 1012 Гц = 1 ТГц. Однако в
действительности инерционность устройств на основе РТД определяется
инерционностью элементов их схем, при этом максимальная частота генерации
автогенераторов на РТД равна  , т.е.
определяется произведением
, т.е.
определяется произведением  . По ряду
оценок эта частота в настоящее время достигает 200 ГГц.
. По ряду
оценок эта частота в настоящее время достигает 200 ГГц.
Двухбарьерная
структура РТД нашла применение в качестве составной части обычных биполярных и
полевых транзисторов и транзисторов на горячих электронах. Эта структура
находится либо в эмиттере, либо в базе БТ или либо в затворе, либо в истоке ПТ.
Это создает на выходных характеристиках БТ и ПТ соответствующие участки с
уменьшением тока при росте напряжения, что существенно расширяет функциональные
возможности БТ и ПТ.
Весьма
интересны и перспективны структуры, содержащие последовательное соединение
нескольких РТД, в частности сверхрешётки. Такие структуры имеют ВАХ, содержащие
несколько падающих участков тока вдоль оси напряжений, и могут найти широкое
применение как в качестве умножителей частоты в большое число раз, так и для
построения ряда логических элементов. Такие структуры также включаются в состав
БТ и ПТ с целью расширения функциональных возможностей последних.
Литература
1. Микроэлектронные устройства СВЧ/ Н.Т. Бова и др. Киев:
Техника, 1984.
. Червяков Г.Г., Кротов В.И. Полупроводниковая электроника:
Учеб. пособие. - М.: Уч-метод.издат.центр «Учебная литература», 2006.
с.
. Полищук А. Полупроводниковые приборы на основе карбида
кремния - настоящее и будущее силовой электроники // Силовая электроника. 2005.
№4.
. Данилин В., Жукова Т. Транзистор на GaN. Пока самый
"крепкий орешек"// Электроника: МТБ. 2005. №4. С. 20 29.
. Sabyasachi Nayak, Ming-Yh Kaoet al. 0.15 мт Power pHEMT Manufacturing Technology
for Ka- and Q- Band MMIC Power Amplifiers. - 2005 GaAs MANTECH Conf. Dig. Ppr.,
2005.
6. Майская В. SiGe-устройства. Нужная технология в нужное
время // Электроника: НТБ. 2001. № 1. С. 28 - 32.
. Шахнович И. Твердотельные СВЧ-приборы и технологии.
Невоспетые герои беспроводной революции //Электроника: НТБ. 2005. №4. С. 14.
. Шахнович И. Твердотельные СВЧ-приборы и технологии
//Электроника: Наука, Технология, Бизнес. 2005. № 5.
. www.gaasmantech.org. Материалы конференций GaAs MANTech.
. НПП "Исток" развивает технологии твердотельной
СВЧ-электроники. Интервью с С.И.Ребровым // Электроника: НТБ. 2005. №4. С. 8
11.
. E. Kohn, M. Schwitters et al. Diamond-MESFETs Synthesis and
Integration. 2nd EMRS DTC Technical Conference, Edinburgh 2005 (www.emrsdtc.c
om/conferences/2005/downloads//pdf/A26.pdf).
12. Валентинова М. Экзотическая память // Электроника: Наука,
Технология, Бизнес. 2001. №6. С. 24 - 29.
. Лебедев И.В. Техника и приборы сверхвысоких частот. Т. 1,
2. М.: Высш. шк. 1972.
. Электронные, квантовые приборы и микроэлектроника/ Под ред.
проф. Н.Д. Фёдорова М.: Радио и связь, 1998.
. Березин В.М., Буряк В.С. Электронные приборы СВЧ. М.:
Высш. шк. 1985.