Применение нанокластеров в оптоэлектронике. Фотоприемники и солнечные элементы
МИНОБРНАУКИ РОССИИ
Государственное образовательное
учреждение высшего профессионального образования
“Ярославский государственный
университет им. П.Г. Демидова”
Кафедра нанотехнологий в электронике
Выпускная квалификационная работа
бакалавра
Применение нанокластеров в
оптоэлектронике. Фотоприемники и солнечные элементы
Научный руководитель
к.ф.-м.н., доцент,
С.А. Кривелевич
Студент группы ЭН-41 БО
К.Д. Шубин
Ярославль, 2014 г.
Реферат
НАНОКЛАСТЕРЫ, КЛАСТЕРООБРАЗОВАНИЯ, ВЕНТИЛЬНАЯ ФОТОЭДС, ЭЛЕМЕНТЫ
ОПТОЭЛЕКТРОНИКИ, ИМПЛАНТАЦИЯ БОРА И КИСЛОРОДА, КРЕМНИЙ
Цель работы - обработка экспериментальных данных и построение
спектральных характеристик вентильной фотоэдс, структур содержащих ансамбли
нанокластеров.
В процессе работы был рассмотрен новый подход к управлению свойствами
полупроводниковых материалов, основанный на формировании в полупроводниковой
матрице наноразмерных кластеров.
При исследовании спектральных характеристик вентильной фотоэдс, структур
содержащих ансамбли нанокластеров, полученных экспериментально, была учтена
спектральная характеристика приборной функции монохроматора.
В результате изучения было наглядно показано, что применение
нанокластеров в оптоэлектронике, делает возможным создание фотоприемников и
солнечных элементов на основе кремния.
Работа выполнена на оборудовании Центра коллективного пользования научным
оборудованием “Диагностики микро- и наноструктур” при финансовой поддержке
Министерства образования и науки РФ.
Содержание
Введение
. Нанокластеры и их энергетическое состояние
. Методы исследования структур с нанокластерами
.1 Сканирующая зондовая микроскопия
2.2 Электронная оже-спектроскопия и растровая электронная
микроскопия
.3 Локальный анализ нанокластеров методом растровой
оже-микроскопии
. Влияние нанокластеров на свойства полупроводниковых
материалов
3.1 ”Захороненные” барьеры Шоттки
.2 Кластер, как участок кристаллической решетки, обработанный
пассивирующим веществом
4. Формирование ансамблей боросиликатных нанокластеров в
кремниевой матрице
4.1 Имплантация в кремний ионов кислорода и бора
.2 Изучение оптических свойства полученных структур
Заключение
Список используемой литературы
Приложение А
Приложение Б
Приложение В
Введение
Основные подходы управления свойствами полупроводниковых материалов
представляют собой использование процессов легирования их примесями для
создания определенной системы электронных уровней в запрещенной зоне. Решение
данной задачи состоит в подборе соответствующей легирующей примеси, обладающей
необходимыми свойствами. Однако в ряде случаев традиционный подход к управлению
свойствами полупроводниковых материалов наталкивается на принципиальные
ограничения:
- отсутствием в природе примесей, обладающих подходящими
свойствами;
- низкий предел растворимости атомов примесей в кристаллической
решетке полупроводника;
- высокая концентрация электрически активных собственных
дефектов решетки в легированном материале.
Новый подход к управлению свойствами полупроводниковых материалов основан
на формировании в полупроводниковой матрице наноразмерных кластеров.
Под понятием нанокластер (с английского cluster - скопление) понимают
объединение нескольких однородных элементов, которое может рассматриваться как
самостоятельная единица, обладающая своими характерными свойствами.
Движущей силой образования кластера, в общем случае, является стремление
системы к состоянию с минимальной свободной энергией.
В современной наноэлектронике в качестве основного материала преобладает
кремний, но в оптоэлектронике одним только этим материалом обойтись не удается.
На каждый спектральный диапазон оптического излучения требуется полупроводник с
соответствующей шириной запрещенной зоны. А стоимость большинства таких
полупроводников довольно велика.
Одним из вариантов решения этой задачи, как раз, является введение в кремниевую
матрицу нанокластеров, ширина запрещенной зоны, которых отличается от ширины
запрещенной зоны кремния.
Например, введение в кремниевую матрицу нанокластеров с шириной
запрещенной зоны большей, чем ширина запрещенной кремния, должно приводить к
увеличению эффективной оптической ширины запрещенной синтезируемого материала.
Это объясняется тем, что ведение в кремний одного такого нанокластера
эквивалентно образованию в валентной зоне потенциальной ямы, в которой из-за
размерного квантования должны возникать дополнительные уровни энергии.
В данной работе приведены основные результаты, касающиеся природы
нанокластеров и процессов их образования. В частности рассмотрены процессы
формирования ансамблей боросиликатных нанокластеров в кремниевой матрице.
1. Нанокластеры и их энергетическое состояние
нанокластер
полупроводниковый спектроскопия оптоэлектроника
Основные подходы управления свойствами полупроводниковых материалов
представляют собой использование процессов легирования их примесями, создание
определенных электронных уровней в запрещенной зоне. Решение данной задачи
состоит в подборе соответствующей легирующей примеси, обладающей необходимыми
свойствами. Однако в некотором ряде случаев традиционный подход к управлению
свойствами полупроводниковых материалов наталкивается на принципиальные
ограничения:
- отсутствием в природе примесей, обладающих подходящими
свойствами;
- низкий предел растворимости атомов примесей в кристаллической
решетке полупроводника;
- высокая концентрация электрически активных собственных
дефектов решетки в легированном материале.
Таким образов появился новый подход к управлению свойствами
полупроводниковых материалов, основанный на формировании в полупроводниковой
матрице наноразмерных кластеров, в состав которых могут входить атомы вводимых
примесей, атомы собственных компонентов и собственные точечные дефекты
кристаллической решетки.
Нанокластером или атомным кластером называется атомное образование,
вызывающее изменение энергетического состояния входящих в его состав компонентов
и их влияние на свойства полупроводниковой матрицы при сохранении неизменным
фазового состояния основного вещества.
В отличие от кластеров, формирующихся в газовой или жидкой фазах, в
данном случае образование кластера протекает в кристаллической решетке
полупроводника. Решетка играет роль матрицы, оказывающей существенное влияние
на все стадии образования кластеров, а также на свойства конечного продукта.
Движущей силой образования кластера, в общем случае, является стремление
системы к состоянию с минимальной свободной энергией. В реальных объектах
равновесное состояние многокомпонентной системы в силу энергетических или
кинетических ограничений достигается далеко не всегда и поэтому, в большинстве
случаев, мы имеем дело с метастабильными образованиями, которые, тем не менее,
могут обладать значительной устойчивостью и в значительной мере влиять на
свойства полупроводникового материала. [1]
В общем случае изменение свободной энергии системы при
кластерообразовании в кристаллической решетке полупроводника можно записать в
виде
∆F = −∆Fv+ ∆Fs+ ∆Fel, (1)
где ∆Fv - изменение
свободной энергии в результате перехода системы в более выгодное энергетическое
состояние, ∆Fs - изменение
свободной энергии, обусловленное формирование поверхности кластера, ∆Eel - изменение свободной энергии из-за
упругой деформации кластера и окружающей матрицы. [1]
Вклад поверхности в изменение свободной энергии системы наиболее
значителен для кластеров малого размера. Влияние упругой деформации возрастает
по мере увеличения размера кластера. Строгие количественные оценки названных
величин затруднены, ибо для этого необходимо построение точной модели кластера.
[1]
В простейших случаях возможно получение количественных результатов.
Например, в случае образования кластеров собственных межузельных атомов (Sii) в кристаллической решетке кремния
из-за пересыщения соответствующего твердого раствора разумно предположить, что
избыточные атомы Sii занимают
несколько соседних междоузлий и связаны между собой как регулярные атомы
решетки. В связи с тем, что междоузлия в решетке кремния образуют, аналогично
регулярным атомам в узлах, алмазоподобную сетку, формирующийся кластер можно
рассматривать как маленький кремниевый ”кристалл”, помещенный в кристаллическую
решетку основного кристалла. [1]
В связи с достаточно большими размерами междоузлий в кристаллической
решетке кремния, вкладом энергии упругой деформации в изменение свободной
энергии системы в данном случае можно пренебречь. Увеличение свободной энергии
кристалла с кластером (по сравнению с совершенным кристаллом, содержащим
аналогичное количество атомов) обусловлено только ненасыщенными (разорванными)
связями периферийных атомов кластера, которые связаны с кластером лишь
частично, ибо нормальная связь обеспечивается четырьмя соседями. Изменение
свободной энергии, обусловленное образованием кластера из n межузельных атомов
∆F(n) = −fvn + fsm, (2)
где
fv= kT log(Ci/
 ) -
изменение свободной энергии, обусловленное пересыщением (движущая сила
кластерообразования), m - количество разорванных связей, fs -
избыточная свободная энергия в расчете на одну разорванную связь, поддающаяся
достаточно строгой количественной оценке.[1]
) -
изменение свободной энергии, обусловленное пересыщением (движущая сила
кластерообразования), m - количество разорванных связей, fs -
избыточная свободная энергия в расчете на одну разорванную связь, поддающаяся
достаточно строгой количественной оценке.[1]
На рис.1 и рис.2 изображены схемы простейших унитарных (состоящих из
одинаковых элементов) и бинарных (состоящих из разноименных элементов)
кластеров.

Рис.1 Схемы простейших унитарных кластеров [2]

Рис.2 Схемы простейших бинарных кластеров [2]
Процессы, позволяющие формировать нанокластеры, их имплантация в аморфную
и кристаллическую матрицу существенное влияют на фундаментальные свойства
получаемых материалов, изменяя ширину запрещенной зоны, проводимость и др.
Именно нанокластеры образуют квантовые элементы, которые составляют сложные
цепи и ансамбли в современных электронных приборах.
2. Методы исследования структур с нанокластерами
Интенсивность развития в последние годы наноэлектроники, позволила
создать приборы, размеры элементов которых составляют несколько единиц
нанометров. Наряду с достижениями в технологии изготовления происходит
совершенствование методов исследования структур, содержащих ансамбли
нанокластеров.
2.1 Сканирующая зондовая микроскопия
Для исследования геометрических характеристик успешно применяют методы
сканирующей зондовой микроскопии.
На рис.3 показан общий принцип организации обратной связи сканирующего
зондового микроскопа.
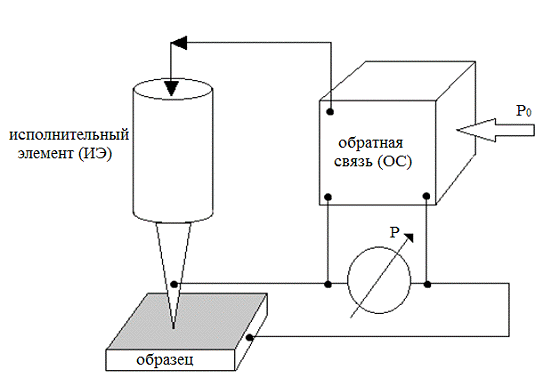
Рис.3 Схема организации системы обратной связи сканирующего зондового
микроскопа
В сканирующих зондовых микроскопах исследование рельефа поверхности
производится с помощью специальных зондов, имеющих вид игл. Рабочей частью
зондов является острие, размеры которого достигают порядка десяти нанометров.
Расстояние между зондом и поверхностью образца составляет от 0,1 до 10 нм. В
основе работы зондовых микроскопов лежат различные типы взаимодействия зонда с
поверхностью, туннельный микроскоп основан на явлении протекания туннельного
тока между иглой и образцом; различные типы силового взаимодействия лежат в
основе работы атомно-силового, магнитно-силового и электросилового микроскопов.
Существуют общие черты, присущие различным зондовым микроскопам. Пусть
взаимодействие зонда с поверхностью характеризуется некоторым параметром Р.
Если существует достаточно резкая и взаимно однозначная зависимость параметра Р
от расстояния от зонда до поверхности образца Р = Р(z), то данный параметр
может быть использован для создания системы обратной связи, которая
контролирует расстояние между зондом и образцом.
Система обратной связи поддерживает значение параметра Р постоянным,
равным Р0, задаваемым оператором. Если расстояние между зондом и поверхностью
изменяется, то параллельно происходит изменение параметра Р. В системе обратной
связи формируется разностный сигнал, пропорциональный величине ∆P = P -
P0 , который усиливается до нужной величины и подается на исполнительный
элемент. Исполнительный элемент изменяет расстояние между зондом и поверхностью
образца до тех пор, пока разностный сигнал не станет равным нулю. В
существующих сканирующих зондовых микроскопах точность удержания расстояния
между зондом и поверхностью достигает ~ 0.01 Å. При перемещении зонда вдоль
поверхности происходит изменение параметра взаимодействия Р, обусловленное ее
рельефом. Система обратной связи обрабатывает эти изменения, так что при
перемещении зонда в плоскости X,Y сигнал на исполнительном элементе оказывается
пропорциональным рельефу поверхности. Для получения СЗМ изображения при
сканировании зонд вначале движется над образцом вдоль определенной линии при
этом величина сигнала на исполнительном элементе, пропорциональная рельефу
поверхности образца, записывается в память компьютера, такую операцию называют
строчной разверткой. Затем зонд возвращается в начальную точку, и переходят на
следующую строку сканирования, так называемая кадровая развертка, и процесс повторяется.
Записанный таким образом при сканировании сигнал обратной связи обрабатывается
компьютером, и после всего этого СЗМ изображение рельефа поверхности строится с
помощью средств компьютерной графики.
2.2 Электронная оже-спектроскопия и растровая электронная микроскопия
Для исследования элементного состава наноструктур применяют оценку
результатов измерений методами рентгеновской дифракции, рамановского рассеяния
и электронной оже-спектроскопии. Основной недостаток этих методов -
невозможность получения достоверной информации о химическом составе отдельных
нанообъектов.
Одним из способов решения данной проблемы может быть комбинация методов
электронной оже-спектроскопии, которая основана на измерении энергетического
спектра электронов, испускаемых с поверхности твердого тела под действием тех
или иных возбуждающих факторов. В данном случае используется пучок электронов,
называемый с энергией от 1 до 25 кэВ, и растровой электронной микроскопии,
такому способу анализа нанообъектов дали свое название растровая
оже-микроскопия.
В 1935 году Кнолем была выдвинута новая идея построения электронного
микроскопа - растровый электронный микроскоп. Согласно его идее изображение
исследуемого образца формируется последовательно по точкам и является
результатом взаимодействия электронного пучка с поверхностью. Каждая точка
образца последовательно облучается электронным пучком, который перемещается по
поверхности. При взаимодействии зонда с поверхностью возникают ответные
сигналы, которые используются для синхронного построения изображения.

Рис.4 Схема образования вторичных сигналов при взаимодействии электронов
зонда с веществом мишени [4]
На рис.4 представлена схема образования вторичных сигналов под влиянием
электронного зонда. Для формирования изображения не используется
электронно-оптическая система. Изменение масштабов изображения осуществляется
радиотехническими средствами.[4]
Растровый электронный микроскоп является вакуумным прибором, это связано
с улучшением фокусировки электронного пучка. На рис.5 приведена схема основных
узлов растрового электронного микроскопа. Электронный пучок от источника
электронов формируется в виде сфокусированного зонда и проходит через систему
управляющих электродов или электромагнитов, которые перемещают пучок электронов
по поверхности образца по траектории, образующей растр.
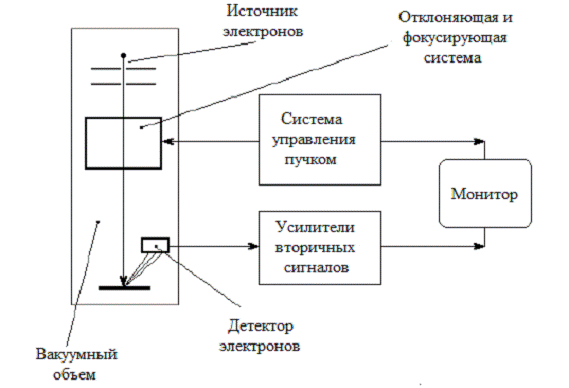
Рис.5 Упрощенная схема, иллюстрирующая работу растрового электронного
микроскопа [4]
Перемещение зонда происходит с очень высокой точностью и в конечном
счете, наряду с его размером, определяется величину разрешения микроскопа. В
результате взаимодействия пучка электронов и поверхности исследуемого образца
возникает ответный сигнал, который регистрируется соответствующими датчиками. Регистрируемый
сигнал используется для модуляции яркости пучка в электронно-лучевой трубке
монитора. Величина этого вторичного сигнала зависит от физических свойств
образца и может меняться от точки к точке. В результате на экране монитора
появляется изображение поверхности исследуемого образца, отображающее
топографию физических свойств исследуемого объекта.
Коэффициент увеличения изображения в растровом электронном микроскопе
определяется отношением линейных размеров растра, освещаемого зондом, на
поверхности образца d и на экране монитора D, т.е. M = D / d .[4]
Разрешение растрового электронного микроскопа ограничено размером области
на поверхности исследуемого образца, возбуждаемой зондом. С другой стороны
величина тока электронного пучка, взаимодействующего с поверхностью, определяет
интенсивность вторичных сигналов. Поэтому электронно-оптическая система,
формирующая электронный зонд, должна обеспечивать получение максимального тока
при минимально размере зонда.
2.3 Локальный анализ нанокластеров методом растровой оже-микроскопии
Ярким примером эффективности применения комбинации методов электронной
оже-спектроскопии и растровой электронной микроскопии является исследование
наноструктуры GeSi/Si, которая получена методом самоорганизованного роста по
механизму Странского - Крастанова. Суть эффекта заключается в переходе от
двухмерного к трехмерному кластерообразованию вследствие рассогласования
параметров решеток выращиваемых слоев. Образцы выращивались двумя способами:
1. Сублимационная молекулярно-лучевая эпитаксия кремния в среде гермáна (GeH4). На подложке
высоколегированного бором кремния (n~1·1019 см-3) ориентации (111) выращивался
буферный слой кремния толщиной 500 нм, легированный бором (n~5·1018 см-3), а
затем слой германия номинальной толщиной 20 нм. Морфология поверхности
исследовалась методом атомно-силовой микроскопии (АСМ), изображение которой
приведена на рис.6. Наблюдались массивы островков с латеральными размерами 100
нм, высотой 20 нм и поверхностной плотностью 7·108 см-3 и островки с большим
числом дислокаций с латеральными размерами 900 нм, высотой 100 нм и
поверхностной плотностью 2·107 см-3. [5]
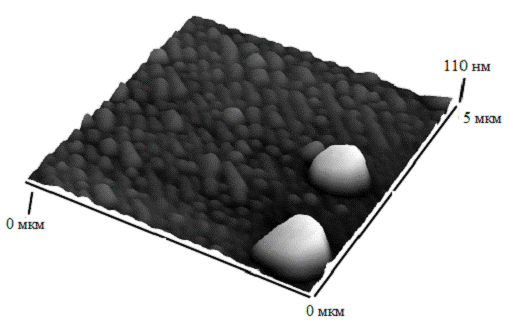
Рис.6 АСМ-изображение GeSi/Si гетероструктур: сублимационная
молекулярно-лучевая эпитаксия [5]
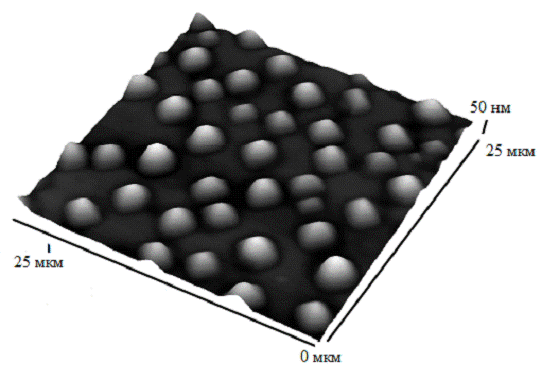
Рис.7 АСМ-изображение GeSi/Si гетероструктур: молекулярно-лучевая
эпитаксия [5]
2. Молекулярно-лучевая эпитаксия. На подложке высоколегированного
мышьяком кремния (n~1·1018 см-3) ориентации (001) выращивался буферный слой
кремния толщиной 100 нм, легированный бором (n~5·1018см-3), а затем слой
германия номинальной толщиной 1,4 нм. АСМ позволяет выявить на поверхности
наличие массивов однородных островков с латеральными размерами 300 нм, высотой
40 нм и поверхностной плотностью 5·108 см-2, смотрите рис.7. [5]
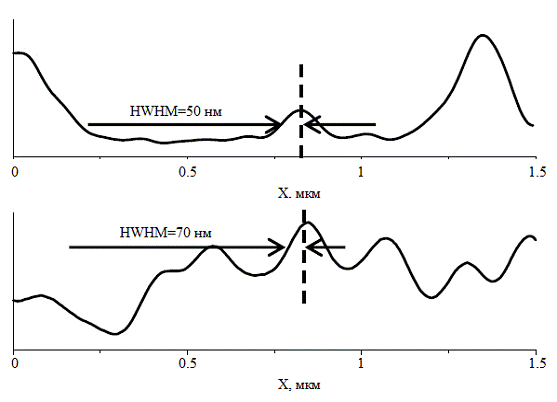
Рис.8 Профиль интенсивности излучения вторичных электронов в режиме РЭМ и
профиль интенсивности оже-линии германия в режиме РОМ [5]
При исследовании полупроводниковых объектов комбинацией методов
электронной оже-спектроскопии и растровой электронной микроскопии проявляется
эффект зарядки поверхности исследуемого образца, из-за чего происходит смещение
и дефокусировка зонда. Как следствие наличия заряда на поверхности, пространственное
разрешение на исследуемых структурах в 2−3 раза хуже, нежели при анализе
хорошо проводящих структур. При исследовании нанокластеров GeSi/Si разрешение в
режиме растровой электронной микроскопии (РЭМ) составило 50 нм, рис.9б, в
режиме растровой оже-микроскопии (РОМ) − 70 нм (рис.8). РОМ -
изображение, которое представлено на рис.9в, регистрировалось в пике. На рис.9а
приведена полученная АСМ-морфология исследуемой GeSi наноструктуры,
используемой для определения латерального разрешения электронной оже-спектроскопии
и растровой электронной микроскопии.
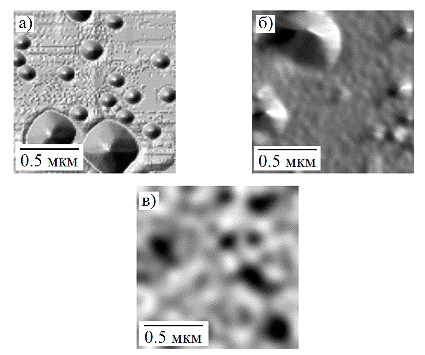
Рис.9 АСМ (а), РЭМ (б), РОМ (в) - изображения нанокластеров GeSi/Si [5]
На рис.10-11 представлено распределение концентрации Ge по глубине.

Рис.10 Распределение концентрации Ge по глубине в нанокластере (1) и между нанокластерами (2) для
образцов, полученных методом молекулярно-лучевой эпитаксии [5]
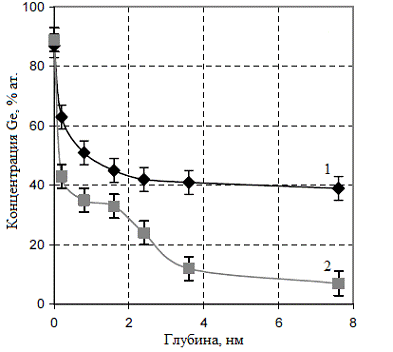
Рис.11 Распределение концентрации Ge по глубине в нанокластере (1) и между нанокластерами (2) для
образцов, полученных методом сублимационной молекулярно-лучевой эпитаксии [5]
Главным достижением является возможность проведения локального
элементного анализа самоорганизованных структур Ge-Si/Si методом растровой
оже-микроскопии.
3. Влияние нанокластеров на свойства полупроводниковых материалов
Если кластеры составляют основную часть материала, то изменения их
размеров и концентрации приводят к изменению фундаментальных свойств
полупроводника, таких как ширина запрещенной зоны, величина проводимости,
энергия фундаментальных оптических переходов и др.
Это открывает возможности для конструирования новых полупроводниковых
материалов, свойства которых могут значительно отличаться от свойств,
проявляемых тем же полупроводником в монокристаллическом или аморфном
состояниях.
.1 ”Захороненные” барьеры Шоттки
Интерес к полупроводниковым материалам с металлическими наноразмерными
включениями обусловлен их широкими возможностями с точки зрения
оптоэлектроники. Одним из примеров такого материала является арсенид галлия,
выращенный при пониженной температуре и содержащий нанокластеры мышьяка.
Известно, что при контакте металла с полупроводниковым материалом
образуется барьер Шоттки. Уровень Ферми данного полупроводника закрепляется на
гетерогранице в некоторой точке запрещенной зоны. В случае контакта большинства
известных металлов с арсенидом галлия, уровень Ферми закрепляется вблизи
середины запрещенной зоны и в материале, независимо от типа проводимости
возникают области обеднения. Ширина областей обеднения зависит от величины
проводимости самого полупроводника.
Поскольку мышьяк является полуметаллом, массив кластеров мышьяка в
арсениде галлия представляет собой систему из большого числа ”захороненных”
барьеров Шоттки, каждый из которых окружен областью обеднения, эта ситуация
проиллюстрирована на рис.12. При не высоких уровнях легирования матрицы
полупроводника размер области обеднения значительно больше собственного размера
кластера. При достаточно высокой концентрации кластеров, создаваемые ими
локальные области обеднения, перекрываются и распространяются на весь объем
полупроводникового материала, как показано на рис.12б. В результате матрица
арсенида галлия приобретает полуизолирующие свойства. Кроме того, высокая
концентрация кластеров и наличие встроенных электрических полей способствуют
быстрому захвату и рекомбинации неравновесных носителей заряда в
полупроводнике. Времена жизни носителей заряда в арсениде галлия, содержащем
кластеры мышьяка, составляют менее 1 пс.
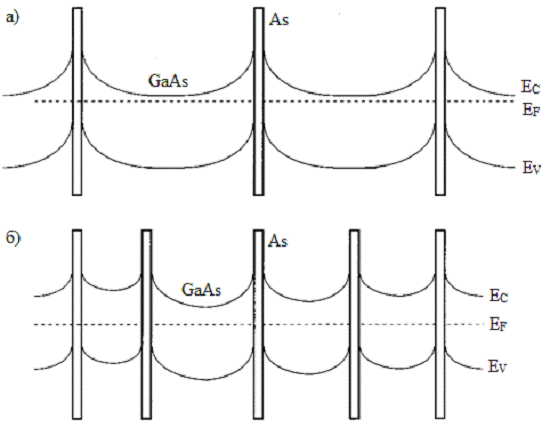
Рис.12 Модель ”захороненных” барьеров Шоттки, формируемых кластерами As в матрице GaAs n-типа. a -
низкая концентрация кластеров, b -
высокая концентрация кластеров.[1]
Большое удельное сопротивление и, рекордно малое временя жизни носителей
заряда и высоким структурным совершенством делают арсенид галлия, содержащий в
своей матрице кластеры мышьяка, чрезвычайно привлекательным для различных
применений в полупроводниковой электронике, среди которых можно отметить
фотоприемники с временем отклика 1 пс.
Арсенид галлия в современной электронике и оптоэлектронике является
лидером среди всех полупроводниковых материалов, но с течением времени интерес
к созданию новых структур на основе кремния с необходимыми свойствами не
угасает и изучения в данном направлении прогрессируют и показывают достойные
результаты.
.2 Кластер, как участок кристаллической решетки, обработанный
пассивирующим веществом
Основным материалом современной электроники является кремний, элемент четвертой
группы под номером четырнадцать, после кислорода является самым
распространенным в природе, что снижает стоимость проборов создаваемых на его
основе, но в оптоэлектронике одним только этим материалом обойтись не удается.
В своем обычном состоянии кремний обладает очень низкой излучательной
способностью в оптическом диапазоне и, несмотря на то, что он является самым
распространенным полупроводниковым материалом в изготовлении электронных
устройств, его нельзя применять для производства оптических устройств.
Объясняется это тем, что в отличие от таких материалов, как арсенид галлия,
ширина запрещенной зоны кремния по сравнению с ним слишком мала. Если бы
свойства кремния путем его модификации удалось приблизить к свойствам арсенида
галлия, то получился бы универсальный материал для создания всех
оптоэлектронных устройств.
Развивая данную идею, было обнаружено, что оптические свойства кремния
могут изменяться при оптическом возбуждении малого объема вещества, например
крупного кластера атомов кремния, который называется квантовой точкой.

Рис.13 а - Экспериментальные данные по зависимости оптической ширины
запрещенной зоны Еg от диаметра D
кремниевых кластеров, два набора экспериментальных данных соответствуют двум
разным методам оценки размеров кластеров, б - модель кластера Si575H276, белые
точки соответствуют атомам водорода, пассивирующим поверхность кластера [9]
Такие кластеры представляют собой участки кристаллической решетки,
обработанные пассивирующим веществом, в роле которого может выступать атомарный
водород. Зависимость ширины запрещенной зоны квантовой точки от ее размеров
представлена на рис.13а. Оптическое возбуждение квантовых точек сильно
усиливается. Этот эффект, называют квантовым удержанием, которое позволяет
достаточно близко приблизить оптические свойства кремния к свойствам арсенида
галлия. Например, энергия возбуждения кремниевых квантовых точек согласно
рис.13а составляет 2-2,5 эВ, что вдвое превышает оптическую ширину запрещенной
зоны кристаллического кремния и сравнимо с ее величиной для арсенида галлия,
которая составляет 1,5 эВ. Для оценки роли квантового удержания и интерпретации
экспериментальных данных оптическая ширина запрещенной зоны была рассчитана «из
первых принципов», без использования параметров. Удалось выполнить
моделирование достаточно больших систем, включая кластеры диаметром до 30
Å.
Наибольший из рассмотренных кластеров Si575H276, представленный на
рис.13б, содержит несколько тысяч электронов, и, следовательно, относительное
изменение его энергии при поглощении света мало по сравнению с полной энергией
электронов, что позволяет моделировать его поведение, учитывая только активные
электронные состояния. [9]
4. Формирование ансамблей боросиликатных нанокластеров в кремниевой матрице
Как говорилось ранее, применение кремния в оптических системах
ограничивается его физическими характеристиками. К таким характеристикам в
первую очередь относится ширина запрещенной зоны, определяющая оптический
диапазон частот. Применение же кремния в светоизлучающих приборах сдерживается
тем, что он является непрямозонным полупроводником. Поэтому задача создания
варизонных полупроводников и гетероструктур на основе кремния является
актуальной.
Одним из вариантов решения этой задачи является введение в кремниевую
матрицу нанокластеров, ширина запрещенной зоны которых отличается от ширины
запрещенной зоны кремния. Например, введение в кремниевую матрицу нанокластеров
с шириной запрещенной зоны большей, чем ширина запрещенной кремния, должно
приводить к увеличению эффективной оптической ширины запрещенной синтезируемого
материала. Это объясняется тем, что ведение в кремний одного такого
нанокластера эквивалентно образованию в валентной зоне потенциальной ямы, в
которой из-за размерного квантования должны возникать дополнительные уровни
энергии Eil, Положение этих уровней определяется
материалом нанокластера и его геометрическими размерами, рис.14.[14]
Хорошо известно, что с помощью имплантации кислорода в кремний можно
формировать КНИ структуры по методу SIMOX.
Суть метода ионно-лучевого синтеза (SIMOX) заключается в имплантации в кремний больших доз
ионов кислорода (1018 см) с энергией 20-200 кэВ с последующим длительным
высокотемпературным отжигом (1300 0С, свыше 4 часов). При этом на определенном
расстоянии от поверхности кремниевой пластины образуется (синтезируется) слой
окисла кремния толщиною 0,4-0,6 мкм, рис.15.

Рис.14 Зонная диаграмма кремния, содержащего «широкозонный» нанокластер
[14]
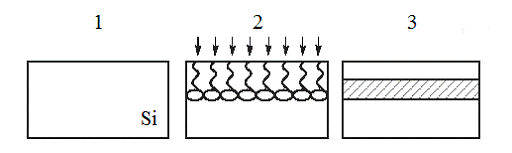
Рис.15 SIMOX-метод: 1 - исходная подложка
кремния; 2 - ионная имплантация кислорода; 3 - высокотемпературный синтез
(формирование КНИ-структуры) [23]
Поэтому, на первый взгляд, привлекательным материалом для формирования в
кремнии широкозонных нанокластеров является его диоксид. Однако проведенные
ранее исследования показали, что кластеры SiO2 не являются стабильными, по крайней мере, при
температурах термообработки 1000 - 1150°С. Однако, было показано также, что с помощью
последовательной имплантации в кремний атомов кислорода и бора возможно
формирование структур, содержащих скрытые силикатные слои. В этой связи в
настоящей работе исследовалась возможность управления эффективной шириной
запрещенной зоны с помощью имплантации в кремний ионов кислорода и бора.
4.1 Имплантация в кремний ионов кислорода и бора
При подготовке образцов имплантацию молекулярного кислорода О2+ проводили
в кремниевые пластины КЭФ- 4,5 (100) с энергией 300 кэВ. и дозами от 1·1017
см-2 до 4·1017 см-2 . После этого пластины отжигали при температуре 900°С в среде сухого кислорода в течение
5 минут. Затем проводили имплантацию бора при энергии ионов В+ 100 кэВ, доза
имплантации - 8·1016 см-2. Имплантированные пластины снова подвергали отжигу
при 900°С в среде сухого кислорода. Затем
проводили отжиги при температурах 1000 - 1050°С. Получаемые структуры, анализировались методом
электронной оже - спектроскопии. Перед проведением оже - анализа поверхность
образцов очищалась с помощью травления ионами аргона от материала контактов,
используемых при электрических измерениях. Послойный оже - анализ осуществляли
на установке PHI-660, которая представлена на рис.16.
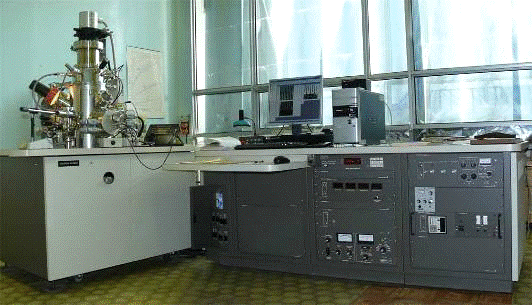
Рис.16 Установка PHI-660 [19]
Энергия пучка первичных электронов составляла 10 кэВ. Удаление слоев
проводилось с помощью пучка ионов азота N2+ c
энергией 9 кэВ. Измерялись интенсивности основных оже - пиков (KLL - для кислорода, LMM - для кремния). Полученные
результаты представлены на рис.17-19. [14]

Рис.17 Зависимость интенсивности основных оже - пиков кислорода и кремния
от глубины: 1 -кремний, 2 - кислород. Температура термообработки 1050°С, доза молекулярного кислорода
1,2·1017 см-2 [14]

Рис.18 Зависимость интенсивности основных оже - пиков кислорода и кремния
от глубины: 1 -кремний, 2 - кислород. Температура термообработки 1050°С, доза молекулярного кислорода
2·1017 см-2 [14]
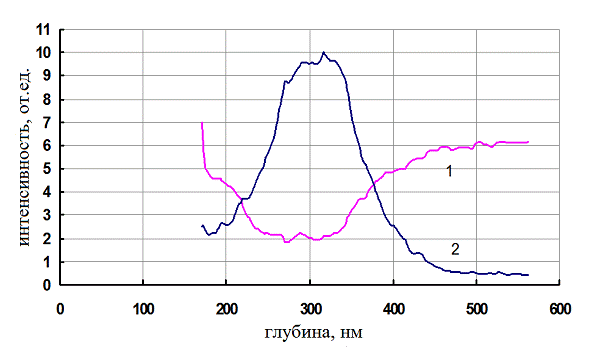
Рис.19 Зависимость интенсивности основных оже - пиков кислорода и кремния
от глубины: 1 -кремний, 2 - кислород. Температура термообработки 1050°С, доза молекулярного кислорода
3,4·1017 см-2 [14]

Рис.20 Установка Cameca IMS-4F [20]
Кроме того, контроль концентрационных распределений бора и кислорода для
образцов с дозой кислорода 3,4·1017 см-2 осуществляли методом ВИМС на установке
Cameca IMS-4F , рис.20. [14]
Вторичная ионная масс-спектрометрия (ВИМС) является одним из физических
методов исследования поверхности твердых тел. Анализ образца проводится в
условиях высокого вакуума. Образец бомбардируется пучком первичных ионов с
энергией 0.1 - 100 кэВ. Сталкиваясь с поверхностью, первичные ионы выбивают
вторичные частицы, часть из которых, обычно менее 5%, покидают поверхность в
ионизированном состоянии. Эти ионы фокусируются и попадают в масс-анализатор,
где они разделяются в соответствии с отношением их массы к заряду. Далее они
попадают на детектор, который фиксирует интенсивность тока вторичных ионов и
передает информацию на ЭВМ.
Методом ВИМС определяли также распределения бора для образцов с другими
дозами кислорода. Анализ распределений бора проводили с использованием пучка
ионов O2+ в качестве первичного. Энергия ионов в пучке была равна 9 кэВ.
Измеряли выход вторичных ионов 11B+ и
30Si+. Анализ концентрационных распределений кислорода проводили в режиме
регистрации отрицательных вторичных ионов. В качестве первичного использовали
пучок ионов Cs+. Ускоряющее напряжение составляло
7,5 кэВ, отрицательный потенциал на мишени был равен -4,5 кэВ. Регистрировались
вторичные ионы 16O- и 28Si-. Измерения показали, что
распределения бора практически не зависят от содержания кислорода в образце.
Это подтверждается и результатами моделирования с помощью программы TRIM. [14]
При интерпретации результатов оже - анализа необходимо было определить
коэффициенты чувствительности характерные для кислорода и кремния в силикатных
системах. Обычно при пересчете кривых интенсивностей в концентрационные распределения
используются стандартные коэффициенты чувствительности, определенные по
отношению к серебряному эталону. Однако, предварительные оценки показали, что
использование стандартных коэффициентов относительной чувствительности приводит
к ошибочным результатам. Одновременное использование ВИМС и оже - анализа
позволило уточнить значения коэффициентов. Пример полученных распределений
концентраций представлен на рис.21. [14]
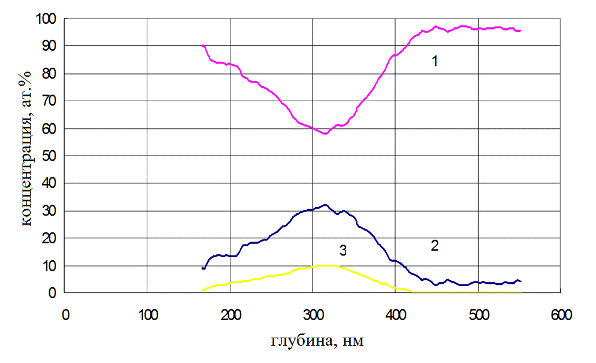
Рис.21 Распределения относительных концентраций атомов кислорода, бора и
кремния, полученные после термообработки при температуре 1050°С в течение 5 минут. 1- концентрация
атомов кремния, 2 - концентрация атомов кислорода, 3 - концентрация атомов
бора. Доза молекулярного кислорода 2·1017 см-2 [14]
Вообще, было обнаружено, что при термообработке образцов с дозой
молекулярного кислорода 3,4·1017 см-2 и больше формируется скрытый слой с
соотношением концентраций близким к стехиометрии диоксида кремния. При
обработке же образцов с меньшими дозами кислорода в системе образуются скрытые
слои с максимальным содержанием кислорода равным примерно 33 атомным процентам.
[14]
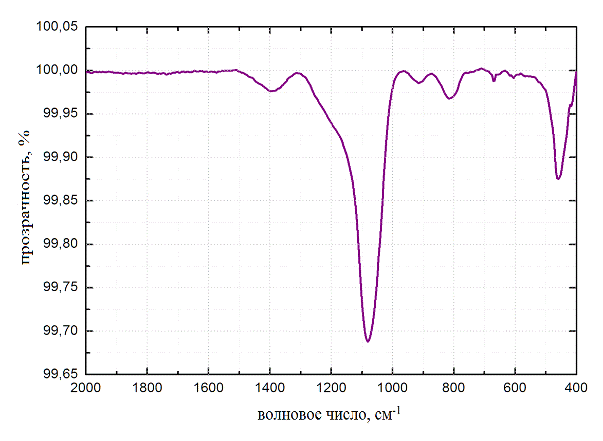
Рис.22 Инфракрасный спектр пропускания для образца с осажденной пленкой
боросиликатного стекла [14]
Получаемые структуры, изучали также методом ИК-спектроскопии. Измерения
ИК спектров поглощения проводились на Фурье-спектрометре IFS-113v при комнатной температуре в диапазоне волновых чисел 4000 -
400 см-1 с разрешением 4 см-1. Прибор IFS-113v является вакуумным, что позволяет
избавиться от характерных полос атмосферного поглощения в спектрах исследуемых
образцов. В качестве контрольных образцов использовали образцы кремния с
нанесенными на них пленками боросиликатного стекла. Пленки наносили методом центрифугирования
из растворов на основе тетраэтоксисилана и затем отжигали при температуре 1050°С. Содержание бора в пленках
соответствовало 9 масс. % в пересчете на борный ангидрид. Свидетельством
образования боросиликатного стекла является появление в спектрах ИК поглощения
полосы вблизи n=1400 см-1,
соответствующей валентным колебаниям B-O и полосы n=920 см-1, соответствующей связи B-O-Si [3]. Трем типам
мостиковых колебаний связей Si-O-Si соответствуют полосы поглощения: n=1100 см-1, n=810 см-1, n=455 см-1. Все эти полосы хорошо
видны на спектрах пропускания контрольных образцов, рис. 22. [14]
ИК - спектр пропускания для образца, имплантированного молекулярным
кислородом с дозой 2·1017 см-2, представлен на рис.23.

Рис.23 Инфракрасный спектр пропускания для образца, полученного в
результате ионной имплантации молекулярного кислорода (доза 2·1017 см-2), бора
и последующей термообработки [14]
Видно, что в этом спектре наблюдаются все основные полосы, характерные
для пленок боросиликатного стекла. Однако, полосы поглощения, соответствующие
мостиковым колебаниям связей Si-O-Si (n=1100
см, n=810 см-1, n=455 см-1) несколько уширены по
сравнению с контрольными образцами. Соотношение амплитуд этих полос также
отличается от соотношений амплитуд, наблюдавшихся для контрольных образцов.
Полосы, соответствующие валентным колебаниям B-O и связи B-O-Si выражены
слабее. Последнее обстоятельство, видимо, обусловлено более низким содержанием
бора в силикатных слоях, формируемых с помощью ионной имплантации, чем в
осажденных пленках боросиликатного стекла. [14]

Рис.24 Инфракрасный спектр пропускания для образца, полученного в
результате ионной имплантации молекулярного кислорода (доза 1,2·1017 см-2),
бора и последующей термообработки [14]
Уменьшение дозы имплантации молекулярного кислорода до 1,2·1017 см-2
привело к существенному искажению вида спектров пропускания, рис.24. Основная
полоса поглощения (n=1100
см-1) существенно уширилась и сместилась в область низких частот. Подобное
искажение спектра может быть обусловлено появлением значительного количества
немостикового кислорода. [14]
.2 Изучение оптических свойства полученных структур
На полученных структурах, были проведены измерения величины вентильной
фотоэдс в зависимости от длины волны падающего излучения.
Вентильная фотоэдс возникает в неоднородных по составу или неоднородно
легированных примесями полупроводниках, а также на контакте полупроводника с
металлом. В области неоднородности в полупроводнике существует внутреннее
электрическое поле, которое ускоряет генерируемые излучением неосновные и
замедляет основные неравновесные носители заряда. В результате фотоносители
разных знаков пространственно разделяются.[25]
Зависимость фотоэдс Uf, от
интенсивности освещения J0 описывается выражением вида:
 , (3)
, (3)
где
параметр g ~ 1 зависит от механизма рекомбинации, а параметр В(hν,Т) зависит от спектрального состава излучения и
температуры. Температурная зависимость В имеет вид:
 , (4)
, (4)
где
энергия активации Ea зависит от конкретного типа барьера.
Измерения
проводились с помощью монохроматора c дифракционной решеткой (МДР),
оптическая схема которого представлена на рис.25.
Источник
света 1 через конденсор 2 освещает входную щель 3. Поворотное зеркало 4 и
зеркальный сферический объектив 5, в фокальной плоскости которого расположена
входная щель, направляют параллельный пучок на дифракционную решётку 6, которая
может поворачиваться вокруг вертикальной оси с помощью шагового двигателя,
вырезая излучение в требуемом диапазоне длин волн. После дифракции параллельный
пучок лучей фокусируется зеркальным сферическим объективом 7 на входную щель. В
зависимости от положения поворотного зеркала 8 пучок света попадает на выходные
щели: либо на щель 9, либо на щель 10, за которыми могут находиться
фотоэлектронные умножители для разных диапазонов длин волн. В случае
необходимости использования одновременно обеих выходных щелей в пучок вводится
зеркало, срезанное по высоте. Для удаления высших порядков спектра, попадающих
в рабочую область спектра, служат светофильтры 11.[24]

Рис.25
Оптическая схема МДР
В
качестве контрольных использовались образцы кремния, имплантированного только
бором и отожженного при температуре 1050°С. Результаты
измерения фотоэдс представлен на рис.26.
Появление
в спектре двух максимумов обусловлено наложением спектральной зависимости
вентильной фотоэдс исследуемых образцов и приборной функции монохроматора.
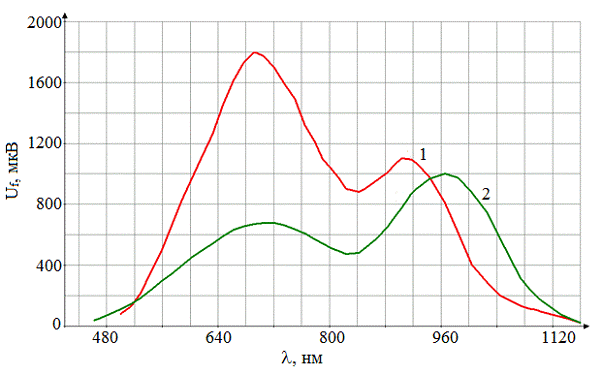
Рис.26 Спектральная зависимость вентильной фотоэдс. 1- образец,
легированный бором и кислородом . 2 - контрольный образец
Учет спектра приборной функции монохроматора, производился с
использованием спектральной зависимости лампы накаливания (Приложение А),
которая использовалась в данном эксперименте. Для каждого значения длины волны
было рассчитано соответствующее значение интенсивности, которая падала на
образец при его исследовании:

 (5)
(5)
где
b=830 нм -
ширина щели;
d·sin
 =m·λ, m=1;
=m·λ, m=1;
d=L/N=1668
нм - период решетки;
N=600 штрихов на
мм;
I0 -
интенсивность лампы накаливания.
Полученные
значения представлены в приложении Б.
После
были уточнены значения вентильной фотоэдс для обоих образцов с учетом
полученного спектра приборной функции монохроматора. Значения представлены в
приложении В.

Рис.27 Спектральная характеристика вентильной фотоэдс контрольного
образца. 1 - до учета спектра приборной функции монохроматора; 2 - после учета
спектра приборной функции монохроматора
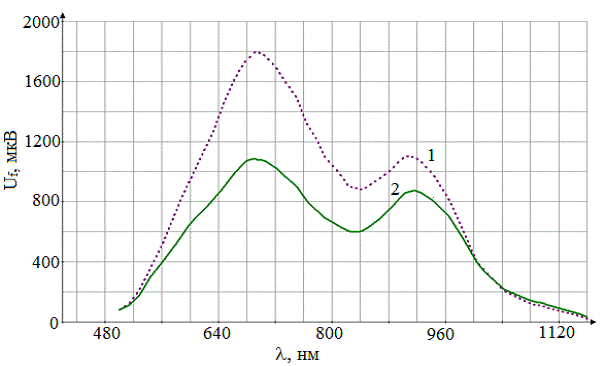
Рис.28 Спектральная характеристика вентильной фотоэдс образца,
легированного кислородов и бором. 1 - до учета спектра приборной функции
монохроматора; 2 - после учета спектра приборной функции монохроматора
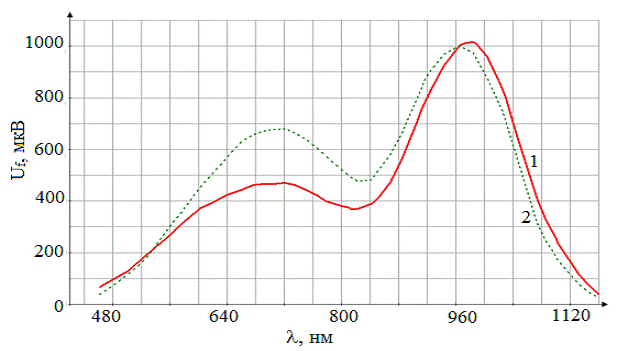
Рис.29 Спектральная характеристика вентильной фотоэдс контрольного
образца. 1 - до учета спектра приборной функции монохроматора; 2 - после учета
спектра приборной функции монохроматора
На рис.29-30 представлены спектральные характеристики вентильной фотоэдс,
после нормировки по амплидуте, для контрольного и образца, легированного бором
и кислородом соответственно.
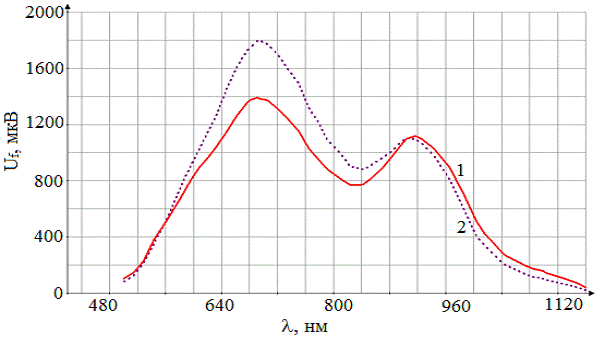
Рис.30 Спектральная характеристика вентильной фотоэдс образца,
легированного кислородов и бором. 1 - до учета спектра приборной функции
монохроматора; 2 - после учета спектра приборной функции монохроматора
Снижение амплитуды коротковолновой полосы после математической обработки
подтверждает гипотезу о том, что максимум в коротковолновой области обусловлен
свойствами дифракционной решетки. Однако, указанный максимум полностью не
исчезает. Это означает, что построенная приборная функция не вполне корректна.
В частности, в ней не учтено поглощение на решетке.
Видно, что по сравнению с контрольными значениями, максимальное значение
вентильной фотоэдс увеличивается для образцов, легированных бором и кислородом
с дозами кислорода меньшими, чем стехиометрическая. При этом максимум фотоэдс
смещается в область более коротких длин волн. Это свидетельствует о том, что в
структурах, содержащих «достехиометрические» дозы кислорода, происходит
увеличение эффективной ширины запрещенной зоны в скрытом слое.
Это подтверждается и измерениями удельного сопротивления скрытых слоев,
которые показали, что последнее составляет величину порядка 108 - 1010
Ом·см.[14]
Полученные результаты подтверждают возможность образования в скрытом слое
системы нанокластеров, содержащей, наряду с атомами кремния, атомы кислорода и
бора, а также возможность управления эффективной шириной запрещенной зоны
кремния. При этом «растворимость» нанокластеров в кремнии оказывается величиной
ограниченной. Последнее обстоятельство и приводит к образованию скрытых слоев с
максимальным содержание кислорода близким к 33 ат.%. Эти результаты
подтверждают также возможность управления эффективной шириной запрещенной зоны.
Заключение
В работе был рассмотрен новый подход к управлению свойствами
полупроводниковых материалов.
Описан эксперимент по формированию ансамблей боросиликатных нанокластеров
в кремнии.
Установлено, что максимальное значение вентильной фотоэдс увеличивается
для образцов, легированных бором и кислородом с дозами кислорода меньшими, чем
стехиометрическая. Максимум смещается в область более коротких длин волн, что
свидетельствует о том, что в структурах, содержащих «достехиометрические» дозы
кислорода, происходит увеличение эффективной ширины запрещенной зоны в скрытом
слое.
Снижение амплитуды коротковолновой полосы после математической обработки
подтверждает гипотезу о том, что максимум в коротковолновой области обусловлен
свойствами дифракционной решетки. Однако, указанный максимум полностью не
исчезает. Это означает, что построенная приборная функция не вполне корректна.
В частности, в ней не учтено поглощение на решетке.
Полученные результаты подтверждают возможность образования в скрытом слое
системы нанокластеров, содержащей, наряду с атомами кремния, атомы кислорода и
бора, а также возможность управления эффективной шириной запрещенной зоны
кремния.
Такой подход является перспективным для создания оптоэлектронных
элементов, например, фотоприемников и солнечных элементов.
Список используемой литературы
1. Физика и техника полупроводников. Т.
32, №5 / Под ред. М. Г. Мильвидский, В. В. Чалдышев. Санкт-Петербург: Изд-во
Физико-технический институт им.А.Ф.Иоффе РАН, 1998. 10 с.
2. Данилюк, А. И. Элементы виртуальной физики
или классические решения “неклассических” задач: Краткое обзорно-справочное
пособие / А. И. Данилюк. Черновцы: Изд-во Земля, 2003. 219 с.
3. Миронов, В. Л. Основы сканирующей
зондовой микроскопии: Учеб. пособие / В. Л. Миронов. Н.Новгород: Изд-во
Российская академия наук, Институт физики микроструктур , 2004. 110 с.
4. Суворов, Э.В. Физические основы
эксперементальных методов исследования реальной структуры кристаллов. Учеб.
пособие / Э. В. Суворов. Черноголовка: Изд-во Российская академия наук,
Институт физики твердого тела, 1999. 231 с.
5. Нано- и микросистемная техника. №5 /
Под ред. П. П. Мальцев.Москва: Изд-во Новые технологии, 2005. 56 с.
6. Нанотехнология в ближайшем
десятилетии / Под ред. М. К. Роко, Р. С. Уильямса, П. Аливисатоса. М., 2002.
189 с.
7. Шелованова, Г. Н. Физические основы
микроэлектроники. Полупроводниковые гетероструктуры в микро- и наноэлектронике.
Учеб. пособие / Г. Н. Шелованова. Красноярск : ИПЦ КГТУ, 2005. 181 с.
8. Бехштейн, Ф. Поверхности и границы
раздела полупроводников / Ф. Бехштейн, Р. Эндерлайн. М. : Мир, 1990. 72 с.
9. Моделирование квантовых областей в кремниевых
наноструктурах. Нанотехнологии, дорога в будующее: <#"863218.files/image036.gif">
Рис.31 Спектральная характеристика лампы накаливания
Приложение Б
Значения интенсивности, падающей на образцы
Таблица 1
Значения интенсивности, падающей на контрольный образец
|
λ,
нм
|
I0, от.ед.
|
IП, от.ед.
|
|
|
462
|
349,1
|
16,40
|
|
|
471
|
407
|
18,40
|
|
|
485
|
505,8
|
21,56
|
|
|
500
|
616,8
|
24,74
|
|
|
515
|
740,1
|
27,98
|
|
|
529
|
826,5
|
29,61
|
|
|
544
|
863,5
|
29,26
|
|
|
559
|
986,8
|
31,66
|
|
|
574
|
1048,6
|
31,91
|
|
|
603
|
1245,9
|
34,36
|
|
|
618
|
1394
|
36,60
|
|
|
632
|
1554,3
|
39,02
|
|
|
647
|
1702,3
|
40,77
|
|
|
662
|
1764,4
|
40,37
|
|
|
676
|
1825,9
|
40,06
|
|
|
691
|
1949
|
40,93
|
|
|
706
|
2035,6
|
40,95
|
|
|
721
|
2121,9
|
40,93
|
|
|
735
|
2195,7
|
40,75
|
|
|
750
|
2282,2
|
40,68
|
|
|
765
|
2368,8
|
40,58
|
|
|
779
|
2454,9
|
40,56
|
|
|
803
|
2468,4
|
38,38
|
|
|
814
|
2488,1
|
37,65
|
|
|
824
|
2529
|
37,35
|
|
|
842
|
2548,3
|
36,04
|
|
|
851
|
2557,5
|
35,41
|
|
|
868
|
2590,9
|
34,48
|
|
|
884
|
2583,1
|
33,14
|
|
|
893
|
2584,7
|
32,50
|
|
|
904
|
2589,2
|
31,77
|
|
|
913
|
2590,1
|
31,16
|
|
|
917
|
2600
|
31,00
|
|
|
926
|
2627,6
|
30,72
|
|
|
943
|
2619,1
|
29,53
|
|
|
λ,
нм
|
I0, от.ед.
|
IП, от.ед.
|
|
965
|
2622,1
|
28,23
|
|
985
|
2619,6
|
27,07
|
2602,2
|
25,88
|
|
1026
|
2588,4
|
24,65
|
|
1044
|
2578,3
|
23,72
|
|
1074
|
2528,9
|
21,98
|
|
1086
|
2517,5
|
21,40
|
|
1097
|
2497,4
|
20,81
|
|
1101
|
2477,3
|
20,49
|
|
1103
|
2479,6
|
20,44
|
|
1132
|
2430,2
|
19,02
|
|
1147
|
2393,3
|
18,24
|
|
1160
|
2361,0
|
17,59
|
|
|
|
|
|
|
Таблица 2
Значения интенсивности, падающей на образец, легированный бором и
кислородом
|
λ, нм
|
I0, от.ед.
|
IП, от.ед.
|
|
500
|
616,8
|
24,74
|
|
515
|
740,1
|
27,98
|
|
529
|
826,5
|
29,61
|
|
544
|
863,5
|
29,26
|
|
559
|
986,8
|
31,66
|
|
574
|
1048,6
|
31,91
|
|
588
|
1110,2
|
32,20
|
|
603
|
1245,9
|
34,36
|
|
618
|
1394,0
|
36,60
|
|
632
|
1554,3
|
39,02
|
|
647
|
1702,3
|
40,77
|
|
662
|
1764,4
|
40,37
|
|
676
|
1825,9
|
40,06
|
|
691
|
1949,0
|
40,93
|
|
695
|
1986,0
|
41,23
|
|
706
|
2035,6
|
40,95
|
|
721
|
2121,9
|
40,93
|
|
735
|
2195,7
|
40,75
|
|
750
|
2282,2
|
40,68
|
|
765
|
2368,8
|
40,58
|
|
779
|
2454,9
|
40,56
|
|
790
|
2435,6
|
39,13
|
|
λ,
нм
|
I0, от.ед.
|
IП, от.ед.
|
|
|
803
|
2468,4
|
38,38
|
|
|
814
|
2488,1
|
37,65
|
|
|
824
|
2529,0
|
37,35
|
|
|
842
|
2548,3
|
36,04
|
|
|
851
|
2557,5
|
35,41
|
|
|
868
|
2590,9
|
34,48
|
|
|
884
|
2583,1
|
33,14
|
|
|
893
|
2584,7
|
32,50
|
|
|
904
|
2589,2
|
31,77
|
|
|
913
|
2590,1
|
31,16
|
|
|
917
|
2600,0
|
31,00
|
|
|
926
|
2627,6
|
30,72
|
|
|
943
|
2619,1
|
29,53
|
|
|
965
|
2622,1
|
28,23
|
|
|
985
|
2619,6
|
27,07
|
|
|
1004
|
2602,2
|
25,88
|
|
|
1026
|
2588,4
|
24,65
|
|
|
1044
|
2578,3
|
23,72
|
|
|
1074
|
2528,9
|
21,98
|
|
|
1086
|
2517,5
|
21,40
|
|
|
1097
|
2497,4
|
20,81
|
|
|
1101
|
2477,3
|
20,49
|
|
|
1103
|
2479,6
|
20,44
|
|
|
1132
|
2430,2
|
19,02
|
|
|
1147
|
2393,3
|
18,24
|
|
|
1160
|
2361,0
|
17,59
|
|
|
|
|
|
|
|
l - длина волны;- интенсивность
лампы накаливания;П -
интенсивность, падающая на образец.
Приложение В
Таблица 3
Значения вентильной фотоэдс для контрольного образца
|
l, нм
|
Uf, мкВ
|
Uf’, мкВ
|
Uf’’, мкВ
|
|
462
|
38,8
|
38,80
|
66,74
|
|
471
|
54,1
|
48,23
|
82,96
|
|
485
|
79,8
|
60,70
|
104,41
|
|
500
|
111,4
|
73,85
|
127,03
|
|
515
|
147,3
|
86,34
|
148,51
|
|
529
|
183,7
|
101,74
|
174,98
|
|
544
|
239,3
|
134,14
|
230,73
|
|
559
|
296,7
|
153,68
|
264,32
|
|
574
|
347,9
|
178,80
|
307,53
|
|
603
|
454
|
216,72
|
372,76
|
|
618
|
500,2
|
224,16
|
385,55
|
|
632
|
542,8
|
228,16
|
392,43
|
|
647
|
588,9
|
236,87
|
407,41
|
|
662
|
631,5
|
256,56
|
441,28
|
|
676
|
655,5
|
268,34
|
461,54
|
|
691
|
670,1
|
268,52
|
461,85
|
|
706
|
676,6
|
270,98
|
466,09
|
|
721
|
678
|
271,69
|
467,30
|
|
735
|
664,1
|
267,26
|
459,68
|
|
750
|
637,3
|
256,92
|
441,91
|
|
765
|
608,5
|
245,89
|
422,94
|
|
779
|
572,1
|
231,32
|
397,86
|
|
803
|
514,2
|
219,70
|
377,89
|
|
814
|
492,3
|
214,44
|
368,83
|
|
824
|
475,2
|
208,68
|
358,92
|
|
842
|
480,1
|
218,47
|
375,77
|
|
851
|
512,8
|
237,51
|
408,52
|
|
868
|
576,4
|
274,16
|
471,55
|
|
884
|
657,6
|
325,40
|
559,69
|
|
893
|
711,1
|
358,85
|
617,22
|
|
904
|
779,6
|
402,47
|
692,25
|
|
913
|
839,2
|
441,75
|
759,82
|
|
917
|
870,3
|
460,39
|
791,87
|
|
926
|
905,3
|
483,22
|
831,14
|
|
943
|
965,6
|
536,24
|
922,33
|
|
l, нм
|
Uf, мкВ
|
Uf’, мкВ
|
Uf’’, мкВ
|
|
965
|
1000
|
580,89
|
999,14
|
|
985
|
973,3
|
589,62
|
1014,15
|
|
1004
|
877
|
555,67
|
955,75
|
|
1026
|
746,2
|
853,76
|
|
1044,1
|
586,1
|
405,26
|
697,04
|
|
1074
|
315,8
|
235,60
|
405,24
|
|
1086
|
248,8
|
190,65
|
327,91
|
|
1097
|
201,5
|
158,81
|
273,16
|
|
1101
|
183
|
146,47
|
251,92
|
|
1103
|
171,5
|
137,63
|
236,73
|
|
1132
|
77,8
|
67,10
|
115,41
|
|
1147
|
45,1
|
40,55
|
69,75
|
|
1160
|
24,6
|
22,93
|
39,44
|
|
|
|
|
|
Таблица 4
Значения вентильной фотоэдс для образца, легированного бором и кислородом
|
l, нм
|
Uf, мкВ
|
Uf’, мкВ
|
Uf’’, мкВ
|
|
500
|
80,2
|
80,21
|
102,67
|
|
515
|
132,1
|
116,81
|
149,52
|
|
529
|
214,8
|
179,45
|
229,70
|
|
544
|
356,9
|
301,81
|
386,32
|
|
559
|
497,1
|
388,41
|
497,16
|
|
574
|
670,5
|
519,83
|
665,38
|
|
588
|
825,2
|
634,11
|
811,66
|
|
603
|
973,3
|
700,89
|
897,13
|
|
618
|
1125,2
|
760,66
|
973,65
|
|
632
|
1263,3
|
801,04
|
1025,33
|
|
647
|
1447,3
|
878,17
|
1124,06
|
|
662
|
1610,7
|
987,15
|
1263,55
|
|
676
|
1728,1
|
1067,17
|
1365,98
|
|
691
|
1797,4
|
1086,52
|
1390,74
|
|
695
|
1804,9
|
1083,16
|
1386,44
|
|
706
|
1772,4
|
1070,84
|
1370,68
|
|
721
|
1695,2
|
1024,74
|
1311,67
|
|
735
|
1590,1
|
965,33
|
1235,62
|
|
750
|
1493,1
|
908,04
|
1162,29
|
|
765
|
1318,8
|
803,93
|
1029,04
|
|
779
|
1211,9
|
739,19
|
946,16
|
|
790
|
1097,2
|
693,72
|
887,96
|
|
l, нм
|
Uf, мкВ
|
Uf’, мкВ
|
Uf’’, мкВ
|
|
803
|
1032,1
|
665,25
|
851,52
|
|
814
|
972,1
|
638,76
|
817,62
|
|
824
|
902,9
|
598,13
|
765,60
|
|
842
|
880,7
|
604,57
|
773,85
|
|
851
|
900,5
|
629,18
|
805,35
|
|
868
|
960
|
688,82
|
881,69
|
|
884
|
1015,4
|
757,96
|
970,19
|
|
893
|
1061,3
|
807,94
|
1034,16
|
|
904
|
1101,2
|
857,60
|
1097,73
|
|
913
|
1097,6
|
871,60
|
1115,64
|
|
917
|
1095,3
|
874,07
|
1118,81
|
|
926
|
1066,5
|
858,76
|
1099,21
|
|
943
|
979,1
|
820,25
|
1049,92
|
|
965
|
812,3
|
711,82
|
911,13
|
|
985
|
613,2
|
560,38
|
717,29
|
|
1004
|
406
|
388,06
|
496,72
|
|
1026
|
287,3
|
288,30
|
369,02
|
|
1044
|
205,6
|
214,46
|
274,50
|
|
1074
|
136,5
|
153,62
|
196,64
|
|
1086
|
117,1
|
135,36
|
173,26
|
|
1097
|
107,4
|
127,70
|
163,45
|
|
1101
|
100,1
|
120,86
|
154,70
|
|
1103
|
95,6
|
115,74
|
148,14
|
|
1132
|
60,1
|
78,19
|
100,09
|
|
1147
|
42,1
|
57,10
|
73,09
|
|
1160
|
23,9
|
33,61
|
43,02
|
|
|
|
|
|
|
l - длина волны; -
экспериментальное значение вентильной фотоэдс;
Uf’ -
значение вентильной фотоэдс с учетом спектральной характеристики приборной
функции монохроматора;
Uf’’ -
значение вентильной фотоэдс после амплитудной нормировки.