Вольтамперные характеристики кремниевого диода при 300 К
ВВЕДЕНИЕ
Техника полупроводниковых приборов стала
самостоятельной областью электроники. Замена электронных ламп
полупроводниковыми приборами успешно осуществлена во многих радиотехнических
устройствах.
По сравнению с электронными лампами у
полупроводниковых приборов имеются существенные достоинства:
Малый вес и малые размеры.
Отсутствие затраты энергии на накал.
Большой срок службы (до десятков тысяч часов).
Большая механическая прочность (стойкость к
тряске, ударам и другим видам механических перегрузок).
Различные устройства (выпрямители, усилители,
генераторы) с полупроводниковыми приборами имеют высокий КПД, так как потери
энергии в самих приборах незначительны.
Маломощные устройства с транзисторами могут
работать при очень низких питающих напряжениях.
Транзисторы могут работать почти во всех
устройствах, в которых применяются вакуумные лампы. В настоящее время
транзисторы успешно применяются в усилителях, приёмниках, передатчиках,
генераторах, измерительных приборах, импульсных схемах и во многих других
устройствах. Такие приборы способны работать при малых напряжениях питания и на
высоких частотах.
Наиболее распространёнными приборами в
электронике являются выпрямительные диоды, полупроводниковые стабилитроны,
туннельные, импульсные и СВЧ диоды, а также биполярные и полевые транзисторы,
которые используются в преобразовательных устройствах в качестве усилителей и
вентилей.
Для того чтобы конструировать электронные схемы
и эффективно применять полупроводниковые приборы нужно знать принципы их
действия и основные параметры.
В данном курсовом проекте будет рассмотрена
технология изготовления полупроводниковых диодов, структура, основные элементы
и принцип действия. А так же будут определены параметры и характеристики
полупроводникового диода. В соответствии с полученными результатами расчетов
будут построены соответствующие графики.
полупроводниковый диод проводимость
переход
1. ПОЛУПРОВОДНИКОВЫЕ ДИОДЫ. АНАЛИЗ КОНСТРУКЦИЙ И
ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ
.1 ПОЛУПРОВОДНИКОВЫЕ ДИОДЫ
Диод - это полупроводниковый прибор с двумя
выводами, имеющий нелинейную ВАХ. Электронно-дырочный переход представляет
собой полупроводниковый диод.
Нелинейные свойства диода видны при рассмотрении
его ВАХ. Она показывает что прямой ток в десятки миллиампер получается при
прямом напряжении порядка десятых долей вольта. Поэтому прямое сопротивление
имеет величину не выше десятков Ом. Для более мощных диодов прямой ток
составляет сотни миллиампер и больше при таком же малом напряжении, а
сопротивление соответственно снижается до единиц Ом и меньше.
Участок характеристики для обратного тока,
малого по сравнению с прямым током, обычно показывают в другом масштабе.
Обратный ток при обратном напряжении до сотен вольт у диодов небольшой мощности
составляет лишь единицы или десятки микроампер. Это соответствует обратному
сопротивлению до сотен кОм и больше.
На рис. 1.1. показаны вольтамперные
характеристики идеализированного p-n перехода и реального диода. Обратный ток
диода не имеет насыщения, а увеличивается с ростом обратного напряжения; он состоит
из трёх компонентов: теплового тока, образованного неосновными носителями,
возникающими за пределами перехода; тока термогенерации пар носителей в области
перехода; и тока утечки.
Величина обратного тока сильно зависит от
окружающей температуры.
На обратной ветви вольтамперной характеристики
при больших обратных напряжениях имеется область быстрого нарастания обратного
обратного тока при незначительном увеличении обратного напряжения. Причиной
этого является развитие одного из видов пробоя p-n переход.
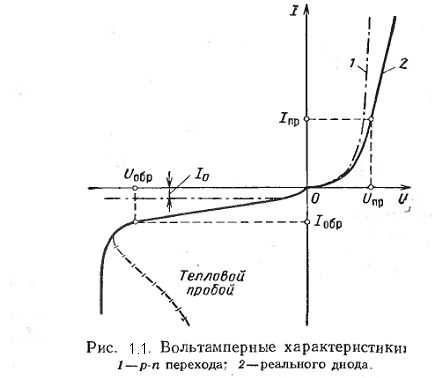
В общем случае диод может быть представлен
эквивалентной схемой, изображённой на рис. 1.2. На схеме приняты обозначения :
Ск - ёмкость корпуса диода;- индуктивность
выводов и контактной пружины, соединяющей кристалл с одним из выводов;п -
сопротивление p-n перехода;
Сп - емкость p-n перехода;б - сопротивление
базы, омического контакта и выводов диода.
Индуктивность Ls составляет 1 - 20 нГн, поэтому
ее имеет смысл учитывать только на частотах выше 100 МГц, где сопротивление ω
Ls
становится соизмеримым с прямым сопротивлением диода. Емкость корпуса Ск диодов
обычно не превышает 0,3 пФ. Сопротивление перехода rп шунтируется емкостью Сп;
в зависимости от напряжения, приложенного к диоду, меняются величины rп и Сп.
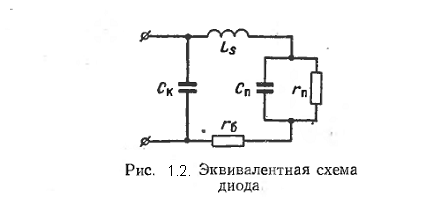
Полупроводниковые диоды подразделяются по многим
признакам. Прежде всего, следует различать точечные, плоскостные и
поликристаллические диоды. У точечных диодов линейные размеры, определяющие
площадь p-n перехода, такого же порядка как толщина перехода, или меньше ее. У
плоскостных диодов эти размеры значительно больше толщины перехода.
Точечные диоды имеют малую емкость p-n перехода
и поэтому применяются на любых частотах вплоть до СВЧ. Но они могут пропускать
токи не более единиц или нескольких десятков миллиампер. Плоскостные диоды в
зависимости от площади перехода обладают емкостью в десятки пикофарад и более.
Поэтому их применяют на частотах не более десятков килогерц. Допустимый ток в
плоскостных диодах бывает от десятков миллиампер до сотен ампер и больше.
Основой точечных и плоскостных диодов являются
пластинки полупроводника, вырезанные из монокристалла, имеющего во всем своем
объеме правильное кристаллическое строение. В качестве полупроводниковых
веществ для точечных и плоскостных диодов применяют чаще всего германий и
кремний, а в последнее время также и арсенид галлия и карбид кремния.
Поликристаллические диоды имеют p-n переход,
образованный полупроводниковыми слоями, состоящими из большого количества
кристаллов малого размера, различно ориентированных друг относительно друга и
поэтому не представляющих собой единого монокристалла. Эти диоды бывают
селеновыми, меднозакисные (купроксные) и титановые.
.2 АНАЛИЗ КОНСТРУКЦИЙ
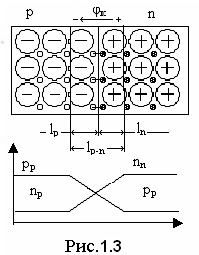
Рассмотрим подробнее процесс образования p-n
перехода. Равновесным называют такое состояние перехода, когда отсутствует
внешнее напряжение. Напомним, что в р-области имеются два вида основных
носителей заряда: неподвижные отрицательно заряженные ионы атомов акцепторной
примеси и свободные положительно заряженные дырки; а в n-области имеются также
два вида основных носителей заряда: неподвижные положительно заряженные ионы
атомов акцепторной примеси и свободные отрицательно заряженные электроны.
До соприкосновения p и n областей электроны
дырки и ионы примесей распределены равномерно. При контакте на границе p и n
областей возникает градиент концентрации свободных носителей заряда и диффузия.
Под действием диффузии электроны из n-области переходит в p и рекомбинирует там
с дырками. Дырки из р-области переходят в n-область и рекомбинируют там с
электронами. В результате такого движения свободных носителей заряда в
пограничной области их концентрация убывает почти до нуля и в тоже время в
р-области образуется отрицательный пространственный заряд ионов акцепторной
примеси, а в n-области положительный пространственный заряд ионов донорной
примеси. Между этими зарядами возникает контактная разность потенциалов φк
и электрическое поле Ек , которое препятствует диффузии свободных носителей
заряда из глубины р- и n-областей через р-n переход. Таким образом область,
объединённая свободными носителями заряда со своим электрическим полем и
называется р-n-переходом.
Толщина электронно-дырочных переходов имеет
порядок (0,1-10)мкм.
В равновесном состоянии (без внешнего
напряжения) через р-n переход движутся два встречных потока зарядов (протекают
два тока). Это дрейфовый ток неосновных носителей заряда и диффузионный ток,
который связан с основными носителями заряда. Так как внешнее напряжение
отсутствует, и тока во внешней цепи нет, то дрейфовый ток и диффузионный ток
взаимно уравновешиваются и результирующий ток равен нулю:
др + Iдиф = 0.
Это соотношение называют условие динамического
равновесия процессов диффузии и дрейфа в изолированном (равновесном) p-n
переходе.
Поверхность, по которой контактируют p и n
области называется металлургической границей. Реально она имеет конечную
толщину - δм . Если δм<<
lp-n , то p-n-переход называют резким. Если δм>>lp-n
, то p-n-переход называют плавным. Внешнее напряжение нарушает динамическое
равновесие токов в p-n-переходе. P-n-переход переходит в неравновесное
состояние. В зависимости от полярности напряжения приложенного к областям в
p-n-перехода возможно два режима работы.
) Прямое смещение p-n перехода. p-n переход
считается смещённым в прямом направлении, если положительный полюс источника
питания подсоединен к р-области, а отрицательный к n-области (рис.1.4)
При прямом смещении, напряжения jк и U
направлены встречно, результирующее напряжение на p-n-переходе убывает до
величины jк - U .
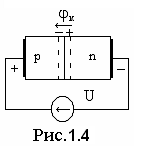
Это приводит к тому, что напряженность
электрического поля убывает и возобновляется процесс диффузии основных
носителей заряда. Кроме того, прямое смещении уменьшает ширину p-n перехода,
т.к. lp-n≈(jк - U)1/2. Ток диффузии, ток основных носителей заряда,
становится много больше дрейфового. Через p-n-переход протекает прямой ток
р-n=Iпр=Iдиф+Iдр =Iдиф .
При протекании прямого тока основные носители
заряда р-области переходят в n-область, где становятся неосновными.
Диффузионный процесс введения основных носителей заряда в область, где они
становятся неосновными, называется инжекцией, а прямой ток - диффузионным током
или током инжекции. Для компенсации неосновных носителей заряда накапливающихся
в p и n-областях во внешней цепи возникает электронный ток от источника
напряжения, т.е. принцип электронейтральности сохраняется.
При увеличении U ток резко
возрастает,  -
температурный потенциал, и может достигать больших величин т.к. связан с
основными носителями концентрация которых велика.
-
температурный потенциал, и может достигать больших величин т.к. связан с
основными носителями концентрация которых велика.
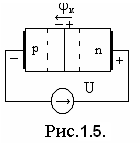
2) Обратное смещение. Возникает,
когда к р-области приложен минус, а к n-области плюс, внешнего источника
напряжения (рис.1.5).
Такое внешнее напряжение U включено
согласно jк . Оно: увеличивает высоту потенциального барьера до величины jк + U
; напряженность электрического поля возрастает; ширина p-n перехода возрастает,
т.к. lp-n≈(jк + U)1/2 ; процесс диффузии полностью прекращается и через
p-n переход протекает дрейфовый ток, ток неосновных носителей заряда. Такой ток
p-n-перехода называют обратным, а поскольку он связан с неосновными носителями
заряда, которые возникают за счет термогенерации, то его называют тепловым
током и обозначают - I0 , т.е.
р-n=Iобр=Iдиф+Iдр ,Iдр= I0.
Этот ток мал по величине т.к. связан
с неосновными носителями заряда, концентрация которых мала. Таким образом, p-n
перехода обладает односторонней проводимостью.
При обратном смещении концентрация
неосновных носителей заряда на границе перехода несколько снижается по
сравнению с равновесной. Это приводит к диффузии неосновных носителей заряда из
глубины p и n-областей к границе p-n-перехода. Достигнув ее, неосновные
носители попадают в сильное электрическое поле и переносятся через p-n-переход,
где становятся основными носителями заряда. Диффузия неосновных носителей
заряда к границе p-n-перехода и дрейф через него в область, где они становятся
основными носителями заряда, называется экстракцией. Экстракция и создает
обратный ток p-n-перехода - это ток неосновных носителей заряда.
Величина обратного тока сильно
зависит: от температуры окружающей среды, материала полупроводника и площади
p-n перехода.
Температурная зависимость обратного
тока определяется выражением  , где
, где  - номинальная температура,
- номинальная температура,  -
фактическая температура,
-
фактическая температура,  -
температура удвоения теплового тока
-
температура удвоения теплового тока  .
.
Тепловой ток кремниевого перехода
много меньше теплового тока перехода на основе германия  (на 3-4
порядка). Это связано с jк материала.
(на 3-4
порядка). Это связано с jк материала.
С увеличением площади перехода
возрастает его объем, а следовательно возрастает число неосновных носителей
появляющихся в результате термогенерации и тепловой ток.
Итак, главное свойство p-n-перехода
- это его односторонняя проводимость.
.3 ТЕХНОЛОГИЯ ИЗГОТОВЛЕНИЯ
Несколько важнейших методов
изготовления полупроводниковых приборов схематически показано на рис. 1.6. При
методе сплавления (рис. 1.6, а) небольшую таблетку алюминия помещают на
поверхность кремневой пластины с проводимостью n-типа, имеющей ориентацию
<111>. Затем пластину с таблеткой нагревают до температуры, немного
превышающей температуру эвтектики (~580 C для системы Al-Si). При расплавлении
таблетки образуется небольшая капля смеси Al-Si, которая с последующим
понижением температуры начинает затвердевать. В результате образуется
рекристаллизованная область, насыщенная акцепторной примесью и имеющая ту же
кристаллографическую ориентацию, что и исходная пластина. Таким образом, в
подложке проводимостью n-типа сформирована сильнолегированная область p-типа
(p+). Алюминиевый выступ на поверхности пластины можно использовать как контакт
к области p-типа. Чтобы получить омический контакт к пластине n-типа, на её
нижнюю поверхность напыляют сплав Au-Sb, содержащий ~0,1 % Sb, и вплавляют его
при температуре 400 С для формирования сильнолегированного слоя n-типа (n+).
При использовании пластины p-типа роли алюминия и сплава Au-Sb меняются. Первый
служит для создания омического контакта p+-p-типа, а второй - для получения
n+-p-перехода. При сплавном методе нельзя контролировать положение
p-n-перехода, поскольку оно сильно зависит от температуры и длительности цикла
сплавления.
Диффузионный метод (или метод
диффузии в твердой фазе), разработанный в 1956 г., позволяет более точно
управлять распределением примеси. Рисунок 1.6, б иллюстрирует диффузионный
метод получения p-n-перехода с мезоструктурой. В подложку n-типа проводят
диффузию примеси p-типа, например бора из соединения BBr3. После диффузии
определенные участки поверхности защищают от действия травителей, например,
слоем воска или металлическим покрытием. Незащищенные участки поверхности
подложки удаляют с помощью травления. В результате образуется мезоструктуры.
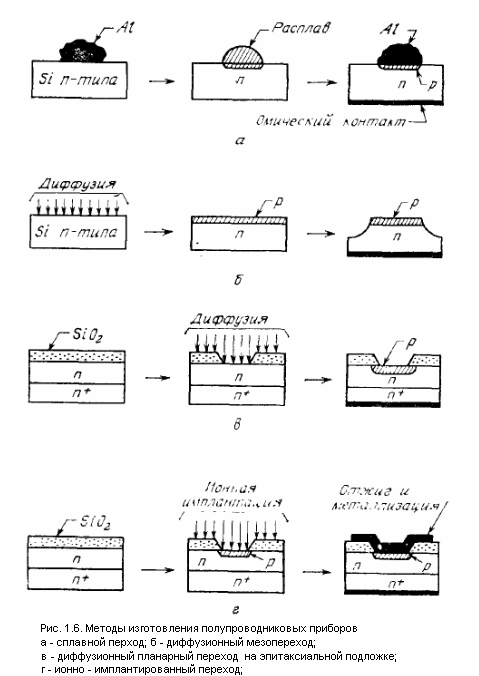
Более точный контроль геометрических
размеров диффузионного перехода был достигнут за счет использования изолирующей
пленки, которая препятствует диффузии большинства донорных и акцепторных
примесей в глубь подложки. Рисунок 1.6, в иллюстрирует типичный пример такого
процесса. На поверхности кремниевой подложки при высокой температуре выращивают
тонкий слой двуокиси кремния толщиной ~1 мкм. Литографическими методами
(например, фотолитографией, рентгенолитографией, электронной литографией)
удаляют определенные участки окисла, образуя в нем окна или более сложные
рисунки. Примеси диффундируют в открытые участки поверхности кремния, и
p-n-переходы образуются только в местах окон в окисле. Этот процесс, получивший
название планарного, является основой технологии изготовления полупроводниковых
приборов и интегральных схем.
Эпитаксиальные структуры типа
показанного на рис. 1.6, в обычно используются в планарной технологии для
уменьшения последовательного сопротивления. Слово «эпитаксия» имеет греческое
происхождение: «эпи» означает, «на» и «таксис» - «расположено в порядке».
Эпитаксией называют метод выращивания путем химической реакции на поверхности
кристалла тонких слоев полупроводниковых материалов с сохранением кристаллической
структуры исходного кристалла. Таким методом на поверхности сильнолегированной
низкоомной подложки выращивают высокоомные эпитаксиальные слои, добиваясь
желаемых электрических свойств и механической прочности.
На рис. 1.6, г показан p-n-переход,
полученный с помощью ионной имплантации. В настоящее время этот метод позволяет
наиболее точно контролировать распределение примесей. Ионную имплантацию можно
производить при комнатной температуре, а возникающие в процессе имплантации
дефекты кристаллической решетки устраняют путем последующего отжига при
температуре 700 С и ниже. Следовательно, ионная имплантация является
относительно низкотемпературным процессом по сравнению с диффузией, которая
обычно проводится при температуре 1000 С и выше.
2. ЭЛЕКТРОФИЗИЧЕСКИЕ ПАРАМЕТРЫ
ЭЛЕКТРО-ДЫРОЧНЫХ ПЕРЕХОДОВ
Высота потенциального барьера равна
контактной разности потенциалов φк. Это разность потенциалов в
переходе, обусловленная градиентом концентрации носителей заряда. Это энергия,
которой должен обладать свободный заряд чтобы преодолеть потенциальный барьер:

где k - постоянная Больцмана; е -
заряд электрона; Т - температура; Nа и NД - концентрации акцепторов и доноров в
дырочной и электронной областях соответственно; рр и рn - концентрации дырок в
р- и n-областях соответственно; ni - собственная концентрация носителей заряда
в нелигированном полупроводнике, jт=кТ/е - температурный потенциал. При
температуре Т=270С jт=0.025В, для германиевого перехода jк=0,6В, для кремниевого
перехода jк=0,8В.

 , отсюда
, отсюда  ,
,
где ε -
относительная диэлектрическая проницаемость материала полупроводника; ε0 -
диэлектрическая постоянная свободного пространства.
Толщина электронно-дырочных
переходов имеет порядок (0,1-10)мкм. Если  , то
, то  и p-n-переход называется
симметричным, если
и p-n-переход называется
симметричным, если  , то
, то  и
p-n-переход называется несимметричным, причём он в основном располагается в
области полупроводника с меньшей концентрацией примеси.
и
p-n-переход называется несимметричным, причём он в основном располагается в
области полупроводника с меньшей концентрацией примеси.
Поверхность, по которой контактируют
p и n области называется металлургической границей. Реально она имеет конечную
толщину - δм . Если δм<<
Wp-n , то p-n-переход называют резким. Если δм>>Wp-n , то
p-n-переход называют плавным.
Коэффициенты диффузии для основных
носителей заряда в эмиттере и в базе:


для неосновных:


Емкость С диода при прямом смещении
состоит из барьерной емкости Сб и диффузионной емкости Сдиф, обусловленной
неосновными носителями в нейтральных областях диода.
Для диодов с резким р-n-переходом:
 ;
;
С плавным:
 ,
,
где а - градиент концентрации
примесей;
Сопротивление базы диода:

Диффузионная длинна носителей заряда
в эмиттере и базе рассчитывается по следующим формулам:
 ;
; .
.
Обратный ток диода:

Коэффициент лавинного умножения М
(имеет место при лавинном пробое):

где n - величина, зависящая от степени
легирования p и n областей (для кремния n=5).
Эффективное время жизни, которое
характеризует совместное влияние объемной и поверхностной рекомбинации:

Генерационный ток перехода:

Напряжение на p-n переходе:
 ;
;
3. РАСЧЕТ ЭЛЕКТРОФИЗИЧЕСКИХ
ПАРАМЕТРОВ ПОЛУПРОВОДНИКОВОГО ДИОДА
.1 Исходные данные
Полупроводниковый материал кремний,
сферический p-n переход, плотность атомов N и ионизированных атомов ni, принять
5,0×1022 и 1012
см-3 соответственно, на каждые 109 атомов кремния приходиться один атом
акцепторной примеси, Nд = 10 000Na на границах ОПЗ, площадь p-n перехода - 0,2
мм2, глубина 0,005 мм, T=300 K., другие справочные данные.
Задание
Изучить основные электрофизические
параметры полупроводниковых диодов и методики их измерений.
Рассчитать:
контактную разность потенциалов;
ширину области пространственного
заряда;
зарядную емкость;
вольтамперную характеристику;
напряжение электрического пробоя.
.2 Расчет
Определим контактную разность
потенциалов:
 , где
, где
 ;
;
 ;
;
 .
.
Из этого следует:
 .
.
Определим ширину области
пространственного заряда:

Определим зарядную емкость:

Построим вольтамперную
характеристику:


 ,
, (см. рис. 3.1)
(см. рис. 3.1)
 10
10
Рис. 3.1. Зависимость подвижности
электронов и дырок от концентрации примеси кремния при 300К


 , где
, где
 ,
, ,
,  ,
,




С помощью математического пакета
MATLAB, строим прямую ВАХ диода:


 - коэффициент лавинного умножения
для кремния;
- коэффициент лавинного умножения
для кремния;
 ;
;
 - напряжение лавинного пробоя;
- напряжение лавинного пробоя;

С помощью математического пакета
MATLAB, строим обратную ВАХ диода:

Рис. 3.3. Обратная ВАХ диода
Определим напряжение электрического
пробоя:

ЗАКЛЮЧЕНИЕ
В результате расчетов параметров и
характеристик полупроводниковых приборов были получены результаты, не
противоречащие справочным данным.
При расчете параметров и
характеристик полупроводникового диода обратный ток  , напряжение
лавинного пробоя
, напряжение
лавинного пробоя  =
= .
.
Барьерная емкость  , поэтому
использование диода в СВЧ диапазоне ограничено, т.к. нужно учитывать влияние
паразитной емкости диода.
, поэтому
использование диода в СВЧ диапазоне ограничено, т.к. нужно учитывать влияние
паразитной емкости диода.
Было определено напряжение
электрического пробоя, которое оказалось гораздо больше напряжения лавинного
пробоя. Это означает, что при увеличении обратного напряжения начинает
проявляться лавинный пробой, который может привести к выходу из строя диода.
Лавинный пробой проявляет себя при довольно больших напряжениях ( =
= ). Это
значение определяет довольно широкую область использования диода.
). Это
значение определяет довольно широкую область использования диода.
В результате расчёта параметров
диода были получены вольтамперные характеристики кремниевого диода при 300К,
которые представлены на рис. 3.2. и рис. 3.3.
Я считаю, что диод с данными
параметрами производить целесообразно, т.к. он обеспечивает достаточно
устойчивую работу при обратном включении.
СПИСОК ЛИТЕРАТУРЫ
Зи.
Физика полупроводников. Москва «МИР» 1984г.
Барсуков
С.Н. Элементная база радиоэлектроники. Ч. 1. Полупроводниковые диоды. - Учеб.
пособие. - Харьков, 2002. - 88с.
Пасынков
В.В., Чиркин Л.К. Полупроводниковые приборы - М.: Высшая школа,1987г.- 479с.
Горюнова
Н.Н., Носова Ю.Р. полупроводниковые диоды. Параметры, методы измерения. Москва
«Советское радио» 1968г.
Исаков
Ю.А., Руденко В.С. Промышленная электроника на базе полупроводниковой техники -
М.: Высшая школа, 1975г. - 328с.
Тугов
Н.М., Глебов Б.А. Полупроводниковые приборы - М.:Энергоатомиздат,1990г.- 576с.
Батушев
В.А. Электронные приборы - М.: Высшая школа,1980г.- 383с.