Расчет температурных зависимостей электрофизических параметров полупроводников
Федеральное
агентство по образованию РФ
Пензенский
государственный университет
Кафедра
нано- и микроэлектроники
Пояснительная
записка
Курсовая
работа по физике твердого тела
на тему:
Расчет температурных зависимостей электрофизических параметров полупроводников
Выполнил
студент
группы 05КМ1
Васецкий
А.М.
Пенза 2008
Содержание
Лист заданий
Реферат
Введение
. Полупроводники
.1 Классификация веществ по
электропроводности
.2 Собственные и примесные
полупроводники
.2.1 Носители заряда в собственных
полупроводниках
.2.2 Носители заряда в примесных
полупроводниках
.2.3 Невырожденные и вырожденные
полупроводники
.3 Эффективная масса плотности
состояний
.4 Статистика носителей в
собственных полупроводниках
. Определение
электрофизических свойств полупроводников
.1 Определение эффективной
массы плотности состояний
.2 Статистика электронов в
примесных полупроводниках донорного типа
.2.1 Область низких температур
.2.2 Область истощения примеси
.2.3 Область высоких температур
(область перехода к собственной проводимости)
Заключение
Список используемых источников
Лист задания
на курсовую работу по физике твердого тела
на тему: Расчет температурных зависимостей
электрофизических параметров полупроводников.
Вариант № 5.11
Рассчитать температурную зависимость
концентрации свободных носителей заряда в полупроводнике.
Построить график этой
зависимости в координатах: ln(n)
= f(1\T).
Определить и построить графически зависимость энергии уровня Ферми от
температуры.
Произвести расчет температур
перехода к собственной проводимости и истощения примеси.
Расчет и построение графиков
осуществить на ПК. Расчет концентрации свободных носителей заряда и энергии
уровня Ферми осуществить в диапазоне температур с интервалом 10К.
Обозначения
Ed(a)
- энергия ионизации донорного, акцепторного уровня соответственно; m1n,
m2n,,
т3n
- массы электронов по главным осям эллипсоидов; m1p,
m2p,
m3p
- массы дырок по главным осям эллипсоидов; Mc(v)
- число долин в зоне проводимости и валентной соответственно, m0
= 9,1 10-31 кг; Nd(a)
- концентрация донорных, акцепторных атомов соответственно, ДEg
- ширина запрещенной зоны; Т - температура.
Исходные данные
Полупроводник донорного типа.
Eд
= 0,007 эВ; ДEg(T)
= 0,5(эВ) - 4,9 · 10-5(эВ/К) · T(К);
Nд
= 3 · 1019 см-3;
m1n = 1,6 · m0;
m2n = 1,7 · m0; m3n = 1,5 · m0; MC
= 4;
m1p
= 1,49 · m0;
m2p
= 1,32 · m0;
m3p
= 1,9 · m0;
MV = 3; T
= (20…690) К.
Литература
1. Павлов
П.В., Хохлов А.Ф. Физика твердого тела. Учебное пособие для вузов. -М.: Высш.
шк., 2000. - 384 с. (16 экз.).
2. Епифанов
Г.И., Мома Ю.А. Физические основы конструирования и технологии РЭА и ЭВА. - М.:
Сов.Радио, 1979. - 350 с.
Реферат
Курсовая работа содержит: 43 страниц, включая 11
рисунков, 7 таблиц, приложения и список литературы, состоящий из семи
наименований.
Ключевые слова: уровень Ферми; эффективная
плотность состояний; полупроводники n-типа;
энергия ионизации донорного уровня; температура истощения примесей; температура
переходов собственной проводимости; запрещённая зона; зона проводимости;
валентная зона; концентрация свободных носителей заряда.
Во введении описаны полупроводники в общем, их
типы и виды, отличие от металлов и диэлектриков, свойства полупроводников,
которыми они характеризуются, а также области их применения и их актуальность.
В первой главе дана классификация веществ по
электропроводности, проанализированы свойства собственных и примесных
полупроводников, рассмотрены типы проводимости полупроводников. Кроме этого
рассмотрены типы примесей и разобраны энергетические зонные диаграммы как
примесных, так и собственных полупроводников, определен критерий
невырожденности электронного газа. Также рассмотрена эффективная масса
плотности состояний и статистика носителей в собственных полупроводниках.
Во второй главе курсовой работе представлен
расчёт эффективной массы плотности состояний электронов в зоне проводимости и
дырок в валентной зоне, температурной зависимости электрофизических свойств
примесных полупроводников донорного типа.
Введение
Научно-технический прогресс немыслим без
электроники. Интенсивное развитие электроники связано с появлением новых
разнообразных полупроводниковых приборов и интегральных микросхем, которые
находят широкое применение в вычислительной технике, автоматике, радиотехнике и
телевидении, в установках измерительной техники, медицины, биологии и т.д.
Полупроводники представляют собой обширную
группу веществ, занимающих по величине удельного сопротивления промежуточное
положение между диэлектриками и проводниками. Отличительным свойством
полупроводников является сильная зависимость их удельного сопротивления от
концентрации примесей. При введении примесей изменяется не только значение
проводимости, но и характер ее температурной зависимости. У большинства
полупроводников удельное сопротивление зависит также от температуры и других
внешних энергетических воздействий (свет, электрическое и магнитное поле,
ионизирующее излучение и т.д.). На управлении с помощью тепла, света,
электрического поля, механических усилий электропроводностью полупроводников
основана работа терморезисторов (термисторов), фоторезисторов, нелинейных
резисторов (варисторов), тензорезисторов [1].
Полупроводниковые материалы по химическому
составу можно разделить на простые и сложные.
Простыми (элементарными) полупроводниковыми
материалами являются 12 химических элементов периодической системы: в III
группе - В; в IV - С, Ge, Si. Sn (серое олово); в V - Р, As, Sb; в VI - S, Se,
Те; в VII -I. В полупроводниковой электронике в основном применяют Ge и Si, а
остальные используют в качестве легирующих добавок или компонентов сложных
соединений.
Сложными полупроводниковыми материалами являются
химические соединения, обладающие полупроводниковыми свойствами и включающие
два, три и более элементов. Полупроводниковые соединения, состоящие из двух
элементов, приято называть бинарными. Они обозначаются буквами латинского
алфавита с цифровыми индексами (римские цифры над буквами обозначаются группу в
периодической системе, а арабские цифры под буквами -стехиометрический
коэффициент): АШВV (GaAs, JnSb), AIIBVI(CdS. ZnSe),
AIVBVI(PbTe), AIVBIV(SiC), A2VB3VI(Bi2Te3) и
т.д.
Твердые растворы полупроводниковых материалов
обозначают символами входящих в него элементов с индексами, которые указывают
атомную долю этих элементов в растворе.
Для изготовления полупроводниковых приборов и устройств
микроэлектроники используют как монокристаллы, так и поликристаллические
материалы [1].
Совершенные кристаллы полупроводников при
абсолютном нуле являются диэлектриками. Характерные для полупроводников
свойства проявляются при конечных температурах, при наличии примесей, при
отклонениях состава вещества от стехиометрии. Проводимость полупроводников
занимает промежуточное значение между типичными диэлектриками и металлами:
диэлектрики - у ~ 10-16 (Ом · м)-1;
полупроводники - у ~ 10-4-105
(Ом · м)-1;
металлы - у ~ 106-108 (Ом
· м)-1
Важным отличием полупроводников от металлов
является характер температурной зависимости проводимости: если для типичных
металлов проводимость обратно пропорциональна температуре (при не слишком
низких значениях температуры), то у беспримесных полупроводников проводимость
растет с ростом температуры по экспоненциальному закону.
Специфические полупроводниковые эффекты
применяются в разнообразных приборах и устройствах, таких, как:
полупроводниковые термоэлектрогенераторы;
полупроводниковые диоды для выпрямления
переменного тока и детектирования модулированных колебаний;
свето- и фотодиоды, фотоэлементы, солнечные
батареи;
термисторы и тензорезисторы (их сопротивления
известным образом зависят от температуры или механического давления);
варикапы (конденсаторы с изменяемой
электрическим полем емкостью);
биполярные и полевые транзисторы, микросхемы
различного назначения на их основе;
запоминающие устройства (оперативная память
ЭВМ);
приборы с зарядовой связью, применяемые,
например, для
создания миниатюрных видеокамер;
высокотемпературные полупроводниковые
нагревательные
элементы [2].
Одной из электрофизических характеристик
полупроводников является концентрация. Она изменяется в зависимости от
температуры. По температурной зависимости концентрации свободных носителей
заряда в координатах ln(n)= f(1/T) можно определить энергия ионизации донорного
или акцепторного уровня и ширину запрещённой зоны.
Другой характеристикой полупроводников является
электропроводность.
Электропроводность собственных полупроводников
является прямой линией построенной в координатах ln(у)= f(1/T). Угол наклона
этой прямой определяет ширину запрещённой зоны собственного полупроводника.
Уровень Ферми также является электрофизической
характеристикой полупроводников. Энергия уровня Ферми также изменяется от
температуры.
1. Полупроводники
.1 Классификация веществ по электропроводности
Все твердые тела по электрофизическим свойствам
разделяются на три основных класса: металлы, диэлектрики и полупроводники. Если
в основу классификации положить величину удельной электропроводности s,
то при комнатной температуре она имеет значения в следующих пределах:
металлы - (107 - 106)
Сим/м
полупроводники - (10-8 - 106)
Сим/м
диэлектрики - (10-8 - 10-16)
Сим/м.
Такая чисто количественная классификация
совершенно не передает специфических особенностей электропроводности и других
свойств, сильно зависящих для полупроводника от внешних условий (температуры,
освещенности, давления, облучения) и внутреннего совершенства кристаллического
строения (дефекты решетки, примеси и др.) [3].
Рассмотрим, например, температурную зависимость
проводимости металлов и полупроводников.
Для химически чистых металлов с ростом
температуры сопротивление увеличивается по линейному закону в широком
температурном интервале
R(t)=R0(1+at),
(1.1.1)
где R0
- сопротивление при t=0°C,
R(t)
- сопротивление при t°C,
a - термический коэффициент сопротивления, равный
примерно 1/273.
Для металлов
 . (1.1.2)
. (1.1.2)
Для полупроводников сопротивление с
ростом температуры быстро уменьшается по экспоненциальному закону
 , (1.1.3)
, (1.1.3)
где R0, B - некоторые
постоянные для данного интервала температур величины, характерные для каждого
полупроводникового вещества. На рисунке 1.1 представлены температурные
зависимости сопротивления металлов и полупроводников.
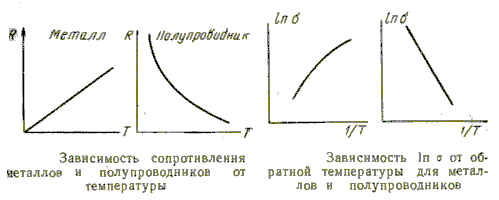
Рисунок 1.1 - Температурные
зависимости сопротивления металлов и полупроводников.
Для удельной проводимости формулу
можно записать в виде
 , (1.1.4)
, (1.1.4)
Или
 , (1.1.5)
, (1.1.5)
где Eа - энергия
активации, k - константа
Больцмана. Наличие энергии активации Eа означает,
что для увеличения проводимости к полупроводниковому веществу необходимо
подвести энергию.
В идеальной решетке все электроны связаны,
свободных носителей заряда нет, и поэтому при наложении электрического поля
электрический ток возникнуть не может [4]. Для его возникновения необходимо
часть электронов сделать свободными. Но для отрыва электрона необходимо
затратить энергию. Ее можно подвести к решетке в виде энергии фотона или в виде
энергии тепловых колебаний решетки. При наложении на кристалл электрического
поля E свободные
электроны, участвуя в хаотическом тепловом движении, будут испытывать действие
силы enE
и придут в дрейфовое движение против поля. Если обозначить концентрацию
электронов через n, их
подвижность через mn,то
плотность электрического тока будет равна
Jn
= qn
mn
E=sn
E, (1.1.6)
где через qn
обозначен заряд электрона.
В полупроводниках проводимость зависит от
внешних условий, поскольку, меняя интенсивность освещения, облучение или
температуру, можно менять концентрацию носителей заряда в широких пределах, в
то время как в металлах число электронов остается неизменным при изменении
внешних условий и температуры. Однако это не единственное различие между
металлами и полупроводниками. В последних существует два механизма проводимости
[2].
Незавершенная связь вследствие движения
электронов может перемещаться от атома к атому, т.е. может совершать
хаотические движения по кристаллу. При наложении внешнего электрического поля E
на связанные электроны будет действовать сила qnE,
поэтому они, перемещаясь против поля, будут занимать вакантную связь. Наличие
вакансий в связях позволяет валентным электронам перемещаться против поля. Тем
самым совокупность валентных электронов также участвует в образовании проводимости
полупроводников.
Удобнее рассматривать не движение совокупности
валентных электронов, а движение вакантных связей.
Обозначив число вакантных связей через p,
а их подвижность через mp,
можно выразить ток совокупности связанных электронов следующим образом:
Jp
= qp
mp
pE = sp
E. (1.1.7)
Вакантная связь получила название дырки. Дырки
рассматривают как некие квазичастицы, движение которых вполне адекватно
движению валентных электронов.
.2 Собственные и примесные полупроводники
.2.1 Носители заряда в собственных
полупроводниках
Проводимость химически чистых (беспримесных)
полупроводников называется собственной проводимостью, а сами полупроводники -
собственными полупроводниками.
На рисунке 1.2,а показана зонная структура
собственного полупроводника при абсолютном нуле: над полностью укомплектованной
валентной зоной I на
расстоянии Eg располагается совершенно свободная зона II.
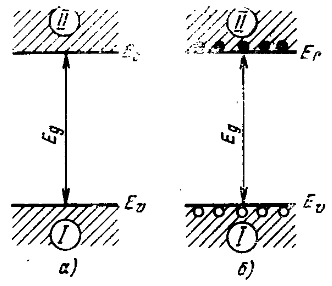
Рисунок 1.2 - Зонная структура собственного
полупроводника:
а - невозбужденного; б - возбужденного.
При температуре Т, отличной от абсолютного нуля,
часть электронов из валентной зоны переходит в свободную зону II
(рисунок 1.2,б), которая, оказавшись укомплектованной лишь частично, становится
зоной проводимости. С другой стороны, ранее целиком заполненная зона I,
потеряв часть электронов, превращается в зону, заполненную также лишь частично.
Появление таких зон делает тело проводником [5].
Таким образом, основная особенность
полупроводника состоит в том, что электрическая проводимость его является
активированной: она появляется лишь под воздействием внешнего ионизирующего
фактора (температуры, облучения, сильного электрического поля и др.),
способного электроны валентной зоны перебросить в зону проводимости.
Зона проводимости, в которую переходит
относительно небольшое число электронов из валентной зоны, заполняется
частично. Перешедшие электроны занимают преимущественно наиболее низкие уровни,
расположенные у дна зоны. Как показано в предыдущей главе, во внешнем поле E,
созданном в полупроводнике, такие электроны ведут себя нормально, как частицы,
обладающие отрицательным зарядом и положительной эффективной массой. От
свободных электронов они отличаются лишь величиной этой массы.
Появление в валентной зоне вакантных мест
(незаполненных уровней) делает возможным возникновение коллективного движения
электронов этой зоны под действием внешнего поля, которое удобно описывать,
пользуясь понятием «дырки».
Поведение электронов и дырок удобно
рассматривать на языке состояний, сопоставляя электрону занятое состояние в
зоне, дырке - свободное состояние. Это позволяет усмотреть симметрию между
зоной проводимости и валентной зоной: в зоне проводимости занятые состояния
перемещаются на фоне свободных состояний, в валентной зоне - свободные состояния
перемещаются на фоне занятых. При этом статистика занятых состояний в зоне
проводимости оказывается аналогичной статистике свободных состояний в валентной
зоне [4].
.2.2 Носители заряда в примесных полупроводниках
В отличие от собственных полупроводников, в
которых проводимость осуществляется одновременно электронами и дырками, в
примесных полупроводниках проводимость обусловливается в основном носителями
одного знака: электронами в донорных полупроводниках (в полупроводниках n-типа)
и дырками в акцепторных полупроводниках (в полупроводниках p-типа).
Эти носители называются основными [3].
Помимо основных носителей полупроводник содержит
всегда и неосновные носители: электронный полупроводник- дырки, дырочный
полупроводник - электроны. Концентрация их, как правило, значительно ниже
концентрации основных носителей. Связь между концентрациями основных и
неосновных носителей в полупроводнике будет рассмотрена ниже.
1.2.3 Невырожденные и вырожденные полупроводники
Число электронов в зоне проводимости и дырок в
валентной зоне полупроводника обычно значительно меньше числа квантовых
состояний, содержащихся в этих зонах. Поэтому средняя плотность заполнения
состояний электронами и дырками f оказывается значительно меньше единицы:
<< 1. (1.2.1)
Функция f представляет собой функцию
распределения частиц по состояниям, а условие (1.2.1) - критерий
невырожденности газа [3].
Таким образом, электронный газ в зоне
проводимости и дырочный газ в валентной зоне являются обычно газами
невырожденными. Полупроводники, у которых газ носителей является невырожденным,
называются невырожденными полупроводниками.
Однако условие (1.2.1) выполняется в
полупроводниках не всегда и газ носителей в них может находиться и в
вырожденном состоянии. Такие полупроводники называются вырожденными.
.3 Эффективная масса плотности состояний
Выражение для плотности состояний в
энергетическом пространстве для электронов в кристалле может быть записано
следующим образом:

Масса mc,
входящая в формулу (1.3.1), представляет собой эффективную массу носителей
заряда. Ее называют эффективной массой плотности состояний [3]. Для свободных
электронов она равна просто массе электрона m;
для кристаллов со сферическими зонами - изотропной эффективной массе электрона.
Для кристаллов, обладающих многодолинной структурой энергетических зон,
эффективная масса плотности состояний mc,
входящая в формулу (1.3.1) равна:
где l
- число долин в зоне; m1,
m2,
m3
- эффективные массы в направлениях kx,
ky, kz.
В частности для кремния, имеющего 6 долин, каждая из которых представляет
эллипсоид вращения, эффективная масса плотности состояний электронов в зоне
проводимости равна:

где ml,
mt -соответственно
продольная и поперечная эффективные массы электрона.
Для германия, имеющего 4 долины, эффективная
масса плотности состояний электронов в зоне проводимости равна:

Экспериментальные измерения показывают, что для
кремния ml
= 0,98m, mt
= 0,19m, поэтому

Для германия ml
= 1,64m, mt
= 0,082m, и mc
=0,56m. (1.3.6)

1.4 Статистика носителей в
собственных полупроводниках
Рассмотрим электронный газ в зоне
проводимости. Примем за начало отсчета энергии электронов дно зоны проводимости
(рис. 1.3,а). Химический потенциал электронов зоны проводимости равен:

где n -
концентрация электронов в зоне проводимости;

эффективное число состояний в зоне,
приведенное ко дну зоны проводимости (к E = 0). Так
как для невырожденного газа n < Nc, то µn < 0.
Следовательно, уровень Ферми (уровень химического потенциала) для электронов
зоны проводимости должен располагаться ниже дна зоны, причем тем ниже, чем
меньше концентрация электронов в зоне, т. е. чем более невырожденным является
электронный газ. С увеличением концентрации электронов в зоне уровень Ферми
непрерывно поднимается ко дну зоны. На рисунке 1.3,а - г показаны положения уровня
Ферми при различных степенях заполнения зоны проводимости электронами; занятые
состояния в зоне выделены вертикальной штриховкой.

Рисунок 1.3 - Изменение положения
уровня Ферми при установлении равновесия между электронами зоны проводимости и
дырками валентной зоны:
а, б - неравновесные состояния при
которых число электронов в зоне проводимости и дырок в валентной зоне меньше
равновесного; в - установление равновесия между электронами и дырками. Уровни
Ферми µn и µp сливаются в
один общий уровень; г - неравновесное состояние, при котором концентрация
электронов и дырок выше равновесной [3].
Рассмотрим теперь дырочный газ в
валентной зоне. За начало отсчета энергии дырок примем, как и ранее, потолок
валентной зоны (рисунок 1.3,а). Химический потен- потенциал дырок равен:

где р - концентрация дырок в
валентной зоне;

- эффективное число незанятых
состояний в валентной зоне, приведенное к ее потолку. Так как p < Nv, то µp < 0 и
уровень Ферми для дырок располагается выше потолка валентной зоны. На рисунке
1.3,а-г показано изменение положения уровня Ферми для дырок по мере увеличения
их концентрации в валентной зоне.
Из рисунка 1.3 видно, что в общем
случае уровни Ферми для электронов µn и для дырок
µp могут не
совпадать друг с другом. Только с установлением равновесия между электронами и
дырками уровни µn и µp сливаются,
образуя единый равновесный уровень µ. Этот случай показан на рис. 1.3,в.
Рисунки 1.3,а и б соответствуют неравновесным состояниям, при которых
концентрация электронов в зоне проводимости и дырок в валентной зоне ниже равновесной.
Установление равновесия происходит путем самопроизвольного перехода электронов
из валентной зоны в зону проводимости, показанного на рисунках широкими
стрелками. Рисунку 1.3,г отвечает неравновесное состояние, при котором
концентрация электронов и дырок выше равновесной. В этом случае установление
равновесия происходит путем перехода избыточных электронов из зоны проводимости
в валентную зону [6].
Обозначим расстояние от равновесного
уровня Ферми до дна зоны проводимости через µ, до потолка валентной зоны -
через µ' (рис. 1.3,в). Тогда выражения (1.4.1) и (1.4.3) перепишутся следующим
образом:


где ni и pi
- соответственно равновесные концентрации электронов в зоне проводимости и
дырок в валентной зоне собственного полупроводника. Из (1.4.5) и (1.4.6)
следует, что


Так как µ и µ’ являются величинами
отрицательными, то из (1.4.7) и (1.4.8) вытекает, что равновесная концентрация
носителей в зоне тем ниже, чем дальше от нее отстоит равновесный уровень Ферми.
Если за нуль отсчета энергии для
электронов и дырок принять дно зоны проводимости, то, как видно из рисунка
1.4.1, в, µ + µ’ = - Еg.
Отсюда находим:

Подставив это выражение в (1.4.8),
получим:

Ввиду того, что в собственных
полупроводниках носители возбуждаются всегда парами, имеет место следующее
равенство:

Приравняв правые части выражений
(1.4.7) и (1.4.10), получим:

Отсюда находим выражение для
равновесного уровня Ферми:

Подставив в (1.4.12) Nv
из (1.4.4) и Nc из (1.4.2),
получим:

Из (1.4.13) видно, что при
абсолютном нуле

равновесный уровень Ферми в
собственном полупроводнике располагается посередине запрещенной зоны [5]. С
повышением температуры он поднимается обычно несколько вверх, так как
эффективная масса дырок, как правило, больше эффективной массы электронов,
располагающихся в зоне проводимости. Для большинства собственных
полупроводников при обычных температурах это смещение столь мало, что им
пренебрегают. Однако в таких полупроводниках, как InSb, в котором mp/mn » 20 и Eg » 0,l7 эВ,
этим смещением уже при комнатной температуре пренебрегать нельзя.
Подставив µ из (1.4.12) и (1.4.13) в
(1.4.7) или в (1.4.10), получим следующее выражение для равновесной
концентрации носителей в собственных полупроводниках:

Из (1.4.15) видно, что равновесная
концентрация носителей тока в собственном полупроводнике определяется шириной
запрещенной зоны и температурой полупроводника. В качестве примера в таблице
1.1 приведена концентрация носителей при комнатной температуре в кремнии,
германии и сером олове, имеющих один и тот же тип решетки, но различную ширину
запрещенной зоны. Из данных таблицы 1.1 видно, что уменьшение ширины
запрещенной зоны с 1,21 до 0,08 эВ (»
в 15 раз) вызывает увеличение концентрации носителей примерно на 9 порядков.
Таблица 1.1 - Концентрация носителей
при комнатной температуре в Si, Ge и Sn.
|
полупроводники
|
Si
|
Ge
|
Sn
|
|
Eg, эВ
ni, м-3
|
1,21
1015
|
0,72
1019
|
0,08
1024
|
Таблица 1.2 - Изменение концентрации носителей в
германии.
|
T, K
|
100
|
300
|
600
|
|
ni, м-3
|
3·107
|
3·1019
|
3·1023
|
В таблице 1.2 показано изменение концентрации
носителей в германии при изменении температуры. Увеличение температуры со 100
до 600° К приводит к увеличению концентрации носителей примерно на 16 порядков.[3]
2. Определение электрофизических свойств
полупроводников
Для свободных электронов эффективная масса
плотности состояний me
равна просто массе электрона m0.
Для кристаллов, обладающих многодолинной структурой энергетических зон,
эффективная масса плотности состояний будет равна [3]:
 (2.1.1)
(2.1.1)
где М - число долин в зоне; m1, m2, m3 -
эффективные массы в направлениях kx, ky, kz.
В частности, для моего варианта
эффективная масса плотности состояний электронов в зоне проводимости и дырок в
валентной зоне равна:


 (2.1.2)
(2.1.2)


 (2.1.3)
(2.1.3)
.2 Статистика электронов в примесных
полупроводниках донорного типа
На рисунке 2.1,а показана зонная
структура примесного полупроводника n-типа.
Обозначим концентрацию примеси (число донорных атомов в единице объема
кристалла) через NД. Энергию
электрона в зоне проводимости будем откладывать, как всегда, вверх от дна зоны,
энергию вакансий (дырок), образующихся на примесных уровнях - вниз от этих
уровней.
Рассмотрим положение равновесного
уровня Ферми и равновесную концентрацию электронов в зоне проводимости при
различных температурах полупроводника.
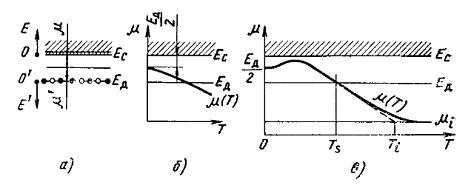
Рисунок 2.1 - Изменение положения
уровня Ферми в зависимости от температуры в примесных полупроводниках n-типа:
а - зона проводимости и примесные
уровни; б - изменение - при Nд < Nc; в -
изменение - при Nд > Nc [3].
.2.1 Область низких температур
Рассмотрим область примесной
проводимости. Изобразим энергетическую зонную диаграмму донорного
полупроводника для заданного диапазона температур (рисунок 2.2). В области
низких температур, в котором kT << Ed, переходами
электронов из валентной зоны в зону проводимости можно пренебречь и считать,
что все электроны проводимости появляются в результате ионизации донорной
примеси.
электропроводность заряд энергия
температура

Рисунок 2.2 - Энергетическая зонная диаграмма
донорного полупроводника для области низких температур [7].
Равновесная концентрация этих электронов,
согласно (1.4.1), равна

где 
 - расстояние от дна зоны
проводимости до равновесного уровня Ферми.
- расстояние от дна зоны
проводимости до равновесного уровня Ферми.
Равновесная концентрация
ионизированных доноров равна:

где 
 - расстояние от примесных уровней
до уровня Ферми. Так как полное число примесных состояний равно концентрации
примесных атомов Nд, а
- расстояние от примесных уровней
до уровня Ферми. Так как полное число примесных состояний равно концентрации
примесных атомов Nд, а 
 то (2.2.2) можно переписать
следующим образом:
то (2.2.2) можно переписать
следующим образом:

В приближении, в котором
концентрацией свободных электронов в зоне проводимости можно пренебречь, n должно,
очевидно, равняться p. Приравнивая (2.2.1) и (2.2.3),
получим:

Отсюда находим равновесный уровень
Ферми:

При T = 20К имеем


Ниже приведена таблица зависимости
энергии уровня Ферми от температуры для данной области.
Таблица 2.1 - Зависимость энергии
уровня Ферми от температуры в области низких температур.
|
Т,
К
|
  , Дж , Дж
|
|
20
|
-0,029·10-20
|
|
30
|
-0,026·10-20
|
|
40
|
-0,028·10-20
|
|
50
|
-0,032·10-20
|
|
60
|
-0,038·10-20
|
|
70
|
-0,045·10-20
|
|
80
|
-0,054·10-20
|
|
90
|
-0,065·10-20
|
|
100
|
-0,076·10-20
|
|
110
|
-0,089·10-20
|
|
120
|
-0,103·10-20
|
При абсолютном нуле равновесный уровень Ферми
располагается посередине между дном зоны проводимости и примесными уровнями
[7].
При повышении температуры в
полупроводнике протекают два процесса: увеличение концентрации электронов n вследствие
ионизации примесных атомов и увеличение числа состояний в зоне Nc ~ T3/2. Если n растет
медленнее, чем Nc, что имеет место при Nд < Nc, то степень
невырожденности газа увеличивается и уровень Ферми (1.4.1) опускается вниз
(рисунок 2.1,б). Если n растет быстрее Nc (при Nд > Nc), то степень
невырожденности газа уменьшается и 
 поднимается вверх до тех пор, пока Nд не
сравняется с Nc. При
дальнейшем повышении температуры n начинает снова отставать от Nc и
поднимается вверх до тех пор, пока Nд не
сравняется с Nc. При
дальнейшем повышении температуры n начинает снова отставать от Nc и 
 начинает опускаться вниз примерно
пропоционально T, как показано на рисунке 2.1,в [3].
начинает опускаться вниз примерно
пропоционально T, как показано на рисунке 2.1,в [3].
Подставив в (2.2.1) равновесный
уровень Ферми из (2.2.4), получим следующее выражение для равновесной
концентрации электронов проводимости:

При T = 20К имеем

Ниже приведена таблица зависимости
концентрации свободных носителей заряда от температуры для данной области.
Таблица 2.2 - Зависимость
концентрации свободных носителей заряда от температуры в области низких
температур.
|
Т,
К
|
n, м-3
|
|
20
|
|
30
|
3,337·1024
|
|
40
|
5,963·1024
|
|
50
|
8,713·1024
|
|
60
|
1,15·1024
|
|
70
|
1,428·1024
|
|
80
|
1,703·1024
|
|
90
|
1,973·1024
|
|
100
|
2,238·1024
|
|
110
|
2,498·1024
|
|
120
|
2,754·1024
|
.2.2 Область истощения примеси
Рассмотрим область истощения примеси. Изобразим
энергетическую зонную диаграмму для донорного полупроводника для данного
диапазона температур (рисунок 2.3).
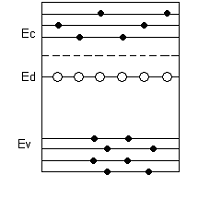
Рисунок 2.3 - Энергетическая зонная диаграмма
донорного полупроводника для области истощения примеси [7].
По мере повышения температуры концентрация
электронов в зоне проводимости увеличивается, концентрация электронов на
примесных уровнях уменьшается - примесные уровни постепенно истощаются. При
полном истощении этих уровней концентрация электронов в зоне проводимости
становится равной концентрации примеси:

Т. е. для всей области истощения примеси
концентрация электронов в зоне проводимости постоянна и равна

Подставив это значение n
в (1.4.1), получим равновесный уровень Ферми, отвечающий полному истощению
примеси:

где Ts -
температура, при которой происходит полное истощение примеси. Уровень 
 должен располагаться ниже Eд, так как
при
должен располагаться ниже Eд, так как
при 
 ионизации подвергается примерно
лишь половина примесных уровней. Часто, однако, за температуру истощения
примеси принимают температуру Ts, при
которой уровень Ферми совпадает с донорными уровнями Eд:
ионизации подвергается примерно
лишь половина примесных уровней. Часто, однако, за температуру истощения
примеси принимают температуру Ts, при
которой уровень Ферми совпадает с донорными уровнями Eд: 
 .
.
Подставив значение 
 в (1.4.1) и положив в этой формуле n = Nд/2, получим:
в (1.4.1) и положив в этой формуле n = Nд/2, получим:

Из (2.2.8) видно, что Ts тем ниже,
чем меньше энергия ионизации доноров Eд и ниже их
концентрация Nд. Для
германия с Nд = 1022
м-3 и Eд = 0,01 эВ Ts = 32 К.
Произведем приближенный расчет
температуры истощения примеси TS:



Произведем числовой расчет
зависимости энергии уровня Ферми от температуры:


Ниже приведена таблица зависимости
энергии уровня Ферми от температуры для данной области.
Таблица 2.3 - Зависимость энергии
уровня Ферми от температуры в области истощения примеси.
|
Т,
К
|
  , Дж , Дж
|
|
130
|
-0,117·10-20
|
|
201
|
-0,363·10-20
|
|
272
|
-0,661·10-20
|
|
343
|
-0,998·10-20
|
|
414
|
-1,366·10-20
|
|
845
|
-1,759·10-20
|
|
556
|
-2,174·10-20
|
|
627
|
-2,608·10-20
|
|
698
|
-3,058·10-20
|
|
769
|
-3,524·10-20
|
|
840
|
-4,003·10-20
|
.2.3 Область высоких температур (область
перехода к собственной проводимости)
Рассмотрим область собственной проводимости.
Изобразим энергетическую зонную диаграмму для данного диапазона температур
(рисунок 2.4).

При всех температурах, отличных от абсолютного
нуля, термическому возбуждению подвергаются не только электроны примесных
атомов, но и электроны валентной зоны. Поэтому концентрация электронов в зоне
проводимости равна сумме концентраций «примесных» электронной nпр
и собственных ni:

Выше температуры истощения примесей nпр
»
Nд
и

До тех пор, пока ni
<< Nд,
концентрация электронов в зоне проводимости сохраняется практически неизменной
и равной Nд.
Однако при достаточно высоких температурах концентрация собственных носителей
может не только достичь значения Nд,
но и значительно превзойти его. В этом случае концентрацией «примесных»
электронов в (2.2.9) можно пренебречь и считать, что n
»
ni. Это соответствует
переходу к собственной проводимости полупроводника [5].
С учетом этого уравнение (2.2.8) можно
переписать в виде:

Подставим в уравнения (1.4.2), (1.4.4) и
(2.2.10) числовые значения:




Ниже приведена таблица зависимости концентрации
свободных носителей заряда от температуры для данной области.
Таблица 2.4 - Зависимость концентрации свободных
носителей заряда от температуры в области высоких температур.
|
Т,
К
|
n, м-3
|
|
843
|
3,002·1025
|
|
853
|
3,187·1025
|
|
863
|
3,379·1025
|
|
873
|
3,579·1025
|
|
893
|
3,786·1025
|
|
903
|
4,001·1025
|
|
913
|
4,224·1025
|
|
923
|
4,455·1025
|
|
933
|
4,694·1025
|
|
943
|
4,941·1025
|
|
953
|
5,197·1025
|
Рассмотрим характер изменения равновесного
уровня Ферми в этой области температур. Подставив n
из (2.2.9) в (1.4.1), получим:

При достаточно низких температурах второе
слагаемое в скобках мало по сравнению с первым и уровень ферми изменяется с
температурой практически линейно, как показано на рисунке 2.1,в. С увеличением
температуры в (1.4.1), получим:

непрерывно уменьшается и 
 стремится к предельному значению,
равному:
стремится к предельному значению,
равному:

химический потенциал электронного
газа в собственном полупроводнике. Это и означает переход к собственной
проводимости полупроводника. За температуру такого перехода принимают
температуру Ti, при
которой пунктирная прямая, показанная на рисунке 2.1,в и описываемая уравнением
(2.2.7), пересекает уровень Ферми в собственном полупроводнике (1.4.11) [5].
Приравнивая при Ti правые части (1.4.11) и (2.2.7),
получим:

Отсюда находим:

Из (2.2.13) видно, что температура
перехода к собственной проводимости тем выше, чем шире запрещенная зона
полупроводника и больше концентрация примеси в нем. Для германия при Nд = 1022
м-3 Ti = 450 К. Произведем приближенный
расчет температуры перехода к собственной проводимости Ti:


Произведем числовой расчет энергии
уровня Ферми:




Ниже приведена таблица зависимости
энергии уровня Ферми от температуры для данной области.
Таблица 2.5 - Зависимость энергии
уровня Ферми от температуры в области высоких температур.
|
Т,
К
|
  , Дж , Дж
|
|
843
|
-4,0,23·10-20
|
|
853
|
-4,021·10-20
|
|
863
|
-4,019·10-20
|
|
873
|
-4,018·10-20
|
|
893
|
-4,016·10-20
|
|
903
|
|
913
|
-4,012·10-20
|
|
923
|
-4,01·10-20
|
|
933
|
-4,009·10-20
|
|
943
|
-4,007·10-20
|
|
953
|
-4,005·10-20
|
По формулам (2.2.5), (2.2.6), (2.2.10) в среде
математического моделирования MathCAD
построим графики для всех трех областей в координатах ln(n)=
f(1/T)
для приближенных значений Ts
и Ti.
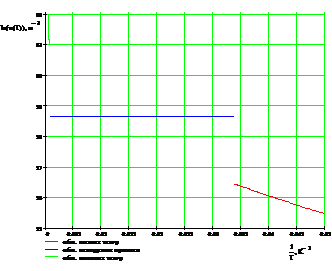
Рисунок 2.5 - Температурная
зависимость концентрации свободных носителей заряда в полупроводнике донорного
типа с учетом приближенных значений температур Ts и Ti.
В графическом редакторе Paint графики
были дочерчены до пересечения между собой. И методом трассировки были
определены точные значения температур истощения примеси Ts = 1/0,0077
= 129,9 К и перехода к собственной проводимости Ti = 1/0,0012
= 843 К (рисунок 2.6).

Рисунок 2.6 - Температурная
зависимость концентрации свободных носителей заряда в полупроводнике донорного
типа с учетом точных значений температур Ts и Ti.
Построим график температурной
зависимости концентрации свободных носителей заряда в полупроводнике донорного
типа с учетом найденных температурных интервалов.

Рисунок 2.7 - Температурная
зависимость концентрации свободных носителей заряда в полупроводнике донорного
типа.
На рисунке 2.7 показана кривая
зависимости натурального логарифма из концентрации электронов в зоне
проводимости полупроводника от обратной температуры. На кривой можно выделить
три участка: участок АБ, отвечающий примесной проводимости полупроводника,
участок БВ, соответствующий области истощения примеси, и участок ВГ, отвечающий
собственной проводимости полупроводников [7]. Из (2.2.6) и (1.4.15) следует,
что


По формулам (2.2.4), (2.2.7),
(2.2.11) и исходным данным курсовой работы в среде математического
моделирования MathCAD был
построен график зависимости энергии уровня Ферми от температуры.
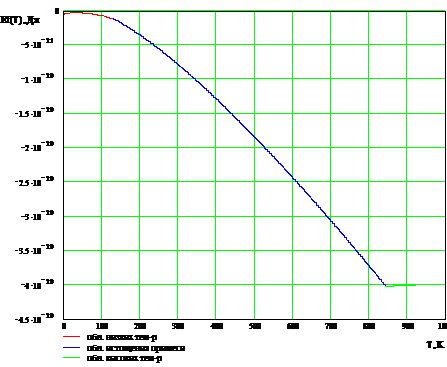
Рисунок 2.8 - Температурная
зависимость энергии уровня Ферми в полупроводнике донорного типа.
Заключение
В ходе выполнения данной курсовой
работы мною была рассчитана эффективная масса плотности состояний электронов в
зоне проводимости и дырок в валентной зоне, определена эффективная плотность
состояний в валентной зоне и зоне проводимости, найдены значения температуры
истощения примесей и температуру перехода к собственной проводимости
графическим методом в среде математического моделирования MathCAD: Тs = 129,9К, Тi = 843К.
Также были рассчитаны концентрации свободных носителей заряда и построены
графики зависимости концентрации свободных носителей заряда от температуры в
координатах ln(n)= f(1/T) для всех
3-х областей. Рассчитана энергия уровня Ферми в зависимости от температуры для
всех 3-х областей и построены графики температурной зависимости энергии уровня
Ферми в координатах Еf= f(T).
Произведен анализ литературных данных, на основе которых составлен алгоритм
выполнения поставленной задачи и получены формулы, необходимые для расчета.
Список используемых источников
1. Антонова В.А., Бородин А.В.,
Гордиенко Ю.Е., Слипченко Н.И. Материалы электронной техники. Учеб. пособ. -
Харьков., ХНУРЭ, 2001. - С. 160.
2. Зиненко. Физика твёрдого
тела.- С. 244-245.
. Епифанов Г.И. Физические
основы микроэлектроники. М., «Советское радио», 1971. - С.150-170.
. Ашкрофт Н., Мермин Н.
Физика твёрдого тела.- М., Мир, 1979.- Т.2.- С. 188.
. Киттель Ч. Введение в
физику твердого тела. М., 1963. - С.390
. Бонч-Бруевич В.Л.,
Калашников С.Г. Физика полупроводников. М., 1977. - с. 679.
. Конспект лекций по физике
твердого тела. - II
семестр.