Установка фотонного отжига
Содержание
Введение
. Ионная имплантация как метод
легирования полупроводников
. Механизмы импульсного фотонного
отжига
. Особенности отжига GaAs
. Экспериментальная часть
Выводы
Список литературы
Введение
Ионно-имплантированные структуры GaAs
нашли широкое применение при изготовлении различных полупроводниковых приборов,
в частности, СВЧ полевых транзисторов с барьером Шоттки. Основные преимущества
использования таких структур связаны, прежде всего, с высокой однородностью
электрических параметров по площади (не хуже 1-2 %), высокой повторяемостью
параметров от одного технологического цикла к другому, относительной простотой
процесса и высокой производительностью, что обеспечивается применением
соответствующего технологического оборудования.
Однако арсенид галлия в технологическом
отношении является более сложным материалом по сравнению с кремнием. При
высоких температурах происходит разложение материала за счёт испарения As с
поверхности. Это создаёт дополнительные трудности при проведении послеимплантационного
отжига структур и вызывает необходимость защиты поверхности при обычном
термическом отжиге или методик импульсного отжига.
Применение импульсных источников энергии для
отжига ионно-легированных структур даёт ряд преимуществ по сравнению с традиционным
термическим отжигом. Наиболее распространёнными методами являются импульсный
лазерный и некогерентный (фотонный) отжиг. Главные их отличия заключаются в
различной степени монохроматичности света, различной плотности потока энергии,
различной длительности импульсов.
При импульсном некогерентном (фотонном) отжиге,
в отличии от лазерного, процесс отжига происходит в твёрдой фазе при
сопоставимых длительностях импульсов, вследствие чего образец прогревается на
всю толщину. Тем не менее, по сравнению с обычным термическим отжигом, процесс
перестройки дефектной структуры происходит значительно быстрее (порядка десятка
секунд), поэтому фотонный отжиг не сопровождается диффузным размыванием профиля
имплантированной примеси.
Преимуществом импульсного отжига световыми
потоками является высокая степень активации примесей, которая приближается к 1.
Поэтому отработка технологии импульсного, в особенности фотонного, отжига
является актуальной задачей в рамках разработки общего технологического
процесса создания ионно-имплантированных GaAs - структур.
1. Ионная имплантация как метод
легирования полупроводников
При отжиге имплантированных слоев возникают две
качественно различные ситуаций: отжиг материала, который под действием ионной
бомбардировки перешел в аморфное состояние, и отжиг частично разупорядоченной
кристаллической решетки. Последняя реализуется при внедрении малых доз легких
ионов, или при облучений нагретых подложек.
Если легируемый ионами слой аморфизировался, то
его восстановление в процессе нагрева, протекает в одну стадию, представляющую
собой эпитаксиальную кристаллизацию на ориентирующей неповрежденной подложке.
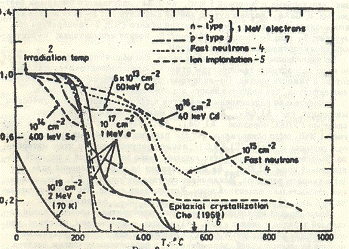
Рис. 1. Данные изохронного отжига для n- и p-
GaAs, облученного электронами (1 МэВ), быстрыми нейтронами и подвергнутого
ионной имплантации
На рис. 1 показаны данные изохронного отжига для
n- и p-типа GaAs, облученного электронами, быстрыми нейтронами подвергнутого
ионной имплантации. Как видно из рисунка, отжиг дефектов в
ионно-имплантированных образцах происходит при более высоких температурах, чем
в образцах облученных электронами или быстрыми нейтронами. При этом, с
увеличением дозы облучения, стадии изохронного отжига сдвигаются в сторону
высоких температур. Дефекты, вводимые при малых дозах имплантации (~ 1014см-2)
отжигаются главным образом на стадиях при 225 и 4000С, характерных для больших
доз или высоких энергии электронов. С другой стороны, при больших дозах
имплантации (>1015см-2) стадии отжига значительно
уширяются, и новая стадия появляется в окрестности 600-7000С. Интересен тот
факт, что аморфные пленки GaAs на подложке GaAs, эпитаксиально кристаллизуются
менее чем за час, при 5800С. Это похоже на отжиг сильно разупорядоченных (почти
аморфных) областей ионной имплантации и действительно, происходит
приблизительно в том же температурном диапазоне.
Для GaAs твердофазная рекристаллизация
начинается при достаточно низких температурах (~2500С) и приводит к
восстановлению монокристалличности материала. Однако для отжига микро-двойников
и активации примеси требуются значительно более высокие температуры
(800-9000С). В этом температурном интервале наблюдается преимущественное
испарение мышьяка с поверхности GaAs. Поэтому, без дополнительного подвода
мышьяка из внешнего источника, незащищенная поверхность GaAs морфологически
сильно деградирует при температурах свыше 657±100С, т.е. выше точки испарения
As. Следует также отметить, что при высоких температурах галлий также уходит с
поверхности, хотя и не столь интенсивно, как мышьяк. Поэтому, возникает необходимость
предохранения поверхности GaAs защитными пленками.
Более сложный характер процесса рекристаллизации
ионно-имплантированного GaAs обусловлено и тем фактом, что для этого материала
увеличение числа дефектов и внутреннего напряжения с дозой имплантации, вплоть
до полной аморфизации, носит нелинейный и немонотонный характер.
Возникающие, при ионной имплантации, напряжения
могут быть настолько велики, что приводят к прогибанию подложки. С ионной
имплантацией наблюдается также и изменение объема кристаллов в сторону
уменьшения - в случае GaAs. Путем вычислений было показано, что имплантация
ионов в GaAs, ведет к нарушению стехиометрии. Полное восстановление
поврежденной решетки зависит от возможности обеспечивать правильное соотношение
элементов на границе раздела между поврежденной и рекристаллизованной
областями.
Поэтому, для высококачественной твердофазной
рекристаллизации, при наличии нарушений стехиометрий, требуются условия, при
которых элементы, образующие решетку, могут диффундировать на большие расстояния.
Действительно, в случае внедрения тяжелых ионов и сильного повреждения решетки,
когда происходит нарушение стехиометрии, для хорошей электроактивации примеси
требуется проведение процесса имплантации при повышенных температурах.
Вместо традиционного термического отжига, после
ионной имплантации, использование импульсного фотонного воздействия (включающее
как лазерный, так и ламповый отжиг) дало возможность не только решить, ряд
трудностей связанных с длительным высокотемпературным термическим воздействием
на кристаллы, но были получены результаты принципиально не достижимые
термоотжигом. Эти особенности ЛО, связанные с существенно неравновесным
характером: высокое совершенство восстановленной кристаллической структуры,
повышенная эффективность легирования, возможность получения метастабильных
пересыщенных систем, локальность отжига в 3-х измерениях.
Импульсный отжиг успешно применяется для
устранения радиационных дефектов в имплантированных слоях. Но возможность
использования коротких импульсных воздействий для восстановления
кристаллической решетки на первых порах была не очевидной. Было не ясно также,
какое влияние окажут на процессы отжига различные факторы, сопутствующие
облучению твердого тела импульсами большой мощности.
2. Механизмы импульсного фотонного
отжига
Имеющиеся на сегодняшний день модели импульсного
фотонного отжига условно можно разделить на две группы: термические и
атермические модели. Под понятием атермических факторов способных повлиять на
процессы лазерного отжига указываются генерированием светом за счет ионизации
неравновесных электронов и дырок, возникновение ударных нагрузок генерация
вакансии, когерентное взаимодействие лазерного излучения с атомами
кристаллической решетки.
Из перечисленных факторов наибольшее внимание привлекают
ионизационные эффекты. Механизм ионизационного ускорения отжига, согласно
различным моделям, заключается в изменении зарядового состояния дефектов,
преимущественной рекомбинации неравновесных носителей на несовершенствах
решетки, разрыве связей и в изменении потенциальной энергии компонентов пар
Френкеля.
Рассмотрим эти модели подробнее.
1) Тепловая модель лазерного отжига.
В тепловой модели плавления и рекристаллизации
считается, что энергия светового импульса передается фотовозбужденными носителями
в решетку в виде тепла. В результате этого происходят локальный разогрев
приповерхностного слоя, его плавление и последующая рекристаллизация.
Сторонники тепловой модели исходят из
предположения, что при типичных режимах наносекундного ЛО основным механизмом
безизлучательной рекомбинации является оже-рекомбинация с характерными
временами τ ≤ 10-9с. Если
это так, то энергия светового кванта передается в той же самой области, где он
поглотился. Если учесть, что коэффициент поглощения при типичных режимах ЛО
составляет ≥ 104 см-1, то вся поглощенная энергия выделяется в тонком
приповерхностном слое толщиной ~1мкм. Это приводит к весьма быстрому (до 1010
°С/с) разогреву этого слоя, вплоть до плавления. После окончания лазерного
импульса вследствие эффективного диффузионного оттока тепла в подложку
происходит резкое (до 108-109 °С/с) охлаждение слоя. Проведенные в рамках
тепловой модели расчеты температурных полей, возникающих в полупроводниках во
время ЛО показали, что путем соответствующего выбора длительности лазерного
импульса, длины волны и плотности энергии импульса светового излучения можно
обеспечить нагрев до заданной температуры лишь тонкого (~ 1 мкм)
приповерхностного слоя, не затрагивая базовый материал. Таким образом,
создаются условия для локального термического отжига разупорядоченного
полупроводника либо путем твердофазной кристаллизации при Т<Тпл. (как это
имеет место при обычном термическом отжиге ионно-легированных слоев), либо
путем жидкофазной эпитаксиальной кристаллизации от ненарушенной подложки при
температуре нагрева Т > Тпл.
2) Модель холодного плазменного
отжига
Суть этой модели заключается в следующем. В
результате воздействия мощного, короткого (10-8-10-7 с)
импульса света с квантом hν>ΔEg в
полупроводнике генерируется плотная (~1021 см-3) долгоживущая (~100 нс)
электронно-дырочная плазма. В этих условиях возможны два механизма отжига.
Во-первых, в присутствии электронно-дырочной плазмы ковалентные связи
тетраэдрических полупроводников, таких, как Si, настолько ослаблены, что они не
могут стабилизировать фононные моды. Кристалл не способен сопротивляться
напряжениям сдвига и поддерживать форму и в этом смысле должен быть назван
жидкостью. Однако эта жидкость отлична от жидкого расплавленного Si, т.к. в
этом случае энергия, сообщенная кристаллу, первоначально концентрируется в нем
в виде электронных возбуждений, а не в виде кинетической энергии колеблющихся
атомов решетки, как это имеет место при классическом (термическом) плавлении.
Переход в такое состояние можно назвать фазовым переходом II рода. Отжиг
разупорядоченного слоя полупроводника происходит в процессе обратного фазового
перехода к ковалентно-связанной фазе, причем без разрушающего влияния сильных
термических градиентов. Второй возможный механизм отжига заключается в том, что
плотная электронно-дырочная плазма нейтрализует кулоновские центры захвата
дефектов в разупорядоченном слое и таким образом стимулирует диффузию дефектов
и примесных атомов. Благодаря этому коэффициенты диффузии вакансий и других
дефектов, а также примесных атомов возрастают на 5-6 порядков величины и тем
самым обеспечиваются условия для эффективного восстановления кристаллической
структуры полупроводника. В дальнейшем эта модель претерпел ряд изменений, но
ее суть все таки заключается в том, что в очень тонком приповерхностном слое
толщиной порядка 10-6 см достигается высокая концентрация экситонов
Френкеля (n≈4х1022см-3), которые связываются с квантами
плазменных колебаний в Бозе-квазичастицы испытывающие Бозе-конденсацию.
Строгий теоретический анализ физических
процессов при ЛО с последовательно микроскопической точки зрения затруднен,
поскольку в наносекундном, а особенно пико- и фемтосекундном режимах, требует
выхода за рамки обычных приближений, используемых в теории неравновесных
процессов в полупроводниках. Попытка же опереться на экспериментальные данные,
чтобы 'сделать объективный выбор в пользу одной из конкурирующих моделей,
оказывается совсем непростым и однозначным делом. Существует большое количество
экспериментальных работ, допускающих интерпретацию с обеих точек зрения и в
равной степени уязвимых для критики.
3. Особенности отжига GaAs
В отличие от Si и Ge процесс ЛО соединениях
AIIIBV и в частности в GaAs затруднен. Это связано с одной стороны, потерями
мышьяка поверхностью GaAs и, как следствие, границей большого числа вакансии в
материале, а с другой стороны, быстрым охлаждением полупроводника в
послеимпульсный период времени, что считается причиной дефектообразования в
отожженном слое при ЛО.
Рассмотрим экспериментальные данные. Монокристаллы
и эпитаксиальные слой GaAs (n=5х1015 3х1018см-3)
облучались ионами Zn, W, Ta и Nb (Е=350кэВ, Ф=8х1012.5х1014см-2). ЛО
проводился с помощью рубинового лазера (λ=0.6943
нм, τ=40
нс, Е=0.3Дж/см2). Значительное нарушение поверхности кристаллов
наблюдалось при Е>0.8 Дж/см2. Отжиг при Е=0.9Дж/см2сравнивалось
с ТО при 7000С, но при этом полный отжиг имплантационных дефектов не
осуществлялся. В условиях эксперимента при Е=0.6-0.8 Дж/см2,
лазерное воздействие создает дефекты, которые являются безизлучательными
центрами. Их концентрация 1015-1017 см-3 и не
могут быть причиной неполного ЛО. При Е=0.8 Дж/см2 толщина
расплавленного слоя 0.4 мкм. В результате проведенных исследований было
установлено, что ионно-легированные слои GaAs после лазерного отжига наносекундной
длительности формируются при сильном влиянии точечных радиационных дефектов,
распространяющихся при проведении имплантации при комнатной температуре далеко
за пределы аморфизованных областей кристаллов.
В другой работе изучался процесс плавления GaAs при
ЛО (λ=0.53
мкм, τ=50нс).
Показано, что порог плавления поверхности слоя 0.35 Дж/см2, а порог
разрушения - 0.8 Дж/см2. Показано наличие процесса
дефектообразования при переплаве поверхностного слоя в процессе ЛО.
Ещё одна работа проводилась при следующих
условиях: полуизолирующие образцы GaAs с ориентацией (100) имплантировались
ионами Те+ (Ф=1015 и 5х1015см-2, Е=100кэВ). Отжиг
проводился рубиновым лазером (τ=15
нс, Е=0.1-1.5 Дж/см2). Лазерному отжигу подвергались образцы, как покрытые
диэлектриком Si3N4, так и не покрытые. Было показано, что
ЛО начинается при Е>0.2 Дж/см2 и более эффективен в образцах с
диэлектрическим покрытием. Полная рекристаллизация (с минимальным количеством
дефектов наблюдается при Е=1.5 Дж/см2. Достигнутые при этом,
электрофизические параметры рекристаллизованной пленки значительно превосходят
достигаемых при термическом отжиге.
4. Экспериментальная часть
В данной работе проводился фотонный отжиг GaAs
образцов. Для этого использовалось следующее оборудование:
затвор вакуумный ДУ 160У
БПРТ-1
двигатель асинхронный 4АМА71А4У3
вакууметр ионизационно-термопарный
печь для фотонного отжига

Целью отжига было получение омических контактов.
Результаты отслеживались на приборе Л2-56.
Образец №1
Характеристика до отжига:



Характеристика после отжига:

Мы можем наблюдать что нелинейная характеристика
стала омической. Следовательно эксперимент проведён успешно. Для того чтобы
проверить это уберём один контакт с контактной площадки на пластину:

И оба контакта уберём с контактных площадок и
поставим на пластину:

Далее рассмотрим изменение характеристики при
различных режимах отжига.
До отжига второй образец обладал следующей
характеристикой:

Рассчитаем сопротивление образца до отжига:

Далее будем проводить отжиг. При постоянном
напряжении (температуре) будем менять время отжига:
1) 5 мВ, 2 сек

2) 5 мВ, 5 сек


Рассчитаем сопротивление для этих трёх
характеристик:




Далее увеличим напряжение (температуру) и время
отжига:
) 10 мВ, 4 сек

) 10 мВ, 8 сек

3) 10 мВ, 16 сек

4) 10 мВ, 32 сек

Рассчитаем сопротивление для этих образцов:




Далее увеличим напряжение (температуру) и время
отжига:
) 15 мВ, 5 сек

2) 15 мВ, 10 сек

) 15 мВ, 20 сек

) 15 мВ, 40 сек

Рассчитаем сопротивление для этих образцов:




Построим зависимость сопротивления омических
контактов от режима отжига:
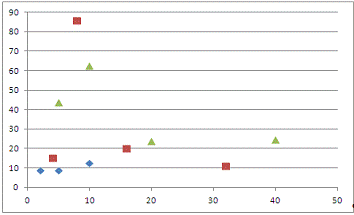
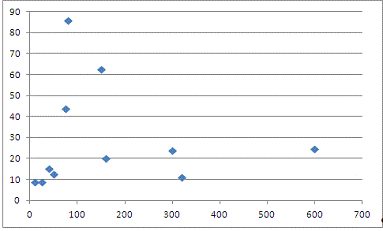
ВЫВОДЫ
Предметом исследования данной работы является
фотонный отжиг. Рассмотрены теоретические основы импульсного отжига GaAs.
Далее в лабораторных условиях произведён фотонный отжиг GaAs
образцов. При проведении эксперимента было использованно следующее
оборудование:
затвор вакуумный ДУ 160У
БПРТ-1
двигатель асинхронный 4АМА71А4У3
вакууметр ионизационно-термопарный
печь для фотонного отжига
Целью отжига являлось получение омических
контактов на GaAs пластине. В ходе работы омические контакты были получены. Это
продемонстрировано в работе. Омичность контактов проверялась на приборе Л2-56.
В работе приведены ВАХи характеристики образца о и после отжига.
Отжиг проводился при различных режимах.
Соответствующие данные по результатам отжига при этих представлены в работе.
Сопротивление контактов до отжига =12.5 Ом. Максимальное сопротивление которое
было получено = 85,7 Ом при 10 мВ, 8 сек, Минимальное сопротивление получено
при 5 мВ, 2 сек - 8,75 Ом.
СПИСОК ЛИТЕРАТУРЫ
полупроводниковый импульсный
фотонный отжиг монокристалл
1. Джибути З.В., Механизмы
импульсного фотонного отжига в полупроводниках с ковалентными и смешанными
связями
. Савицкий Г.В., Модернизация
установки фотонного отжига полупроводниковых пластин "Оникс"
. Шауцуков А.Г., Моделирование
нагрева пластин кремния в процессе фотонного отжига их ионно - легированных
слоёв.