Исследование производительности работы магнетронной распылительной системы с жидкометаллической мишенью
Министерство
образования и науки Российской Федерации
Государственное
образовательное учреждение высшего профессионального образования
«НАЦИОНАЛЬНЫЙ
ИССЛЕДОВАТЕЛЬСКИЙ
ТОМСКИЙ
ПОЛИТЕХНИЧЕСКИЙ УНИВЕРСИТЕТ»
Физико-технический
институт
Направление
(специальность) - физика
Кафедра
водородной энергетики и плазменных технологий
Выпускная
квалификационная работа
Исследование
производительности работы магнетронной распылительной системы с
жидкометаллической мишенью
Томск
- 2011
Реферат
Выпускная квалификационная работа содержит 39
рисунков, 6 таблиц, 27 источников, 1 приложение, 15л. графич. материала.
Ключевые слова: тонкие пленки, магнетронная
распылительная система с жидкометаллической мишенью, дополнительная магнитная
система, коэффициент эрозии поверхности.
Объектом исследования являются пленки свинца,
полученные с помощью магнетрона с жидкометаллической мишенью.
Цель работы - получить данные о зависимостях
производительности работы магнетронной распылительной системы с
жидкометаллической мишенью от её мощности.
В процессе работы проводились: Нанесение
свинцовых пленок с помощью магнетрона с жидкометаллической мишенью. Измерение
толщин пленок. Измерение скорости напыления. Вычисление коэффициента эрозии
поверхности мишени.
В результате исследования выяснилось:
. Магнетронная распылительная система с
жидкометаллической мишенью включает в себя преимущества двух процессов:
магнетронное распыление и термическое испарение в вакууме.
. При увеличении плотности мощности доминирует
испарительная компонента.
. Наблюдается увеличение скорости роста тонких
пленок с увеличением плотности мощности.
. Увеличивается коэффициент эрозии поверхности
мишени на 2 порядка за счет испарительной компоненты.
. Обнаружена зависимость скорости осаждения
тонкопленочных покрытий от материала тигля.
Введение
Осажденные тонкие пленки были, по-видимому,
впервые получены в 1857 г. Фарадеем при проведении им опытов по взрыву
металлических проволочек в инертной атмосфере. Дальнейшие эксперименты по
осаждению пленок были стимулированы в XIX-м столетии интересом к оптическим
явлениям, связанным с тонкими слоями вещества, и исследованиями кинетики и
диффузии газов. В 1887 г. Нарволд на примере проволок из платины
продемонстрировал возможность осаждения тонких металлических пленок в вакууме с
использованием джоулева тепла. Годом позже Купдт применил этот же метод для
измерения показателя преломления пленок металлов.
В последующие десятилетия тонкие пленки
использовались только для чисто физических исследований. Только с совершенствованием
вакуумного оборудования, которое позволило организовать массовое производство и
контроль свойств тонких осажденных пленок, последние нашли промышленное
применение. За последнюю четверть века области применения тонких пленок
значительно расширились. В качестве примера можно привести просветляющие
покрытия, зеркала, интерференционные фильтры, солнечные очки, декоративные
покрытия на пластиках и тканях, использование тонких пленок в
электронно-лучевых трубках и совсем недавно - в производстве микроэлектронных
схем. [1]
Технологии нанесения тонких пленок становятся
все более важными для получения материалов с различными физико-механическими и
трибологическими свойствами. Тонко-пленочные покрытия находят широкое
применение в машиностроении, медицине и микроэлектронике. Как показывают
литературные данные, проблема влияния состава мишени на преимущественное
распыление компонентов мишени в настоящее время остается открытой. Условия и
процессы массопереноса распыленного материала мишени к поверхности конденсации,
определяют состав и структуру получаемых покрытий. [2]
Часто вакуумное осаждение тонких пленок
рассматривают как один процесс, однако правильнее его представлять как
несколько различных процессов, а именно:
) переход вещества из конденсированной фазы, которая
может
быть твердой или жидкой, в газообразную;
) перенос паров вещества в пространстве от
испарителя до
подложки при пониженном давлении газа;
) конденсация паров вещества при достижении
подложки [1].
В последние годы, благодаря интенсивным экспериментальным
и теоретическим исследованиям, имеются различные методики получения образцов,
дающие результатом пленки с воспроизводимыми и стабильными характеристиками[3].
Целью работы является получение данных о
зависимостях производительности работы магнетронной распылительной системы с
жидкометаллической мишенью от режимов её мощности.
Для достижения этой цели нужно решить следующие
задачи:
проанализировать магнитное поле магнетронной;
распылительной системы с жидкометаллической
мишенью;
получить тонкопленочные покрытия;
измерить толщину полученных пленок;
получить данные о скоростях роста толщины
пленок;
исследовать механизмы эрозии поверхности;
определить коэффициенты эрозии.
1. Получение тонкопленочных покрытий в вакууме
.1 Термическое испарение
Процесс нанесения тонких пленок в вакууме
состоит в создании (генерации) потока частиц, направленного в сторону
обрабатываемой подложки, и последующей их конденсации с образованием
тонкопленочных слоев на покрываемой поверхности.
Таким образом, при нанесении тонких пленок
одновременно протекают три основных процесса: генерация направленного потока
частиц осаждаемого вещества; пролет частиц в разряженном (вакуумном)
пространстве от их источника к обрабатываемой поверхности; осаждение
(конденсация) частиц на поверхности с образованием тонкопленочных слоев.[4]
Для понимания физических явлений, происходящих
при нанесении тонких пленок в вакууме, необходимо знать, что процесс роста
пленки на подложке состоит из двух этапов: начального и завершающего.
Рассмотрим, как взаимодействуют наносимые частицы в вакуумном пространстве и на
подложке (рисунок 1).
Покинувшие поверхность источника частицы 1
вещества движутся через вакуумное (разреженное) пространство с большими
скоростями (порядка сотен и даже тысяч метров в секунду) к подложке 6 и
достигают ее поверхности, отдавая ей при столкновении часть своей энергии
(например, частица 8). Доля передаваемой энергии тем меньше, чем выше
температура подложки. Сохранив при этом некоторый избыток энергии, частица 8
вещества способна перемещаться (мигрировать) по поверхности подложки, как это
показано ломаными стрелками 7.
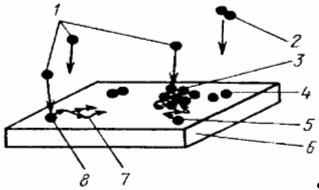
- частицы в вакуумном пространстве; 2 - дуплет
частиц в вакуумном пространстве; 3 - центр кристаллизации; 4 - адсорбированный
дуплет частиц; 5 - рост кристаллита за счет мигрирующих частиц; 7 -
поверхностная миграция частиц; 8 - адсорбированная частица.
Рисунок 1 - Взаимодействие осаждаемых частиц с
подложкой.
При миграции по поверхности частица постепенно
теряет избыток своей энергии, стремясь к тепловому равновесию с подложкой, и
при этом может произойти следующее. Если на пути движения частица потеряет
избыток своей энергии, она фиксируется на подложке (конденсируется). Встретив
же на пути движения другую мигрирующую частицу (или группу частиц), она вступит
с ней в сильную связь (металлическую), создав адсорбированный дуплет 4. При
достаточно крупном объединении такие частицы полностью теряют способность
мигрировать и фиксируются на подложке, становясь центром кристаллизации 3.
Вокруг отдельных центров кристаллизации
происходит рост кристаллитов, которые впоследствии срастаются и образуют
сплошную пленку. Рост кристаллитов происходит как за счет мигрирующих по
поверхности частиц 5, так и в результате непосредственного осаждения частиц 1
на поверхность кристаллитов. Возможно также образование дуплетов 2 в вакуумном
пространстве при столкновении двух частиц, которые в конечном итоге
адсорбируются на подложке.
Различные загрязнения в виде пылинок и следов
органических веществ существенно искажают процесс роста пленок и ухудшают их
качество.
Образованием сплошной пленки заканчивается
начальный этап процесса. Так как с этого момента качество поверхности подложки
перестает влиять на свойства наносимой пленки, начальный этап имеет решающее
значение в их формировании. На завершающем этапе происходит рост пленки до
необходимой толщины.
При прочих неизменных условиях рост температуры
подложки увеличивает энергию, т. е. подвижность адсорбированных молекул, что
повышает вероятность встречи мигрирующих молекул и приводит к формированию
пленки крупнокристаллической структуры. Кроме того, при увеличении плотности
падающего пучка повышается вероятность образования дуплетов и даже многоатомных
групп. В то же время рост количества центров кристаллизации способствует
образованию пленки мелкокристаллической структуры.
Эти факторы обусловливают необходимость
стабильного поддержания температуры подложек и скорости испарения материала.
[4]
Тонкие пленки оксидов металлов и полупроводников
можно получить различными способами [3]. В настоящее время известно большое
число методов нанесения тонких пленок на подложку, для начала рассмотрим один
из них.
Испарение различных материалов в вакууме, в том
числе и металлов, происходит при нагревании до температуры плавления и
испарения (сублимации) либо при распылении (методы катодного и магнетронного
распыления). Металлы можно нагревать резистивным методом (испарители
прямонакального и косвенного нагрева), электронным лучом, электрической дугой,
токами высокой частоты. Способы нагрева, определяющие конструкции
соответствующих внутри камерных устройств промышленных вакуумных установок,
детально описаны в инструкции по эксплуатации установок. Большая часть металлов
при нагреве переходит в паровую фазу через жидкое состояние, т.е. сначала они
плавятся, а затем испаряются. Некоторые металлы (Cd, Zn, Mn и в отдельных
случаях чистый Cr) переходят из твёрдого состояния, в паровую фазу минуя жидкую
(сублимируют)[5].
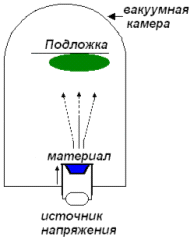
Рисунок 2 - Схема установки для получения тонких
пленок методом термического испарения металлов и сплавов в вакууме.
Первое систематическое исследование скоростей
испарения в вакуум было проведено Герцем в 1882 г. Он перегонял ртуть и
определял потери вещества на испарение при одновременном измерении
гидростатического давления на испаряющейся поверхности. Исследуя вещества с
хорошей теплопроводностью, такие как ртуть, он пришел к заключению, что
скорость испарения может быть ограничена вследствие недостаточного подвода
тепла к поверхности. Для всех выбранных условий Герц обнаружил, что скорость
испарения пропорциональна разности между равновесным давлением ртути р* при
температуре поверхности резервуара и гидростатическим давлением р на этой
поверхности. Из этих экспериментов он вывел важное заключение о том, что
жидкость имеет особую способность к испарению и скорость испарения при данной
температуре не может превосходить определенную максимальную величину, даже если
подача тепла неограниченна. Более того, теоретический максимум скорости
испарения получается только в том случае, если с поверхности испаряется такое
число молекул, которое необходимо для установления равновесного давления р* на
той же поверхности, причем ни одна из молекул не возвращается на поверхность.
Это последнее условие означает, что должно устанавливаться гидростатическое
давление p = 0. На основе такого рассмотрения можно показать, что число молекул
dNв, испаряющихся с площади поверхности Ав за время dt, равно числу молекул,
соударяющихся с поверхностью в единицу времени при давлениир*, за вычетом
обратного потока, соответствующего гидростатическому давлению р испаряемого
вещества в газовой фазе
в / Ав dt = (2πmkT)-1/2
(р* - р) см-2∙с-1. (1)
Скорости испарения, первоначально измеренные
Герцем, всего на одну десятую превышали теоретические максимальные значения.
Это было объяснено Кнудсепом в 1915 г. При этом он предположил, что молекулы,
сталкивающиеся с испаряющейся поверхностью, могут быть скорее отражены обратно,
чем внедрены в жидкую фазу. Следовательно, имеется определенная часть(1 - α0)
молекул пара, которые дают вклад в давление испаряемого вещества, но не
участвуют в молекулярном потоке при переходе из конденсированной в газообразную
фазу. Для учета такого предположения он ввел коэффициент испарения α0,
который определяется как отношение наблюдаемой скорости испарения в вакуум к
теоретически возможной величине, представленной уравнением (1). Тогда наиболее
общее уравнение для скорости испарения имеет вид
в / Ав dt =α0
(2πmkT)-1/2
(р* - р) (2)
Это уравнение называется уравнением
Герца-Кнудсепа. Кнудсен обнаружил, что величина коэффициента испарения сильно
зависит от состояния поверхности ртути. В своих первоначальных экспериментах, в
которых испарение происходило с поверхности малых количеств ртути, он получил
малые значения α0, равные 5∙10-4.
Кнудсен предположил, что низкие скорости испарения связаны с загрязнением
поверхности, и проявляется это в обесцвечивании поверхности металла. Для
проверки этого предположения он брал тщательно очищенную ртуть и испарял ее из
ряда капелек, которые падали из пипетки и имели, таким образом, свежую чистую
поверхность. Результаты этого эксперимента совпали с полученной ранее величиной
максимальной скорости испарения
в / Ав dt = (2πmkT)-1/2
р*(3)
Свободное испарение и эффузия. В 1913 г. Ленгмюр
впервые показал, что уравнение Герца - Кнудсена применено также и для описания
испарения со свободной поверхности твердого тела. Он исследовал испарение
вольфрама с нитей в откачанных стеклянных баллонах и предположил, что скорость
испарения вещества при давлениях, меньших 1 мм рт. ст., такая же, как если бы
поверхность находилась в равновесии со своим паром. Поскольку повторная
конденсация испаренных молекул была исключена, то он вывел выражение для
максимальной скорости испарения, совпадающее с уравнением (3). Зная величину
уменьшения веса нити за определенное время испарения, Ленгмюр рассчитал
давление паров вольфрама. Для того, чтобы сделать это, необходимо молекулярную
скорость испарения, см. уравнение (3), умножить на массу молекулы. Это приводит
к скорости испарения по массе[1]:
Г = mdNв / Ав dt = (m / 2πkT)1/2
р* (4)
Характер распределения испаряемого вещества в
пространстве над испарителем определяется двумя основными параметрами: рабочим
давлением в вакуумной камере. Если давление паров испаряемого вещества(металла)
при температуре Tи не превышает 1.33 Па, то при рабочем давлении в вакуумной
камере порядка 10-2 Па и менее молекулы и атомы испаряемого вещества достигают
поверхности подложки без столкновений между собой и с молекулами остаточных
газов. В этом случае говорят, что реализуется молекулярный режим испарения и
конденсации, для которого справедливы законы Ламберта-Кнудсена: распределение в
пространстве потока вещества, испарённого с плоской поверхности, пропорционально
косинусу угла между направлением распространением паров и нормалью к
поверхности; число частиц, попадающих на поверхность подложки, обратно
пропорционально квадрату расстояния между испарителем и под ложкой. Эти законы
являются базовыми при анализе закономерностей формирования плёнок на
поверхностях различной конфигурации.
При анализе процесса формирования покрытий на
положках следует выделить два аспекта - физический и технологический.
Физический аспект отражает закономерности
формирования начальных слоёв покрытия, характер продольной и поперечной
структур, рельефа поверхности и др.
Не рассматривая детально теорию
зародышеобразования и основные закономерности начального роста кристаллов,
отметим, что процесс конденсации и структура сформированной плёнки существенно
зависят от кинетических параметров конденсации, температуры и потенциального
рельефа подложки, плотности падающего молекулярного пучка, характера
взаимодействия осаждаемых атомов с подложкой. Из указанных параметров
существенным является температура подложки. Многочисленными исследованиями
установлено, что на нейтральной (неориентированной) подложке молекулярный пучок
конденсируется только в том случае, если температура ниже некоторой критической
Tкр.
Принципиально возможны и реализуются на практике
два механизма конденсации молекулярных пучков испарённых веществ на различных
подложках -ПК(пар - кристалл) и ПЖК(пар - жидкость - кристалл). Если
реализуется механизм ПК, то частицы, конденсирующиеся на начальных стадиях
испарения навески, имеют кристаллическое строение, и в дальнейшем формируется
только кристаллическая плёнка. Механизм ПЖК проявляется в том, что образование
конденсированной фазы на подложке начинается с появления на подложке жидкой
фазы в виде капель, которые длительное время существуют на подложке, после чего
начинается процесс кристаллизации.
Рассмотренные механизмы кристаллизации
определяют различные характеры формирования и роста плёнки из паровой фазы, что
в конечном счёте определяет свойства плёнок. Если конденсируемые атомы связаны
с собой сильнее, чем с поверхностью нейтральной подложки, они свободно и
достаточно интенсивно мигрируют с её поверхности. При достаточно высокой
плотности потока испаряемого вещества на поверхности подложки образуются
зародыши кристаллической фазы или жидкой конденсированной фазы, которые сначала
разрастаются сначала в двух, а затем и в трёх направлениях. Если же силы
взаимной связи атомов или молекул конденсирующегося вещества меньше сил их
связи с подложкой, резко возрастает влияние кинетических параметров подложки на
процесс формирования плёнки по механизму ПК.
Следует отметить, что механизм конденсации
зависит (в первом приближении) от соотношения температур подложки Tп и
температур плавления Tпл конденсирующихся веществ. При изменении Tп может
измениться механизм конденсации. При конденсации молекулярных пучков сложного
состава (например, при нанесении покрытий изсплавов) механизм конденсации
зависит и от состава паровой фазы. После завершения формирования сплошного слоя
закономерности дальнейшего роста плёнки определяются не непосредственно
механизмом конденсации материала, а в основном структурой первично
сформированных слоёв. Технологический аспект процесса конденсации отражает
характер распределения толщины плёнки вдоль поверхности подложки и
рассматривает влияние геометрических параметров испарения (размеров и формы
испарителей и подложки, их взаимного расположения) и режима металлизации на
равномерность толщины покрытия.
Для анализа равнотолщинности используют, как
правило, идеальную модель испарения и конденсации, которая предусматривает
выполнение законов Ламберта - Кнусена и формулы Лэнгмюра для скоростей
испарения, а также полную конденсацию паров испарённого вещества на подложке
(коэффициент конденсации равен 1 независимо от материала подложки и
интенсивности потока испарённого вещества). Процесс испарения происходит с
зеркальной поверхности расплава.
Качество формируемых покрытий, технологические
возможности оборудования для напыления, техника проведения процесса нанесения
покрытий и ряд других практических вопросов во многом определяются выбором
материала испарителя (тигля) с учётом физико-химических свойств испаряемого
вещества, а также возможных взаимодействий испаряемого вещества с испарителем.
В литературе есть сведения, позволяющие подобрать не только материал
испарителя, но и наиболее оптимальную его конструкцию с учетом специфики
получения покрытий конкретного функционального назначения.
Технологические параметры процесса нанесения
покрытий определяются в основном способностью испарителя поддерживать
испаряемое вещество при определенной температуре длительное время. Для
получения приблизительных оценок рабочих температур испарителей нужно
учитывать, что нормальный(технологически) режим металлизации реализуется при
давлении паров испаряемого вещества порядка 1.33 Па. Для большей части
материалов, применяемых в практике вакуумной металлизации для получения
покрытий, рабочие температуры составляют 1300…2500 К.Основные требования к
материалу испарителя: незначительное (минимально возможное) давление
насыщенного пара при рабочей температуре; инертность по отношению к испаряемому
материалу; обеспечение возможности изготовления различных конструкций.
Соблюдение первого требования обеспечивает получение качественных пленок, не
загрязненных атомами материала испарителя, соблюдения второго требования
-длительную работу испарительного элемента, так как образование справа
испаряемого вещества с материалом испарителя приводит к быстрому разрушению
испарителя. Кроме того, в результате химической реакции возможно образование
соединений с низкой температурой испарения, что также приводит к загрязнению
формируемого конденсата. Третье (дополнительное) требование подбора материала
испарителя обусловлено, прежде всего, технологическими соображениями -
конструкцией токовых вводов и зажимов вакуумной установки [5].
Достоинствами метода являются: реализация
высоких скоростей осаждения материалов в высоком вакууме, простота,
отработанность технологических операций и наличие современного высокопроизводительного
оборудования. Однако этому методу свойственны такие недостатки, как трудность
обеспечения высокой воспроизводимости свойств пленок при осаждении веществ [6].
В гибридных микросхемах тонкие пленки
используются для изготовления резисторов, конденсаторов, контактных площадок и
соединительных проводников [6].
Метод термического окисления, как правило,
требует высокотемпературной обработки подложек с металлическими или
полупроводниковыми прекурсорами, что не всегда допустимо. Поэтому разработаны
достаточно низкотемпературные методы получения пленок основанные на различных
формах внешнего осаждения оксидов или их компонентов на подложки [3].
.2 Магнетронное распыление
Еще сравнительно недавно основным методом
нанесения тонкопленочных покрытий были испарение и конденсация веществ в
высоком вакууме.[7]
Среди методов нанесения защитных покрытий,
основанных на воздействии на поверхность детали потоков частиц и квантов с
высокой энергией, большое внимание привлекают вакуумные ионно-плазменные
методы. Характерной их чертой является прямое преобразование эклектической
энергии в энергию технологического воздействия, основанной на
структурно-фазовых превращениях в осажденном на поверхности конденсате или в
самом поверхностном слое детали, помещенной в вакуумную камеру.
Основным достоинством данных методов является
возможность создания весьма высокого уровня физико-механических свойств
материалов в тонких поверхностных слоях, нанесение плотных покрытий из
тугоплавких химических соединений, а также алмазоподобных, которые невозможно
получить традиционными методами. Кроме того, эти методы позволяют:
обеспечивать высокую адгезию покрытия к
подложке;
равномерность покрытия по толщине на большой
площади;
варьировать состав покрытия в широком диапазоне,
в пределах одного
технологического цикла;
получить высокую чистоту поверхности покрытия;
экологическую чистоту производственного цикла
[8].
Методы ионного распыления материалов вследствие
низких скоростей осаждения и высоких радиационных воздействий на обрабатываемые
структуры использовались ограниченно. Появившиеся сравнительно недавно
магнетронные распылительные системы, позволяющие наносить как тонкопленочные
слои, так и пленочные покрытия толщиной в сотни микрон, позволили существенно
расширить область применения ионного распыления материалов.
В последние годы в нашей стране и за рубежом
проведены научные исследования и конструктивно-технологические разработки по
созданию широкого класса магнетронных распылительных систем, а также установок
и линий (в том числе непрерывного действия) на их основе. Однако в публикациях
по этим вопросам по существу не отражены вопросы проектирования и расчета
основных параметров магнетронных распылителей, в то время как такие сведения
совершенно необходимы инженерно-техническим работникам, занимающимся
проектированием, производством и эксплуатацией этих систем.
Действие магнетронного источника основано на
распылении материала мишени-катода при его бомбардировке ионами рабочего газа,
образующимися в плазме аномального тлеющего разряда, возбуждаемого в скрещенных
электрическом и магнитном полях. Магнетронная распылительная система (МРС)
является одной из разновидностей схем диодного распыления.
К основным рабочим характеристикам МРС относятся
напряжение и сила тока разряда, удельная мощность на катоде, давление рабочего
газа и магнитная индукция. В качестве рабочего газа в МРС обычно используют
аргон. Давление рабочего газа поддерживается в диапазоне 10-2-1,0 Па,
напряжение разряда - 300-800 В. Магнитная индукция вблизи поверхности катода
имеет значения 0,03-0,1 Тл. При таких условиях плотность тока на мишень
находится на уровне нескольких тысяч ампер на м2, а поверхностная плотность
энергии * 106 Вт/м2. Магнетронные распылительные системы на постоянном токе
могут работать только с мишенями из проводящих материалов. Если используются
высокочастотные источники питания, то возможно распыление также и мишеней из
непроводящих материалов (ВЧ-магнетроны).
Магнетронный метод позволяет:
Получать покрытия практически из любых металлов,
сплавов, полупроводников и диэлектриков без нарушения стехиометрии или
исходного соотношения компонентов распыляемой мишени;
Используя смеси рабочего и реакционных газов
(N2, O2, CH4, СО, SO2 и др.) и распыляемые мишени из металлов или сплавов,
получать покрытия из окислов, нитридов, карбидов, сульфидов металлов и др.
соединений, в т.ч. и тех, которые невозможно получить методами обычного
термического испарения;
Производить обработку покрываемых поверхностей в
плазме тлеющего разряда с целью их ионной очистки и активации перед нанесением
покрытий.
Нанесение тонкопленочных проводящих, изолирующих
и др. покрытий в электронной, радиотехнической промышленности, приборостроении
и др. областях;
Нанесение просветляющих, отражающих, защитных и
др. покрытий на детали оптических систем и приборов;
Нанесение упрочняющих, защитных и
защитно-декоративных покрытий на металлы, диэлектрические материалы, стекло,
пластмассы в производстве изделий различного назначения, включая товары
народного потребления. [9]
Физические основы работы МРС заключаются в
следующем: сложность изучения разряда в магнетронных распылительных системах
заключается в том, что в этих системах используются неоднородные скрещенные
электрическое и магнитное поля, причем электрические параметры разряда в
значительной степени зависят от рабочего давления, величины и конфигурации
магнитного поля, конструктивных особенностей распылительной системы. Все это
делает практически невозможным точное аналитическое описание явлений,
происходящих в разряде магнетронной системы.
Магнетронные распылительные системы получили
свое название от СВЧ приборов М-типа (магнетронных устройств), хотя, кроме
наличия скрещенных электрического я магнитного полей, ничего общего с ними не
имеют. Магнетронные системы относятся к системам распыления диодного типа, в
которых распыление материала происходит за счет бомбардировки поверхности
мишени ионами рабочего газа (обычно аргона), образующимися в плазме аномального
тлеющего разряда. Высокая скорость распыления, характерная для этих систем,
достигается увеличением плотности ионного тока за счет локализации плазмы у
распыляемой поверхности мишени с помощью сильного поперечного магнитного поля.
Принцип действия магнетронной распылительной
системы показан на рисунке 3.
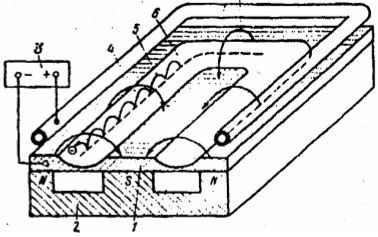
- катод-мишень; 2 - магнитная система; 3 -
источник питания; 4 - анод;
- траектория движения электрона; 6 - зона
распыления; 7 - силовая линия магнитного поля.
Рисунок 3- Схема МРС с плоской мишенью.
Основными элементами устройства являются
катод-мишень, анод и магнитная система. Силовые линии магнитного поля
замыкаются между полюсами магнитной системы. Поверхность мишени, расположенная
между местами входа и выхода силовых линий магнитного поля, интенсивно
распыляется и имеет вид замкнутой дорожки, геометрия которой определяется
формой полюсов магнитной системы.
При подаче постоянного напряжения между мишенью
(отрицательный потенциал) и анодом (положительный или нулевой потенциал)
возникает неоднородное электрическое поле и возбуждается аномальный тлеющий разряд.
Наличие замкнутого магнитного поля у распыляемой поверхности мишени позволяет
локализовать плазму разряда непосредственно у мишени. Эмитированные с катода
под действием ионной бомбардировки электроны захватываются магнитным полем, им
сообщается сложное циклоидальное движение по замкнутым траекториям у
поверхности мишени. Электроны оказываются как бы в ловушке, создаваемой с одной
стороны магнитным полем, возвращающим электроны на катод, а с другой стороны -
поверхностью мишени, отталкивающей электроны. Электроны циклируют в этой
ловушке до тех пор, пока не произойдет несколько ионизирующих столкновений с
атомами рабочего газа, в результате которых электрон потеряет полученную от
электрического поля энергию. Таким образом, большая часть энергии электрона,
прежде чем он попадет на анод, используется на ионизацию и возбуждение, что
значительно увеличивает эффективность процесса ионизации и приводит к
возрастанию концентрации положительных ионов у поверхности мишени. Это в свою
очередь обусловливает увеличение интенсивности ионной бомбардировки мишени и
значительный рост скорости распыления, следовательно, и скорости осаждения
пленки.
Следует отметить, что плазма разряда существует
только в области магнитной ловушки в непосредственной близости от мишени и ее форма
определяется геометрией и величиной магнитного поля.
Создание магнитной ловушки у распыляемой
поверхности мишени представляет собой простое, но весьма эффективное решение
проблемы увеличения скорости распыления материалов, в плазменных распылительных
системах. Но помимо этого достоинства МРС обладает рядом специфических свойств,
основным из которых является отсутствие бомбардировки подложки
высокоэнергетическими вторичными электронами.
Известно, что при распылении материалов в плазме
тлеющего разряда высокоэнергетические вторичные электроны с мишени являются
основным источником нагрева подложек. Интенсивный перегрев подложек не
позволяет увеличивать скорости распыления, повышая рабочее напряжение.
В магнетронной распылительной системе вторичные
электроны захватываются магнитной ловушкой и не бомбардируют подложку, что
обеспечивает ее сравнительно низкую температуру. Источниками нагрева подложки в
этих системах служат энергия конденсации распыленных атомов, кинетическая
энергия осаждаемых атомов, энергия отраженных от мишени нейтрализованных ионов,
а также излучение плазмы [9].
.2.1 Несбалансированный (разбалансированный) и
сбалансированный
магнетроны
Известно, что при распылении материалов в плазме
тлеющего разряда высокоэнергетические вторичные электроны с мишени являются
основным источником нагрева подложек. В магнетронной распылительной системе
вторичные электроны захватываются магнитной ловушкой и не бомбардируют
подложку, что обеспечивает ее сравнительно низкую температуру. Источниками
нагрева подложки в этой системе служат кинетическая энергия и энергия
конденсации осаждаемых атомов, энергия отраженных от мишени нейтрализованных
ионов и энергия ионов вторичной плазмы, а также излучение плазмы. Энергия
конденсации составляет 3-9 эВ/атом, кинетическая энергия в зависимости от
распыляемого материала от 5 (для алюминия) до 20 эВ/атом (для вольфрама), а
излучение плазмы 2-10 эВ/атом. Энергия вторичных ионов в зависимости от
конструкции магнетрона и подложкодержателя может составлять 30-50 эВ/ион. Плотность
ионного тока на подложку зависит только от концентрации вторичной плазмы в
области подложки, а она, в свою очередь, зависит от мощности магнетронного
разряда и конфигурации и напряженности магнитного поля магнетрона. Магнетроны
условно подразделяются на «сбалансированные» и «разбалансированные» с разной
степенью разбалансированности. Эту степень разбалансированности можно
характеризовать отношением плотности тока вторичных ионов на подложку к
плотности потока падающих на нее распыленных атомов. От степени
разбалансированности магнетрона зависит и крутизна вольтамперной характеристики
разряда, и термическая нагрузка на подложки, и во многих случаях, качество и
структура напыляемых пленок.[10].
В «обычных» или «сбалансированных» магнетронных
распылительных системах плазма локализуется магнитным полем у поверхности
распыляемого катода и область плотной плазмы простирается не более чем на 50 мм
от его поверхности. Поэтому плотность ионного тока на подложки находящиеся на
большем расстоянии (обычно << 1 мА/см2) недостаточна для того чтобы
влиять на морфологические, композиционные и кристаллизационные свойства
наносимых покрытий. Плотные покрытия без избыточных внутренних напряжений
обычно получаются при бомбардировке большими потоками (> 1 мА/см2) относительно
низкоэнергетичных (100 эВ) ионов. Такие условия обеспечиваются в
несбалансированных магнетронных распылительных системах. Благодаря конструкции
магнитной системы, создающей магнитное поле, часть линий которого не замыкается
на расположенный рядом магнит с противоположным полюсом, а направляется в
сторону подложки (см. рисунок 4).
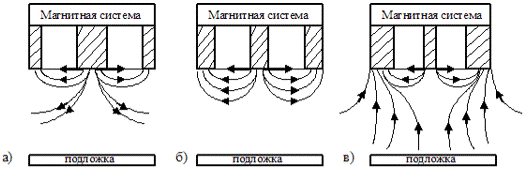
а) несбалансированный магнетрон (Тип 1),
б) сбалансированный магнетрон,
в) несбалансированный магнетрон (Тип 2).
Рисунок 4 - Возможные конфигурации магнитного
поля.
В конструкции магнетрона типа 2, представляющей
наибольший практический интерес, это может достигаться, например, если магниты
внешнего ряда значительно превосходят по величине магниты центрального ряда.
Наличие несбалансированных линий магнитного поля дает возможность вторичным
электронам уходить по ним в сторону подложки и совершать там ионизацию газа.
Конструкция несбалансированного магнетрона типа 1 не получила широкого
распространения, т.к. в ней несбалансированные линии магнитного поля направлены
в сторону стенок камеры в результате чего плотность плазмы у подложки низкая.
Магнитное поле в несбалансированных магнетронах
может создаваться как постоянными магнитами, так и магнитными катушками, но
катушки позволяют регулировать степень ионного воздействия на растущую пленку
непосредственно во время ее нанесения. Изменением тока в этих катушках можно
реализовать оба типа конфигурации магнитного поля несбалансированного
магнетрона, а также плавный переход между ними. Изменять степень
несбалансированности магнетрона можно и с помощью магнитных систем на постоянных
магнитах. Для этого внешний и внутренний ряды магнитов делаются подвижными
относительно друг друга. В сбалансированном режиме внешние магниты отодвинуты
от мишени, в то время как внутренние магниты максимально к ней приближены. Если
в слабо несбалансированном режиме все магниты приближены к мишени, то в сильно
несбалансированном режиме к ней приближены только внешние магниты, а внутренние
отодвинуты вглубь магнетрона. Повышение интенсивности ионной бомбардировки
растущей пленки позволяет радикальным образом влиять на ее характеристики, в
частности создавать метастабильные фазы, формировать нанокомпозитные структуры
и т.д.[11]
Какой тип магнетронной распылительной системы
предпочтительнее использовать, зависит от конкретной технологической задачи.
1.3 Магнетрон с жидкометаллической мишенью
(жидкофазный
магнетрон)
При односекционной магнитной системе можно
достигать высокой плотности мощности до 103 Вт/см2 при распылении из твердой
фазы и до 104 Вт/см2 - из жидкой фазы. Жидкофазный процесс распыления проводится
с высокой линейной скоростью перемещения магнитной системы >100 мм/с при
интенсивном охлаждении катода водой с температурой 10-12оС. Специально
подобранная магнитная система позволяет вести осаждение покрытия на дистанции
от 7 до 10 мм[12].
Скорости напыления металлических пленок,
полученных с помощью термического испарения в вакууме, очень большие (порядка
170 нм/сек), но с другой стороны они имеют очень рыхлую структуру.
При магнетронном распылении получаются весьма
плотные пленки, но при незначительной скорости. Как же объединить два
вышеперечисленных метода. Существует конструкция магнетрона с
теплоизолированной мишенью, которая объединяет в себе два этих метода. Пленки,
полученные с помощью данной конструкции, имеют хорошую адгезию, так как каждый
последующий слой частиц, летящих на подложку, уплотняет предыдущие слои. Ещё
одно преимущество магнетрона с теплоизолированной мишенью - это высокие
скорости осаждения, такие как при термическом испарении металлических пленок в
вакууме.
По теоретическим расчетам, подтвержденным
экспериментальными исследованиями, процесс ионного (распыления происходит в
приповерхностном слое металла толщиной 0,3-0,8 нм и на него в диодной
распылительной системе (PC) затрачивается менее 3% подводимой энергии. Вся остальная
энергия переходит в основном в тепло, вследствие чего приходится обеспечивать
интенсивное охлаждение мишени. При этом удельная мощность ионного тока на
мишени Wи = Iи∙Uм ограничивается величиной критической удельной мощности
Wи. крит, которую выдерживает материал мишени без расплавления.
Условия существования тлеющего разряда в диодной
PC накладывают ограничение на выбор технологических параметров процесса
распыления . Для обеспечения горения разряда в аргоне (независимо от материала
мишени) должно выполняться условие Pd≥ 13 Па∙см, поэтому необходимо
работать при давлении Р>3 Па и значительном расстоянии анод - мишень (d>5
см). Естественно, что при этом наблюдается значительный возврат распыленных
атомов обратно на мишень вследствие рассеяния их на молекулах рабочего газа.
Это резко снижает скорость распыления, Которая в диодных PC обычно не превышает
50 нм/мин, и энергетическую эффективность процесса.
В том случае, если материал мишени находится в
твердом состоянии, максимально допустимая плотность ионного тока в значительной
мере ограничена теплопроводностью материала мишени, которая в зависимости от
вида материала с ростам температуры может увеличиваться или уменьшаться, а
вблизи точки плавления скачкообразно изменяет свою величину.
Скорость распыления материала Vp зависит от двух
основных факторов: коэффициента распыления kpи плотности ионного тока Jи При
увеличении напряжения на мишени с 0,5 до 5 кВ kр возрастает всего в 2 раза,
причем наиболее интенсивное увеличение kpв диапазоне до 2 кВ, после чего рост
kp замедляется. Следовательно, такой путь повышения Vp мало эффективен.
Плотность ионного тока на мишени можно увеличить
за счет увеличения степени ионизации плазмы и при использовании режима
распыления, при котором Uм соответствует энергии ионов, обеспечивающей
максимальную энергетическую эффективность процесса, что имеет место в
магнетронных системах ионного распыления (МСИР) [8].
Для распыления материала из жидкой фазы
использовалась МСИР, изображенная на рисунке 5. Под номером 3 представлена
подложка, на которую осаждается тонкая пленка. Непосредственно под тиглем 2,
изготовленным из немагнитного материала, располагалась водоохлаждаемая
магнитная система 1, создающая кольцевое неоднородное магнитное поле.

-магнитная система; 2 - тигель; 3 - подложка; 4
- анод; 5-мишень (А1); 6 - экран.
Рисунок 5 - Схема устройства для распыления из
жидкой фазы.
Между тиглем и корпусом магнитной системы был
зазор величиной около 2 мм, (препятствующий отводу тепла от тигля в процессе
его разогрева. В тигель помещались диски 5 из меди или алюминия, выполняющие
роль мишени. Для снижения лучистого теплоотвода от тигля использовался
радиационный экран 6. Анод 4 выполнен в виде водоохлажденной медной трубки,
размещенной на расстоянии 25 мм над тиглем.
В предварительно откачанную до высокого вакуума
(Р<10-3 Па) камеру напускался аргон при давлении 0,6-1,3 Па, после чего на
тигель по отношению к аноду подавалось отрицательное напряжение величиной до
700 В. При этом загорался разряд, локализованный у поверхности мишени магнитным
полем. Материал мишени за счет интенсивной ионной бомбардировки в течение 5-10
мин переходил в жидкое состояние. Сначала расплавлялась зона горения разряда,
затем центральная часть мишени и, наконец, краевая ее область. С появлением
жидкой фазы свечение разряда становилось более интенсивным, ток разряда
возрастал (рис. 6, кривая 2), а напряжение на источник питания разрядном
промежутке за счет ограниченной мощности источника питания снижалось (рис. 6,
кривая 1). Характерно, что если в обычной МСИР, когда распыляемая мишень
находится в твердой фазе, разряд гаснет при Р<10-1 На, то при распылении из
жидкой фазы разряд устойчиво горел при Р≈1*10-2 Па, что может быть
объяснено как явлением самораспыления мишени под воздействием на нее
интенсивного потока ионов распыленного металла, так и высокой упругостью пара
распыляемого материала (которая, например, для меди при температуре 1430° С
составляет 13 Па). Это говорит о том, что, когда давление пара распыляемого
металла (возрастет настолько, что процесс ионизации паров станет достаточно
интенсивным, чтобы поддерживать горение разряда, можно прекратить напуск
аргона, что существенно снизит загрязнение пленки активными газами,
содержащимися в аргоне.
По словам автора, при мощности источника питания
1,5 кВт, плотности мощности на мишени 40 Вт/мм2, плотности ионного тока 70
мА/см2 и расстоянии от мишени до подложки 5 см скорость осаждения меди
составляла от 4 до 5 мкм/мин, что в 100- 120 раз превышает скорости,
характерные для диодной системы распыления на постоянном токе. Следует также
отметить, что подача на подложку отрицательного смещения 100 В вызывает ионный
ток к подложке, величина которого составляет 25% разрядного тока. Это позволяет
улучшить адгезию и другие свойства пленок.

Рисунок 6 - Изменение напряжения (1) и тока (2)
разряда во времени.
Метод осаждения пленок путем распыления из
жидкой фазы может найти реализацию при изготовлении печатных плат,
микрополосковых линий ИС и других изделий, где требуются высокие скорости
осаждения и значительные толщины пленок [13].
2. Проектирование магнетрона с
теплоизолированной мишенью
.1 Выбор оптимальных параметров магнетрона с
теплоизолированной
мишенью (геометрические размеры, выбор материала)
В конструкции магнетрона с теплоизолированной
мишенью присутствуют следующие элементы: фланец, корпус, тигель, а также
несколько магнитов.
Существуют два класса материалов: магнитные и
немагнитные. Магнитные материалы играют огромную роль в формировании магнитного
поля. Эти материалы помогаю концентрировать магнитное поле там, где нужно.
Немагнитные материалы - это функциональные узлы, которые не оказывают
существенного влияния на распределение магнитного поля.
В учебнике “Магнетронные распылительные системы»
(см. источник 8) была предложена конструкция магнетрона с жидкой мишенью, но
величина магнитного поля не устроила. Было решено смоделировать другую
конструкцию на основе предложенной. Для увеличения магнитного поля существует 2
решения: во-первых, можно уменьшить расстояния между тиглем и магнитной
системой, во-вторых, вставить дополнительные магнитопроводящие материалы,
которые помогают концентрировать линии магнитного поля.
Мишень, тигель и часть корпуса будут изготовлены
из нержавеющей стали. Фланец, боковая часть корпуса и различного рода магниты
будут представлять собой изделия из магнитной стали.
Размеры разрабатываемого магнетрона с
теплоизолированной мишенью небольшие. Это обусловлено двумя причинами:
во-первых, данный экземпляр установки будет лабораторным, во-вторых, малая
затрачиваемая мощность для его работы, то есть не нужно будет использовать
очень мощные источники питания.
2.2 Моделирование магнитного поля с помощью
пакета программ для выбранной конструкции
- это мощный современный комплекс программ для
инженерного моделирования электромагнитных, тепловых и механических задач
методом конечных элементов. Дружественный русскоязычный пользовательский
интерфейс, простота описания даже самых сложных моделей, широкие аналитические
возможности комплекса и высокая степень автоматизации всех операций позволяют
разработчику полностью сосредоточиться на своей задаче.
Редактор модели позволяет легко и быстро описать
геометрию модели. Также можно импортировать фрагменты модели из AutoCAD или
других систем проектирования. При построении сетки конечных элементов можно
использовать удобные средства управления ее густотой или полностью довериться
автоматической системе построения сетки. Источники и граничные условия
полностью независимы от сетки, и могут быть изменены в любое время [14].
позволяем решить следующие плоские и осесимметричные задачи:
Линейная и нелинейная магнитостатика.
Магнитное поле переменных токов (с учетом
вихревых токов).
Нестационарное магнитное поле.
Электростатика.
Электрическое поле переменных токов в
неидеальном диэлектрике.
Растекание токов в проводящей среде.
Линейная и нелинейная, стационарная и
нестационарная теплопередача.
Линейный анализ напряженно-деформированного
состояния.
Связанные задачи.
С помощью ELCUT пользователь может в течение
одного сеанса описать задачу - ее геометрию, свойства сред, источники поля,
граничные и другие условия, решить ее с высокой точностью и проанализировать
решение с помощью средств цветной графики. ELCUT позволяет решать сложные
задачи расчета полей на персональных компьютерах, не прибегая к помощи больших
ЭВМ или рабочих станций.использует следующие типы документов, относящиеся к
каждой конкретной задаче:
описание задачи;
геометрическая модель;
физические свойства;
результаты решения;
Кнопка “Открыть модель”  открывает
окно геометрической модели, ассоциированной с активной в данный момент задачей;
открывает
окно геометрической модели, ассоциированной с активной в данный момент задачей;
Кнопка “Решить”  -
перед тем как воспользоваться этой кнопкой необходимо: создать геометрическую
модель, задать свойства сред, граничные условия и построить расчетную сетку;
-
перед тем как воспользоваться этой кнопкой необходимо: создать геометрическую
модель, задать свойства сред, граничные условия и построить расчетную сетку;
Кнопка “Увидеть результат”  -
позволяет отразить результаты решения задачи [15].
-
позволяет отразить результаты решения задачи [15].
Методика работы:
В программе ELCAT разрабатывалась геометрическая
модель магнетрона. Данная модель представлена на рисунке7.
После того как разработка геометрической модели
завершена необходимо задать свойства материалов.

Рисунок 7 -- Геометрическая модель магнетрона с
жидкометаллической мишенью в пакете программ ELCAT.
Для этого выбирают необходимую часть
разрабатываемой конструкции (как показано на рисунке 8) и задают нужные
свойства для этой части.

Рисунок 8 -- Геометрическая модель магнетрона с
жидкометаллической мишенью с выделенной частью корпуса для задания ему
необходимых свойств в пакете программ ELCAT.
Далее, если все материалы без исключения
выбраны, то можно получить распределение магнитного поля в данной конструкции
магнетрона с жидкометаллической мишенью. Для этого в верхней части окна
программы ELCAT выбирается кнопка СЕТКА для построения расчетной сетки (рисунок
9).

Рисунок 9 - Геометрическая модель магнетрона с
жидкометаллической мишенью в программе ELCAT с рабочей сеткой.
После этого кнопка РУШИТЬ позволяет программе ELCAT произвести необходимые расчеты. Для построения
силовых линий магнитного поля для выбранной конструкции магнетрона с теплоизолирующей
мишенью. Результат решения представлен на рисунке 10.
позволяет программе ELCAT произвести необходимые расчеты. Для построения
силовых линий магнитного поля для выбранной конструкции магнетрона с теплоизолирующей
мишенью. Результат решения представлен на рисунке 10.

Рисунок 10 -- Геометрическая модель магнетрона с
жидкометаллической мишенью в программе ELCAT с силовыми линиями магнитного
поля.
Величину индукции магнитного поля можно
вычислить как для отдельной точки, так и для определенного отрезка данной
конструкции. Наглядно это представлено на рисунке 11.

Рисунок 11 - Геометрическая модель магнетрона с
жидкометаллической мишенью в программе ELCAT с выделенной поверхностью мишени.
Также в программе ELCAT величину магнитной
индукции можно увидеть в графическом представлении (рис.12).

Рисунок 12 -- График величины горизонтальной
составляющей индукции магнитного поля для магнетрона с жидкометаллической
мишенью.
Из данного графика видно, что величина магнитной
индукции составляет 73 мТл. Было разработано несколько конструкций магнетрона с
жидкометаллической мишенью для сравнения величины горизонтальной составляющей
магнитного поля, но конструкция магнетрона с полюсным наконечником наиболее
оптимальна, так как в ней значение индукции магнитного поля имеет максимальное
значение из всех остальных конструкций.
Также представлено моделирование конструкции
магнетрона с жидкометаллической мишенью с дополнительной магнитной системой.
Результаты моделирования представлены на рисунке 13.

Рисунок 13- Распределение магнитного поля
магнетрона с жидкометаллической мишенью с дополнительной магнитной системой в
пакете программ ELCAT.
Для примера можно привести другие конструкции
магнетрона с жидкометаллической мишенью, которые представлены на рисунке 14.
Силовые линии магнитного поля конструкций
магнетронов в жидкометаллической мишенью с конусным наконечником и без него
изображены на рисунке 15. Из данного рисунка видно, что силовые линии
магнитного поля распределены по-разному.

Рисунок 14 - Геометрическая модель магнетрона с
жидкометаллической мишенью в пакете программ ELCATа) без полюсногонаконечника,
б) с полюсным наконечником.
С конструкции с полюсным наконечником плазма
будет гореть непосредственно над поверхностью мишени, что препятствует
прогрессивному распылению корпуса МРС.

Рисунок 15 - Геометрическая модель магнетрона с
жидкометаллической мишеньюв пакете программELCAT с силовыми линиями магнитного
поля а) без полюсного наконечника, б) с полюсным наконечником.
Величина индукции магнитного поля для
сравнительной конструкции изображена на рисунке 16.

Рисунок 16 - Величина индукции магнитного поля
на поверхности магнетрона с жидкометаллической мишенью а) без полюсного
наконечника, б) с полюсным наконечником.
Из данных графиков видно, что величина индукции
магнитного поля МРС без полюсного наконечника сравнительно меньше, чем в
конструкции магнетрона с жидкометаллической мишенью с наконечником и составляет
58 и 87 мТл соответственно.
.3 Конструирование жидкофазного магнетрона с
помощью
инструментов для автоматизированного
проектирования AutoCAD
(англ. Computer-Aided Design) - 2- и 3-мерная
система автоматизированного проектирования и черчения, разработанная компанией
Autodesk и на начальных этапах существования этой фирмы - основа её бизнеса.
AutoCAD является наиболее распространённой САПР в мире благодаря средствам
черчения [16].2004 дает проектировщику все необходимые средства для оформления
чертежей: широкий набор графических примитивов, средства для автоматического
нанесения размеров, штриховки, заливки, инструменты для копирования, поворота,
масштабирования создаваемых объектов, функции для компоновки чертежей и
последующего их вывода на печать, возможность создания собственных библиотек
чертежей и часто применяемых элементов.
В AutoCAD можно создавать 3D-модели и
формировать чертежи уже на их основе, можно вести коллективную работу над
проектом, можно связывать информацию, присутствующую на чертеже, с внешними
базами данных.
Ключевая особенность AutoCAD - это его
неисчерпаемые возможности настройки. Менять можно что угодно: пользовательские
меню, систему команд, стили отображения объектов. Развитый интерфейс
программирования, поддерживающий языки AutoLISP, Visual Lisp, Visual Basic for
Applications и даже C++, дает возможность пользователю строить собственные
системы автоматизированного проектирования, в полной мере пользуясь
функционалом AutoCAD. Благодаря этому, AutoCAD стал общепринятой платформой для
создания САПР [17].
При создании рисунка могут использоваться
различные стандарты. Иногда они диктуются государственными и отраслевыми
стандартами или нормами предприятия, иногда - требованиями заказчика. Ключевой
момент как для непосредственных исполнителей, так и для руководителей групп,
контролирующих ход выполнения проекта, - грамотная подготовка начальных
параметров рисунка [18].
Для разработки чертежей конструкции МРС с
жидкометаллической мишенью использовалась программа AutoCAD 2004. Был
разработан комплект чертежей. Общий корпус данного чертежа представлен на
рисунке17.

Рисунок 17-Общий корпус магнетрона с
жидкометаллической мишенью.
В ходе работы была освоена методика работы в
среде AutoCAD. Размеры данной МРС небольшие, так как это устройство
используется в лабораторных целях и, тем самым, не нужно применять мощные
источники питания.
Материалы составных частей:
мишень (свинец);
тигель (молибден);
корпус (сталь 3);
фланец (сталь 3);
постоянные магниты(SmCo)
3. Методы исследования параметров тонких пленок
.1 Методы измерения толщины тонкопленочных
покрытий
Пленка в зависимости от толщины имеет разные
свойства. Какими же способами определяется толщина тонкопленочных покрытий[7]?
Существует огромное количество методов для
определения толщины пленок. В данной работе измерение толщины тонкопленочных
покрытий будет осуществляться методом ступеньки. Данный метод является самым
надежным. Присутствует образец свидетель (специальные пластинки, на которые
наносится пленки в тех же условиях). Если пленка непрозрачна, а в некоторых
случаях также и при исследовании прозрачных пленок, на образце делается
ступенька (часть поверхности остается без пленки). Ступеньку можно получить
экранирования части поверхности при нанесении пленки или вытравливании канавки
специальным реактивом, растворяющим пленку, но не действующим на деталь[19].
Толщина является основным параметром тонких
пленок. Стандартные методы прямого измерения толщины заключаются в определении
разности высот между границами пленка-подложка и пленка-поверхность или
пленка-пленка в случае многослойных структур. Для этого различными способами
(например, раскалывания, царапания или травления) получают поперечное сечение
пленочной структуры и анализируют при помощи микроскопов его изображение [20].
В данной работе для исследования поверхности
использовался контактный метод. Контактные электромеханические приборы,
предназначенные для измерений параметров шероховатости поверхности, называют
профилометрами, а такие же приборы для записи неровностей поверхности - профилографами[21].
Профилометры появились во 2-й половине 30-х
годов XX века одновременно со схожими приборами профилографами. Контактный
профилометр имеет датчик, оборудованный алмазной иглой. Алмазная игла
перемещается перпендикулярно проверяемой поверхности, а датчик генерирует
сигналы. Сигналы, полученные от датчика, проходят через электронный усилитель,
обработка нескольких сигналов позволяет получить усреднённый параметр
шероховатости поверхности - усреднённый показатель количественно характеризует
неровности поверхности в расчёте на определённую длину [22].
Существует два вида профилометров: оптические и
механические. Оптический профилометр содержит источник белого цвета, что
позволяет визуализировать поверхность, восстанавливать трехмерный рельеф
поверхности, проводить измерение толщины покрытий, шероховатости поверхности
[23].
Механический профилометр производит измерение
неровности поверхности с помощью заточенной иглы.
При контактном методе измерения неровностей
поверхности в качестве щупа используют остро заточенную иглу, поступательно
перемещающуюся по определенной трассе относительно поверхности. Ось иглы
располагают по нормали к поверхности. Опускаясь во впадины, а затем, поднимаясь
на выступы во время движения ощупывающей головки по испытуемой поверхности,
игла колеблется относительно головки соответственно огибаемому профилю.
Механические колебания иглы преобразуются, как правило, в электрические при
помощи электромеханического преобразователя того или иного типа. Снятый с
преобразователя полезный сигнал усиливают, а затем измеряют его параметры,
характеризующие неровности исследуемой поверхности (профилометрирование), или
записывают параметры профиля поверхности в заранее выбранных вертикальном и
горизонтальном масштабах (профилографирование) [21].
Измерение толщины покрытия производилось с
помощью контактного профилометра, степени точности 1 по ГОСТ 19300-86, модели
130, предназначен для измерения профиля и параметров шероховатости по системе
средней линии (ГОСТ 25142-82) в соответствии с диапазонами значений,
предусмотренными ГОСТ 2789-73.Данный профилометр представлен на рисунке 18.

Рисунок 18- Внешний вид профилометра модели 130
с управляющим компьютером.
Принцип работы профилометра основан на
ощупывании алмазной иглою неровностей измеряемой поверхности в процессе её
перемещения вдоль измеряемой поверхности и последующем преобразованием
возникающих при этом механических колебаний иглы индуктивным датчиком в
измеряемый сигнал. Схематическая конструкция профилометра модели 130 показана
на рисунке19.

Рисунок 19 - Схематическая конструкция
профилометра модели 130.
Измеряемая деталь устанавливается на плиту 1
стойки или, если это необходимо, на призму 2, которую можно двигать по плите
вдоль направления трассирования, а также класть набок для укладки плоских
деталей. Датчик 14 закрепляется своим хвостовиком диаметром 10 мм в гнезде
движущегося при трассировании штока привода 12 и фиксируется винтом 13. Привод
7, предназначенный для осуществления трассирования, крепится на каретке 10
стойки винтом крепления привода 5. Каретка имеет сзади стопорный винт, при
ослаблении которого каретка может свободно перемещаться по колонне 11 стойки
вверх-вниз с поворотом вокруг оси колонны. При этом для страховки от удара
датчика о деталь при перемещении каретки вниз необходимо использовать стопорное
кольцо 4. После фиксации каретки на какой-то ориентировочной высоте каретка
может плавно перемещаться в вертикальном направлении по колонне стойке с помощью
рукояток 8 с обеих сторон каретки с фиксатором 9 перемещения каретки, который
наряду с усилителем 3 колонны стойки служит для уменьшения вибраций датчика
относительно детали в процессе трассирования.
На плите могут измеряться детали высотой до 220
мм. Если повернуть привод с датчиком на 180 градусов, то под датчик можно
устанавливать сколь угодно большие детали, например, железнодорожное колесо.
Измерения можно проводить и без стойки, сняв с неё привод с датчиком, и положив
датчик на его ножки 6 на плоскость измеряемой детали. Привод с датчиком можно
также просто положить на стол, подкладывая под датчик измеряемые детали и
подкладывая под привод пластины толщиной, примерно равной высоте измеряемой
детали (плюс 1 мм или минус 0.2 мм относительно высоты измеряемой детали).
Из передней части корпуса 14 датчика (выноска по
рисунку) выступает носик датчика 15 из нержавеющей стали, на конце которого
снизу укреплена твердосплавная опора 17, и за ней на расстоянии около 0.5 мм
выступает алмазная игла датчика 16 [24].
4. Экспериментальные исследования
.1 Схема экспериментальной установки «УВН 2Н»
Схема установки показана на рисунке 20.
Вакуумная схема (ВС) собрана по стандартной
схеме получения высокого вакуума на базе диффузионного паромасляного насоса
Н-400.
ВС включает в себя:
Диффузионный паромасляный Н-400
Вакуумный золотниковый насос АВЗ-20д
Магистраль откачки диффузионного насоса
Затвор
Клапан вакуумный электромагнитный.
Клапан вакуумный электромеханический
Клапан вакуумный электромеханический.
Насос НВР-20 служит для форвакуумной откачки
диффузионного насоса и предварительной откачки рабочей камеры.

Рисунок - 20 Вакуумная схема установки КВО.
На рисунке 20 представлена схема вакуумной
установки «УВН 2Н» На данном рисунке VF 1 VF 2 VE1, VE2, VE3, VE4 - клапан
вакуумный с электромагнитным приводом; Р1, СV1 ;VP1, VP2, VP3 - клапан
вакуумный с электромеханическим приводом; VT1- затвор вакуумный с
электромеханическим приводом; ND1 - насос вакуумный диффузионный паромасляный
(Н-250); NL1 - форвакуумный насос (НВР-20); КМ1 - компрессор.

Рисунок 21 - Внешний вид установки «УВН 2Н».
На рисунке 21 представлен внешний вид установки
«УВН 2Н». Слева представлен блок управленияустановки. На рисунке справа можно
увидеть рабочую камеру установки «УВН 2Н».
Включение установки и получение вакуума:
Открыть общий вентиль подачи воды на установку.
Открыть вентиль подачи воды на диффузионный
насос.
Подать напряжение на установку включив тумблер
«380 В 50 Гц»
Включить источник питания постоянного тока
Закрыть клапан VЕ4 в положении «Закрыт». При
этом на панели должна загореться соответствующая (VЕ4) индикаторная лампа
красного цвета.
Включить форвакуумный насос NL кнопкой «ПУСК
NL».
Открыть клапан VР1, VР3 установив тумблер VР2,
VР3 в положении «Открыт» При этом на панели должна загореться соответствующая
(VР1, VР3) индикаторная лампа зеленого цвета.
После достижения разряжения в камере ~ 10 Па
(соответствует 2,5 mV (10 Па) по шкале термопарного индикатора вакуумметра ВИТ
- 3).
Закрыть клапан VР1, открыть клапан VР2
Включить диффузионный насос ND кнопкой «ПУСК ND»
на панели. Выход диффузионного насоса в рабочий режим происходит через ~ 40÷45
мин.
Закрыть клапан VР2, через 30 сек ~ 1 мин открыть
затвор VТ1.
Камеру откачиваем до давления 2∙10-7mV(10-2
Па) по ионизационному датчику на ВИТ-3. После проведения вышеуказанных процедур
и достижения необходимого разряжения в рабочей камере установка готова к работе
с ионно-плазменными устройствами.
.2 Методика эксперимента
а) изготовление образцов
Для получения тонких пленок использовался
магнетрон с жидкометаллической мишенью. Пленки осаждались в вакуумной среде на
стеклянные подложки размером76х25 мм.
Перед напылением подложки были подвержены
механической очистке с помощью смеси зубного порошка с водой. Затем стекло
помещалось над магнетроном с жидкометаллической мишенью, после чего
производилось напыление тонких пленок в атмосфере аргона с использование
свинцовой мишени.
Было произведено напыление двадцати двух
образцов при различных режимах. Параметры напыления образцов представлены в
таблицах 1 - 3.
б) измерение толщины
Измерение толщины тонкопленочных покрытий
осуществлялось с помощью профилометра.
Перед началом измерения толщин тонких пленок
была вырезана ступенька на середине покрытия каждого из образцов с помощью
бритвы.
Образец с пленкой помещается на предметный
столик, щуп с остро заточенной иглой опускается на поверхность образца. Игла
поступательно перемещается по определенной трассе относительно поверхности
пленки. Механические колебания иглы преобразуются в электрические, которые
передаются на персональный компьютер для последующей обработки и анализа.
После обработки на экране ЭВМ отображается
фотография поверхности, профиль поверхности и основные параметры, по которым
можно количественно оценить толщину осажденной пленки.
5. Результаты экспериментальных исследований
.1 Вольтамперные характеристики
Напыление производилось в вакуумной среде с
использование магнетрона с теплоизолированной мишенью. Внешний вид данного
магнетрона представлен на рисунке 22.

Рисунок 22- Внешний вид МРС с теплоизолированной
мишень.
В результате экспериментов было произведено
напыление двадцати двух образцов. Образцы представляли собой тонкие пленки
свинца, осажденные на стеклянные подложки. Свинец Тпл=600К. В ходе напыления
использовалась дополнительная магнитная система, которая представляла собой
кольцеобразную магнитную ловушку. Также изменялось расстояние между мишенью и
подложкой. Результаты данного эксперимента приведены ниже,
где:-
расстояние мишень-подложка, см;- выход на режим, с;- время напыления, с;
Рраб
- давление рабочего газа, Па;- напряжение на магнетроне, В;- ток разряда, А;
Р
- мощность, Вт.
Температура
плавления свинца Тпл=600К, давление откачки Р = 10-2 Па.
Таблица
1 - Протокол напыления образцов жидкофазным магнетроном с дополнительной
магнитной системой (15см)
|
Параметры
напыления
|
|
d,
см
|
t1,c
|
t2,c
|
Pраб
, Па
|
|
15
|
320 240 (800 Bт)
|
60 30 (800 Bт)
|
2*10-5
мВт
|
|
Напыление
|
|
Р,
Вт
|
I,
A
|
U,
B
|
|
500
|
0.90
|
560
|
|
600
|
1.00
|
595
|
|
700
|
1.14
|
618
|
|
800
|
1.18
|
672
|
|
|
|
|
|
|
Таблица 2 - Протокол напыления образцов
жидкофазным магнетроном без дополнительной магнитной системы (15 см)
|
Параметры
напыления
|
|
d,
см
|
t1,c
|
t2,c
|
Pраб
, Па
|
|
15
|
320 240 (800 B)
|
60 30 (800 B)
|
2*10-5
мВт
|
|
Напыление
|
|
Р,
Вт
|
I,
A
|
U,
B
|
|
500
|
0.78
|
653
|
|
600
|
0.85
|
712
|
|
700
|
0.95
|
738
|
|
800
|
1.09
|
742
|
Параметры
напыления
|
|
d,
см
|
t1,c
|
t2,c
|
Pраб
, Па
|
|
13
|
320
|
60
|
2*10-5
мВт
|
|
Напыление
|
|
Р,
Вт
|
I,
A
|
U,
B
|
|
500
|
0.79
|
637
|
|
600
|
0.92
|
650
|
|
700
|
1.08
|
651
|
|
|
|
|
|
|
Приведем графики зависимости тока и напряжения
от мощности (см. рисунки 23 -24). Данные с полученных графиков будут
использоваться для определения скорости осаждения покрытий и расчета
коэффициента эрозии поверхности мишени в программе для расчета для расчета
скорости эрозии и осаждения пленок.
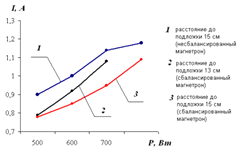
Рисунок 23- Зависимостьтока от мощности для
тонкопленочных покрытий свинца.
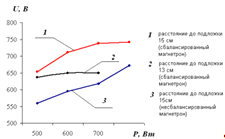
Рисунок 24 - Зависимость напряжения от мощности
для тонкопленочных покрытий свинца.
Данные значения необходимы для получения
теоретических результатов: скорость осаждения, коэффициент эрозии поверхности
мишени. После расчетов полученные теоретические результаты будут сопоставлены с
экспериментальными.
5.2 Измерение толщины тонкопленочных покрытий с
помощью
профилометра марки 130
Для измерения толщины тонких пленок свинца
использовался профилометр марки 130.Ниже приведено графическое представление
результатов. На рисунке 25 представлен результат измерения толщины пленки
свинца с использование дополнительной магнитной системы. Параметры
эксперимента: расстояние до подложки: 15 см, Р откачки = 3*10-7 мВт, Р аргона =
2*10-5 мВт, стабилизация по мощности: 500 Вт, выход на режим: 5 минут 20
секунд, время напыления: 1 минута, I = 0,9 А,U = 560 В, толщина 6,88 мкм,
скорость напыления 14,7 нм/с.

Рисунок 25-Изображениефрагмента рабочей программы
для профилометра поверхности образца №2, полученного с помощью магнетрона с
жидкометаллической мишенью, используя дополнительную магнитную систему.

Рисунок 26- Профиль поверхности образца №2,
полученного с помощью магнетрона с жидкометаллической мишенью, используя
дополнительную магнитную систему(расстояние мишень подложка 15см).
После измерения толщины данной пленки (образец
№2) методом ступеньки выяснилось, что она составила 6.88 мкм.
На рисунке 27 также измерение толщины свинцовой
пленки, но уже без дополнительной магнитной системы. Параметры эксперимента:
расстояние до подложки: 15 см, Р откачки = 3*10-7 мВт, Р аргона = 2*10-5 мВт,
стабилизация по мощности: 600 Вт, выход на режим: 5 минут 20 секунд, время напыления:
1 минута, I = 0,85 А, U = 712 В, толщина 17,5 мкм, скорость напыления 291,3
нм/с.
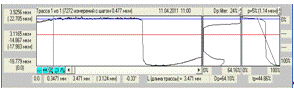
Рисунок 27 - Изображение фрагмента рабочей
программы для профилометра поверхности образца №11, полученного с помощью
магнетрона с жидкометаллической мишенью без дополнительной магнитной системы.

Рисунок 28 -Профиль поверхности образца №11,
полученного с помощью магнетрона с жидкометаллической мишень без дополнительной
магнитной системы (расстояние мишень подложка 15см)
На рисунке 29 приведен результат измерения
толщины тонкой пленки свинца с учетом уменьшения расстояния между мишенью и
подложкой.
Параметры эксперимента: расстояние до подложки:
13 см, Р откачки = 3*10-7 мВт, Р аргона = 2*10-5 мВт, стабилизация по мощности:
600 Вт, выход на режим: 5 минут 20 секунд, время напыления: 1 минута, I = 0,89
А,U = 688 В, толщина 18,7 мкм, скорость напыления 311,7.

Рисунок 29 - Изображение фрагмента рабочей
программы для профилометра поверхности образца №20, полученного с помощью
магнетрона с жидкометаллической мишенью без дополнительной магнитной системы
(расстояние мишень подложка 13см)

Рисунок 30 -Профиль поверхности образца №20, полученного
с помощью магнетрона с жидкометаллической мишенью без дополнительной магнитной
системы (расстояние мишень подложка 13см)
Остальные графики профиля толщины тонких пленок
представлены в приложении А.
Из полученных данных видно, что толщины тонких пленок
и скорости их напыления имеют относительно большие значения. Если сравнить
данные показатели со значениями толщин и скоростей МРС с твердой мишенью, то
можно увидеть, что показатели МРС с жидкой мишенью превосходят в десятки раз.
Это говорит о том, что данный магнетрон позволяет получать «толстые»
тонкопленочные покрытия. Такие покрытия являются незаменимой составляющей в
различных отраслях науки и техники - получение микросхем, космическая
промышленность и т.д.
.3 Измерение скорости напыления тонкопленочных
покрытий
Вычисление скорости напыления осуществлялось по
следующей формуле V = h / t , где h-толщина тонкой пленки, t - время напыления
данной пленки, V - скорость напыления пленки. Результаты приведены в таблице 4.
Таблица 4 - Протокол скорости осаждения образцов
при различных режимах напыления
|
P
стаб., мВт
|
Напыление
с дополнительной магнитной системой (15 см)
|
Напыление
без дополнительной магнитной системой (15 см)
|
Напыление
без дополнительной магнитной системой (13 см)
|
|
h,
мкм
|
V,
нм/с
|
h,
мкм
|
V,
нм/с
|
h,
мкм
|
V,
нм/с
|
|
500
|
3.36
|
56.0
|
8.5
|
141.7
|
7.1
|
118.3
|
|
500
|
6.88
|
114.7
|
11.0
|
183.3
|
7.8
|
130.0
|
|
600
|
7.70
|
128.3
|
17.5
|
291.3
|
19.5
|
325.0
|
|
600
|
10.90
|
181.7
|
21.6
|
360.0
|
18.7
|
311.7
|
|
700
|
20.20
|
336.7
|
25.1
|
418.3
|
31.9
|
531.7
|
|
700
|
31.00
|
516.7
|
21.0
|
346.0
|
27.9
|
463.7
|
|
800
|
14.90
|
496.7
|
9.5
|
316.7
|
|
|
|
800
|
15.00
|
499.3
|
12.9
|
430.0
|
|
|
Полученные данные представлены графически в виде
зависимости V(P)(рисунок 31).
Анализируя график можно сделать выводы, что
скорости напыления при разных режимах напыления для разных систем лежат приблизительно
в одном диапазоне. Это говорит о том, что наличие дополнительной магнитной
системы и уменьшение расстояния мишень-подложка существенно не влияют на
скорости напыления.
Однако, для более точных результатов необходимо
провести серию экспериментов. Более того, очень сложно создать идентичные
условия для проведения экспериментов.
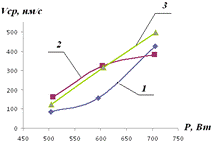
Рисунок 31 - График зависимости Vср (Р): 1-
несбалансированный магнетрон (d=15 см), 2- сбалансированный магнетрон (d=15
см), 3- сбалансированный магнетрон (d=13 см).
Если рассмотреть процесс осаждения тонких
пленок, полученных с помощью магнетрона с жидкометаллической мишенью, используя
дополнительную магнитную систему, то столб плазмы горит от катода до анода.
Концентрация рабочего газа у подложки уменьшатся с внедрением дополнительной
магнитной системы. Следовательно, скорости напыления будут меньше, но пленки
лучше, т. е. структура пленок будет более плотной.
Что касается расстояния между подложкой и
мишенью, то оно влияет на процесс осаждения тонкопленочного покрытия. Это видно
из предыдущих экспериментов. Если расстояние между мишенью и подложкой очень
мало (до 10 см), то начинается процесс реиспарения. Процесс реиспарения
заключается в следующем: материал мишени, который очень быстро осадился на
подложку, начинает испаряться и капать вниз с подложки (в нашем случае - капли
свинца). Исходя из этого, выбрано расстояние для напыления более 10 см (15 и 13
см).
.4 Измерение величин магнитного поля с помощью
магнитометра
Измерение величины магнитного поля
осуществлялось с помощью магнитометра. Внешний вид данного магнитометра
представлен на рисунке 32.

Рисунок 32 - Внешний вид магнитометра.
Для измерения горизонтальной составляющей
индукции магнитного поля использовался магнитометр.
Щуп магнитометра подводился перпендикулярно к
поверхности мишени и каждые 3 мм, измерялась горизонтальная составляющая
индукции магнитного поля. После чего строилась зависимость индукции магнитного
поля от ширины мишени. Полученные результаты представлены на рисунке 33. На
данном рисунке представлена положительная часть распределения горизонтальной
составляющей индукции магнитного поля.
Анализируя график, можно определить максимум
магнитного поля Вx(эксп)= 61,2 мТл, что немного меньше результата полученного с
помощью компьютерного моделирования в пакете программ ELCUT (73 мТл).

Рисунок 33 - График распределения горизонтальной
составляющей индукции магнитного поля от середины до центра поверхности мишени.
6. Механизмы эрозии поверхности. Определение
скорости роста пленок
и коэффициентов эрозии
Методы обработки твёрдых тел с помощью пучков
заряженных частиц являются перспективным направлением в радиационном
материаловедении. Заметное место среди них занимают технологии, построенные на
использовании эффекта эрозии поверхности.
Попадая в конденсированное вещество, ускоренная
частица теряет свою энергию в результате столкновений с атомами среды. При этом
происходит их ионизация, возбуждение, смещение, образование радиационных
дефектов, нагрев облучаемого вещества и другие эффекты. Структурно-фазовые
превращения, вызванные тепловым действием пучка, регламентируются балансом
энергии, т.е. интенсивностью её ввода в твёрдое тело и её потерь из системы по
всем каналам диссипации (теплопроводность, фазовые превращения, испарение и
т.д.).
Под термином «эрозия» здесь понимается явление
разрушения поверхности твёрдого тела в результате удаления вещества в виде
отдельных атомов, молекул или их соединений как в жидком, так и в твердом
состояниях.
В основе его лежат следующие процессы:
радиационно-стимулированная и тепловая десорбция
атомов и молекул;
распыление атомов, расположенных на поверхности
и вблизи неё;
блистеринг (отслоение вещества мишени в
результате образования куполообразных вздутий в приповерхностном слое при
имплантации в них больших доз ионов слаборастворимых газов);
испарение атомов из твёрдой фазы (сублимация);
испарение атомов из жидкой фазы, полученной в
результате плавления мишени;
откол мишени вследствие её хрупкого разрушения;
разбрызгивание вещества из жидкой фазы и др.
Ключевым параметром для характеристики
эффективности процесса удаления вещества с поверхности мишени во время
облучения является коэффициент эрозии (количество удаленных атомов на одну
падающую частицу) [25].
Магнетронные распылительные системы (МРС)
являются очень эффективным средством осаждения тонких пленок на твердотельные
подложки. Однако им свойственен существенный недостаток - относительно малая
производительность (для МРС на постоянном токе скорость роста металлических
пленок обычно составляет 1...10 нм/с). Ситуация существенно улучшается, если
появляется возможность использовать жидкофазную мишень. Благодаря этому удается
примерно на 1..2 порядка увеличить скорость роста осаждаемых покрытий [26].
Этот эффект связан с тем, что при температурах,
превышающих точку плавления, дополнительно к распылению возникает интенсивное
испарение атомов с поверхности мишени. Поэтому скорость осаждения покрытий
также заметно увеличивается. Кроме этого, за счет того, что в жидкой фазе все
металлы - немагнитные, появляется возможность осаждать пленки из железа и
никеля. Эти обстоятельства представляет большой интерес для технологических
целей.
Однако МРС с жидкометаллическими мишенями
сегодня еще не получили широкого промышленного применения. Одна из причин этого
состоит в том, что их технологические возможности изучены пока недостаточно.
Было бы желательно иметь средство для прогнозирования плотности потока
эмитирующих с поверхности атомов в зависимости от мощности, вкладываемой в
магнетронный разряд.
Данное прогнозирование можно осуществить с
помощью разработанной модели процесса эмиссии атомов с поверхности
жидкометаллических мишеней магнетронных распылительных систем, в основе которой
лежит представление о том, что их поток складывается из двух независимых
компонент, создаваемых столкновительным распылением и испарением. С ее помощью
получены данные о характеристиках потока атомов с поверхности и скорости роста
осаждаемых покрытий в зависимости от плотности мощности магнетронного разряда
[25].
Ниже приведены графики зависимости коэффициента
эрозии поверхности мишени от мощности при напыление образцов с помощью
различных систем напыления при разных режимах. Данные графики построены с
использованием данных, полученных в программе для расчета скорости осаждения
покрытий и определения коэффициентов эрозии покрытий.
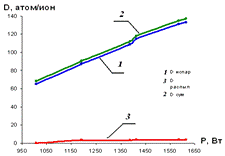
Рисунок 34 - Зависимость коэффициента эрозии
поверхности мишени от мощности при напылении образцов с дополнительной
магнитной системой (расстояние мишень-подложка 15 см).

Рисунок 35 - Зависимость коэффициента эрозии
поверхности мишени от мощности при напылении образцов без дополнительной магнитной
системы (расстояние мишень-подложка 15 см).
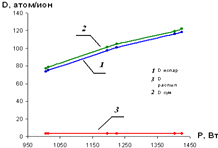
Рисунок 36 - Зависимость коэффициента эрозии
поверхности мишени от мощности при напылении образцов без дополнительной
магнитной системы (расстояние мишень-подложка 13 см).
Из графиков видно, что с появлением
испарительной компоненты коэффициент эрозии поверхности мишени. Нелинейность
наблюдается за счет разогревания поверхности. Данную нелинейность можно
наблюдать на всех трех графиках. За счет испарения увеличивается коэффициент
эрозии примерно на два порядка.
Таблица 5 - Сравнение расчетных и
экспериментальных значений скорости осаждения покрытий
|
Pстаб.,
Вт
|
Ррасчет,
Вт
|
I,
А
|
U,
В
|
(I*1.44),
А
|
(U*1.2),
В
|
J,
А/м2
|
Dисп,
атом/ион
|
Dрасп
атом/ион
|
Dсумм
атом/ион
|
Vdep
теор, нм/с
|
Vdep
экспер,нм/с
|
|
Напыление
с использованием дополнительной магнитной системы (15 см)
|
|
|
500
|
1008
|
0.90
|
560
|
1.30
|
672.0
|
182
|
65.2
|
3.00
|
68.2
|
168
|
56.0
|
|
500
|
1008
|
0.90
|
560
|
1.30
|
672.0
|
182
|
65.2
|
3.00
|
68.2
|
168
|
114.7
|
|
600
|
1190
|
1.00
|
595
|
1.44
|
714.0
|
201
|
86.9
|
3.19
|
90.1
|
278
|
128.3
|
|
600
|
1192
|
1.00
|
596
|
1.44
|
715.2
|
201
|
87.4
|
3.20
|
90.6
|
278
|
181.7
|
|
700
|
1409
|
1.14
|
618
|
1.64
|
741.6
|
229
|
109.0
|
3.32
|
112
|
384
|
336.7
|
|
700
|
1413
|
1.08
|
654
|
1.56
|
784.8
|
218
|
115.0
|
3.50
|
118
|
384
|
516.7
|
|
800
|
1586
|
1.18
|
672
|
1.70
|
806.4
|
238
|
131.0
|
3.61
|
135
|
450
|
496.7
|
|
800
|
1615
|
1.20
|
673
|
1.73
|
807.6
|
242
|
133.0
|
3.61
|
137
|
450
|
499.3
|
|
Напыление
без дополнительной магнитной системы (15 см)
|
|
|
500
|
1019
|
0.78
|
653
|
1.12
|
783,6
|
157
|
77.9
|
3.52
|
81.4
|
199
|
141.7
|
|
500
|
1012
|
0.76
|
666
|
1.09
|
799.2
|
153
|
78.6
|
3.59
|
82.2
|
168
|
183.3
|
|
600
|
1210
|
0.85
|
712
|
1.22
|
854.4
|
171
|
107.0
|
3.83
|
110.0
|
278
|
291.3
|
|
600
|
1201
|
0.87
|
690
|
1.25
|
828.0
|
175
|
102.0
|
3.71
|
106.0
|
278
|
360.0
|
|
700
|
1402
|
0.95
|
738
|
1.37
|
885.6
|
192
|
129.0
|
3.95
|
133.0
|
384
|
418.3
|
|
700
|
1418
|
1.19
|
596
|
1.71
|
715.2
|
239
|
105.0
|
3.20
|
109.0
|
384
|
346.0
|
|
800
|
1618
|
1.09
|
742
|
1.57
|
890.4
|
220
|
148.0
|
3.98
|
152.0
|
450
|
|
800
|
1617
|
1.10
|
735
|
1.58
|
882.0
|
221
|
147.0
|
3.96
|
151.0
|
450
|
430.0
|
|
Напыление
без дополнительной магнитной системы (13 см)
|
|
|
500
|
1007
|
0.79
|
637
|
1.14
|
764.4
|
159
|
73.9
|
3.41
|
77.3
|
218
|
118.3
|
|
500
|
1014
|
0.79
|
642
|
1.14
|
770.4
|
159
|
75.2
|
3.44
|
78.6
|
218
|
130.0
|
|
600
|
1196
|
0.92
|
650
|
1.32
|
780.0
|
185
|
95.9
|
3.50
|
99.4
|
360
|
325.0
|
|
600
|
1225
|
0.89
|
688
|
1.28
|
825.6
|
179
|
104.0
|
3.70
|
108.0
|
361
|
311.7
|
|
700
|
1404
|
1.08
|
650
|
1.56
|
780.0
|
218
|
114.0
|
3.48
|
117.0
|
498
|
531.7
|
|
700
|
1425
|
1.07
|
666
|
1.54
|
799.2
|
215
|
118.0
|
3.58
|
122.0
|
498
|
463.7
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Для построения зависимости скорости осаждения
покрытий с учетом различных составляющих процесса напыления также
использовались данные, полученные в программе для расчета скорости осаждения
покрытий и расчета коэффициентов эрозии поверхности мишени. Данные представлены
в таблице 6.
Таблица 6 -Влияние компонентов процесса на
величину скорости осаждения покрытий при различных режимах
|
P
стаб., Вт
|
Vdep
испарение, нм/с
|
Vdep
распыление, нм/с
|
P
стаб., Вт
|
Vdep
испарение, нм/с
|
Vdep
распыление, нм/с
|
P
стаб., Вт
|
Vdep
испарение, нм/с
|
Vdep
распыление, нм/с
|
|
Напыление
с использованием дополнительной магнитной системы (15 см)
|
Напыление
без дополнительной магнитной системы (15 см)
|
Напыление
без дополнительной магнитной системы (13 см)
|
|
500
|
160
|
7.81
|
500
|
191
|
7.91
|
500
|
208
|
10.10
|
|
500
|
160
|
7.81
|
500
|
160
|
7.86
|
500
|
208
|
10.20
|
|
600
|
268
|
9.23
|
600
|
268
|
9.39
|
600
|
348
|
12.00
|
|
600
|
268
|
9.28
|
600
|
268
|
9.33
|
600
|
348
|
12.30
|
|
700
|
373
|
11.00
|
700
|
373
|
10.90
|
700
|
484
|
14.20
|
|
700
|
373
|
11.00
|
700
|
373
|
11.00
|
700
|
484
|
14.40
|
|
800
|
437
|
12.30
|
800
|
437
|
12.60
|
|
|
|
|
800
|
437
|
12.60
|
800
|
437
|
12.60
|
|
|
|
На рисунка 37 - 39 представлены графики
зависимости скорости осаждения покрытий от удельной мощности, показана
зависимость с учетом различных компонент напыления, таких как: распыление,
испарение.
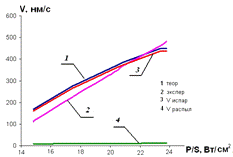
Рисунок 37- Зависимость скорости осаждении
покрытий от удельной мощности для образцов, полученных с помощью магнетрона с
жидкометаллической мишенью с использованием дополнительной магнитной системы
(расстояние мишень- подложка 15 см).

Рисунок 38- Зависимость скорости осаждении
покрытий от удельной мощности для образцов, полученных с помощью магнетрона с
жидкометаллической мишенью без дополнительной магнитной системы (расстояние
мишень- подложка 15 см).
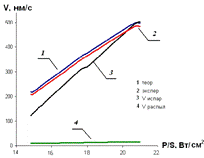
Рисунок 39- Зависимость скорости осаждении
покрытий от удельной мощности для образцов, полученных с помощью магнетрона с
жидкометаллической мишенью без дополнительной магнитной системы (расстояние
мишень- подложка 13 см).
Скорости осаждения зависят от механизмов,
происходящих на поверхности мишени. Если имеется испарительная компонента, то
скорости осаждения покрытий значительно увеличиваются. Из расчетов видно, что
данная составляющая присутствует.
Скорость осаждения материала существенно зависит
от материала тигля. На данный показатель влияет степень черноты тигля
(отношение лучеиспускательной способности какого-либо тела к лучеиспускательной
способности абсолютно черного тела при той же температуре). Чем меньше степень
черноты того или иного материала, тем выше скорость роста осаждаемой пленки.
Для всех реально существующих физических тел степень черноты меньше 1 [27].
Например, если взять графитовый тигель (степень черноты 0,9), то скорости
значительно уменьшатся, это связно с тем, что тигель меньше испускает тепла,
тем самым больше энергии тратится на удаление атомов мишени.
Заключение
В данной работе рассматриваем способы получения
тонкопленочных покрытий в вакууме: термическое испарение, магнетронное
распыление, кроме этого, был рассмотрен случай распыления из жидкой фазы
(магнетронное распыление с теплоизолированной мишенью).Приведены недостатки и
преимущества данных систем.
Была исследована производительность работы
магнетрона с жидкометаллической мишенью. Смоделировано магнитное поле на
поверхности мишени для данной конструкции с помощью программы ELCAT.
Произведено сравнение теоретического и экспериментального значения
горизонтальной составляющей индукции магнитного поля. Затем магнетрон был
начерчен в программе AutoCAD.
Производилось напыление образцов с
использованием следующих конструктивных особенностей - в эксперименте
использовалась дополнительная магнитная система. Также изменялось расстояние
пленка- подложка. Пленки осаждались на стеклянные подложки в атмосфере аргона с
использованием свинцового катода.
Для измерения толщины использовался метод
ступеньки. На образце бритвой вырезалась ступенька, после чего с помощью
профилометра марки 130 было произведено измерение толщины тонкопленочного
покрытия.
Используя данные о толщине, полученные с помощью
профилометра марки 130, были получены скорости осаждения покрытия в случае
использования дополнительной магнитной системы и без неё. Скорости напыления
при разных режимах напыления для разных систем лежат приблизительно в одном
диапазоне. Это говорит о том, что наличие дополнительной магнитной системы и
уменьшение расстояния мишень-подложка существенно не влияют на скорости
напыления. Однако, для более точных результатов необходимо провести серию
экспериментов. Более того, очень сложно создать идентичные условия для
проведения экспериментов. Что касается изменения расстояния мишень-подложка, то
оно влияет на процесс осаждения тонкопленочного покрытия. Это видно из
предыдущих экспериментов. Если расстояние между мишенью и подложкой очень мало
(до 10 см), то начинается процесс реиспарения.
Далее с помощью программы, разработанной на
кафедре водородной энергетики и плазменных технологий, были получены данные о
коэффициентах эрозии поверхности тонкопленочных покрытий. Было выявлено, что
присутствует не только эффект распыления поверхности, но также и испарительная
компонента, которая доминирует при увеличении плотности мощности, что
увеличивает значение коэффициента эрозии поверхности почти на 2 порядка.
Также обнаружена зависимость скорости осаждения
пленок от степени черноты тигля магнетрона с жидкометаллической мишенью. Чем
меньше степень черноты того или иного материала, тем выше скорость роста
осаждаемой пленки.
Список используемых источников
1.
Технология тонких пленок. Т.1./ Пер. с англ. Под ред. М.И. Елинсона, Г.Г.
Смолко ; Под ред. Л. Майселла, Р. Глэнга. - М.: 1970. «Сов. Радио», 1977. - 664
с.
.
В.В. Петухов, А.А. Гончаров, В.А. Коновалов, Д.Н. Терпий, В.А. Ступак. Влияние
режимов распыления и геометрии распылительной системы на толщину и состав
получаемых пленок[Электронный ресурс]. - 2005. - Режим доступа:
#"553504.files/image043.gif">
Рисунок А1 -Профиль поверхности образца №1,
полученного с помощью магнетрона с жидкометаллической мишенью, используя
дополнительную магнитную систему. Толщина 3,36мкм.

Рисунок А2 -Профиль поверхности образца №2,
полученного с помощью магнетрона с жидкометаллической мишенью, используя
дополнительную магнитную систему. Толщина 6,88 мкм.

Рисунок А3 -Профиль поверхности образца №3,
полученного с помощью магнетрона с жидкометаллической мишенью, используя
дополнительную магнитную систему. Толщина 7,7 мкм.

Рисунок А4 -Профиль поверхности образца №4,
полученного с помощью магнетрона с жидкометаллической мишенью, используя
дополнительную магнитную систему. Толщина 10,9 мкм.
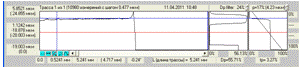
Рисунок А5 -Профиль поверхности образца №5,
полученного с помощью магнетрона с жидкометаллической мишенью, используя
дополнительную магнитную систему. Толщина 20,2 мкм.

Рисунок А6 -Профиль поверхности образца №6,
полученного с помощью магнетрона с жидкометаллической мишенью, используя
дополнительную магнитную систему. Толщина 31 мкм.

Рисунок А7 -Профиль поверхности образца №7,
полученного с помощью магнетрона с жидкометаллической мишенью, используя
дополнительную магнитную систему. Толщина 14,9 мкм.

Рисунок А8 -Профиль поверхности образца №8,
полученного с помощью магнетрона с жидкометаллической мишенью, используя
дополнительную магнитную систему. Толщина 15 мкм.

Рисунок А9 -Профиль поверхности образца №9,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 15см. Толщина 8,5
мкм.
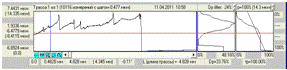
Рисунок А10 -Профиль поверхности образца №10,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 15см. Толщина 11
мкм.

Рисунок А 11 -Профиль поверхности образца №11,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 15см). Толщина
17,5 мкм.

Рисунок А12 -Профиль поверхности образца №12,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 15см).Толщина 21,6
мкм.

Рисунок А13 -Профиль поверхности образца №13,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 15см).Толщина 25,1
мкм.

Рисунок А14 -Профиль поверхности образца №14,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 15см).Толщина 21
мкм.

Рисунок А15 -Профиль поверхности образца №15,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 15см).Толщина 9,5
мкм.

Рисунок А16 -Профиль поверхности образца №16,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 15см).Толщина 12,9
мкм.
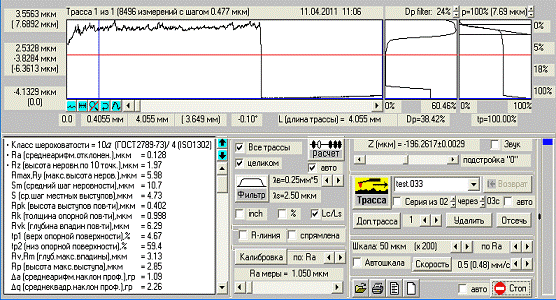
Рисунок А17 -Профиль поверхности образца №17,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 13см).Толщина 7,1
мкм.

Рисунок А18 -Профиль поверхности образца №18,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 13см).Толщина 7,8
мкм.

Рисунок А19 -Профиль поверхности образца №19,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 13см).Толщина 19,5
мкм.
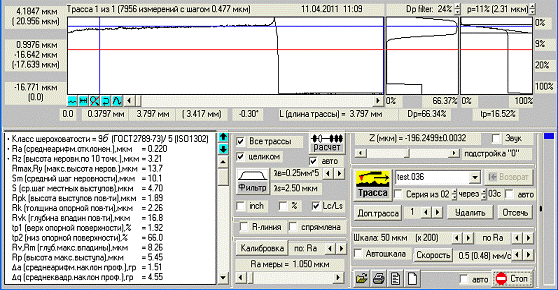
Рисунок А20 -Профиль поверхности образца №20,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 13см.Толщина 18,7
мкм.

Рисунок А21 -Профиль поверхности образца №21,
полученного с помощью магнетрона с жидкометаллической мишенью, без
дополнительной магнитной системы (расстояние мишень подложка 13см).Толщина 31,9
мкм.
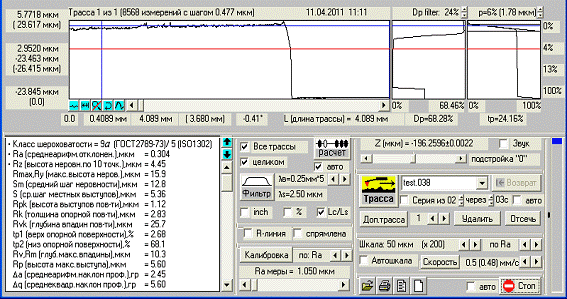
Рисунок А22 -Профиль поверхности образца №22,
полученного с помощью магнетрона с жидкометаллической мишенью, без дополнительной
магнитной системы (расстояние мишень подложка 13см).Толщина 27,9 мкм.
Похожие работы на - Исследование производительности работы магнетронной распылительной системы с жидкометаллической мишенью
|