Спектроскопия ионного рассеяния
Спектроскопия ионного рассеяния
Спектроскопия ионного рассеяния изучает
распределение по энергиям (энергетический спектр) ионов, упруго рассеянных
поверхностью под определенным углом q. Спектр получают при действии на
исследуемую поверхность моноэнергетический пучков ионов. По положению пиков
такого спектра идентифицируют элементы, а по высоте пиков определяют
концентрацию последних. Кроме того, исследуя энергетический спектр в
зависимости от углов падения и рассеяния, можно получить информацию о структуре
поверхности. Энергию иона, упруго рассеянного под углом q при однократном
парном столкновении, можно рассчитать по ф-ле E = E п(1 + М/т)-2{cosq +
[(M2/m2) - sin2q]1/2}2 = КЕ п, где Е п -энергия первичных ионов, М - масса
атомов образца, m - масса первичных ионов, К - коэф. рассеяния ионов. Формула
справедлива при М/т >1. Зная величины m, E п, q, а также заряд (степень
нейтрализации) рассеянных частиц и измерив Е, можно рассчитать M и
идентифицировать поверхностные атомы. В зависимости от энергии первичных ионов
различают спектроскопию рассеяния медленных ионов (E п = 10-17 Ч 10-13 Дж) и
спектроскопию рассеяния быстрых ионов (Е п = 10-14 Ч 10-13 Дж), наз. также
спектроскопией резерфордовского или обратного ядерного рассеяния. В
спектроскопии рассеяния медленных ионов в ионизованном состоянии покидает
поверхность лишь 0,1-1% однократно рассеянных ионов. Т. к. зависимость Кот
сечений рассеяния и эффективность нейтрализации точно неизвестны, то
количественные определения проводят в осн. по эмпирич. градуировочным
зависимостям. Аппаратура состоит из источника однозарядных моноэнергетический
ионов инертных газов (обычно Не +, Ne+, Аr+), напр. дуоплазмотрона с полым
катодом, вакуумной камеры с давлением остаточных газов < 10-7 Па, держателя
мишени, позволяющего вращать образец относительно направления первичного пучка,
и энергетический спектрометра (чаще всего электростатический анализатора). При
этом можно анализировать поверхностные монослои толщиной ~ 0,5 нм. В
спектроскопии рассеяния быстрых ионов в качестве источника первичных ионов (в
основном a-частиц) используют электростатический генератор, тандемный
ускоритель ионов или циклотрон. Ускоритель ионов должен давать
высокомонохроматичные пучки первичных ионов в широком интервале E п. Для
регистрации энергетический спектра рассеянных ионов обычно применяют
полупроводниковый детектор (с разрешением 5-20 кэВ) в сочетании с
многоканальным анализатором импульсов.
Количественная интерпретация данных о рассеянии
быстрых ионов проще, чем в случае медленных ионов, и проводится с применением
резерфордовского закона рассеяния, когда эффектом экранирования ядер
электронами можно пренебречь. Частица, отраженная от поверхности твердого тела,
обладает большей энергией, чем частица, отраженная от внутренних слоев мишени.
Потери энергии связаны с электронным и ядерным торможением внутри твердого
тела. Т.к. сечение рассеяния невелико, часть ионов, проникнувших в глубь
мишени, двигается по прямой, испытывая в основное электронное торможение. После
соударения с атомом, в результате которого направление движущегося иона
меняется на угол > 90° (обратное рассеяние), он под действием электронного
торможения опять по прямой направляется к поверхности материала. Т. обр.,
фиксируя спектры энергетический потерь обратнорассеянных ионов, можно без
разрушения образца получить информацию о распределении определяемого элемента
по глубине. Напр., используя рассеяние a-частиц с энергией ~ 10-13 Дж, можно
исследовать слои толщиной в доли мкм с разрешением по глубине ~ 20 нм без
послойного травления, которое необходимо в случае использования медленных
ионов. Разрешение по глубине зависит от массы и энергии первичных ионов, массы
атомов материала и энергетический разрешения регистрирующей аппаратуры. По
величине потерь энергии можно определять также толщину пленок на подложках.
Пределы обнаружения элементов в И. р. с. достигают 10 %. Этот метод применяют в
основном для определения тяжелых примесей в легких основах: с использованием
медленных ионов - на реальной поверхности, с использованием быстрых ионов - в
субмикронных поверхностных слоях твердых тел (гл. обр. полупроводников).
Метод спектроскопии обратно рассеянных ионов
низких энергий (СОРИНЭ) основан на эффекте парного упругого рассеяния
налетающих ионов атомами поверхности и заключается в бомбардировке поверхности
ионами и в регистрации под определенным углом энергетического спектра вторичных
(рассеянных) ионов. Спектр содержит максимумы (пики), по энергии которых
определяется масса атомов поверхности, а по величине пика - их концентрация.
При низких энергиях соударений (ниже 10 кэВ) размер иона (сечение рассеяния)
становится сравнимым с расстоянием между атомами. Поэтому рассеяние в
результате парного упругого соударения происходит только от одного внешнего
слоя атомов. Поэтому СОРИНЭ является методом анализа элементного состава
поверхности только одного внешнего моноатомного слоя поверхности.

Рис. 1
Налетающий первичный ион с массой М0 и энергией
Е0 сталкивается с покоящимся атомом поверхности (имеющим массу М1 и энергию
Е2=0), передает ему часть своей кинетической энергии и изменяет свою траекторию
от первоначального направления на угол θ (угол
рассеяния). Атом отдачи М1 с полученной энергией Е2 отлетает под углом отдачи χ
вглубь
твердого тела. Энергии рассеянного иона Е1 и атома отдачи Е1 определяются из
условия законов сохранения энергии и импульса по примеру расчета столкновения
двух бильярдных шаров. Энергия упруго рассеянных ионов и атомов отдачи
определяется соотношениями:
Е1 = Е0[Mо/(Mo+M1)]^2*{cosθ
+[(M1/Mo)^0.5-sin^2θ]^0.5}^2, (1)
E2 = E0M0 M1/ (M0+M1)2 cos2 χ,
где Ео и Мo - энергия и масса бомбардирующих
ионов, θ
- угол
рассеяния, M1 - масса атомов поверхности.
Эти формулы справедливы при М1>Мо. Энергия
отраженных ионов растет с увеличением массы атомов мишени М1, при этом скорость
роста в области больших значений масс атомов замедляется, так как энергия
является функцией отношения масс М1/М0 взаимодействующих частиц.
Величина угла рассеяния зависит от прицельного
параметра p - кратчайшего расстояния траектории иона от центра атома при
отсутствии взаимодействия, изменяется в пределах от нуля до 180о и определяется
интегралом рассеяния проще всего в относительной системе координат(в
О-системе):
θотн = π
- ∫
rмин∞ [p/ (1 - U(r)/Eотн - r2/p2)1/2] dr (2)
где Еотн=Е0[M0/(M0+M2)] - энергия иона в
относительной системе координат; U(r) - потенциал взаимодействия иона с атомом;
rмин - расстояние минимального сближения иона и атома при соударении
(апсидальное расстояние); r - расстояние от иона до центра атома, изменяющееся
от времени. Для перевода значения относительного угла рассеяния θотн
в значение в лабораторной системекоординат θ служит
формула
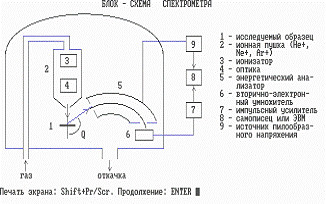
Рис. 2
θ = sinθотн / (M0/M2
- cosθотн). (3)
Спектрометр обратно рассеянных ионов низких
энергий содержит ионную пушку, держатель исследуемого объекта, энергетический
анализатор, помещенные в вакуумную камеру. В качестве первичных ионов
используются ионы инертных газов (He, Ne, Ar, Kr, Xe). Они не взаимодействуют с
поверхностью химически и ввиду малой энергии адсорбции не накапливаются на
поверхности. Большие потенциалы ионизации атомов инертных газов способствуют
повышенной нейтрализации ионов отраженных от второго атомного слоя поверхности
и выделению сигнала в спектре только от первого слоя атомов. Величина
первичного тока выбирается из условия, чтобы в процессе анализа доза облучения
ионами поверхности была бы меньше количества атомов на облучаемой поверхности.
При этом каждый ион в среднем падает на не бомбардированную свежую поверхность.
Этим условием обеспечивается достоверность результатов элементного анализа. При
длительности регистрации спектра в единицы минут величина зондирующего тока
составляет порядка 10-8 - 10-9 А. Чем меньше первичный ток, тем меньше
регистрируемый сигнал рассеянных ионов. Токи рассеянных ионов составляют 10-19
- 10-12 А и измеряются в режиме счета ионов с помощью вторичного электронного
умножителя и широкополосного (импульсного) усилителя.
Энергетический спектр рассеянных ионов
регистрируется под определенным углом рассеяния с помощью энергетического
анализатора с малым углом входа. Если измерить энергии пиков в спектре, то при
известных массе М0, энергии Е0 первичных ионов и угле рассеяния θ
можно
определить массу атомов, от которых рассеиваются ионы с такой энергией по
следующей формуле, полученной из формулы ():
M1 = M0 (1 - E1/E0 - 2 (E1/E0)1/2
cos θ)
/ (1-E1/E0). (4)
Согласно формуле (4) от каждого типа атомов в
спектре образуется один пик. При отсутствии всяких потерь количество рассеянных
ионов Nпик в пике примесных атомов М1’ за время анализа составило бы такую же
долю от дозы облучения N0ион, какую долю составляют примесные атомы NM1’ от
полного количества атомов Nат.полн на анализируемой площади:
пик/N0ион = NM1’/ Nат.полн. (5)
Однако в процессе регистрации происходят потери
ионов за счет физических и аппаратных факторов. К аппаратным факторам Фапп
относятся коэффициент пропускания анализатора kан, счета ионов коллектором
kколл, согласования аксептансов ионной оптики и эмиттансов ионных потоков
kсогл, телесный угол входа в анализатор ΔΩ:
Фапп = kан kколл kсогл ΔΩ.
(6)
ион рассеяние спектроскопия энергия
К физическим факторам Ффиз относятся вероятность
сохранения ионом своего заряда при рассеянии Р+ = 1 - Pн, где Pн - коэффициент
нейтрализации, дифференциальное сечение (площадь) рассеяния иона атомом dσ/dΩ,
изотопный
коэффициент kизотоп, расширяющий пик и уменьшающий его величину:
Ффиз = P+ dσ/dΩ kизотоп.
(7)
В целом все коэффициенты характеризуют
уменьшение количества рассеянных ионов в пике. Число ионов в максимуме пика
определится
пик = (Фапп Ффиз) N0ион NM1’/ Nат.полн, (8)
или ток в максимуме пика примесных атомов равен
пик = (I0ион P+ dσ/dΩ
ΔΩ kизотоп kанал kколл kсогл) СМ1’, (9)
где СМ1’ - концентрация примесных атомов.
Аппаратные коэффициенты могут быть измерены.
Полный физический фактор Ффиз определяется экспериментально для объекта с
известной концентрацией компонентов, то есть методом внешних стандартов. Зная
коэффициенты в скобках и измеряя величину пика, можно определять концентрации
компонентов во внешнем монослое атомов.
Практическая часть
. Зависимость энергии рассеянных ионов от массы
атомов мишени. Энергия рассеянных ионов уменьшается с ростом их массы Мо, т.к.
при этом увеличивается импульс бомбардирующих ионов и повышается возможность
передачи энергии атомам мишени. Энергия рассеянных ионов уменьшается с ростом
угла рассеяния Q (при Q=180 град. столкновение “лобовое” и ведет к наибольшей
потере энергии). В соответствии с зависимостью Е1/Ео = f(М1) интервалу энергии ΔE1,
разрешаемому
энергоанализатором, соответствует разрешаемый интервал массы ΔM1,
и
чем меньше этот интервал, тем выше разрешающая способность метода СОРИНЭ по
массе, определяемая как соотношение Rm = M1/dM1. Разрешающая способность Rm
уменьшается с ростом массы M1, т.к. в области больших масс интервалу ΔE1
соответствуют
большие значения ΔM1. Разрешающая
способность Rm увеличивается с увеличением массы бомбардирующих ионов M0 и угла
их рассеяния θ, что соответствует
изменениям графика функции E1/E0 = f(M1,θ,M0).
Исследуйте графики зависимостей относительной
энергии рассеянных ионов Е1/Ео и разрешающей способности по массе Rm от массы
атомов мишени М1. Варьируя параметры таблицы - значения массы бомбардирующих
ионов M0 (He-4, Ne-20, Ar-40) и угла рассеяния Q (10 - 170 град.) - проследите
изменения графика. Выберите благоприятный режим для анализа заданного (или
выбранного самостоятельно) материала.

Рис. 3
. Форма энергетических спектров двухкомпонентных
материалов.
Определите условия наложения пиков и их
разрешения с помощью изменения значений энергии Eо, массы бомбардирующих ионов
Mo, угла рассеяния Q, разрешения спектрометра R. Энергетический спектр - это
зависимость относительной интенсивности потока рассеянных ионов от их энергии.
Каждому типу атомов поверхности М1 в спектре соответствует один пик с энер-гией
Е1, которая пропорциональна энергии первичного пучка ионов Ео и увеличивается с
ростом М1. Энергия пика увеличивается с уменьшением массы бомбардирующих ионов
М0 и угла их рассеяния θ; Ширина
пиков определяет способность спектрометра разрешать близкие массы. Два пика
считаются разрешенными, если провал между ними превышает 25% амплитуды меньшего
пика. Пики лучше разрешаются, если Мо близка к М1, велик угол рассеяния θ
и
мало отношение R = ΔE/E*100%, называемое
разрешением спектрометра. Амплитуда пиков пропорциональна концентрации атомов
данного рода на поверхности (% занимаемой атомами площади). Амплитуда пиков
увеличивается с ростом разрешения спектрометра R из-за увеличения потока
бомбардирующих ионов, пропускаемых энергоанализатором. Абсолютные значения
амплитуды пиков очень малы (10^-12 - 10^-19 А), что определяется мощностью
ионного источника и стремлением к сохранению состояния поверхности в процессе
измерений.
Введие значения θ, Е0,
M0. На экране получится энергетический спектр поверхности кремния (М2=27) с
примесью бора (М1=11) в первом монослое с содержанием С1=40%. Исследуйте
закономерности изменений энергетического спектра (зависимость интенсивности
потока рассеянных ионов в относительных единицах от энергии ионов) изменяя
разрешение спектрометра R = 1-10%, пределы развертки спектра от Е1 до Е2 (вся
ширина спектра от 0 до Е0) тип адатома (примеси) М1, его концентрацию С1.
Наиболее часто на поверхности встречаются атомы
B (11), N (14), O (16), F (19), Na (23), Mg (24), Al (27), Si (28), P (31), Cl
(35), K (39), Ca (40), Fe (56), Ni (59), As (175), Mo (96), In (115), Cs (132),
Ba (137), W (184), Au (197), Pb (207). Для смены угла рассеяния θ,
энергии
Е0 и массы М0 первичных ионов необходимо выйти из программы Ctrl+C и
перезапустить программу.
Изменяя тип и концентрацию примеси М1(С1) на
поверхности Si-подложки, исследуйте закономерности изменения спектра. Изменяя
разрешение спектрометра и ширину окна развертки спектра, выберите наиболее
лучшую форму отображения спектров.
Определите необходимое разрешение спектрометра
для анализа атомов с близкими к кремнию массами при разных концентрациях
примеси. Определите предел обнаружения для атомов примеси с близкими и дальними
к кремнию массами. Выберите наиболее лучшую форму отображения спектров.

Рис. 4
Спектр двухкомпонентного материала.
Введите значения θ, Е0,
M0, R. На экране получится энергетический спектр. Исследуйте закономерности
изменений энергетического спектра изменяя массы атомов поверхности М1 и М2 и
концентрацию С1. Концентрации атомов С2 изменяется в соответствии C1 + C2 =
100%. Изменением ширины энергетического окна ( ширины развертки) выбирается
информативный вид спектра.
Для смены угла рассеяния θ,
энергии
Е0, массы М0 первичных ионов и разрешения спектрометра R необходимо выйти из
программы Ctrl+C и перезапустить программу.
Заключение
Исследование взаимодействия ионов с поверхностью
является одним из основных направлений физической электроники. В результате
облучения поверхности ионами происходит множество процессов: распыление,
рассеяние, эмиссия электронов и квантов, имплантация. В этом ряду изучение
рассеяния весьма важно для выяснения закономерностей взаимодействия в системе
ион-поверхность твердого тела, а также для развития методов элементного и
структурного анализа.
Как известно, характерными особенностями
энергетического спектра рассеянных частиц, являются пики однократного и
двукратного рассеяния налетающего иона на атомах мишени и пик частиц отдачи.
Большинство выполненных до настоящей работы исследований посвящено изучению
однократного рассеяния и его применению для элементного анализа твердых тел.
Этот вопрос разработан достаточно подробно, так как сигнал от однократно рассеянных
частиц присутствует в спектре практически при любых условиях проведения
эксперимента. Полученные в настоящей работе данные по однократному рассеянию
медленных ионов полностью согласуются с результатами предшествующих
исследований.
Эффект двукратного рассеяния изучен в меньшей
степени. После предсказания и последующего экспериментального подтверждения
эффекта двукратного рассеяния в 1965 году его исследованию было посвящено
существенно меньшее количество работ, чем однократному рассеянию. Вклад частиц,
испытавших двукратное рассеяние, проявляется в энергетических спектрах только
при определенных условиях, которые зависят от энергии бомбардирующих частиц,
ориентации и типа мишени, угла наблюдения. Вид спектра эмитированных частиц,
испытавших двукратное рассеяние, существенно зависит от их зарядового состояния
(атомы или ионы).
Список литературы
1.
Шуппе Г.Н. Диагностика поверхностей электронными, ионными и фотонными зондами.
Учебное пособие. Рязань. 1982 г. - ч.1, 1984 г. - ч.2.
.
Шуппе Г.Н. Физические основы электронной техники. Учебное пособие. РРТИ.
Рязань. 1982 г. - ч.1, 1986 г. - ч.2.
.
Волков С.С. Толстогузов А.Б. Спектроскопия обратно рассеянных ионов низких
энергий. Обзоры по электронной технике. Сер.7. Технология, организация
производства и оборудование. Вып. 15 (820). 1981 г.
.
http://dic.academic.ru/dic.nsf/enc_chemistry/1786/ИОННОГО